針對HPC芯片封裝技術,臺積電已在2019年6月于日本VLSI技術及電路研討會(2019 Symposia on VLSI Technology & Circuits)中,提出新型態SoIC(System on Integrated Chips)之3D封裝技術論文;透過微縮凸塊(Bumping)密度,提升CPU/GPU處理器與存儲器間整體運算速度。
整體而言,期望借由SoIC封裝技術持續延伸,并作為臺積電于InFO(Integrated Fan-out)、CoWoS(Chip on Wafer on Substrate)后端先進封裝之全新解決方案。
運用垂直疊合與微縮體積方法,3D封裝成功提升HPC工作效率
由于半導體發展技術的突破、元件尺寸逐漸微縮之際,驅使HPC芯片封裝發展必須考量封裝所需之體積與芯片效能的提升,因此對HPC芯片封裝技術的未來發展趨勢,除了現有的扇出型晶圓級封裝(FOWLP)與2.5D封裝外,將朝向技術難度更高的3D封裝技術為開發目標。
所謂的3D封裝技術,主要為求再次提升AI之HPC芯片的運算速度及能力,試圖將HBM高頻寬存儲器與CPU/GPU/FPGA/NPU處理器彼此整合,并藉由高端TSV(硅穿孔)技術,同時將兩者垂直疊合于一起,減小彼此的傳輸路徑、加速處理與運算速度,提高整體HPC芯片的工作效率。
臺積電與Intel積極推出3D封裝,將引領代工封測廠一并跟進
依現行3D封裝技術,由于必須垂直疊合HPC芯片內的處理器及存儲器,因此就開發成本而言,比其他兩者封裝技術(FOWLP、2.5D封裝)高出許多,制程難度上也更復雜、成品良率較低。
目前3D封裝技術已對外公告的最新成果,現階段除了半導體代工制造龍頭臺積電最積極,已宣布預計于2020年導入量產SoIC和WoW(Wafer on Wafer)等3D封裝技術外,另有IDM大廠Intel也提出Foveros之3D封裝概念,將于2019下半年迎戰后續處理器與HPC芯片之封裝市場。
隨著半導體代工制造商與IDM廠陸續針對3D封裝技術投入研發資源,也將引領另一波3D封測技術風潮,相信代工封測廠(如日月光、Amkor等)也將加緊腳步,跟上此波3D封裝技術的發展趨勢。
-
臺積電
+關注
關注
44文章
5742瀏覽量
169288 -
intel
+關注
關注
19文章
3494瀏覽量
188192
原文標題:OnePlus 7 Pro評測:詮釋快的新定義
文章出處:【微信號:Qualcomm_China,微信公眾號:高通中國】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 臺積電、Intel推出3D封裝,引領代工封測廠跟進
臺積電、Intel推出3D封裝,引領代工封測廠跟進



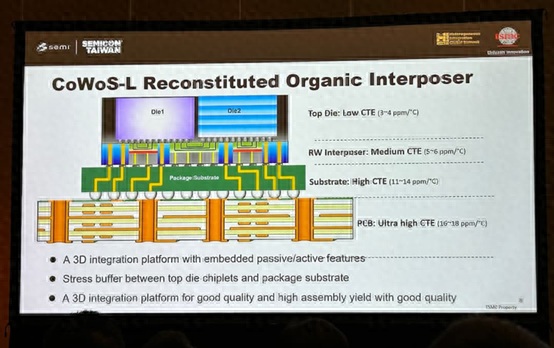










評論