三星計劃明年開始與臺積電在封裝先進芯片方面展開競爭,因而三星正在加速部署3D芯片封裝技術。
三星的3D芯片封裝技術,簡稱“Extended-Cube”或“X-Cube”,在本月中旬進行了演示,目前已經(jīng)可以用于7納米制程。
三星的3D芯片封裝技術是一種采用垂直電連接代替導線的封裝解決方案,允許多層超薄疊加,并使用貫穿硅通孔技術構建邏輯半導體。
利用3D封裝技術,芯片設計人員在創(chuàng)建滿足其特殊要求的定制解決方案時具有更大的靈活性。
本月中旬向公眾展示時,三星透露他們的技術已經(jīng)成功投入試產(chǎn),可以提高芯片的運行速度和能效。
三星目前是全球第二大芯片制造商。
-
芯片
+關注
關注
459文章
52450瀏覽量
439922 -
三星電子
+關注
關注
34文章
15887瀏覽量
182314 -
封裝
+關注
關注
128文章
8642瀏覽量
145330
發(fā)布評論請先 登錄
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
回收三星S21指紋排線 適用于三星系列指紋模組
三星在4nm邏輯芯片上實現(xiàn)40%以上的測試良率
芯片3D堆疊封裝:開啟高性能封裝新時代!






 三星為什么部署3D芯片封裝技術
三星為什么部署3D芯片封裝技術

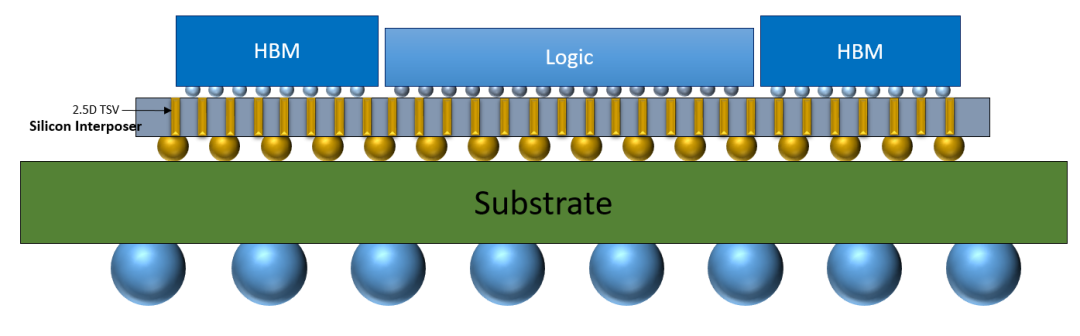

















評論