純化學刻蝕、純物理刻蝕及反應式離子刻蝕
刻蝕有三種:純化學刻蝕、純物理刻蝕,以及介于兩者之間的反應式離子刻蝕(ReactiveIonEtch,RIE)。
純化學刻蝕包括濕法刻蝕和遙控等離子體光刻膠去除。純化學刻蝕中沒有物理轟擊,由化學反應移除物質。純化學刻蝕的速率根據工藝需要可以很高也可以很低。純化學刻蝕一定會有等向性刻蝕輪廓,因此當圖形尺寸小于3um時,就無法使用純化學刻蝕進行薄膜圖形化技術。
由于純化學刻蝕具有很好的刻蝕選擇性,所以純化學刻蝕通常用在剝除工藝上。例如,去光刻膠、去氮化硅、墊基氧化層、屏蔽氧化層和犧牲氧化層等。遙控等離子體(RP)刻蝕是在遠端反應室中利用等離子體產生自由基,再將自由基送入反應室和晶圓產生反應,因此屬于純化學刻蝕。
氯轟擊屬于純物理刻蝕,廣泛使用在電介質濺射回刻削平開口部分,以利于后續的空隙填充。氯轟擊也用于金屬PVD前的清洗過程,用于移除氧化物以減少接觸電阻。氯是一種惰性氣體,制造中不會產生化學反應。材料受氯離子轟擊后從表面脫離,如用一只錘子把材料從表面敲擊移除一樣。
純物理刻蝕的速率一般很低,主要取決于離子轟擊的流量和能量。因為離子會轟擊并移除任何與襯底接觸的材料,所以純物理刻蝕的選擇性很低。等離子體刻蝕中,離子轟擊的方向通常和晶圓表面互相垂直。所以純物理刻蝕主要是朝垂直方向刻蝕,它是一種非等向性刻蝕過程。
反應離子蝕刻(RIE)的名稱可能是有些誤導。這種類型的蝕刻工藝的正確名稱應為離子輔助蝕刻,因為在此蝕刻工藝中的離子不一定有化學反應。例如在許多情況下氯離子被用來增加離子轟擊。而作為一種惰性原子,氯離子是沒有化學反應的。大多數蝕刻制程中的化學活性物是中性的自由基。
在半導體蝕刻加工等離子體中,中性的自由基的濃度比離子濃度高得多。這是因為電離活化能明顯高于解離的活化能,而物種濃度與活化能指數相關。然而,RIE這個詞在半導體業界已被用了很長時間,可能沒有人會改變它。下圖顯示離子輔助蝕刻的原理與早期實驗的結果。
首先將XeF2氣體單獨由閉鎖閥門注入。XeF2是一種不穩定的氣體。徹是一種惰性氣體,所以不會與其他原子形成化學鍵。干法化學刻蝕中通常用于輸送氟自由基。當XeF2接觸到已加熱的單晶硅時,就會分解并釋放出兩個氟自由基。因為氟自由基只有一個不成對的電子,所以能從其他原子獲得一個電子,在化學上很容易起反應。氟會與樣品表面的硅反應形成易揮發性的四氟化硅(SiF4)。下圖中的測量結果表明了這種純化學刻蝕的刻蝕速率很低。
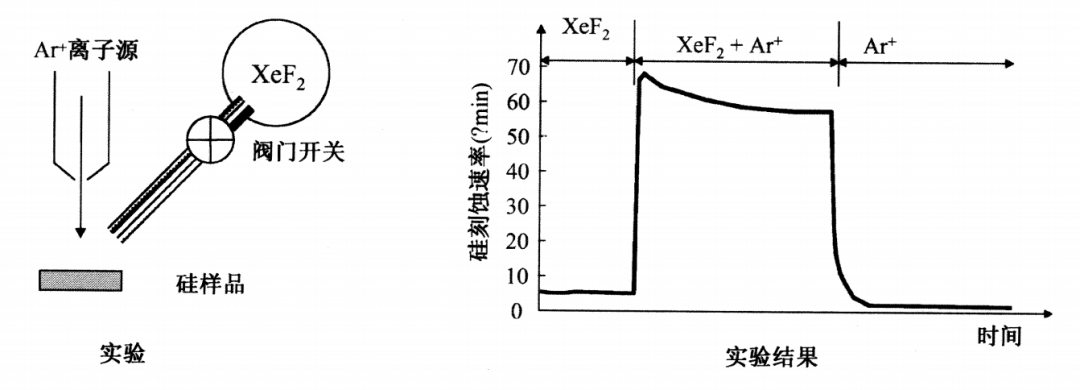
接著開啟氯離子槍。結合了物理的離子束轟擊和氟自由基的化學刻蝕,硅的刻蝕速率明顯增加。當關閉閥門停止輸送XeF2氣流后,硅就單獨由氯離子濺射刻蝕。這是一種純物理刻蝕,刻蝕速率比使用XeF2氣流的純化學刻蝕還要慢。
審核編輯:劉清
-
PVD
+關注
關注
4文章
51瀏覽量
17326 -
反應離子刻蝕
+關注
關注
0文章
6瀏覽量
1861
原文標題:半導體行業(一百五十六)之刻蝕工藝(七)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
【轉帖】干法刻蝕的優點和過程
AOE刻蝕系統
干法刻蝕之鋁刻蝕的介紹,它的原理是怎樣的






 純化學刻蝕、純物理刻蝕及反應式離子刻蝕介紹
純化學刻蝕、純物理刻蝕及反應式離子刻蝕介紹

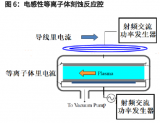
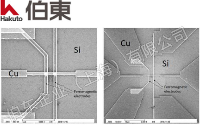

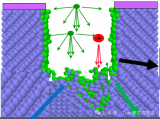












評論