水浸超聲掃描顯微鏡自研發成功以來在工業和軍事應用中使用的高端半導體電子產品的制造商長期一直依賴精確的測試方法來識別缺陷的位置,例如微電子設備中的空隙、裂縫和不同層的分層,也稱為一個微芯片。制造商還采用掃描聲學顯微鏡 (SAM),這是一種非侵入性和非破壞性的超聲波檢測方法,已成為在各種芯片生產步驟和封裝后的最終質量檢測中檢測和分析缺陷的行業標準。

Hiwave和伍超聲掃描顯微鏡的掃描方式
關于超聲掃描顯微鏡的掃描模式的不同常用的掃描模式主要有這些:按照檢測結果分為A掃描、B掃描、C掃描,三種不同的檢測模式,各有不同的優勢,選擇合適的檢測模式,可以達到事半功倍的效果。
一點掃描:用波形圖來反應缺陷的大致位置,優點:最客觀的缺陷判基準。缺點:缺陷展示不直觀,無法有效計算缺陷面積厚度等參數。需要有波形判斷經驗的專業人員分析判斷,人為誤判的影響較大。常見于低頻無損探傷領域,便攜式無損探傷儀器常用方法,專業無損探傷人員需要考取無損探傷證書。
A掃描是波形顯示,在示波器屏幕上橫坐標代表時間,縱坐標代表反射波的強度,根據反射波的強度大致估計缺陷的嚴重程度,根據反射波在橫軸的位置人工計算出缺陷的位置。操作人員需要根據示波器上的波形,將缺陷的大致范圍標記在工件上。
B掃描顯示
B掃描顯示的是縱向截面掃描圖像,B掃描的結果相對比較直觀,采用數字像技術,B掃描是將反射波信號的相對位置顯示在一張圖上。在B掃描的圖像上,我們可以看到樣品不同位置的反射波信號。和金相圖像基本對應。 優點是利于計算物件的縱深,及厚度。
C掃描顯示
C掃描顯示的是橫向截面的情況。首先C掃描采用圖像處理技術,不同于A,B掃描模式時候的數字處理計算,可以方便直觀的找出缺陷情況,看出缺陷趨勢,甚至計算出缺陷的面積,更全面精準的反映出工件質量情況。

C掃描顯示
審核編輯黃宇
-
芯片
+關注
關注
459文章
52332瀏覽量
438374 -
超聲
+關注
關注
1文章
104瀏覽量
21788 -
顯微鏡
+關注
關注
0文章
616瀏覽量
24143
發布評論請先 登錄
超聲波掃描顯微鏡的工作原理和應用案例


掃描電子顯微鏡的應用場景有哪些?

聚焦離子束掃描電子顯微鏡(FIB-SEM)的用途

掃描電子顯微鏡(SEM)類型和原理
掃描電子顯微鏡(SEM)有哪些分類?

掃描電子顯微鏡(SEM)類型和原理

VirtualLab Fusion案例:單分子顯微鏡高NA成像系統的建模
VirtualLab Fusion案例:高NA反射顯微鏡系統
壓電納米運動技術在“超級顯微鏡”中的應用

掃描電子顯微鏡用在半導體封裝領域
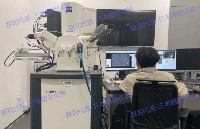
這些因素影響蔡司顯微鏡掃描電鏡的價格

開爾文探針力顯微鏡檢測的是什么信號
進口SEM掃描電子顯微鏡品牌推薦






 Hiwave和伍超聲掃描顯微鏡的掃描方式
Hiwave和伍超聲掃描顯微鏡的掃描方式












評論