英特爾率先在產(chǎn)品級(jí)芯片上實(shí)現(xiàn)背面供電技術(shù),使單元利用率超過(guò)90%,同時(shí)也在其它維度展現(xiàn)了業(yè)界領(lǐng)先的性能。
英特爾宣布在業(yè)內(nèi)率先在產(chǎn)品級(jí)測(cè)試芯片上實(shí)現(xiàn)背面供電(backside power delivery)技術(shù),滿足邁向下一個(gè)計(jì)算時(shí)代的性能需求。作為英特爾業(yè)界領(lǐng)先的背面供電解決方案,PowerVia將于2024年上半年在Intel 20A制程節(jié)點(diǎn)上推出。通過(guò)將電源線移至晶圓背面,PowerVia解決了芯片單位面積微縮中日益嚴(yán)重的互連瓶頸問(wèn)題。
英特爾技術(shù)開(kāi)發(fā)副總裁Ben Sell表示:“英特爾正在積極推進(jìn)‘四年五個(gè)制程節(jié)點(diǎn)’計(jì)劃,并致力于在2030年實(shí)現(xiàn)在單個(gè)封裝中集成一萬(wàn)億個(gè)晶體管,PowerVia對(duì)這兩大目標(biāo)而言都是重要里程碑。通過(guò)采用已試驗(yàn)性生產(chǎn)的制程節(jié)點(diǎn)及其測(cè)試芯片,英特爾降低了將背面供電用于先進(jìn)制程節(jié)點(diǎn)的風(fēng)險(xiǎn),使得我們能領(lǐng)先競(jìng)爭(zhēng)對(duì)手一個(gè)制程節(jié)點(diǎn),將背面供電技術(shù)推向市場(chǎng)。”
英特爾將PowerVia技術(shù)和晶體管的研發(fā)分開(kāi)進(jìn)行,以確保PowerVia可以被妥善地用于Intel 20A和Intel 18A制程芯片的生產(chǎn)中。在與同樣將與Intel 20A制程節(jié)點(diǎn)一同推出的RibbonFET晶體管集成之前,PowerVia在其內(nèi)部測(cè)試節(jié)點(diǎn)上進(jìn)行了測(cè)試,以不斷調(diào)試并確保其功能良好。經(jīng)在測(cè)試芯片上采用并測(cè)試PowerVia,英特爾證實(shí)了這項(xiàng)技術(shù)確實(shí)能顯著提高芯片的使用效率,單元利用率(cell utilization)超過(guò)90%,并有助于實(shí)現(xiàn)晶體管的大幅微縮,讓芯片設(shè)計(jì)公司能夠提升產(chǎn)品性能和能效。
英特爾將在于6月11日至16日在日本京都舉行的VLSI研討會(huì)上通過(guò)兩篇論文展示相關(guān)研究成果。
作為大幅領(lǐng)先競(jìng)爭(zhēng)對(duì)手的背面供電解決方案,PowerVia讓包含英特爾代工服務(wù)(IFS)客戶在內(nèi)的芯片設(shè)計(jì)公司能更快地實(shí)現(xiàn)產(chǎn)品能效和性能的提升。長(zhǎng)期以來(lái),英特爾始終致力于推出對(duì)行業(yè)具有關(guān)鍵意義的創(chuàng)新技術(shù),如應(yīng)變硅(strained silicon)、高K金屬柵極(Hi-K metal gate)和FinFET晶體管,以繼續(xù)推進(jìn)摩爾定律。隨著PowerVia和RibbonFET全環(huán)繞柵極技術(shù)在2024年的推出,英特爾在芯片設(shè)計(jì)和制程技術(shù)創(chuàng)新方面將繼續(xù)處于行業(yè)領(lǐng)先地位。
通過(guò)率先推出PowerVia技術(shù),英特爾可幫助芯片設(shè)計(jì)公司突破日益嚴(yán)重的互連瓶頸。越來(lái)越多的使用場(chǎng)景,包括AI或圖形計(jì)算,都需要尺寸更小、密度更高、性能更強(qiáng)的晶體管來(lái)滿足不斷增長(zhǎng)的算力需求。從數(shù)十年前到現(xiàn)在,晶體管架構(gòu)中的電源線和信號(hào)線一直都在“搶占”晶圓內(nèi)的同一塊空間。通過(guò)在結(jié)構(gòu)上將這兩者的布線分開(kāi),可提高芯片性能和能效,為客戶提供更好的產(chǎn)品。背面供電對(duì)晶體管微縮而言至關(guān)重要,可使芯片設(shè)計(jì)公司在不犧牲資源的同時(shí)提高晶體管密度,進(jìn)而顯著地提高功率和性能。
此外,Intel 20A和Intel 18A制程節(jié)點(diǎn)將同時(shí)采用PowerVia背面供電技術(shù)和RibbonFET全環(huán)繞柵極技術(shù)。作為一種向晶體管供電的全新方式,背面供電技術(shù)也帶來(lái)了散熱和調(diào)試設(shè)計(jì)方面的全新挑戰(zhàn)。
通過(guò)將PowerVia與RibbonFET這兩項(xiàng)技術(shù)的研發(fā)分開(kāi)進(jìn)行,英特爾能夠迅速應(yīng)對(duì)上述挑戰(zhàn),確保能在基于Intel 20A和Intel 18A制程節(jié)點(diǎn)的芯片中實(shí)現(xiàn)PowerVia技術(shù)。英特爾開(kāi)發(fā)了散熱技術(shù),以避免過(guò)熱問(wèn)題的出現(xiàn),同時(shí),調(diào)試團(tuán)隊(duì)也開(kāi)發(fā)了新技術(shù),確保這種新的晶體管設(shè)計(jì)結(jié)構(gòu)在調(diào)試中出現(xiàn)的各種問(wèn)題都能得到適當(dāng)解決。因此,在集成到RibbonFET晶體管架構(gòu)之前,PowerVia就已在測(cè)試中達(dá)到了相當(dāng)高的良率和可靠性指標(biāo),證明了這一技術(shù)的預(yù)期價(jià)值。
PowerVia的測(cè)試也利用了極紫外光刻技術(shù)(EUV)帶來(lái)的設(shè)計(jì)規(guī)則。在測(cè)試結(jié)果中,芯片大部分區(qū)域的標(biāo)準(zhǔn)單元利用率都超過(guò)90%,同時(shí)單元密度也大幅增加,可望降低成本。測(cè)試還顯示,PowerVia將平臺(tái)電壓(platform voltage)降低了30%,并實(shí)現(xiàn)了6%的頻率增益( frequency benefit)。PowerVia測(cè)試芯片也展示了良好的散熱特性,符合邏輯微縮預(yù)期將實(shí)現(xiàn)的更高功率密度。
接下來(lái),在將于VLSI研討會(huì)上發(fā)表的第三篇論文中,英特爾技術(shù)專家Mauro Kobrinsky還將闡述英特爾對(duì)PowerVia更先進(jìn)部署方法的研究成果,如同時(shí)在晶圓正面和背面實(shí)現(xiàn)信號(hào)傳輸和供電。
英特爾領(lǐng)先業(yè)界為客戶提供PowerVia背面供電技術(shù),并將在未來(lái)繼續(xù)推進(jìn)相關(guān)創(chuàng)新,延續(xù)了其率先將半導(dǎo)體創(chuàng)新技術(shù)推向市場(chǎng)的悠久歷史。
審核編輯黃宇
-
芯片
+關(guān)注
關(guān)注
459文章
52316瀏覽量
438115 -
英特爾
+關(guān)注
關(guān)注
61文章
10184瀏覽量
174202
發(fā)布評(píng)論請(qǐng)先 登錄
世紀(jì)大并購(gòu)!傳高通有意整體收購(gòu)英特爾,英特爾最新回應(yīng)

英特爾先進(jìn)封裝,新突破
新思科技與英特爾在EDA和IP領(lǐng)域展開(kāi)深度合作
英特爾持續(xù)推進(jìn)核心制程和先進(jìn)封裝技術(shù)創(chuàng)新,分享最新進(jìn)展

超700位客戶及合作伙伴齊聚英特爾Vision 2025

背面供電搭配全環(huán)繞柵極,英特爾打造芯片制造“新星組合”

英特爾代工在IEDM 2024展示多項(xiàng)技術(shù)突破
英特爾IEDM 2024大曬封裝、晶體管、互連等領(lǐng)域技術(shù)突破

英特爾展示互連微縮技術(shù)突破性進(jìn)展
英特爾Intel 18A制程芯片2025年量產(chǎn)計(jì)劃公布
英特爾12月或發(fā)布Battlemage GPU芯片
英特爾和AWS共同投資定制芯片
英特爾是如何實(shí)現(xiàn)玻璃基板的?
英特爾OCI芯粒在新興AI基礎(chǔ)設(shè)施中實(shí)現(xiàn)光學(xué)I/O(輸入/輸出)共封裝
英特爾實(shí)現(xiàn)光學(xué)IO芯粒的完全集成
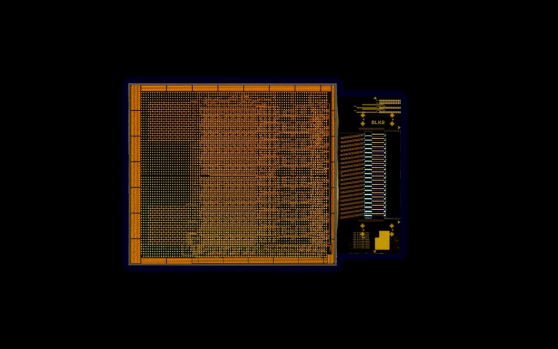





 英特爾PowerVia技術(shù)率先實(shí)現(xiàn)芯片背面供電,突破互連瓶頸
英特爾PowerVia技術(shù)率先實(shí)現(xiàn)芯片背面供電,突破互連瓶頸










評(píng)論