四面無引線扁平封裝(Quad Flat No-lead Package, QFN)屬于表面貼裝型封裝, 是一種無引腳且呈方形的封裝, 其封裝四側(cè)有對外電氣連接的導(dǎo)電焊盤(引腳),引腳節(jié)距一般為0.65mm、0.5mm、0.4mm、0. 35mm。
由于封裝體外部無引腳, 其貼裝面積和高度比QFP小。QFN封裝底部中央有一個大面積外露的導(dǎo)熱焊盤。QFN封裝無鷗翼狀引線, 內(nèi)部引腳與焊盤之間的導(dǎo)電路徑短, 自感系數(shù)及體內(nèi)線路電阻低, 能提供優(yōu)越的電性能。外露的導(dǎo)熱焊盤上有散熱通道, 使QFN封裝具有出色的散熱性。
上圖分別是WB-QFN (Wire Bonding-QFN)和FC-QFN(Filp Chip-QFN)基本結(jié)構(gòu)示意圖。這些結(jié)構(gòu)加上MCP技術(shù)和SiP等封裝技術(shù),為QFN的靈活多樣性提供了良好的I/O設(shè)計解決方案,也進一步提高了封裝密度。
QFN的工藝流程與傳統(tǒng)封裝的接近, 主要差異點如下所述。
(1)Q FN產(chǎn)品框架在塑封前一般采取貼膜工藝,進行球焊時的球焊參數(shù)模式與傳統(tǒng)的有差異, 若控制不當(dāng), 會造成焊線第2點的斷裂;另外,矩陣框架的塑封工藝必須采取多段注射方式來避免氣泡和沖線的發(fā)生。
(2)QFN產(chǎn)品的分離是采取切割工藝來實現(xiàn)的,切割過程中要采取合適的工藝(如低溫水)來避免熔錫,采用樹脂軟刀來減少切割應(yīng)力, 采用合適的切割速度來避免分層等。
(3)QFN產(chǎn)品通過選擇不同收縮率的塑封料來控制翹曲, 不同厚度和大小的芯片需要選擇不同收縮率的塑封料。
(4)QFN產(chǎn)品的框架均為刻蝕框架, 框架設(shè)計包含應(yīng)力、抗分層、預(yù)防毛刺等考慮因素, 框架設(shè)計的好壞決定著產(chǎn)品品質(zhì)的水平。
傳統(tǒng)上芯(裝片)的QFN產(chǎn)品的生產(chǎn)工藝流程如下:

倒裝上芯的QFN產(chǎn)品的生產(chǎn)工藝流程如下

在常見的QFN封裝下,宇凡微還提供定制封裝服務(wù),如QFN20等,能定制十多種特殊的封裝。
-
封裝
+關(guān)注
關(guān)注
128文章
8568瀏覽量
144919 -
qfn
+關(guān)注
關(guān)注
3文章
208瀏覽量
56923 -
封裝工藝
+關(guān)注
關(guān)注
3文章
64瀏覽量
8121
發(fā)布評論請先 登錄
晶振常見封裝工藝及其特點

半導(dǎo)體封裝工藝流程的主要步驟

芯片封裝工藝詳解
半導(dǎo)體貼裝工藝大揭秘:精度與效率的雙重飛躍

一文詳解2.5D封裝工藝

倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

功率模塊封裝工藝

功率模塊封裝工藝有哪些

深入剖析:封裝工藝對硅片翹曲的復(fù)雜影響

瑞沃微:一文詳解CSP(Chip Scale Package)芯片級封裝工藝

芯片封裝工藝集成工程師的必修課程指南
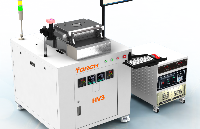





 QFN封裝工藝講解
QFN封裝工藝講解












評論