一對N溝道和P溝道 MOS 管以推挽形式工作,構(gòu)成互補(bǔ)的金屬氧化物半導(dǎo)體器件(Complementary Metal-Oxide-Semiconductor, CMOS)。其組成的反相器基本電路單元所實(shí)現(xiàn)一定邏輯功能的集成電路稱為CMOS 電路。其特點(diǎn)是:①靜態(tài)功耗低,每門功耗為納瓦級;②邏輯擺幅大,近似等于電源電壓;③抗干擾能力強(qiáng),直流噪聲容限達(dá)邏輯擺幅的35%左右;④可在較廣泛的電源電壓范圍內(nèi)工作,便于與其他電路接口;⑤速度快,門延遲時(shí)間達(dá)納秒級;⑥在模擬電路中應(yīng)用,其性能比 NMOS 電路好;⑦與 NMOS 電路相比,集成度稍低;⑧有“自鎖效應(yīng)”,影響電路正常工作。圖1.8為當(dāng)代先進(jìn)CMOS 器件結(jié)構(gòu)示意圖。
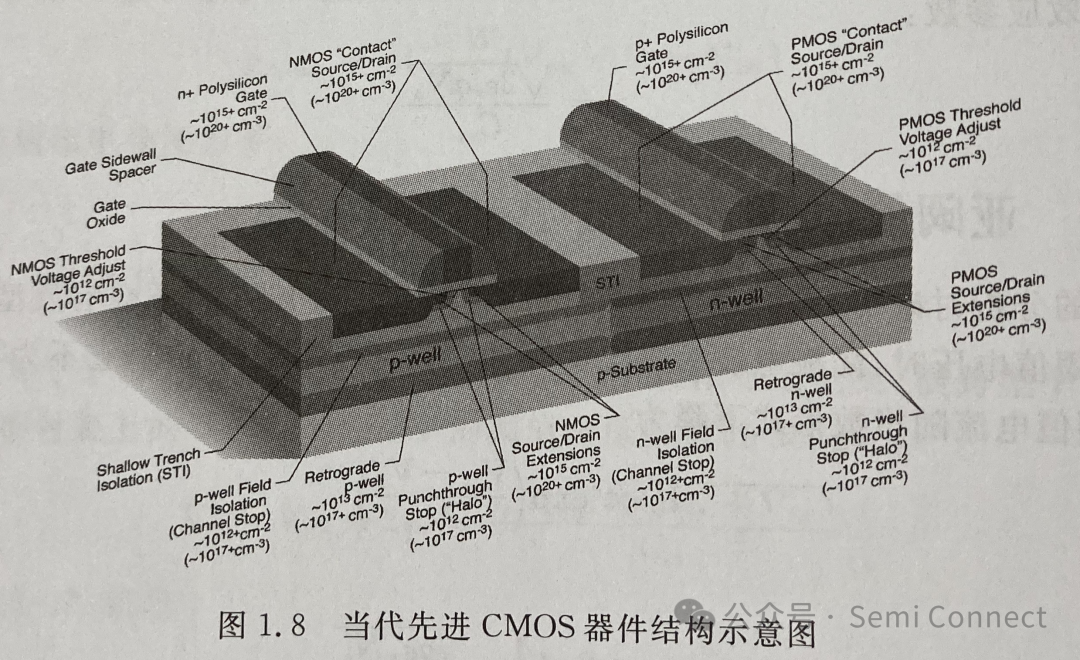
MOS 器件不斷地按比例縮小,通常伴隨柵極氧化層的厚度的減薄,發(fā)生強(qiáng)反型時(shí),溝道中的電阻將進(jìn)一步降低,MOS器件速度將進(jìn)一步提升。理論上MOSFET 的柵極應(yīng)該盡可能選擇導(dǎo)電性良好的導(dǎo)體,重?fù)诫s多晶硅普遍用于制作MOSFET 的柵極,但這并非完美的選擇。采用多晶硅柵極的理由如下:MOSFET 的閾值電壓主要由柵極與溝道材料的功函數(shù)之間的差異來決定,因?yàn)槎嗑Ч璞举|(zhì)上是半導(dǎo)體,所以可以通過摻雜不同極性及濃度的雜質(zhì)來改變其功函數(shù)。更重要的是,因?yàn)槎嗑Ч韬推涞紫伦鳛闇系赖墓柚g禁帶寬度相同,因此在降低 PMOS或NMOS的閾值電壓時(shí),可以通過直接調(diào)整多晶硅的功函數(shù)來達(dá)成需求。反過來說,金屬材料的功函數(shù)并不像半導(dǎo)體那么易于改變,如此一來要降低 MOSFET的閾值電壓就變得比較困難。而且如果想要同時(shí)降低PMOS 和 NMOS 的閾值電壓,將需要兩種不同的金屬分別做其柵極材料,增加了工藝的復(fù)雜性;經(jīng)過多年的研究,已經(jīng)證實(shí)硅-二氧化硅界面兩種材料之間的缺陷相對而言比較少。反之,金屬-絕緣體界面的缺陷多,容易在兩者之間形成很多表面能階,大幅影響器件的性能;多晶硅的熔點(diǎn)比大多數(shù)的金屬高,而在現(xiàn)代的半導(dǎo)體工藝中,習(xí)慣在高溫下沉積柵極材料以增進(jìn)器件性能。金屬的熔點(diǎn)較低,將會影響工藝所能使用的溫度上限。
不過雖然多晶硅在過去的二十多年里已成為制造MOSFET 柵極的標(biāo)準(zhǔn),但也有若干缺點(diǎn)使得工業(yè)界在先進(jìn)CMOS 器件產(chǎn)品中使用高介電常數(shù)的介質(zhì)和金屬柵極(High-kMetal Gate,HKMG),這些缺點(diǎn)如下:多晶硅導(dǎo)電性不如金屬,限制了信號傳遞的速度。雖然可以利用摻雜的方式改善其導(dǎo)電性,但效果仍然有限。有些熔點(diǎn)比較高的金屬材料如:鎢(Tungsten)、鈦(Titanium)、鈷(Cobalt)或鎳(Nickel)被用來和多晶硅制成合金。這類混合材料通常稱為金屬硅化物(silicide)。加上了金屬硅化物的多晶硅柵極導(dǎo)電特性顯著提高,而且又能夠耐受高溫工藝。此外因?yàn)榻饘俟杌锏奈恢檬窃跂艠O表面,離溝道區(qū)較遠(yuǎn),所以也不會對MOSFET的閾值電壓造成太大影響。在柵極、源極與漏極都鍍上金屬硅化物的工藝稱為“自我對準(zhǔn)金屬硅化物工藝”(Self-Aligned Silicide),通常簡稱 salicide 工藝。當(dāng) MOSFET 的器件尺寸縮得非常小、柵極氧化層也變得非常薄時(shí),例如,最新工藝可以把氧化層厚度縮小到1nm 左右,一種過去沒有發(fā)現(xiàn)的稱之“多晶硅耗盡”現(xiàn)象也隨之產(chǎn)生。當(dāng)MOSFET 的反型層形成時(shí),有多晶硅耗盡現(xiàn)象的MOSFET柵極多晶硅靠近氧化層處,會出現(xiàn)一個耗盡層,無形中增加了柵氧化層厚度,影響 MOSFET 器件性能。要解決這種問題,一種解決方案是將多晶硅完全的合金化,稱為 FUSI(FUlly-Sllicide Polysilicon Gate)工藝。金屬柵極是另一種最好的方案,可行的材料包括鉭(Tantalum)、鎢、氮化鈕(TantalumNitride),或是氮化鈦(Titalium Nitride)再加上鋁或鎢。這些金屬柵極通常和高介電常數(shù)物質(zhì)形成的氧化層一起構(gòu)成 MOS電容。
在過去的半個多世紀(jì)中,以CMOS 技術(shù)為基礎(chǔ)的集成電路技術(shù)一直遵循“摩爾定律”,即通過縮小器件的特征尺寸來提高芯片的工作速度、增加集成度以及降低成本,取得了巨大的經(jīng)濟(jì)效益與科學(xué)技術(shù)的重大發(fā)展,推動了人類文明的進(jìn)步,被譽(yù)人類歷史上發(fā)展最快的技術(shù)之一。伴隨 MOS器件特征尺寸按比例不斷縮小,源與漏之間的距離也越來越短,溝道不僅受柵極電場,同時(shí)也受到漏極電場的影響,這樣一來柵極對溝道的控制能力變差,柵極電壓夾斷溝道的難度也越來越大,如此便容易發(fā)生亞閥值漏電(Sub-threshold leakage)現(xiàn)象,形成短溝道效應(yīng)(Short-Channel Effects,SCE)。這樣會導(dǎo)致晶體管性能的嚴(yán)重退化,影響其開關(guān)效率以及速度。如果短溝道效應(yīng)得不到有效控制,傳統(tǒng)的平面體硅MOSFET 的尺寸持續(xù)按比例縮小將變得越來越困難。集成電路技術(shù)發(fā)展到當(dāng)今20nm 技術(shù)節(jié)點(diǎn)及以下時(shí),在速度、功耗、集成度、可靠性等方面將受到一系列基本物理和工藝技術(shù)問題的限制。
為了克服這些挑戰(zhàn),人們致力于兩方面的研究:一方面積極研發(fā)全新的信息處理技術(shù),以便在CMOS技術(shù)的能力范圍之外繼續(xù)實(shí)現(xiàn)或超越摩爾定律;另一方面積極研究器件新結(jié)構(gòu)、新材料,以便充分挖掘CMOS 技術(shù)的潛力,實(shí)現(xiàn)CMOS技術(shù)沿摩爾定律進(jìn)一步按比例縮小。比如,在傳統(tǒng)晶體管的工藝設(shè)計(jì)中采用新的材料,如高k電介質(zhì),金屬柵材料以及隱埋應(yīng)變硅源漏,或者發(fā)展替代傳統(tǒng)平面結(jié)構(gòu)的晶體管器件結(jié)構(gòu)。圖1.9給出當(dāng)代CMOS 集成電路材料與器件結(jié)構(gòu)的演進(jìn)。
1949年肖克菜(W. B. Shockley)提出少子(少數(shù)載流子)在半導(dǎo)體中的注入和遷移的PN 結(jié)理論以及基于 PN 結(jié)的雙極型晶體管器件結(jié)構(gòu)。1960年,貝爾實(shí)驗(yàn)室的D.Kahng和M. Atalla 發(fā)明并首次制作成功金屬-氧化物-半導(dǎo)體場效應(yīng)晶體管(MOSFET)。MOSFET 的發(fā)明也是基于PN 結(jié)理論。
在發(fā)展替代傳統(tǒng)平面結(jié)構(gòu)的晶體管器件結(jié)構(gòu)方面,一種特器件結(jié)構(gòu)即所謂的鰭式場效應(yīng)晶體管 FinFET吸引了人們的廣泛關(guān)注。這個詞最初被加利福尼亞大學(xué)伯克利分校的胡正明教授用來描述一個基于絕緣層上硅(Silicon On Insulator, SOI)襯底的非平面雙柵晶體管器件。由于晶體管的溝道很像魚的鰭,由此稱之為鰭型場效應(yīng)晶體管。它的發(fā)展基礎(chǔ)是 Hitachi 公司的年輕工程師 Hisamoto 于1989年提出的基于體硅襯底,采用局域化絕緣體隔離襯底技術(shù)(local SOI)制成的首個三維器件 Delta FET。在傳統(tǒng)晶體管結(jié)構(gòu)中,柵極只能從溝道的一側(cè)控制器件的導(dǎo)通與關(guān)閉,屬于平面結(jié)構(gòu)。FinFET 器件采用三維立體結(jié)構(gòu),由其中一個設(shè)置于源漏之間的薄鰭狀溝道和類似魚鰭的叉狀柵極組成。柵電極能夠從鰭形硅的兩側(cè)及頂部控制溝道,且與鰭形硅溝道垂直,兩個側(cè)邊柵電極能夠互相自對準(zhǔn),有效地縮小了有源區(qū)在平面上的占有面積,并且很大程度上增加了溝道的有效寬度,使得柵極對溝道電勢控制更加完美,具有非常高的靜電完整性,從而增加了器件的電流驅(qū)動能力和器件抑制短溝道效應(yīng)的能力,并增加了器件的跨導(dǎo),減小了漏極感應(yīng)勢壘降低(DrainInduced Barrier Lowering,DIBL)效應(yīng)和閾值電壓隨溝道長度的變化量等。FinFET 因其優(yōu)異的性能以及與傳統(tǒng) CMOS工藝的兼容性,被認(rèn)為是很有前途的新穎器件,可以使摩爾定律得以延續(xù)。
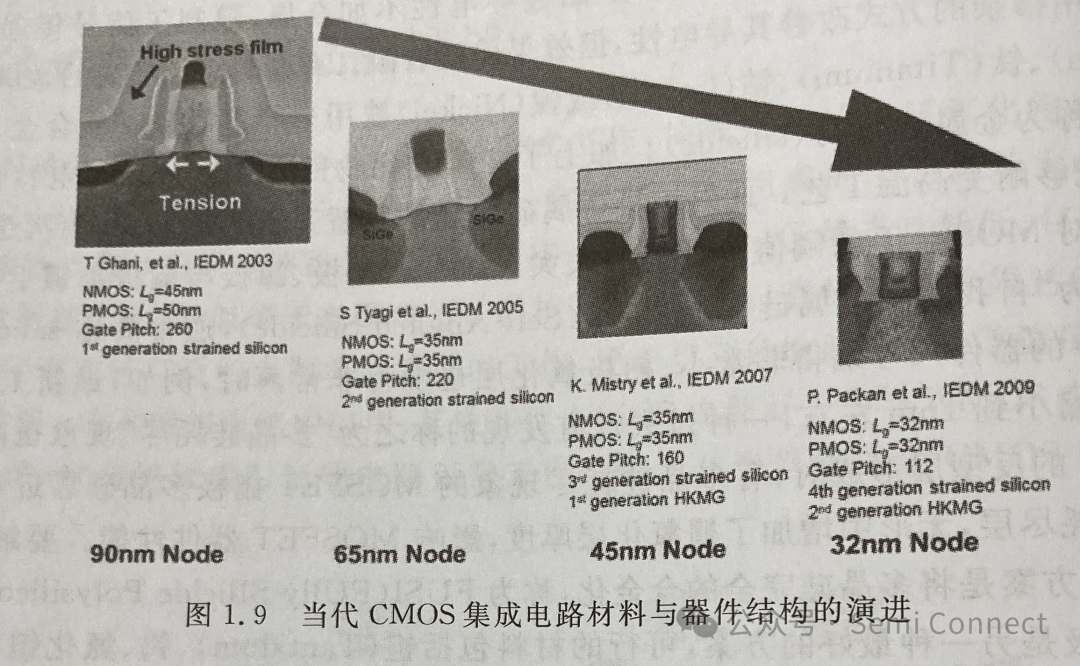
在14nm 節(jié)點(diǎn),由于 FinFET鰭的寬度只有5nm 左右,溝道寬度的變化可能會導(dǎo)致不良的V.以及驅(qū)動電流的變化等。采用全包圍柵(Gate-Al-Around Rectangular,GAAR)器件結(jié)構(gòu)是 FinFET器件的自然延伸D4.15。在這種結(jié)構(gòu)中,柵極結(jié)構(gòu)將鰭形溝道全部包裹起來,進(jìn)一步改善了器件對短溝道效應(yīng)的控制。然而由于工藝的限制,這些 GAAR型器件的溝道多為長方體形狀,不可避免的銳角效應(yīng)使得矩形溝道截面中的電場仍然不均勻。更進(jìn)一步的是采用圓柱體全包圍柵(Gate-All-Around Cylindrical, GAAC)器件結(jié)構(gòu)。在這種結(jié)構(gòu)中,柵極結(jié)構(gòu)將圓柱體溝道全部包裹起來,克服了銳角效應(yīng),進(jìn)一步改善了器件對短溝道效應(yīng)的控制。由于具備近乎完美的靜電完整性,圓柱體全包圍柵器件備受關(guān)注。圖1.10給出CMOS 器件由二維平面結(jié)構(gòu)向三維非平面結(jié)構(gòu)的演進(jìn)。
2011年初,Intel 公司在其22nm 工藝技術(shù)節(jié)點(diǎn)上首次推出了商品化的 FinFET 產(chǎn)品Ivy-Bridge。其器件結(jié)構(gòu)與早期 Hisamoto 的Delta FET及其相似,如圖1.10所示,只是省略了局域化襯底絕緣隔離工藝,依舊采用阱隔離技術(shù)將溝道與體硅襯底隔離開來。環(huán)柵納米線器件因其更優(yōu)異的靜電完整性和彈道輸運(yùn)特性,有望取代 FinFET 并應(yīng)用在10nm以下節(jié)點(diǎn)。但由于PN結(jié)漏電問題,也將面臨一些挑戰(zhàn)。

-
集成電路
+關(guān)注
關(guān)注
5422文章
12024瀏覽量
368103 -
CMOS
+關(guān)注
關(guān)注
58文章
6009瀏覽量
238670 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28831瀏覽量
236334 -
晶體管
+關(guān)注
關(guān)注
77文章
10009瀏覽量
141383
原文標(biāo)題:CMOS 器件面臨的挑戰(zhàn)
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
分析MOS管未來發(fā)展與面臨的挑戰(zhàn)
移動電視射頻技術(shù)面臨什么挑戰(zhàn)
使用空中鼠標(biāo)系統(tǒng)面臨哪些挑戰(zhàn)?如何去克服這些挑戰(zhàn)?
有什么方法可以解決HID設(shè)計(jì)面臨的挑戰(zhàn)?
無線智能IP監(jiān)控面臨的技術(shù)挑戰(zhàn)是什么?怎么解決?
機(jī)器開發(fā)人員面臨哪些軟件挑戰(zhàn)以及硬件挑戰(zhàn)?如何去應(yīng)對這些挑戰(zhàn)?
碳化硅功率器件面臨的挑戰(zhàn)
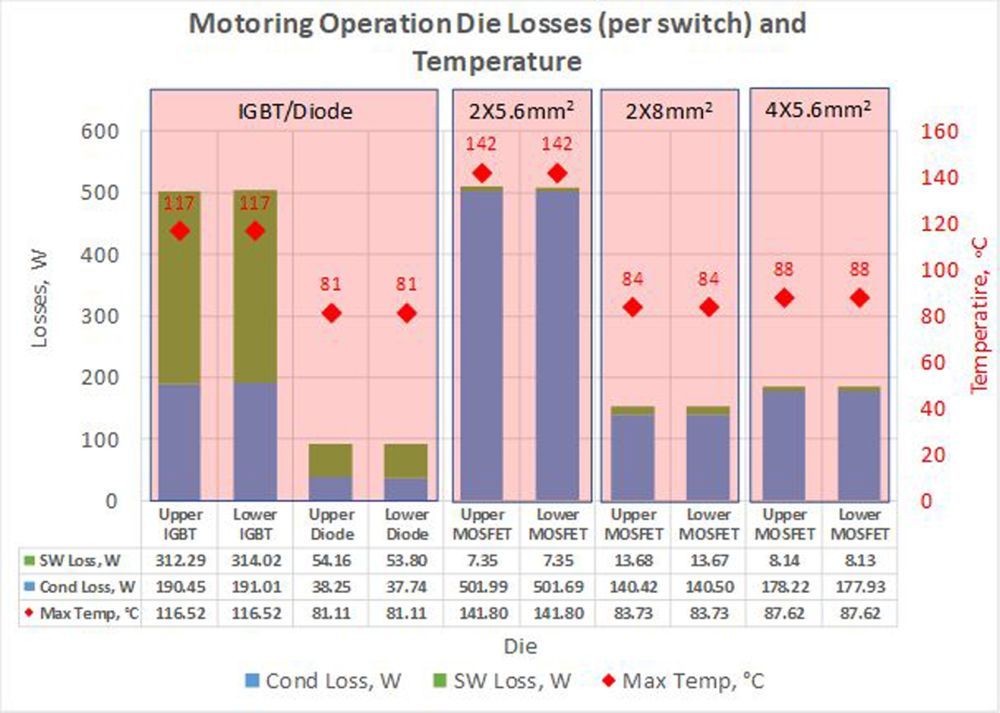





 CMOS器件面臨的挑戰(zhàn)
CMOS器件面臨的挑戰(zhàn)











評論