印刷電路板(PCB)在電子設備和其他相關應用中無處不在。一般來說,PCB是由多層層壓材料和多層樹脂粘合而成的。這些層嵌入有導電金屬部件和垂直穿過這些層的金屬通孔。
在有限元分析(FEA)中,將PCB中的主體和跡線建模為單元通常使用具有耦合或接觸的實體、殼和梁單元。然而,由于PCB的每個樹脂層中所涉及的嵌入體數量巨大,該方法通常是困難和耗時的
網格獨立增強單元技術通過使用MESH200單元定義嵌入區域的拓撲并無縫創建嵌入增強單元,為PCB建模和網格化提供了更好的選擇。不涉及復雜的接觸建模、耦合或困難的網格劃分技術。
該示例問題演示了如何使用獨立于網格的增強單元來執行印刷電路板(PCB)的熱結構分析。
重點介紹了以下特性和功能:
使用離散和涂抹的加固單元進行建模。
熱分析后進行下游結構分析。
問題描述:
分析分為兩部分:
步驟1.求解熱邊界條件引起的熱分析。
步驟2.解決熱載荷引起的下游結構分析。
由于運行載荷而在一些嵌入式金屬跡線上產生的熱量會導致整個PCB的溫度梯度。梯度會導致PCB在操作期間變形,并引起熱應力和應變。
建模
用于穩態熱分析的模型使用ANSYS Mechanical創建,生成初始網格的單元:
表示小銅通孔的線體用LINK33劃分網格。
代表樹脂中嵌入銅和較大通孔的其他表面體用SHELL131劃分。
使用SOLID70對層壓板和樹脂實體進行網格化。SOLID70單元進行了修改(EMODIF),以創建SOLID278單元,以支持增強單元的生成。
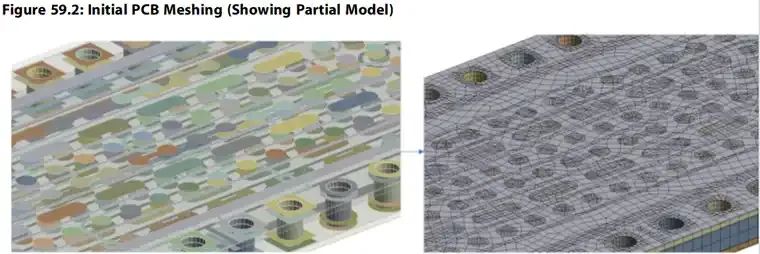
每個固體層壓板和樹脂體在內表面處彼此默認接合接觸,從而形成六個接合接觸對。
為了創建嵌入的加強單元(REINF264和REINF265),LINK33和SHELL131單元被修改(EMODIF)以創建等效的MESH200單元。
厚度為0.042 mm的涂抹加固的截面特性定義如下:

截面積為0.16053 mm2的離散加固的截面特性定義如下:

在選擇適當的基礎SOLID278和MESH200單元后,將創建加強構件(EREINF)并成形(/ESHAPE):

對于下游結構分析,修改了SOLID278單元(EMODIF)以創建等價SOLID185單元。作為熱結合接觸對的一部分的CONTA174單元也被修改以說明結構解決方案。然后重新選擇增強單元REINF264和REINF265,以實現它們的結構自由度(EREINF)。
材料屬性
以下是22°C下銅、層壓材料和樹脂材料的熱性能和結構材料性能:

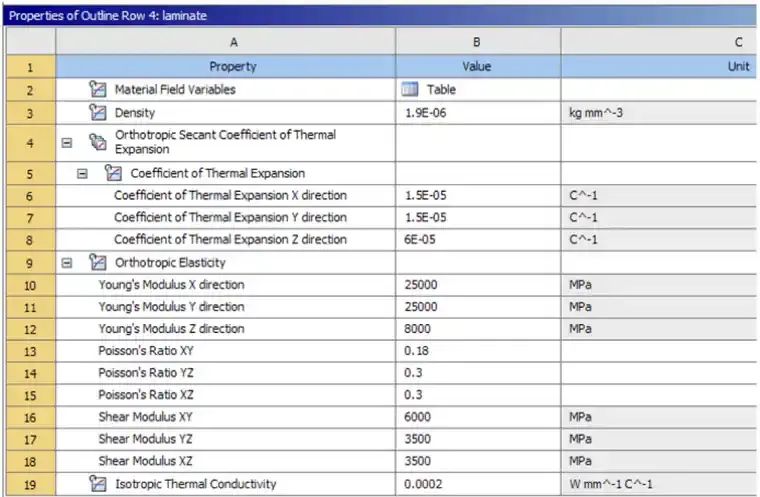
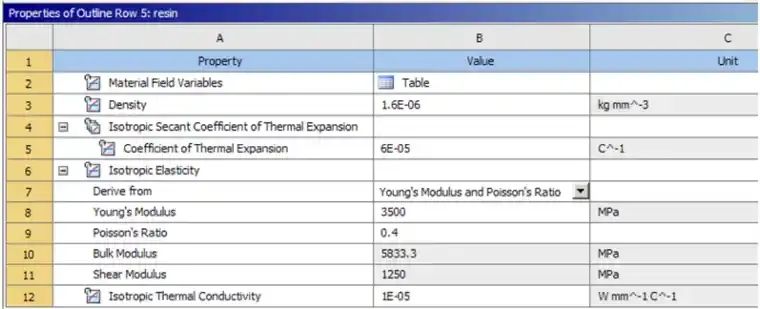
邊界條件和加載
穩態熱分析:邊界條件和加載
將內部發熱載荷應用于代表嵌入式銅跡線和通孔的選定MESH200單元組件:
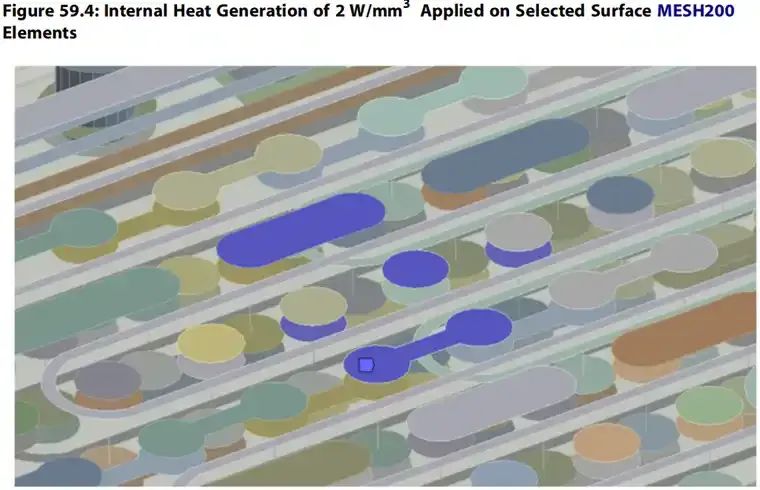

在從MESH200和基礎構件交叉點創建加固(EREINF)后,應用于MESH200的邊界條件被轉移到涂抹加固構件(BFPORT):
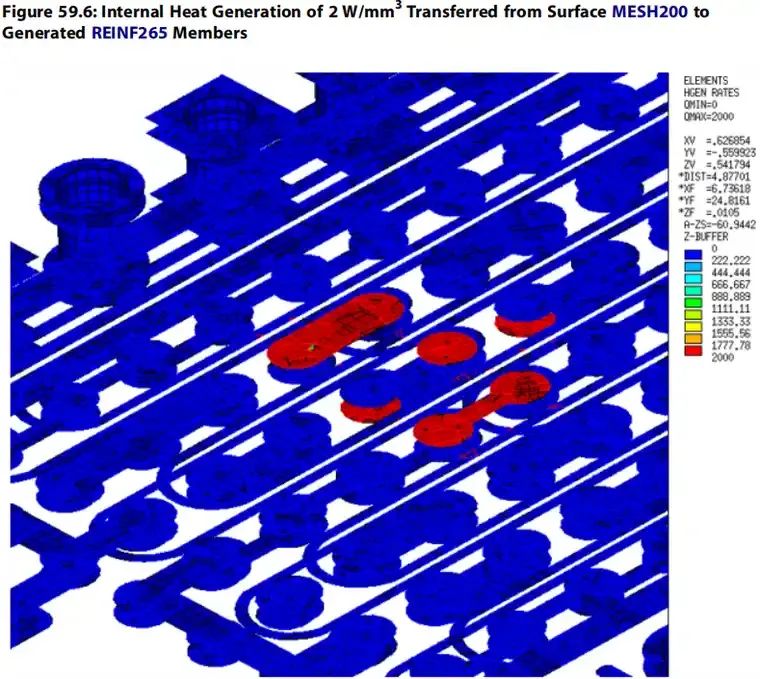
對流邊界條件應用于PCB的頂面和底面:


下游結構分析:邊界條件和加載
PCB的端部受到所有位移自由度的約束(以綠色表示):

分析和求解控制
該求解包括穩態熱分析和下游結構分析。
在應用熱產生載荷和對流邊界條件后,穩態熱解是直接的。
隨后的結構解涉及從.rth文件(LDREAD)讀取溫度。
通過定義至少五個子步,可以實現大撓度。
位移收斂被啟用,熱流收斂被禁用(CNVTOL)。在求解結構分析之前,取消選擇之前為對流定義的SURF152單元。
結果和討論
在穩態熱分析之后,溫度結果是最重要的。以下是部分涂抹加固件的結果:
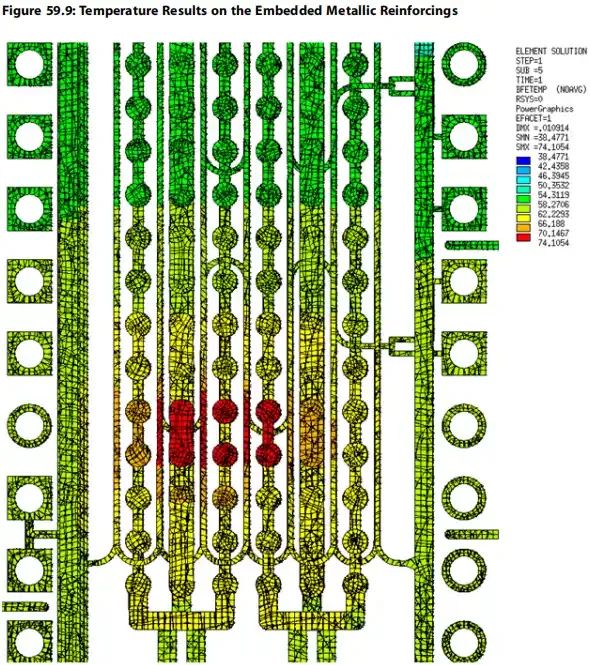
溫度梯度導致下游結構分析中的變形和應力。
以下是涂抹加固件同一部分的變形結果:

整個PCB的等效熱應變圖(從正X軸側觀察)顯示,應變發生在預期位置,并對應于熱分析的加載條件:

孔隙壓力分布在某些方面與參考文獻的結果不同進行類似分析時,考慮以下提示和建議:
為實心基礎單元選擇足夠大的尺寸,以避免過于精細的基礎網格。如果基礎單元小于嵌入部件的橫截面或厚度,則熱產生載荷可能不會充分分布,從而導致對受影響區域的熱結果的過度估計。
對加固單元使用適當的截面控制設置(SECCONTROL),以提高結果。
考慮對所有支撐基礎材料使用基底移除選項,對均質嵌入構件使用全膜選項。
-
pcb
+關注
關注
4357文章
23439瀏覽量
407263 -
印刷電路板
+關注
關注
4文章
833瀏覽量
35912 -
模型
+關注
關注
1文章
3499瀏覽量
50083
原文標題:印刷電路板的熱結構分析!
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 印刷電路板的熱結構分析
印刷電路板的熱結構分析










評論