文章來源:老虎說芯
原文作者:老虎說芯
本文分析了晶圓背面二氧化硅邊緣腐蝕現象的現象和原因。
在集成電路生產過程中,晶圓背面二氧化硅邊緣腐蝕現象是一個常見但復雜的問題。每個環節都有可能成為晶圓背面二氧化硅邊緣腐蝕的誘因,因此需要在生產中嚴格控制每個工藝參數,尤其是對邊緣區域的處理,以減少這種現象的發生。
1. 晶圓氧化工藝
氧化工藝主要用于在晶圓表面生長一層二氧化硅(SiO2)薄膜,常用的氧化方法包括熱氧化法、濕氧化法和干氧化法。
邊緣效應。在氧化過程中,晶圓邊緣的氧化速率可能與晶圓表面中央有所不同。由于晶圓邊緣暴露在氧化氣氛中的面積相對較大,邊緣氧化速率往往更快。這種不均勻的氧化速率可能導致邊緣氧化層厚度不均。
2. 邊緣刻蝕問題
刻蝕工藝用于去除指定區域的材料,以實現圖形化。在集成電路制造中,常見的刻蝕方法有濕法刻蝕和干法刻蝕。
邊緣刻蝕問題。在濕法刻蝕中,刻蝕液可能會由于毛細作用沿晶圓背面流動,造成背面氧化層的刻蝕。在干法刻蝕中,刻蝕氣體可能會擴散到晶圓邊緣,導致背面氧化層受到腐蝕。
3. 邊緣腐蝕問題
清洗工藝用于去除晶圓表面的有機物、金屬雜質和顆粒物,常用的清洗液有氫氟酸(HF)、硝酸(HNO3)等。
邊緣腐蝕問題。在使用氫氟酸清洗時,氫氟酸對二氧化硅有很強的刻蝕能力。如果清洗不均勻或者清洗液在晶圓背面殘留,可能會造成晶圓背面氧化層的腐蝕。另外,清洗過程中如果控制不當,清洗液可能會沿晶圓邊緣滲透,導致邊緣腐蝕。
4. 邊緣光刻問題
光刻工藝用于將圖形轉移到光刻膠上,再通過刻蝕工藝將圖形轉移到晶圓上。
邊緣光刻問題。在光刻過程中,光刻膠的涂布和顯影可能在晶圓邊緣產生不均勻性,導致邊緣區域的圖形轉移和刻蝕精度下降。這種不均勻性可能進一步導致后續工藝中的邊緣腐蝕問題。
5. 物理和化學因素
晶圓處理過程中的機械應力。在晶圓搬運和處理過程中,邊緣可能受到機械應力,這些應力可能導致氧化層的微裂紋,增加腐蝕的可能性。
化學反應不均勻性。在各種化學工藝中(如清洗、刻蝕),邊緣區域的化學反應速率可能與中心區域不同,這種不均勻性也會導致邊緣腐蝕。
綜上所述,晶圓背面二氧化硅邊緣腐蝕現象主要由以下幾個原因引起:氧化工藝中晶圓邊緣的氧化速率較高,導致厚度不均。刻蝕工藝中刻蝕液或刻蝕氣體沿晶圓邊緣的滲透和擴散。清洗工藝中清洗液在晶圓邊緣的殘留或不均勻分布。光刻工藝中光刻膠涂布和顯影的不均勻性。晶圓處理過程中的機械應力和化學反應不均勻性。
-
晶圓
+關注
關注
53文章
5151瀏覽量
129680 -
場集成電路
+關注
關注
0文章
3瀏覽量
4707 -
光刻工藝
+關注
關注
1文章
36瀏覽量
1972
原文標題:晶圓背面二氧化硅邊緣腐蝕的原因
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
PECVD工藝參數對二氧化硅薄膜致密性的影響
二氧化硅玻璃陶瓷刻蝕化學及HF輔助刻蝕的觀察

晶圓處理工程常用術語
硅晶圓是什么?硅晶圓和晶圓有區別嗎?
晶圓制造工藝的流程是什么樣的?
石灰石二氧化硅化驗儀器設備系列
用磷酸揭示氮化硅對二氧化硅的選擇性蝕刻機理

碳化硅和二氧化硅之間穩定性的刻蝕選擇性

二氧化硅蝕刻標準操作程序研究報告

在超臨界二氧化碳中蝕刻氧化硅薄膜
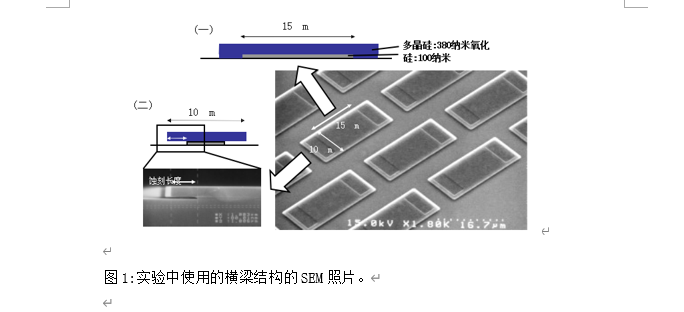





 晶圓背面二氧化硅邊緣腐蝕的原因
晶圓背面二氧化硅邊緣腐蝕的原因












評論