Yole預(yù)計(jì)2019年半導(dǎo)體產(chǎn)業(yè)將出現(xiàn)放緩。然而,先進(jìn)封裝將保持成長(zhǎng)趨勢(shì),同比成長(zhǎng)約6%。總體而言,先進(jìn)封裝市場(chǎng)將以8%的年復(fù)合成長(zhǎng)率成長(zhǎng),到2024年達(dá)到近440億美元。相反,在同一時(shí)期,傳統(tǒng)封裝市場(chǎng)將以2.4%的年復(fù)合成長(zhǎng)率成長(zhǎng),而整個(gè)IC封裝產(chǎn)業(yè)CAGR將達(dá)5%。
2019-07-29 10:12:41 7714
7714 先進(jìn)IC封裝是超越摩爾時(shí)代的一大技術(shù)亮點(diǎn)。當(dāng)芯片在每個(gè)工藝節(jié)點(diǎn)上的縮小越來(lái)越困難、也越來(lái)越昂貴之際,工程師們將多個(gè)芯片放入先進(jìn)的封裝中,就不必再費(fèi)力縮小芯片了。 然而,先進(jìn)IC封裝技術(shù)發(fā)展十分迅速
2020-11-19 16:00:58 5863
5863 SiP的關(guān)注點(diǎn)在于:系統(tǒng)在封裝內(nèi)的實(shí)現(xiàn),所以系統(tǒng)是其重點(diǎn)關(guān)注的對(duì)象,和SiP系統(tǒng)級(jí)封裝對(duì)應(yīng)的為單芯片封裝;先進(jìn)封裝的關(guān)注點(diǎn)在于:封裝技術(shù)和工藝的先進(jìn)性,所以先進(jìn)性的是其重點(diǎn)關(guān)注的對(duì)象,和先進(jìn)封裝對(duì)應(yīng)的是傳統(tǒng)封裝。
2021-03-15 10:31:53 8490
8490 
在IC封裝領(lǐng)域,是一種先進(jìn)的封裝,其內(nèi)涵豐富,優(yōu)點(diǎn)突出,已有若干重要突破,架構(gòu)上將芯片平面放置改為堆疊式封裝,使密度增加,性能大大提高,代表著鳳凰技術(shù)的發(fā)展趨勢(shì),在多方面存在極大的優(yōu)勢(shì)特性,體現(xiàn)在以下幾個(gè)方面。
2022-10-18 09:46:44 4823
4823 先進(jìn)封裝是“超越摩爾”(More than Moore)時(shí)代的一大技術(shù)亮點(diǎn)。當(dāng)芯片在每個(gè)工藝節(jié)點(diǎn)上的微縮越來(lái)越困難、也越來(lái)越昂貴之際,工程師們將多個(gè)芯片放入先進(jìn)的封裝中,就不必再費(fèi)力縮小芯片了。本文將對(duì)先進(jìn)封裝技術(shù)中最常見(jiàn)的10個(gè)術(shù)語(yǔ)進(jìn)行簡(jiǎn)單介紹。
2023-07-12 10:48:03 625
625 
說(shuō)起傳統(tǒng)封裝,大家都會(huì)想到日月光ASE,安靠Amkor,長(zhǎng)電JCET,華天HT,通富微電TF等這些封裝大廠(chǎng)OSAT;說(shuō)起先進(jìn)封裝,當(dāng)今業(yè)界風(fēng)頭最盛的卻是臺(tái)積電TSMC,英特爾Intel,三星SAMSUNG等這些頂尖的半導(dǎo)體晶圓廠(chǎng)IC Foundry,這是為何呢?
2023-12-21 09:32:02 474
474 
誰(shuí)有精工IC的封裝,共享一下
2016-06-06 15:14:21
您只構(gòu)建了一個(gè)專(zhuān)業(yè)設(shè)計(jì)的電路實(shí)驗(yàn)板。您完成了布局以前需要做的所有仿真,并查看了廠(chǎng)商對(duì)于特定封裝下獲得較好散熱設(shè)計(jì)的建議方法。您甚至仔細(xì)檢查了紙面上的初步熱分析方程式,給予了它們應(yīng)有的注意,旨在確保不
2018-09-14 16:36:06
作為一名電子工程師,日常工作基本上都會(huì)接觸上很多各種類(lèi)型的IC,比如邏輯芯片、存儲(chǔ)芯片、MCU或者FPGA等;對(duì)于各種類(lèi)型的IC的功能特性,或許會(huì)清楚得更多,但對(duì)于IC的封裝,不知道了解了多少?
2019-10-09 08:28:12
要更改一下PCB板,之前的data是3*3的,現(xiàn)在要修改成4*4的,請(qǐng)問(wèn)有什么網(wǎng)站可以查選到QFN 4*4的封裝尺寸大小
2015-05-15 10:39:08
材料有塑料和陶瓷兩種。DIP是最普及的插裝型封裝,應(yīng)用范圍包括標(biāo)準(zhǔn)邏輯IC,存貯器LSI,微機(jī)電路等。引腳中心距2.54mm,引腳數(shù)從6到64。封裝寬度通常為15.2mm。有的把寬度為7.52mm
2020-07-13 16:07:01
IC的噪聲有哪幾種類(lèi)型?如何計(jì)算IC的噪聲?低噪聲系統(tǒng)的設(shè)計(jì)技巧
2021-04-08 06:37:30
IC芯片封裝陣容 詳細(xì)介紹了市場(chǎng)上常見(jiàn)芯片的封裝知識(shí),芯片封裝技巧、封裝注意事項(xiàng)及封裝規(guī)格都有詳細(xì)的描述,并且對(duì)不同芯片的封裝方法進(jìn)行了對(duì)比。該資料的可參考價(jià)值很強(qiáng) IC芯片封裝陣容 [hide][/hide]
2008-06-11 16:12:38
ic封裝的種類(lèi)及方式1、BGA(ball grid array) 球形觸點(diǎn)陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點(diǎn)用以 代替引腳,在印刷基板的正面裝配LSI 芯片,然后
2008-05-26 12:38:40
先進(jìn)汽車(chē)儀表板及車(chē)身控制設(shè)計(jì)要領(lǐng)是什么?車(chē)用MCU常見(jiàn)接口是什么?
2021-05-12 06:07:06
有什么方法可以降低IC封裝的熱阻嗎?求解
2021-06-23 07:24:48
,EV-DO版本B 將會(huì)向DO增強(qiáng)型 再演進(jìn)。 EV-DO從版本0演進(jìn)到版本A,只需要對(duì)版本0網(wǎng)絡(luò)設(shè)備進(jìn)行軟件更新,同時(shí)升級(jí)基站中的信道板
2010-03-16 09:13:42
各位大神!誰(shuí)知道有沒(méi)有圖中專(zhuān)門(mén)用做LED矩陣控制的IC,原來(lái)的設(shè)計(jì)是單片機(jī)直接控制LED矩陣;但因?yàn)槭莾蓧K板排線(xiàn)太多沒(méi)有空間走線(xiàn);現(xiàn)改為圖中的單片機(jī)用I2C控制LED矩陣IC再來(lái)驅(qū)動(dòng)LED,能不能幫推薦幾款這種類(lèi)型的IC???
2014-03-25 14:24:39
LM7805是什么?LM7805穩(wěn)壓IC有哪幾種常見(jiàn)的封裝?
2021-09-29 08:29:55
` 誰(shuí)來(lái)闡述一下bga封裝種類(lèi)有哪些?`
2020-02-25 16:16:36
一起來(lái)漲姿勢(shì),如題,分享一張頻率控制技術(shù)演進(jìn)的圖(圖片來(lái)源:世強(qiáng)先進(jìn)),了解下電子產(chǎn)品心臟的技術(shù)發(fā)展過(guò)程。貌似CMEMS可編程振蕩器有替代石英振蕩器的趨勢(shì),作為一個(gè)新出現(xiàn)的技術(shù),想問(wèn)問(wèn)壇友們,對(duì)CMEMS技術(shù)如何看?
2014-03-28 18:57:00
由于先進(jìn)IC上板技術(shù)已從BGA、QFN、QFP等慢慢演進(jìn)成WLCSP、CSP、SoC、SiP等高階制程,造成可靠度驗(yàn)證有許多的改變,為了更能符合先進(jìn)IC封裝技術(shù)之可靠度驗(yàn)證,iST宜特科技上板可靠度
2018-12-27 11:28:34
何為長(zhǎng)期演進(jìn)(LTE)?LTE有哪些特性?
2021-05-26 06:25:54
解決問(wèn)題,但是CPO下只能更換整個(gè)芯片,成本會(huì)更高。第二個(gè)是散熱問(wèn)題,本身硅光器件對(duì)溫度比較敏感,當(dāng)芯片集成度提高,散熱也亟需好的解決方案; 圖2 封裝演進(jìn)路線(xiàn)原作者:光學(xué)追光者
2023-03-29 10:48:47
多芯片整合封測(cè)技術(shù)--種用先進(jìn)封裝技術(shù)讓系統(tǒng)芯片與內(nèi)存達(dá)到高速傳輸ASIC 的演進(jìn)重復(fù)了從Gate Array 到Cell Base IC,再到系統(tǒng)芯片的變遷,在產(chǎn)業(yè)上也就出現(xiàn)了,負(fù)責(zé)技術(shù)開(kāi)發(fā)的IC
2009-10-05 08:11:50
關(guān)于電路板IC類(lèi)封裝尺寸的匯總——電路板設(shè)計(jì)檢驗(yàn)或者維修檢查參考可用
2019-02-13 10:35:28
目前新項(xiàng)目要用到midi音頻播放IC,沒(méi)有有推薦的,封裝要小,不需外掛flash
2018-01-16 18:38:59
。開(kāi)發(fā)設(shè)計(jì)人員在IC電氣性能設(shè)計(jì)上已接近國(guó)際先進(jìn)水平,但常常會(huì)忽視工藝方面的要求。本文介紹一種高性能IC封裝設(shè)計(jì)思想,解決因封裝使用不當(dāng)而造成的器件性能下降問(wèn)題。 如今的IC正面臨著對(duì)封裝進(jìn)行變革
2010-01-28 17:34:22
什么是舵機(jī)?舵機(jī)的常見(jiàn)種類(lèi)有哪些?
2021-10-12 07:16:41
有24V轉(zhuǎn)4V-12V 最大電流3A,封裝ESOP8類(lèi)小一點(diǎn)的,這樣的IC推薦嗎?
2018-08-27 10:45:53
請(qǐng)問(wèn)下,AD的IC相對(duì)應(yīng)的PCB封裝那里有提供呢?一般在那找 ,請(qǐng)隨便舉個(gè)例子 謝謝
2018-09-10 10:34:31
印制電路板基板材料有哪幾種類(lèi)型?
2021-04-25 09:28:22
在POWERPCB中如何制作綁定IC封裝?
2021-04-26 07:11:09
選擇IC封裝時(shí)的五項(xiàng)關(guān)鍵設(shè)計(jì)考慮
2021-01-08 06:49:39
筆者在日本大學(xué)、研究所和公司的研究工作經(jīng)歷,對(duì)高端IC封裝的最主要幾種類(lèi)型的設(shè)備作一一闡述。進(jìn)入2002年,隨著液晶顯示器TFT—LCD的流行,液晶Cell的IC Driver芯片貼付機(jī)開(kāi)始暢銷(xiāo),本文也
2018-08-23 11:41:48
IC 封裝名詞解釋?zhuān)ㄒ唬?txt
IC封裝名詞解釋(二).txt
IC封裝名詞解釋(三).txt
2008-01-09 08:48:25 89
89 芯片的封裝種類(lèi)
球形觸點(diǎn)陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點(diǎn)用 以 代替引腳,在印刷基板的正面裝配LSI 芯片,
2008-05-26 12:40:47 1630
1630 半導(dǎo)體封裝種類(lèi)大全 3 封裝的分類(lèi)
半導(dǎo)體(包括集成電路和分立器件)其芯片的封裝已經(jīng)歷了好幾代的變遷,從DIP、SOP、QFP、PGA
2010-03-04 11:00:38 5856
5856 IC常用封裝封裝尺寸,很好的資料,硬件工程師必備
2016-01-14 16:27:33 45
45 Keil C51安裝演示視頻,好東西,喜歡的朋友可以下載來(lái)學(xué)習(xí)。
2016-02-15 17:14:06 14
14 IC--------所有IC封裝庫(kù)文件 protel格式
2016-03-11 15:37:14 0
0 Siemens 業(yè)務(wù)部門(mén) Mentor 今天宣布推出業(yè)內(nèi)最全面和高效的針對(duì)先進(jìn) IC 封裝設(shè)計(jì)的解決方案 — Xpedition 高密度先進(jìn)封裝 (HDAP) 流程。
2017-06-27 14:52:20 1777
1777 這一講是:SM+軟件安裝演示視頻。
2018-06-15 03:32:00 30610
30610 
C編譯器軟件安裝演示視頻
2018-07-23 00:35:00 2833
2833 設(shè)備文件(Device file)安裝演示視頻
2018-07-23 00:55:00 1290
1290 Applilet軟件安裝演示視頻
2018-07-23 00:04:00 2549
2549 全球晶圓代工龍頭臺(tái)積電次代先進(jìn)封裝布局可望再進(jìn)一步,持續(xù)替摩爾定律延壽。日前苗栗縣政府已經(jīng)表示,臺(tái)積電竹南之先進(jìn)封測(cè)廠(chǎng)建廠(chǎng)計(jì)畫(huà)已經(jīng)展開(kāi)環(huán)評(píng),而熟悉半導(dǎo)體先進(jìn)封裝業(yè)者表示,臺(tái)積電近期陸續(xù)研發(fā)并推動(dòng)
2018-09-25 13:56:20 4157
4157 本文將介紹一些日常常用IC的封裝原理及功能特性,通過(guò)了解各種類(lèi)型IC的封裝,電子工程師在設(shè)計(jì)電子電路原理時(shí),可以準(zhǔn)確地選擇IC,而對(duì)于工廠(chǎng)批量生產(chǎn)燒錄,更可以快速地找到對(duì)應(yīng)IC封裝的燒錄座型號(hào)。
2019-05-09 15:21:41 19536
19536 本文首先介紹了sop封裝的概念,其次介紹了sop封裝種類(lèi),最后介紹了SOP封裝應(yīng)用范圍。
2019-05-09 16:07:45 7916
7916 作為一名電子工程師,日常工作基本上都會(huì)接觸上很多各種類(lèi)型的IC,比如邏輯芯片、存儲(chǔ)芯片、MCU或者FPGA等;對(duì)于各種類(lèi)型的IC的功能特性,或許會(huì)清楚得更多,但對(duì)于IC的封裝,不知道了解了多少?
2019-05-09 16:36:49 7055
7055 作為一名電子工程師,日常工作基本上都會(huì)接觸上很多各種類(lèi)型的IC,比如邏輯芯片、存儲(chǔ)芯片、MCU或者FPGA等;對(duì)于各種類(lèi)型的IC的功能特性,或許會(huì)清楚得更多,但對(duì)于IC的封裝,不知道了解了多少?本文
2019-09-15 14:36:00 1330
1330 本文將介紹日常IC的一些封裝原理和功能特性。通過(guò)了解各種類(lèi)型IC的封裝,電子工程師可以在設(shè)計(jì)電子電路原理時(shí)準(zhǔn)確選擇IC,并可以快速準(zhǔn)確地?zé)乒S(chǎng)批量生產(chǎn)。找到與IC封裝相對(duì)應(yīng)的刻錄機(jī)型號(hào)。
2019-07-31 15:21:00 4325
4325 經(jīng)常有想學(xué)IC封裝設(shè)計(jì)的朋友問(wèn),用什么軟件來(lái)做封裝設(shè)計(jì)?說(shuō)明大家都比較重視軟件學(xué)習(xí),下面簡(jiǎn)單介紹下主流的IC封裝設(shè)計(jì)軟件。
2020-07-13 09:07:53 20781
20781 臺(tái)積電和三星于先進(jìn)封裝的戰(zhàn)火再起。2020年,三星推出3D封裝技術(shù)品牌X-Cube,宣稱(chēng)在7納米芯片可直接堆上SRAM內(nèi)存,企圖在先進(jìn)封裝拉近與臺(tái)積電的距離。幾天之后,臺(tái)積電總裁魏哲家現(xiàn)身,宣布推出自有先進(jìn)封裝品牌3D Fabric,臺(tái)積電最新的SoIC(系統(tǒng)集成芯片)備受矚目。
2021-01-04 10:37:09 1269
1269 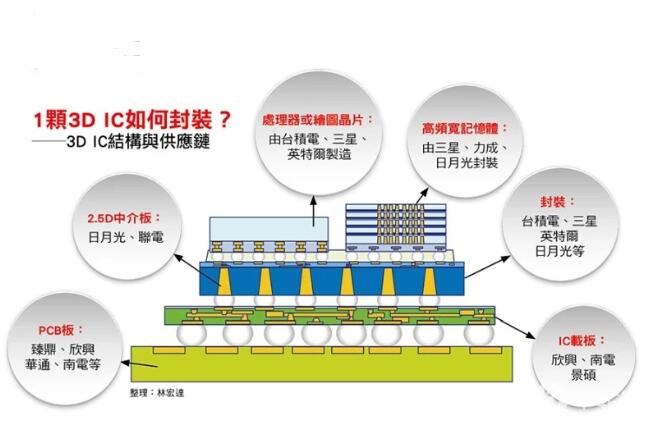
IC Package (IC的封裝形式)指芯片(Die)和不同類(lèi)型的框架(L/F)和塑封料(EMC)形成的不同外形的封裝體。 IC Package種類(lèi)很多,可以按以下標(biāo)準(zhǔn)分類(lèi): 按封裝材料劃分
2021-02-12 18:03:00 10790
10790 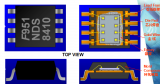
先進(jìn)封裝大部分是利用「晶圓廠(chǎng)」的技術(shù),直接在晶圓上進(jìn)行,由于這種技術(shù)更適合晶圓廠(chǎng)來(lái)做,因此臺(tái)積電大部分的先進(jìn)封裝都是自己做的。
2021-02-22 11:45:21 2200
2200 
、金屬,現(xiàn)在一般都是使用塑料封裝。 封裝大致發(fā)展歷程大概是TO→DIP→PLCC→QFP→PGA→BGA→CSP→MCM,技術(shù)一代比一代先進(jìn),并且可靠性也得到了提高。 1.MCM MCM是多芯片組件,是一種新技術(shù),省去了IC的封裝材料和工藝,能夠節(jié)省材料。 2.CSP CSP是芯
2021-09-20 17:08:00 24832
24832 的建模速度更為重要,需要方便快捷的模型庫(kù),提升任務(wù)的時(shí)效性、節(jié)約計(jì)算資源。接下來(lái)的兩篇文章將簡(jiǎn)單探討工程中常用的IC封裝模型種類(lèi),并介紹在Simcenter Flotherm中的IC建模方法。 01IC封裝建模分類(lèi) IC封裝建模主要分成詳細(xì)建模(Detailed Thermal Mo
2021-09-22 10:15:02 2255
2255 
什么是封裝?封裝即隱藏對(duì)象的屬性和實(shí)現(xiàn)細(xì)節(jié),將數(shù)據(jù)與操作數(shù)據(jù)的源代碼進(jìn)行有機(jī)的結(jié)合,那么封裝的種類(lèi)有哪些呢?
2022-01-07 17:08:39 13084
13084 IC芯片的常見(jiàn)種類(lèi)有哪些,主要用途是什么?
2022-01-18 11:55:57 17225
17225 作為一名電子工程師,日常工作基本上都會(huì)接觸上很多各種類(lèi)型的IC,比如邏輯芯片、存儲(chǔ)芯片、MCU或者FPGA等;對(duì)于各種類(lèi)型的IC的功能特性,或許會(huì)清楚得更多,但對(duì)于IC的封裝,不知道了解了多少?
2022-02-10 10:42:26 2
2 隨著先進(jìn) IC 封裝技術(shù)的快速發(fā)展,工程師必須跟上它的步伐,首先要了解基本術(shù)語(yǔ)。
2022-08-12 15:06:55 1419
1419 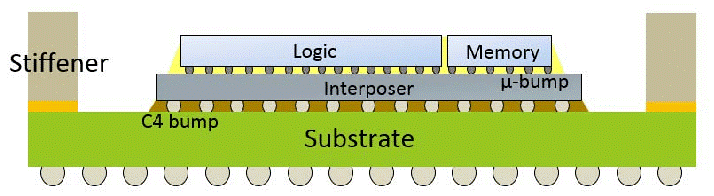
芯和半導(dǎo)體技術(shù)總監(jiān)蘇周祥在2022年EDA/IP與IC設(shè)計(jì)論壇中提出,在SoC的設(shè)計(jì)階段需要克服可靠性問(wèn)題,而在2.5D和3D方面需要解決的問(wèn)題則是系統(tǒng)級(jí)封裝和模塊仿真。
2022-08-18 10:48:58 943
943 2.5D封裝是傳統(tǒng)2D IC封裝技術(shù)的進(jìn)展,可實(shí)現(xiàn)更精細(xì)的線(xiàn)路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-10-26 09:34:04 627
627 2.5D封裝是傳統(tǒng)2D IC封裝技術(shù)的進(jìn)展,可實(shí)現(xiàn)更精細(xì)的線(xiàn)路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-11-15 09:35:36 1598
1598 來(lái)源:SiSC半導(dǎo)體芯科技 近年來(lái),先進(jìn)封裝市場(chǎng)已成為一條快速賽道,傳統(tǒng)封裝技術(shù)演進(jìn)到先進(jìn)2.5D/3D封裝技術(shù)已經(jīng)成為未來(lái)的重點(diǎn)發(fā)展方向。“芯片國(guó)產(chǎn)化”的興起帶動(dòng)封裝需求,同時(shí)先進(jìn)封裝技術(shù)開(kāi)始積極
2023-01-31 17:37:51 504
504 RX65N 云套件預(yù)裝演示快速入門(mén)指南
2023-02-02 19:07:31 0
0 來(lái)源:半導(dǎo)體芯科技SiSC 近年來(lái),先進(jìn)封裝市場(chǎng)已成為一條快速賽道,傳統(tǒng)封裝技術(shù)演進(jìn)到先進(jìn)2.5D/3D封裝技術(shù)已經(jīng)成為未來(lái)的重點(diǎn)發(fā)展方向。“芯片國(guó)產(chǎn)化”的興起帶動(dòng)封裝需求,同時(shí)先進(jìn)封裝技術(shù)開(kāi)始積極
2023-02-17 18:20:04 499
499 來(lái)源:半導(dǎo)體芯科技SiSC 后摩爾時(shí)代,半導(dǎo)體傳統(tǒng)封裝工藝不斷迭代,先進(jìn)封裝技術(shù)嶄露頭角,它們繼續(xù)著集成電路性能與空間的博弈。從傳統(tǒng)的平面封裝演進(jìn)到先進(jìn)2.5D/3D封裝,使系統(tǒng)集成度的不斷提高
2023-02-28 11:29:25 909
909 
來(lái)源:半導(dǎo)體芯科技SiSC 近年來(lái),先進(jìn)封裝市場(chǎng)已成為一條快速賽道,傳統(tǒng)封裝技術(shù)演進(jìn)到先進(jìn)2.5D/3D封裝技術(shù)已經(jīng)成為未來(lái)的重點(diǎn)發(fā)展方向。“芯片國(guó)產(chǎn)化”的興起帶動(dòng)封裝需求,同時(shí)先進(jìn)封裝技術(shù)開(kāi)始積極
2023-02-28 11:32:31 3851
3851 
來(lái)源:SiSC半導(dǎo)體芯科技 近年來(lái),先進(jìn)封裝市場(chǎng)已成為一條快速賽道,傳統(tǒng)封裝技術(shù)演進(jìn)到先進(jìn)2.5D/3D封裝技術(shù)已經(jīng)成為未來(lái)的重點(diǎn)發(fā)展方向。“芯片國(guó)產(chǎn)化”的興起帶動(dòng)封裝需求,同時(shí)先進(jìn)封裝技術(shù)開(kāi)始積極
2023-03-06 18:07:31 880
880 
Package--封裝體:指芯片(Die)和不同類(lèi)型的框架(L/F)和塑封料(EMC)形成的不同外形的封裝體
。>IC Package種類(lèi)很多,可以按以下標(biāo)準(zhǔn)分類(lèi):·按封裝材料劃分為:金屬封裝、陶瓷封裝、塑料封裝
2023-04-10 11:49:29 3
3 芯片升級(jí)的兩個(gè)永恒主題:性能、體積/面積。芯片技術(shù)的發(fā)展,推動(dòng)著芯片朝著高性能和輕薄化兩個(gè)方向提升。而先進(jìn)制程和先進(jìn)封裝的進(jìn)步,均能夠使得芯片向著高性能和輕薄化前進(jìn)。面對(duì)美國(guó)的技術(shù)封裝,華為
2023-04-15 09:48:56 1953
1953 Package--封裝體:
指芯片(Die)和不同類(lèi)型的框架(L/F)和塑封料(EMC)形成的不同外形的封裝體。
IC Package種類(lèi)很多,可以按以下標(biāo)準(zhǔn)分類(lèi):
?按封裝材料劃分為:金屬封裝、陶瓷封裝、塑料封裝
2023-05-19 09:36:49 2706
2706 
先進(jìn)封裝是對(duì)應(yīng)于先進(jìn)圓晶制程而衍生出來(lái)的概念,一般指將不同系統(tǒng)集成到同一封裝內(nèi)以實(shí)現(xiàn)更高效系統(tǒng)效率的封裝技術(shù)。
2023-06-13 11:33:24 282
282 
★前言★集成電路芯片與封裝之間是不可分割的整體,沒(méi)有一個(gè)芯片可以不用封裝就能正常工作,封裝對(duì)芯片來(lái)說(shuō)是必不可少的。隨著IC生產(chǎn)技術(shù)的進(jìn)步,封裝技術(shù)也在不斷更新?lián)Q代,每一代IC都與新一代的IC封裝技術(shù)
2022-04-08 16:31:15 641
641 
據(jù)2022年2月7日消息,上海微電子裝備(集團(tuán))股份有限公司(SMEE)舉行首臺(tái)2.5D/3D先進(jìn)封裝光刻機(jī)發(fā)運(yùn)儀式,向客戶(hù)正式交付先進(jìn)封裝光刻機(jī)。需要指出的是,上海微電子此次交付的是用于IC
2022-02-11 09:37:04 10435
10435 
在異質(zhì)異構(gòu)的世界里,chiplet是“生產(chǎn)關(guān)系”,是決定如何拆分及組合芯粒的方式與規(guī)則;先進(jìn)封裝技術(shù)是“生產(chǎn)力”,通過(guò)堆疊、拼接等方法實(shí)現(xiàn)不同芯粒的互連。先進(jìn)封裝技術(shù)已成為實(shí)現(xiàn)異質(zhì)異構(gòu)的重要前提。
2023-06-26 17:14:57 601
601 RX65N 云套件預(yù)裝演示快速入門(mén)指南
2023-07-04 18:53:46 0
0 1. 先進(jìn)制程受限,先進(jìn)封裝/Chiplet提升算力,必有取舍。
2023-07-07 09:42:04 1693
1693 
半導(dǎo)體器件有許多封裝形式,按封裝的外形、尺寸、結(jié)構(gòu)分類(lèi)可分為引腳插入型、表面貼裝型和高級(jí)封裝三類(lèi)。從DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技術(shù)指標(biāo)一代比一代先進(jìn)。
2023-08-11 09:43:43 1796
1796 
都對(duì)集成電路封裝技術(shù)和工藝提出了更高的要求,在現(xiàn)有半導(dǎo)體制程逼近物理極限的條件下,先進(jìn)封裝技術(shù)和工藝已成為拓展摩爾定律不容忽視的技術(shù)路徑。傳統(tǒng)封裝技術(shù)演進(jìn)至2.5D/3D先進(jìn)封裝是未來(lái)重點(diǎn)發(fā)力的方向。先進(jìn)封裝技術(shù)不僅能提
2023-08-18 17:57:49 775
775 
半導(dǎo)體產(chǎn)品在由二維向三維發(fā)展,從技術(shù)發(fā)展方向半導(dǎo)體產(chǎn)品出現(xiàn)了系統(tǒng)級(jí)封裝(SiP)等新的封裝方式,從技術(shù)實(shí)現(xiàn)方法出現(xiàn)了倒裝(FlipChip),凸塊(Bumping),晶圓級(jí)封裝(Waferlevelpackage),2.5D封裝(interposer,RDL等),3D封裝(TSV)等先進(jìn)封裝技術(shù)。
2023-10-31 09:16:29 836
836 
先進(jìn)封裝基本術(shù)語(yǔ)
2023-11-24 14:53:10 362
362 
信息時(shí)代,我們目睹著數(shù)據(jù)量不斷膨脹,推動(dòng)著芯片性能的飛速提升,例如處理器的浮點(diǎn)計(jì)算能力、網(wǎng)絡(luò)芯片的帶寬、存儲(chǔ)器的容量。核心芯片必須不斷提升互連速度和密度,IO速率每4~6年翻一番的發(fā)展速度已不能滿(mǎn)足對(duì)芯片性能提升的訴求,因此,提升密度成為不可或缺的途徑。
2023-12-12 11:03:20 596
596 
2.5/3D-IC封裝是一種用于半導(dǎo)體封裝的先進(jìn)芯片堆疊技術(shù),它能夠把邏輯、存儲(chǔ)、模擬、射頻和微機(jī)電系統(tǒng) (MEMS)集成到一起
2024-03-06 11:46:05 394
394 
根據(jù)IRDS的樂(lè)觀預(yù)測(cè),未來(lái)5年,邏輯器件的制造工藝仍將快速演進(jìn),2025年會(huì)初步實(shí)現(xiàn)Logic器件的3D集成。TSMC和Samsung將在2025年左右開(kāi)始量產(chǎn)基于GAA (MBCFET)的2nm和3nm制程的產(chǎn)品 [17]。
2024-03-15 09:16:27 52
52 
先進(jìn)封裝和先進(jìn) IC 載板構(gòu)成了強(qiáng)大而高效的 AI 加速器和高性能計(jì)算 (HPC) 應(yīng)用的基礎(chǔ)。隨著AI浪潮的興起,對(duì)AICS行業(yè)賦能下一代AI和HPC產(chǎn)品提出了巨大挑戰(zhàn)。
2024-03-18 14:06:30 111
111 
Bump Metrology system—BOKI_1000在半導(dǎo)體行業(yè)中,Bump、RDL、TSV、Wafer合稱(chēng)先進(jìn)封裝的四要素,其中Bump起著界面互聯(lián)和應(yīng)力緩沖的作用。Bump是一種金屬凸
2023-09-06 14:26:09

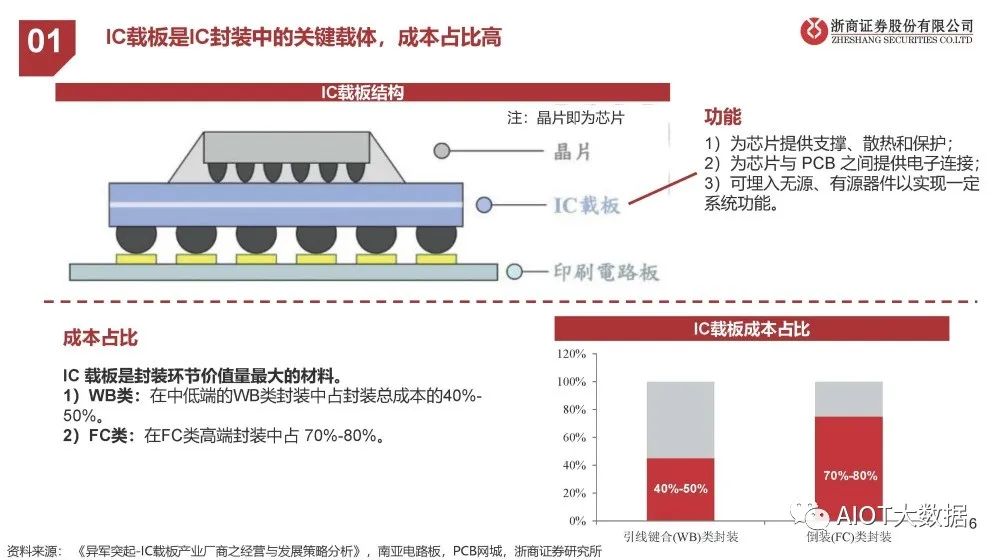


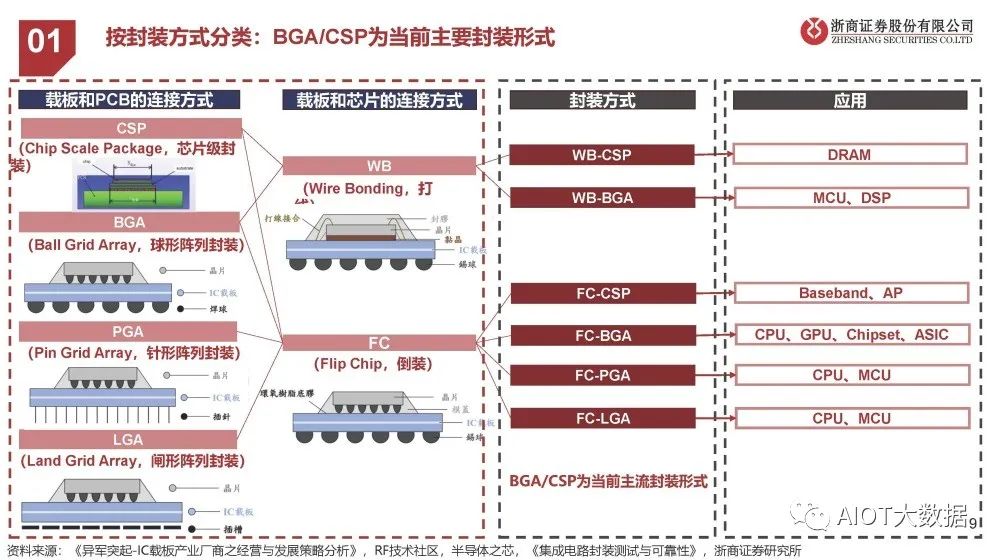

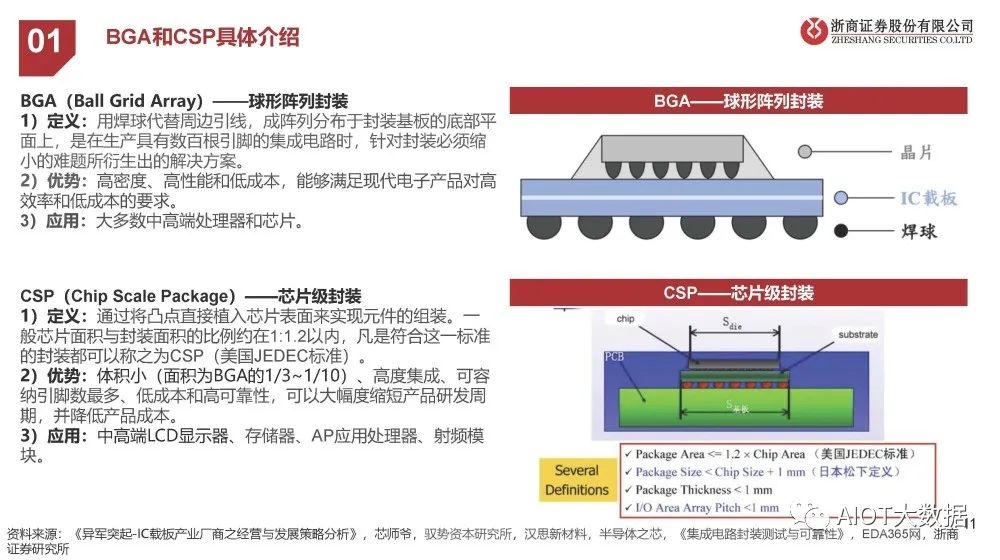
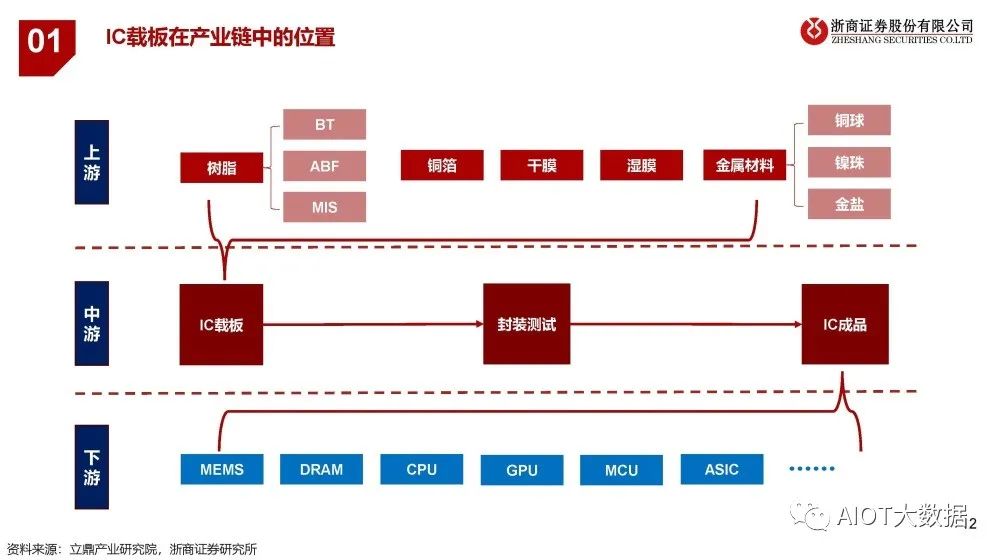











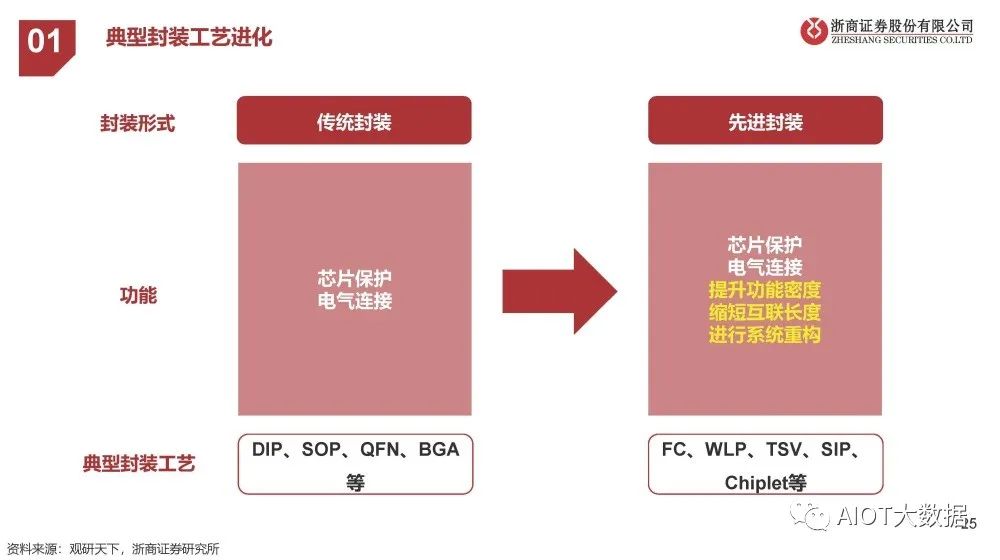
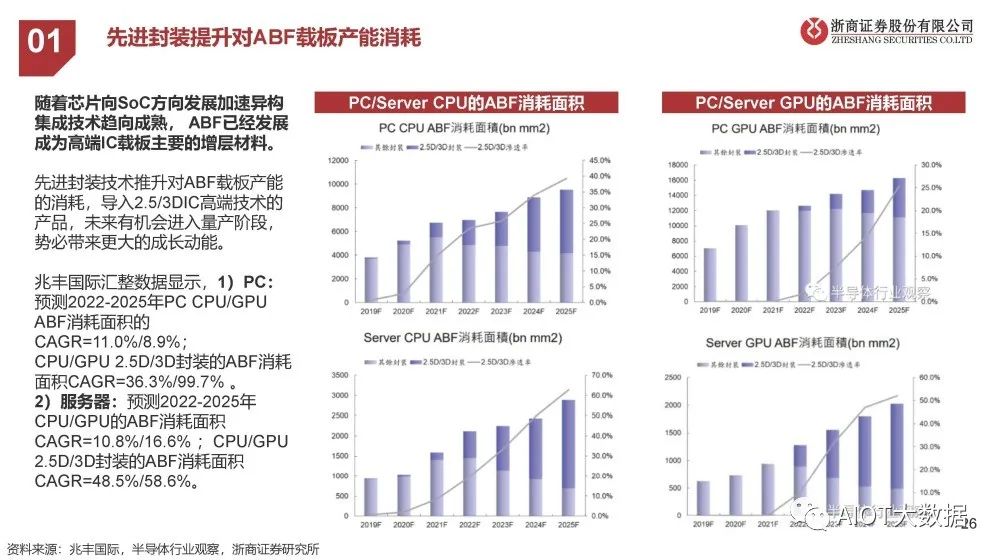

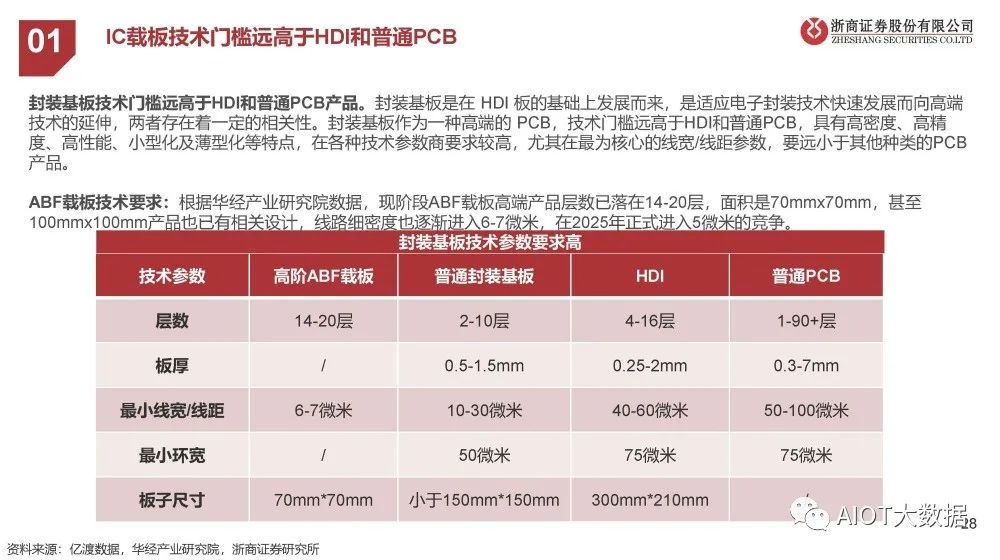













 電子發(fā)燒友App
電子發(fā)燒友App
















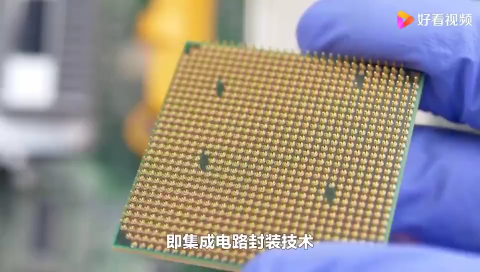

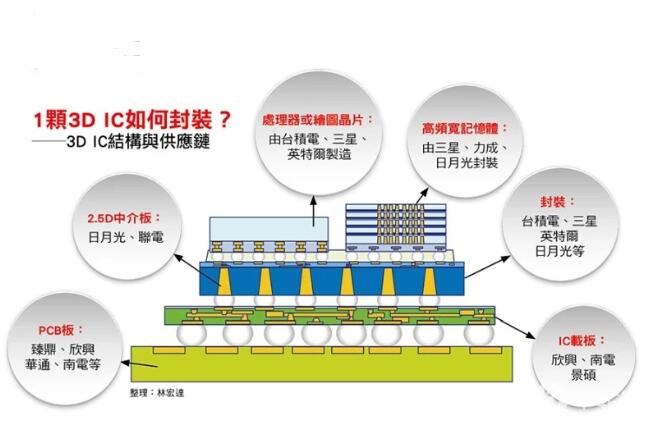
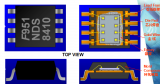


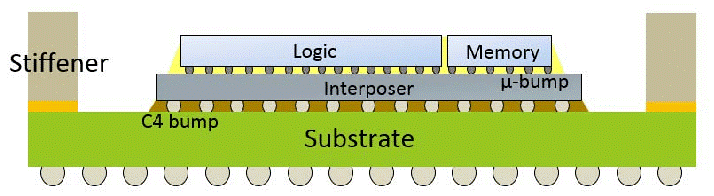


























評(píng)論