【摘 要】 伴隨功率金氧半場效晶體管(mosfet)電流和工作電壓的大幅度增加,以及芯片尺寸的逐漸減小,從而導(dǎo)致器件芯片內(nèi)部電場也相應(yīng)增大。這些現(xiàn)象都嚴(yán)重影響功率M0SFET的可靠性,怎樣提升功率器件的可靠性備受業(yè)界的期待。而其中關(guān)鍵的影響因素是功效器件封裝失效的問題。本文介紹功率器件封裝的內(nèi)涵和分類,通過對失效機理的分析,提出功率器件封裝工藝優(yōu)化的路徑。
封裝工藝是為了提升電子設(shè)備運行的可靠性,采取的相應(yīng)保護措施,即針對可能發(fā)生的力學(xué)、化學(xué)或者環(huán)境等不確定因素的攻擊,利用封裝技術(shù)和特殊材料對電子設(shè)備進行保護。封裝技術(shù)已經(jīng)廣泛應(yīng)用于航空航天設(shè)備、汽車、計算機以及移動通信設(shè)備等諸多領(lǐng)域中。
但伴隨著超低壓、超高壓、強濕熱、大溫差等特殊條件下電子設(shè)備運行要求的增加,加之封裝器件日趨大功率應(yīng)用、小尺寸化、功能高集成化以及越發(fā)復(fù)雜化的因素,經(jīng)常發(fā)生因為封裝失效引起電子設(shè)備運行過程中故障問題,嚴(yán)重影響了功率器件的可靠性。因此,封裝失效問題以及如何對封裝工藝進行優(yōu)化,是目前封裝行業(yè)需要研究的課題 [1] 。
1 功率器件封裝簡介及分類
1.1 封裝簡介在芯片的應(yīng)用過程中,封裝(Package)工藝是必不可少的。簡單地說,該工序就是為半導(dǎo)體集成電路芯安裝一個外殼,具備兩方面的功能,其一是穩(wěn)定、密封和保護芯片;其二是發(fā)揮芯片散熱的作用,其三是連接芯片內(nèi)部和外部的載體。
從作用機理來說,通常包括連接電氣、物理保護以及標(biāo)準(zhǔn)規(guī)格化。封裝質(zhì)量的好壞直接影響器件運行效率的高低,尤其針對功率半導(dǎo)體器件,封裝還會起到兩方面特殊的作用:良好的封裝可以幫助器件散熱;針對較大的芯片,封裝可以產(chǎn)生封裝和焊接芯片過程中的應(yīng)力,避免芯片破碎。
1.2 封裝形式分類
1.2.1 塑封直列式封裝塑料封裝最大優(yōu)勢是適合大批量生產(chǎn)、工藝簡單、成本較低,由此適應(yīng)性極強,應(yīng)用和發(fā)展的趨勢良好,在封裝行業(yè)的總體份額中占比越來越大,在全球集成電路的封裝市場上,95%以上為塑封直列式。消費類電路合格器件的封裝幾乎都是該類型的封裝;
同時工業(yè)類電路中也占據(jù)很大的比例。該類封裝的形式也是最多的。最普遍使用的有兩種封裝形式:TO—220;TO—247。塑料封裝的電流傳送量很大。為了提升散熱效果,會將塑封器件緊貼線路板或者散熱器,實現(xiàn)最佳的散熱效果。
1.2.2 大功率器件應(yīng)用模塊隨著近些年日益普及的igbt,可以將單個igbt、兩個或者三個igbt,與控制電路放在一個模塊中實施封裝。而且正在出現(xiàn)的多模塊(mcm)形式,代表了封裝領(lǐng)域的新趨勢。
1.2.3 塑封表面貼裝及其他塑料封裝是一種對功率器件表面貼裝模式,這是80年代得到迅速發(fā)展的塑封形式。通常采用兩端和三端進行分立器件的封裝。雖然單個分立器件不需要許多端子,但是端子的增加有利于電流的流動和散熱。例如,t0263、t0262和其他形式的包裝類似于此特性 [2] 。
1.2.4 高可靠性封裝該封裝模式多半在軍工或航天領(lǐng)域應(yīng)用。基于可靠性的要求,外殼利用金屬封裝。
2 功率器件的失效分析
2.1 焊料空洞導(dǎo)致EOS失效本文借鑒了相關(guān)文獻的研究成果,確定了影響器件散熱的因素為焊料的空洞,對不同尺寸空洞影響器件散熱的程度進行深刻分析,并以此為基礎(chǔ)深入探討研究器件芯片可靠性受焊料空洞影響程度及其熱應(yīng)力的狀況。
目前廣泛應(yīng)用的環(huán)氧塑封料形式呈現(xiàn)熱導(dǎo)系數(shù)非常低,熱導(dǎo)體效果不佳,功率器件運行中形成的熱量傳遞的途徑唯有芯片。如圖1所示,圖1中箭頭的方向就是芯片在工作狀態(tài)下產(chǎn)生熱的傳輸方向。從圖1中不難看出,如果焊料內(nèi)空洞形成的原因是器件生產(chǎn)過程中工藝不當(dāng),基于空氣導(dǎo)熱系數(shù)只有0.03w/ (m.k),表現(xiàn)熱導(dǎo)體的不佳狀態(tài),器件散熱受到影響,在這樣的狀態(tài)下長久運行,ESO會因為大量熱量的積累而導(dǎo)致器件失效。
2.2 柵極開路導(dǎo)致EOS失效場效應(yīng)晶體管(mosfet),是電壓管控的一種手段,在絕緣層的溝道區(qū)對柵壓實施有效的管控,而利用柵壓大小的改變對此區(qū)域的載流子濃度實施調(diào)控,從而確保源漏間電流大小的有效控制。因為打線不牢導(dǎo)致柵極引線升離或是因為長時間的熱循環(huán)讓引線跟部裂紋產(chǎn)生斷裂后,產(chǎn)生柵極開路,從而失去柵極控制電流的能力,引發(fā)EOS,導(dǎo)致器件失效。
2.3 芯片裂紋導(dǎo)致EOS失效硬而脆的單晶硅晶體具備金剛石的品質(zhì),一旦形成硅片受力容易脆斷與開裂。在引線鍵合、晶圓減薄、芯片焊接、圓片劃片等工序中都可以形成硅芯片裂紋。
通常情況下,芯片只是在引線區(qū)域外的微裂紋,就難以被發(fā)現(xiàn),最糟糕的情況是在工藝實施中沒有發(fā)現(xiàn)芯片裂紋,更甚者是電學(xué)測試芯片的時候,微裂紋的芯片與沒有裂紋的芯片在電特反應(yīng)上不存在差別,但微裂紋會危及封裝后器件的可靠性、降低器件的使用年限。裂紋只有下列幾種情況才能顯示出來:采用十分靠譜的高低溫循環(huán)實驗或者是器件散熱時候瞬間加熱,呈現(xiàn)不匹配的芯片和封裝材料熱膨脹系數(shù),還有運行中的外界應(yīng)力作用等。否則是難以發(fā)現(xiàn)裂紋的,這也會成為器件封裝失效的原因。
3 功率器件封裝工藝優(yōu)化研究
3.1 問題分析在功率器件封裝工藝中,最關(guān)鍵的工序就是芯片焊接 [3] 。焊接過程是利用熔融合金焊料將芯片與引線框架結(jié)合,使引線框架散熱器與芯片集熱器的歐姆接觸形成良好的散熱途徑。因為性質(zhì)不同的粘結(jié)劑和固體表面,以及化學(xué)、吸附、力學(xué)、靜電、配位鍵、擴散等諸多因素,并不能對不同表面和粘結(jié)劑粘結(jié)的道理做出清楚解釋。
同時,氣體、油污、塵埃等污染物都會被固體表面所吸附,導(dǎo)致表面因為氧化膜而污跡斑斑。
另外,基于加工精度的影響,因為加工精度不夠,固體表面會存在宏觀和微觀的幾何形狀誤差,粘貼的界面只是中幾何面積的2%-7%,所以,嚴(yán)重降低了粘結(jié)劑對固體表面的保濕功能。
所以,針對器件封裝的芯片焊接工藝,焊料中的空洞成為最嚴(yán)重的問題,不僅削弱了器件的散熱能力、阻礙了與歐姆接觸,更對功率器件的可靠性構(gòu)成威脅。
由于芯片必須先焊接在引線框架上,然后將芯片連接到框架上,最后實施高溫焊接,因為器件和粘合劑類型的差異性,也會呈現(xiàn)不同的焊接曲線和溫度。3.2 優(yōu)化措施確定在優(yōu)化電源裝置的焊接工藝之前,對該裝置進行 x 射線掃描。結(jié)果表明,焊料空洞約占芯片面積的1%-7% 。
按照電源裝置的有關(guān)規(guī)定,焊料里的空洞大小不超過芯片面積的百分之十才可定性為合格產(chǎn)品。可是在具體的運行實踐顯示,就算低于10%的空洞面積的器件可靠性也難以保障。本文的試驗利用對時間曲線、焊接溫度的優(yōu)化,以減少焊料的空洞,明顯提升了器件的可靠性、讓使用壽命得以有效延長。
3.3 優(yōu)化效果對比分析在進行芯片封裝工藝優(yōu)化之前,試驗樣品選擇的片焊溫度-時間曲線溫度最高值358.9℃,熔融時間為37分鐘,焊接后降溫速率是9.71℃/秒;工藝實施優(yōu)化后,芯片焊接溫度-時間曲線的最高溫度為358.3℃,需要39分熔融時間,焊接后的降溫速率為8.95℃/秒。
提升相關(guān)工序的溫度,可以促進芯片下悍膏的流動性,加速悍膏內(nèi)空氣的排出;而對焊后降溫速率的降低,有助于對芯片的保護,最大限度避免芯片產(chǎn)生裂紋。針對優(yōu)化措施前、優(yōu)化措施后,隨機分別抽取5個樣品,利用X—Ray對焊料的空洞實施測量同時對兩者的結(jié)果進行比較,結(jié)果顯示,在工藝優(yōu)化措施實施前焊料空洞量為1.4%-6.6%之間。
優(yōu)化前,芯片焊接空洞的孔隙率不同,部分孔隙率甚至達到10% 的最大范圍。而對芯片的焊接采用優(yōu)化措施后的焊接曲線,器件的焊料空洞已經(jīng)沒有,表現(xiàn)顯著的優(yōu)化效果。焊接溫度的提高會讓熱應(yīng)力加強,但優(yōu)化結(jié)果獲悉,焊料的空洞更能夠減少。
因為考慮到提升器件的可靠性,雖然極大的應(yīng)力會因為焊接溫度升高而加大,但空洞減少的價值和意義更大。同時測試優(yōu)化前后的樣品采用Undamped Inductive Loading進行測試,Uil 可以作為衡量設(shè)備阻力的參數(shù)。
測試原理如下: 將柵極電壓施加到器件上后,由外部電源對電感器進行充電,直至電感器產(chǎn)生預(yù)期的電流測試值,從而完成電感器的充電過程; 電感器對器件進行反向放電,完成電感器的放電過程。感應(yīng)器反向放電到設(shè)備,會導(dǎo)致器件的雪崩狀態(tài),以此測試器件的抗EOS能力。
對優(yōu)化前后的兩組樣品,隨機抽取15個樣品進行 uil 檢測,測試公式為:V DD =23V,V GS =10V,L=0.3mH。同時,對物態(tài)方程的能量和電流進行了比較和分析。實驗結(jié)果表明,eos的能量為279.3mj,平均電流為41.8a,沒有焊接腔的 eos 的能量為307.6mj,平均電流為46.1a。
因此,無焊接腔器件必須具有較高的能量和電流才能導(dǎo)致 eos 失效,因此,沒有焊點的器件比有焊點的器件具有更高的抗失效能力。4 結(jié)束語盡管目前對封裝實效問題的研究已經(jīng)成為熱點,也取得了一定成效。但對于封裝失效形成以及演化規(guī)律的研究才剛剛開始,以往的多數(shù)研究主要是基于對封裝材料的研究,對金屬與聚合物界面的影響關(guān)注甚少。
所以,對封裝失效問題的后續(xù)的深入研究,必須在現(xiàn)有基礎(chǔ)上進行關(guān)鍵的補充,研究領(lǐng)域應(yīng)該注重封裝功率器件整體的關(guān)注,要以器件與封裝材料界面彼此作用前提下,綜合試驗研究與仿真建模研究的實踐數(shù)據(jù),對封裝失效過程的形成、變化的軌跡以及多場耦合效應(yīng)進行全面分析,找出功率器件實際使用壽命低于預(yù)期使用壽命的真正原因,為提升封裝工藝以及器件的可靠性提供幫助。
4.1 大數(shù)據(jù)挖掘技術(shù)流程在前面分析過大數(shù)據(jù)挖掘的概念,即利用數(shù)據(jù)挖掘技術(shù)發(fā)現(xiàn)海量數(shù)據(jù)的特征,通過建立模型來發(fā)現(xiàn)數(shù)據(jù)間的關(guān)系,從而為企業(yè)發(fā)展提供參考。大數(shù)據(jù)挖掘的流程分為以下幾個階段:數(shù)據(jù)源 — —數(shù)據(jù)抽取 — —數(shù)據(jù)匯集與清洗 — —數(shù)據(jù)加工 — —數(shù)據(jù)分析 — —可視化,如圖1所示。
4.2 利用大數(shù)據(jù)挖掘技術(shù)構(gòu)建財務(wù)分析框架圖利用大數(shù)據(jù)挖掘技術(shù)可以構(gòu)建財務(wù)分析框架。構(gòu)建思路如下:首先確定數(shù)據(jù)源。該數(shù)據(jù)源不僅僅指傳統(tǒng)財務(wù)分析中的報表財務(wù)數(shù)據(jù),還有很多非財務(wù)數(shù)據(jù)。其次是數(shù)據(jù)抽取和數(shù)據(jù)匯集與清洗,從而得到目標(biāo)數(shù)據(jù)。從這些數(shù)據(jù)源中抽取出對企業(yè)有用的信息,或者企業(yè)需要分析的某一方面的數(shù)據(jù)。
例如,企業(yè)想通過分析員工的出差天數(shù),或者差旅費來對公司成本進行控制,那么就需要從數(shù)據(jù)源中抽取相關(guān)數(shù)據(jù)。抽取這些數(shù)據(jù)之后,需對其進行去重,清洗,截取字段等工作,去除無用信息,保留有用數(shù)據(jù)。再次是數(shù)據(jù)挖掘。該步驟包括了數(shù)據(jù)加工和數(shù)據(jù)分析。
在該過程中,需要企業(yè)利用大數(shù)據(jù)平臺中的語言和符號,利用規(guī)定的算法,模型等來對前一步驟篩選出的財務(wù)數(shù)據(jù)進行處理分析,發(fā)現(xiàn)數(shù)據(jù)內(nèi)部存在的關(guān)系,從而為企業(yè)的商機預(yù)測和風(fēng)險防控做鋪墊。最后是數(shù)據(jù)可視化。
該步驟可以通過形象直觀的內(nèi)容來表現(xiàn)出財務(wù)分析結(jié)果的內(nèi)容,從可視化圖形中可以直觀觀察財務(wù)數(shù)據(jù)和各種指標(biāo)走勢,使得大數(shù)據(jù)挖掘技術(shù)的結(jié)果更加形象生動,并且容易被管理層所理解。根據(jù)以上分析,利用大數(shù)據(jù)挖掘技術(shù)構(gòu)建財務(wù)分析框架圖。
5 結(jié)語“互聯(lián)網(wǎng)+”時代是萬物互聯(lián)的時代,也是海量數(shù)據(jù)和信息的時代,將大數(shù)據(jù)挖掘技術(shù)深入應(yīng)用到企業(yè)財務(wù)分析領(lǐng)域還值得更深層次的研究。
當(dāng)然,要把大數(shù)據(jù)挖掘技術(shù)應(yīng)用于財務(wù)分析,還需要解決以下幾個問題:
一是財務(wù)人員的技術(shù)問題。企業(yè)所雇傭的財務(wù)人員是否能夠熟練運用大數(shù)據(jù)挖掘技術(shù)并進行財務(wù)工作的開展。
二是企業(yè)是大數(shù)據(jù)平臺問題。自己搭建大數(shù)據(jù)平臺耗時耗力,而企業(yè)通過第三方服務(wù)機構(gòu)購買一些大數(shù)據(jù)平臺又可能無法滿足自己所有的工作需求。
三是完全依賴網(wǎng)絡(luò)處理財務(wù)問題。大數(shù)據(jù)挖掘技術(shù)不可避免存在漏洞,也會有很多黑客技術(shù)盜竊數(shù)據(jù)信息,企業(yè)如果一味依賴大數(shù)據(jù)挖掘技術(shù)處理財務(wù)問題,企業(yè)財務(wù)乃至整體都會遇到更加嚴(yán)重的安全問題 [4] 。因此,企業(yè)需要從各個方面合理、安全的利用大數(shù)據(jù)挖掘技術(shù),讓其為自身所用,而非被其所困。
來源:輕工科技 2021年第37卷第7期
作者:陳逸晞
(以上文章系轉(zhuǎn)載,并不代表電子發(fā)燒友的觀點,如有涉及版權(quán)等問題,請聯(lián)系我們以便處理)
編輯:jq
-
芯片
+關(guān)注
關(guān)注
459文章
52416瀏覽量
439475 -
封裝
+關(guān)注
關(guān)注
128文章
8630瀏覽量
145249 -
晶體管
+關(guān)注
關(guān)注
77文章
10009瀏覽量
141359 -
大功率器件
+關(guān)注
關(guān)注
0文章
16瀏覽量
6768 -
大數(shù)據(jù)
+關(guān)注
關(guān)注
64文章
8957瀏覽量
139973
原文標(biāo)題:功率器件封裝失效分析及工藝優(yōu)化研究
文章出處:【微信號:jszkjx,微信公眾號:君芯科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
提升功率半導(dǎo)體可靠性:推拉力測試機在封裝工藝優(yōu)化中的應(yīng)用

深入剖析典型潮敏元器件分層問題

電子元器件失效分析與典型案例(全彩版)
深入剖析智芯傳感開口封封裝技術(shù)

高密度封裝失效分析關(guān)鍵技術(shù)和方法

深入剖析:封裝工藝對硅片翹曲的復(fù)雜影響

塑封器件絕緣失效分析

功率模塊封裝全攻略:從基本流程到關(guān)鍵工藝






 深入剖析功率器件封裝失效分析及工藝優(yōu)化
深入剖析功率器件封裝失效分析及工藝優(yōu)化

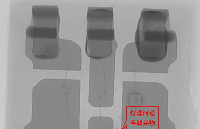















評論