傳統(tǒng)的引線鍵合 SOT-23封裝的功耗能力有限。由于內(nèi)部結(jié)構(gòu)不同,倒裝芯片 (FCOL) SOT-23 封裝具有更好的功耗能力。本應(yīng)用筆記比較了兩種封裝技術(shù),并提出了一些如何優(yōu)化 PCB 布局以實(shí)現(xiàn)最佳熱性能的實(shí)用指南。
一、簡(jiǎn)介
SOT-23 封裝因其小尺寸和低成本而廣受歡迎,而 6 引腳和 8 引腳版本仍然允許它們用于各種應(yīng)用,例如 LDO 和開(kāi)關(guān)穩(wěn)壓器。
SOT-23 封裝的缺點(diǎn)之一是它們的功耗能力有限,因?yàn)檫@些封裝沒(méi)有散熱墊。
JEDEC 熱參考板中的標(biāo)準(zhǔn)引線鍵合 SOT-23-6 封裝熱阻顯示 θ JA值(從結(jié)點(diǎn)到環(huán)境的熱阻)約為 220 ~ 250 o C/W,這意味著在環(huán)境溫度約為 55 ℃的應(yīng)用中o C,0.3W 的 IC 耗散已經(jīng)達(dá)到 125 o C的最大推薦結(jié)溫。
在實(shí)際的 PCB 布局中,有一些方法可以增加功耗能力,通過(guò)增加連接到引腳的走線寬度,但這些措施的有效性很大程度上取決于 SOT-23 封裝的內(nèi)部結(jié)構(gòu)。
與倒裝芯片 (FCOL) 封裝相比,傳統(tǒng)的引線鍵合封裝在熱方面的表現(xiàn)截然不同。為了做出最佳的 PCB 布局,了解更多關(guān)于這兩種封裝類型的內(nèi)部結(jié)構(gòu)非常重要。
2.Wire-Bond SOT-23-6封裝結(jié)構(gòu)
下面的圖 1 顯示了引線鍵合 SOT-23-6 封裝的基本結(jié)構(gòu)。
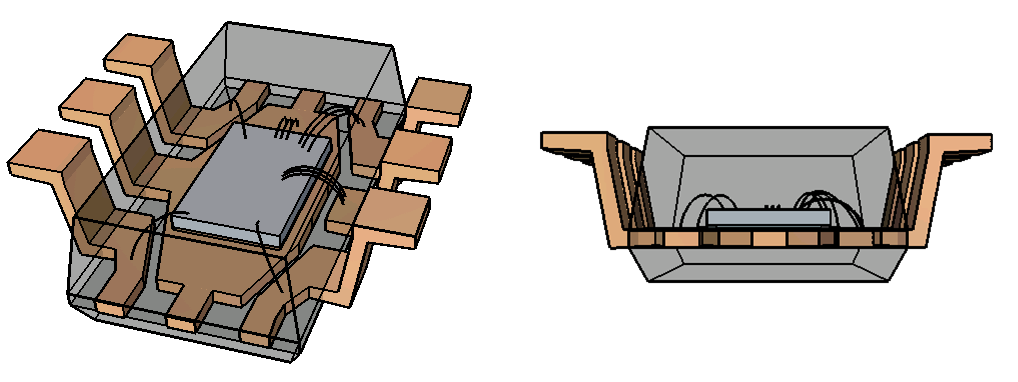
圖1
硅管芯粘在中心接地引線上,管芯電氣連接通過(guò)鍵合線連接到引線框架引腳,鍵合線通常是 25-38 微米的金線或銅線。
這些細(xì)線會(huì)增加關(guān)鍵電路節(jié)點(diǎn)的電阻、電感和雜散電容,從而降低高頻開(kāi)關(guān)轉(zhuǎn)換器的性能。尤其是在更高電流的降壓轉(zhuǎn)換器中,鍵合線會(huì)在器件的總功率損耗中發(fā)揮重要作用。
細(xì)的鍵合線也是不良的熱導(dǎo)體,因此引腳的大部分潛在熱傳遞都會(huì)丟失。熱傳遞主要是從芯片背面通過(guò)粘合劑傳遞到中心接地引腳,從而在中心引腳上產(chǎn)生熱點(diǎn)。
圖 2 顯示了降壓轉(zhuǎn)換器應(yīng)用中引線鍵合 SOT-23-6 封裝的熱圖像仿真。
器件功耗設(shè)置為 0.5W。

圖 2
可以清楚地看到,中心引腳的溫度遠(yuǎn)高于相鄰引腳。該單個(gè)引腳在將所有熱量從管芯傳導(dǎo)到 PCB 方面受到限制,并且在器件中心引腳周圍形成熱點(diǎn)。
3.FCOL SOT-23-6封裝結(jié)構(gòu)
下面的圖 3 顯示了 Flip-Chip-On-Lead SOT-23-6 封裝的內(nèi)部結(jié)構(gòu)。
(為了清楚起見(jiàn),模具是透明的)
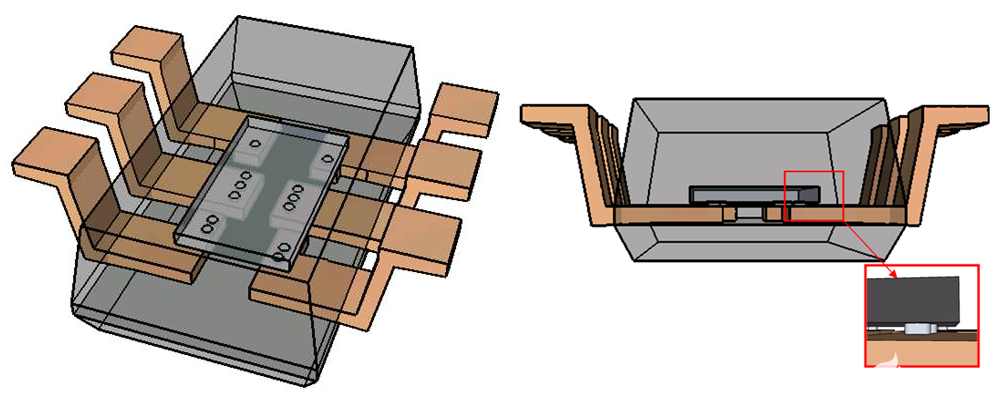
圖 3
硅管芯的頂面通過(guò)柱接合安裝到引線框架,提供從硅管芯到引線框架的直接熱和電連接。
柱鍵合的短互連長(zhǎng)度可顯著降低電阻、電感和保持電容,從而最大限度地降低 I 2 R 和開(kāi)關(guān)損耗,同時(shí)減少?gòu)U熱。
所有引腳現(xiàn)在都充當(dāng)小型散熱器,可用于高效冷卻,因此從封裝到 PCB 的熱傳遞更多,從而降低芯片溫度。圖 4 顯示了具有相同 0.5W 器件功耗的 FCOL 封裝的熱仿真。
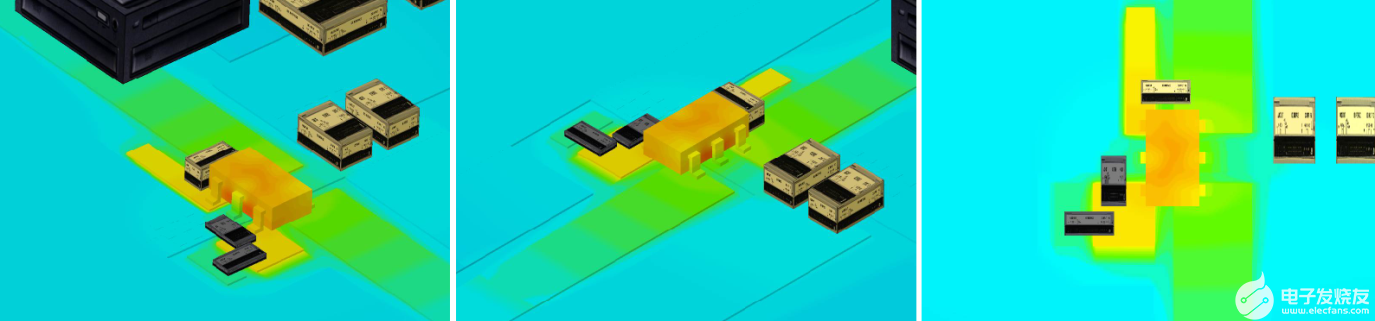
圖 4
熱仿真清楚地顯示了 FCOL 封裝對(duì)所有引腳的熱傳導(dǎo)更加均勻,并且中心引腳周圍沒(méi)有明顯的熱點(diǎn)。
4.SOT-23 PCB布局技巧
很明顯,引線鍵合和 FCOL SOT-23 封裝在其對(duì)器件引腳的熱傳導(dǎo)特性方面存在一些明顯差異。PCB 設(shè)計(jì)人員可以利用這些知識(shí)來(lái)優(yōu)化每個(gè)封裝的 PCB 布局。
圖 6 顯示了使用RT7295C GJ6F的示例布局,它是基于立锜 ACOT? 拓?fù)涞?FCOL SOT-23 中的 3.5A 降壓轉(zhuǎn)換器。(“F”后綴代表 FCOL)。簡(jiǎn)單示意圖如圖 5 所示。
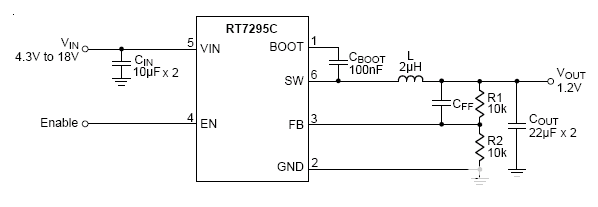
圖 5
基本設(shè)置如下所示。它使用 4 層板。標(biāo)準(zhǔn)通孔用于連接內(nèi)層和底層。

圖 6
在圖 6 的布局中,每個(gè)引腳都有額外的銅。對(duì)于 Boot 和 SW 引腳,較大的銅層可能會(huì)導(dǎo)致額外的輻射,因此必須做出妥協(xié)。FB 引腳對(duì)噪聲拾取很敏感,因此也不能有大的覆銅面積。GND 和 VIN 引腳通過(guò)多個(gè)通孔連接到內(nèi)層銅平面。使能引腳也可以有一些額外的銅并連接到底層。

圖 7
PCB 橫截面按比例顯示過(guò)孔和內(nèi)層。通孔在將熱量從頂層傳導(dǎo)到其他層方面非常有效。可以添加額外的過(guò)孔以獲得更好的熱傳導(dǎo)。
下表顯示了不同層的布局。

以上布局僅供參考。在某些 PCB 設(shè)計(jì)中,頂層和底層可能沒(méi)有那么多空間。在這些情況下,IC 引腳可以通過(guò)通孔連接到內(nèi)層的銅平面。重要的是要認(rèn)識(shí)到,在 FCOL 封裝中,所有 IC 引腳都是潛在的熱導(dǎo)體,與 PCB 銅平面的良好熱連接可以增強(qiáng)熱冷卻效果。
5.熱測(cè)量
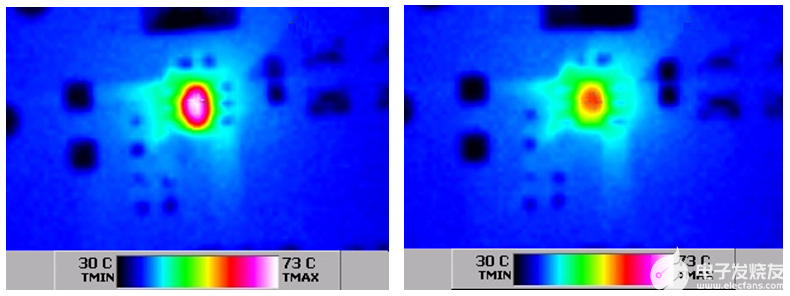
圖 8
圖 8 顯示了兩個(gè)熱掃描圖:左側(cè)是標(biāo)準(zhǔn)引線鍵合 SOT-23-6 封裝,而右側(cè)掃描圖顯示的是 FCOL SOT-23-6。兩款 IC 均安裝在 Richtek 評(píng)估板上,器件功耗相同,約為 0.7W。根據(jù)第 4 章中提到的指南,對(duì)布局進(jìn)行了優(yōu)化,以獲得良好的熱性能。焊線 SOT-23-6 清楚地顯示了一個(gè)大熱點(diǎn),并且掃描還顯示封裝左側(cè)的引腳比引腳更熱在右側(cè)。這是因?yàn)?GND 引腳位于左側(cè)。FCOL 封裝熱點(diǎn)比引線鍵合溫度低 20 ~ 30 度左右,所有引腳的熱傳導(dǎo)均勻。
基于上述結(jié)果,在高度優(yōu)化的布局中,F(xiàn)COL SOT-23-6 封裝從結(jié)到環(huán)境的熱阻可以低至55 o C/W。在可用空間較小的布局中,冷卻性能可能會(huì)稍差,但絕對(duì)可以實(shí)現(xiàn) 70~80 o C/W 的值。這使得在 60 o C 的環(huán)境條件下耗散大約 0.85W 成為可能。
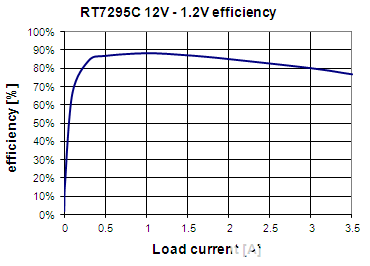
圖 9
圖 9 顯示了RT7295C在 12V 至 1.2V 應(yīng)用中的效率圖。
3.1A 負(fù)載下的 IC 損耗約為 0.85W。
這意味著當(dāng)RT7295C應(yīng)用在熱增強(qiáng)布局中時(shí),該器件絕對(duì)可以提供 3A 負(fù)載電流而不會(huì)過(guò)熱。
6.總結(jié)
FCOL 封裝具有一些電氣和熱學(xué)優(yōu)勢(shì)。在 FCOL 封裝中,每個(gè)引腳與硅芯片都有良好的熱連接。可以優(yōu)化 PCB 布局,讓每個(gè)引腳將更多的熱量從芯片傳導(dǎo)到 PCB,從而降低從結(jié)到環(huán)境的整體熱阻。與具有引線鍵合連接的相同封裝相比,這允許在 FCOL 封裝中消耗更多功率。
-
pcb
+關(guān)注
關(guān)注
4362文章
23460瀏覽量
408408 -
封裝
+關(guān)注
關(guān)注
128文章
8624瀏覽量
145168 -
SOT-23
+關(guān)注
關(guān)注
0文章
26瀏覽量
13411
發(fā)布評(píng)論請(qǐng)先 登錄
封裝SOT-23 貼片EA2 請(qǐng)問(wèn)是什么元件
關(guān)于三極管SOT-23封裝的問(wèn)題
緊急求助SOT-23封裝絲印1KPG3管子型號(hào)
SOT-23 FCOL封裝的散熱效能
關(guān)于SOT-23封裝的TVS管怎么用
采用SOT-23封裝的SMBU風(fēng)扇速度控制器
UG-838:5引線SOT-23和6引線SOT-23封裝的單高速運(yùn)算放大器評(píng)估板

ADG465:SOT-23封裝中的單通道保護(hù)器和MSOP封裝數(shù)據(jù)表

電源PCB布局、布線、調(diào)試要點(diǎn)及注意事項(xiàng)






 SOT-23封裝的注意事項(xiàng)及PCB布局技巧
SOT-23封裝的注意事項(xiàng)及PCB布局技巧











評(píng)論