介紹
對(duì)于集成電路(IC)芯片,焊盤金屬化是在晶片被切割和芯片被封裝之前的制造過程中的最后一步。自集成電路工業(yè)開始以來,鋁(Al)一直是使用最廣泛的互連金屬。然而,在過去十年中,它已被新一代IC的銅(Cu)互連所取代。與鋁不同,銅易受環(huán)境退化的影響,并且由于可靠性問題而不能用于金(Au)引線鍵合。因此,對(duì)于Cu互連技術(shù),IC制造商要么用Al覆蓋Cu,要么用Al 成最后的互連層。
本文介紹了我們?nèi)A林科納半導(dǎo)體使用化學(xué)鍍鎳-磷/鈀(NiP-Pd)來覆蓋銅焊盤,而不是用鋁來覆蓋它。使用無電工藝覆蓋銅鍵合焊盤比其他替代方案便宜得多,因?yàn)闊o電薄膜可以選擇性地沉積在鍵合焊盤上。這消除了許多步驟,包括光圖案化、蝕刻和清洗。在銅墊上化學(xué)鍍鎳的工作非常有限。然而,近年來,無電NiP/無電Pd (ENEP)、無電NiP/無電鍍金(ENIG)或無電NiP/無電Pd/浸金被廣泛研究和使用,用于覆蓋引線鍵合應(yīng)用的Al焊盤以及倒裝芯片應(yīng)用的凸點(diǎn)下冶金。
銅覆蓋的無電鍍工藝提出了許多獨(dú)特的挑戰(zhàn)。無電鍍工藝中的所有子步驟都必須優(yōu)化,因?yàn)槊總€(gè)步驟都可能導(dǎo)致嚴(yán)重的缺陷問題,如腐蝕、表面污染、橋接、臺(tái)階沉積、漏鍍、結(jié)節(jié)和毯式電鍍(圖1)。腐蝕是焊盤可靠性最關(guān)鍵的問題之一,也是本文的重點(diǎn)。

結(jié)果和討論
鎳腐蝕
對(duì)被腐蝕的鍵合焊盤的檢查顯示,由于焊盤表面上鎳腐蝕副產(chǎn)物的積累,焊盤變色(圖3)。根據(jù)腐蝕的嚴(yán)重程度,墊表面上的腐蝕副產(chǎn)物的量不同,在嚴(yán)重的情況下,副產(chǎn)物膜厚且破裂(見圖3c)。與表面污染的嚴(yán)重程度相關(guān)的引線鍵合失敗,顯示了晶片內(nèi)的條紋特征(圖4)。
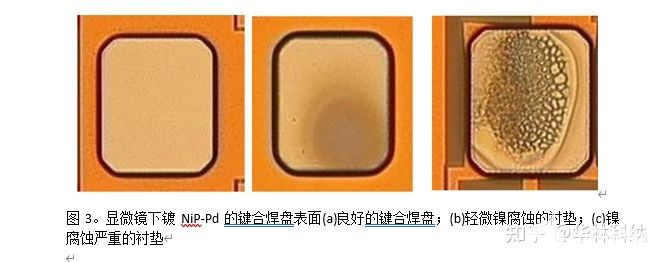
結(jié)論
用于接合焊盤金屬化的無電鍍工藝的實(shí)施需要用于無缺陷電鍍的子工藝的適當(dāng)優(yōu)化。除了更好地研究活化、鎳和鈀浴的效果之外,理解和優(yōu)化干燥過程對(duì)于實(shí)現(xiàn)無缺陷電鍍也是至關(guān)重要的。已經(jīng)表明NiP和Cu膜由于干燥不良而被腐蝕。在干燥過程中實(shí)施改進(jìn),并消除腐蝕剝離化學(xué)物質(zhì)在晶片上的凝結(jié),消除了腐蝕。
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28838瀏覽量
236424 -
化學(xué)
+關(guān)注
關(guān)注
1文章
83瀏覽量
19780 -
腐蝕
+關(guān)注
關(guān)注
0文章
43瀏覽量
9729
發(fā)布評(píng)論請(qǐng)先 登錄
芯片制造中的化學(xué)鍍技術(shù)研究進(jìn)展
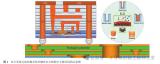
芯片制造“鍍”金術(shù):化學(xué)鍍技術(shù)的前沿突破與未來藍(lán)圖

基于推拉力測(cè)試機(jī)的化學(xué)鍍鎳鈀金電路板金絲鍵合可靠性驗(yàn)證

質(zhì)量流量控制器在薄膜沉積工藝中的應(yīng)用
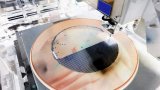
探秘化學(xué)鍍鎳金:提升電子元件可靠性的秘訣
激光焊接技術(shù)在焊接鍍鎳板的工藝應(yīng)用
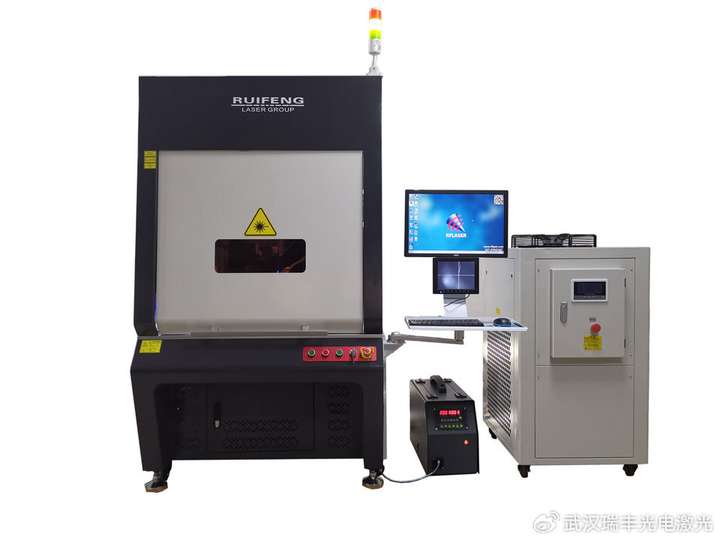
電子電路中的覆銅是什么
PCB化學(xué)鎳鈀金、沉金和鍍金的區(qū)別

鍍鎳金屬表面處理技術(shù) 鍍鎳行業(yè)的未來發(fā)展趨勢(shì)
鍍鎳的應(yīng)用領(lǐng)域 鍍鎳材料的耐腐蝕性能
鍍鎳處理工藝步驟 鍍鎳與鍍鉻的區(qū)別
多晶硅生產(chǎn)過程中硅芯的作用
預(yù)鍍框架銅線鍵合的腐蝕失效分析與可靠性






 化學(xué)鍍NiP-Pd沉積過程中銅和鎳的腐蝕
化學(xué)鍍NiP-Pd沉積過程中銅和鎳的腐蝕












評(píng)論