當前,隨著微電子產業的飛速發展,對陶瓷材料有了更高的需求。高溫共燒陶瓷(HTCC),采用材料為鎢、鉬、鉬、錳等高熔點金屬發熱電阻漿料按照發熱電路設計的要求印刷于92~96%的氧化鋁流延陶瓷生坯上,4~8%的燒結助劑然后多層疊合,在1500~1600℃下高溫下共燒成一體。
HTCC技術可實現密封的直通過孔密集的金屬互連。因此HTCC技術常用于軍事、航空航天、醫療器械、和高溫領域,特別是在汽車、高功率、無線通信和RF封裝方面。
PART1HTCC的分類
HTCC材料是在高于1500℃的環境下燒結而成。由于HTCC材料的熱穩定性良好,因此它非常適合在超高溫環境下的應用,在大功率微組裝電路中具有廣泛的應用前景。
高溫共燒陶瓷中較為重要的是以氧化鋁、莫來石(主體為Al2O3-SiO2)和氮化鋁為主要成分的陶瓷。常見的HTCC生瓷帶有氧化鋁陶瓷、氮化鋁陶瓷以及氧化鋯陶瓷等,采用流延法制備的生瓷帶厚度一般為50μm到700μm不等。
① 氧化鋁
在燒結過程中,陶瓷顆粒相變為致密材料,樣品大約收縮15%到20%不等。其中,在超高溫領域中,99.99%氧化鋁高溫共燒陶瓷的應用最為廣泛,HTCC氧化鋁生瓷帶的一些基本材料特性參數如下表所示。
| 參數 | 大小 |
| 介電常數 | 9.5-9.9 |
| 密度(g/cm3) | 3.8-3.95 |
| 楊氏模量(GPa) | 340-380 |
| 泊松比 | 0.2-0.23 |
| 抗彎強度(MPa) | 450-650 |
| 熱導率(Wm-1K-1) | 25-35 |
| 熱膨脹系數(ppm℃-1) | 6-8 |
| 莫氏硬度 | 9.0 |
| 介電損耗(25℃,1MHz) | 0.0001 |
| 體積電阻率(Ω.cm) | 1×1014 |
| 介電擊穿電壓(KV/mm) | >15 |
| 燒結溫度 | 1500-1700 |
生瓷坯在進行高溫燒結的過程中往往會有一定的收縮比例,其收縮比例大約在15%-20%之間,為了使本論文設計的傳感器達到設計要求以及性能要求,在燒結前,必須給生瓷坯按照收縮比來計算尺寸,防止其最終產品達不到要求。
氧化鋁陶瓷技術是一種比較成熟的微電子封裝技術,它由92~96%氧化鋁,外加4~8%的燒結助劑在1500-1700℃下燒結而成,其導線材料為鎢、鉬、鉬一錳等難熔金屬。該基板技術成熟,介質材料成本低,熱導率和抗彎強度較高。
但氧化鋁多層陶瓷基板的介電常數高,影響信號傳輸速度的提高;導體電阻率高,信號傳輸損耗較大;熱膨脹系數與硅相差較大,從而限制了它在巨型計算機上的應用。
② 莫來石
莫來石的介電常數為7.3-7.5,而氧化鋁(96%)的介電常數為9.4,高于莫來石,所以莫來石的信號傳輸延遲時間可比氧化鋁小17%左右,并且,莫來石的熱膨脹系數與硅很接近,所以這種基板材料得到了快速發展。
例如日立、Shinko等公司均開發了莫來石多層陶瓷基板,并且其產品具有良好的性能指標。不過此基板的布線導體只能采用鎢、鎳、鉬等,電阻率較大而且熱導率低于氧化鋁基板。
③ 氮化鋁
對于氮化鋁基板來說,由于氮化鋁熱導率高,熱膨脹系數與Si、SiC和GaAs等半導體材料相匹配,其介電常數和介質損耗均優于氧化鋁,并且AlN是較硬的陶瓷,在嚴酷的環境條件下仍能很好地工作。
| 材料 | Al?O? | AlN |
| 熔點/℃ | 1860 | 2470 |
|
熱導率 (W·m-1·K-1) |
29 | 240 |
| 相對介電常數 | 9.7 | 8.9 |
|
擊穿電場強度 (kV·mm-1) |
10 | 15 |
| 綜合評價 | 性價比高,應用廣 | 性能優良,價格高 |
比如在高溫時AlN陶瓷依然具有極好的穩定性,因此,氮化鋁用作多層基板材料,在國內外都得到了廣泛研究并已經取得令人矚目的進展。但氮化鋁基板也有一定的缺點:
● 布線導體電阻率高,信號傳輸損耗較大;
● 燒結溫度高,能耗較大;
● 介電常數與低溫共燒陶瓷介質材料相比還較高;
● 氮化鋁基板與鎢、鉬等導體共燒后,其熱導率有所下降;
● 絲網印刷的電阻器及其他無源元件不能并入高溫共燒工藝,因為這些無源元件的漿料中的金屬氧化物,會在該工藝的還原氣氛下反應而使性能變壞;
● 外層導體必須鍍鎳鍍金保護其不被氧化,同時增加表面的電導率并提供能夠進行線焊和錫焊元器件貼裝的金屬化層。
雖然有這些缺點,但從總體上來說,氮化鋁基板比其他高溫共燒陶瓷基板有更多的優勢,在高溫共燒陶瓷領域有很好的發展前途。主要應用在傳感器封裝、表面貼裝封裝、MEMS封裝、光通信封裝、LED封裝等。
PART2HTCC的應用
HTCC陶瓷發熱片是一種新型高效環保節能陶瓷發熱元件,相比PTC陶瓷發熱體,具有相同加熱效果情況下節約20~30%電能。
整體而言,HTCC基板具有結構強度高、熱導率高、化學穩定性好和布線密度高等優點,因此在當前大功率微組裝電路中具有廣泛的應用前景。被廣泛應用于日常生活、工農業技術、軍事、科學、通訊、醫療、環保、宇航等眾多領域。
PART3HTCC的發展
HTCC作為一種新型的高導熱基板和封裝材料,具有高熱導率、低熱膨脹系數、低介電常數和低介質損耗、高機械強度等特點。因此它可以實現電性能、熱性能和機械性能的優化設計,能夠滿足器件、模塊和組件的高功、高密度、小型化和高可靠要求。
但是,高溫共燒陶瓷(HTCC)電路互連基板中,W、Mo的電阻率較高,電路損耗較大。隨著超大規模集成電路的應用頻率和電路速度提升,電子設備的小型化等趨勢對高密度封裝提出更高要求。
而且,HTCC的陶瓷粉末并無加入玻璃材質,HTCC必須在高溫1300~1600℃環境下干燥硬化成生胚,接著鉆上導通孔,以網版印刷技術填孔與印制線路,因其共燒溫度較高,使得金屬導體材料的選擇受限,而且會大大增加其成本。因此,低溫共燒陶瓷(LTCC)應運而生。
審核編輯:郭婷
-
電路設計
+關注
關注
6704文章
2535瀏覽量
213985 -
無線通信
+關注
關注
58文章
4732瀏覽量
145010 -
RF
+關注
關注
65文章
3175瀏覽量
168703
原文標題:HTCC:在大功率微組裝電路中具有廣泛的應用前景
文章出處:【微信號:中科聚智,微信公眾號:中科聚智】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
過孔處理:SMT訂單中的隱形裁判
過孔處理:SMT訂單中的隱形裁判

TE的高速可插拔I O互連產品有什么用?-赫聯電子
智能密集架控制系統的功能與特點
一文了解金屬互連中阻擋層
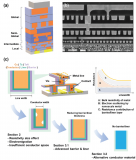
金屬瓶密封測試儀的工作原理

詳解金屬互連中介質層
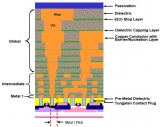





 HTCC技術可實現密封的直通過孔密集的金屬互連
HTCC技術可實現密封的直通過孔密集的金屬互連




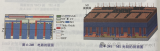

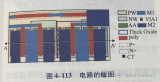










評論