前言
SMA轉(zhuǎn)接頭是射頻微波、天線和高速高頻電路中經(jīng)常用到的一種連接器,將SMA 3D結(jié)構(gòu)組裝到PCB上進(jìn)行聯(lián)合仿真,優(yōu)化SMA PCB封裝焊盤,回流地孔的排布,找到最佳阻抗匹配值,評(píng)估3D結(jié)構(gòu)器件對(duì)指標(biāo)的影響變的越來(lái)越重要。
芯和半導(dǎo)體Hermes平臺(tái) 目前包含layered和3D兩個(gè)流程,其中3D流程可以方便地完成PCB與SMA 3D結(jié)構(gòu)的裝配,同時(shí)結(jié)合Hermes 高精度的FEM算法可快速得到精準(zhǔn)的電磁場(chǎng)仿真數(shù)據(jù),指導(dǎo)設(shè)計(jì)優(yōu)化。
PCB+SMA聯(lián)合仿真流程
1.導(dǎo)入PCB設(shè)計(jì)文件
打開Hermes軟件在home菜單下點(diǎn)擊,選擇需要導(dǎo)入的工程文件,和對(duì)應(yīng)網(wǎng)絡(luò)完成版圖導(dǎo)入,用戶除了可以通過(guò)導(dǎo)入常見設(shè)計(jì)文件(.brd/.sip/.mcm/ODB++/.gds)的方式創(chuàng)建版圖模型外,還可以在此區(qū)域中手動(dòng)繪制PCB版圖。

圖 1
創(chuàng)建layout
2.疊層文件編輯
點(diǎn)擊layout模型工程樹下的Stackup,進(jìn)入到疊層編輯的頁(yè)面,如圖2所示。在此頁(yè)面Layers欄中設(shè)置每層的名字和厚度以及所賦予的材料,Materials欄中編輯所用到的材料參數(shù)。在本案例中,PCB板為6層,導(dǎo)入數(shù)據(jù)為PCB默認(rèn)數(shù)據(jù)如與加工信息不符可以進(jìn)行修改,同時(shí)也可以設(shè)置背鉆信息。

圖2
疊層文件設(shè)置
3.過(guò)孔信息編輯
點(diǎn)擊layout模型工程樹下的Padstack,修改過(guò)孔焊盤,反焊盤的尺寸,孔壁鍍銅厚度等信息。

圖 3
焊盤信息設(shè)置
4.版圖切割
在Edit選擇ClipDesign可以對(duì)版圖進(jìn)行切割減少仿真規(guī)模,本案例選擇仿真網(wǎng)絡(luò)名稱為“RF”的信號(hào)為切割保留部分。

圖4
版圖切割
5.導(dǎo)出PCB 3D模型
選擇切割出來(lái)的版圖工程文件,右鍵選擇Switch to 3D一鍵導(dǎo)出3D模型。

圖5
PCB 3D模型
6.導(dǎo)入SMA連接器模型
選擇上面創(chuàng)建的3D模型樹,右鍵選擇Insert Model可通過(guò) SAT,STP格式導(dǎo)入3D模型數(shù)據(jù),導(dǎo)入后如下顯示。
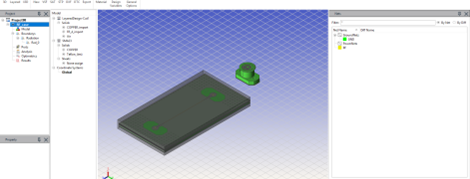
圖6
仿真結(jié)果
7.模型組裝與仿真配置
導(dǎo)入后通過(guò)Draw 菜單欄下的移動(dòng),旋轉(zhuǎn),鏡像等功能,完成PCB板和SMA結(jié)構(gòu)的組裝,點(diǎn)擊Auto Identify 查看仿真網(wǎng)絡(luò)是否和SMA物理聯(lián)通,修改原來(lái)空氣盒子的尺寸,設(shè)置為輻射邊界,在SMA上繪制環(huán)形sheet圖層選擇對(duì)應(yīng)的返回路徑設(shè)置為port,完成仿真建模。
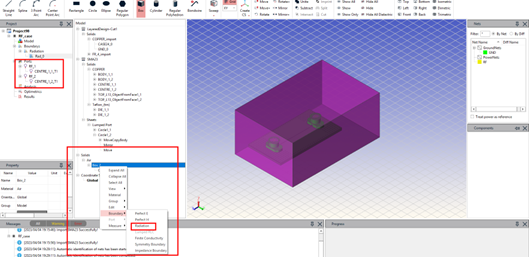
圖7
3D建模
8.導(dǎo)入SMA連接器模型
在Analysis選項(xiàng)右鍵添加一個(gè)FEM3D_Analysis流程,通過(guò)solver option配置求解頻率,收斂條件,MPI以及求解Core數(shù)量,完成后右鍵點(diǎn)擊Analysis開始仿真。

圖8
仿真配置
9.仿真結(jié)果顯示
仿真完成后可以點(diǎn)擊Results添加想要查看的S參數(shù)曲線,或TDR數(shù)據(jù)結(jié)果。
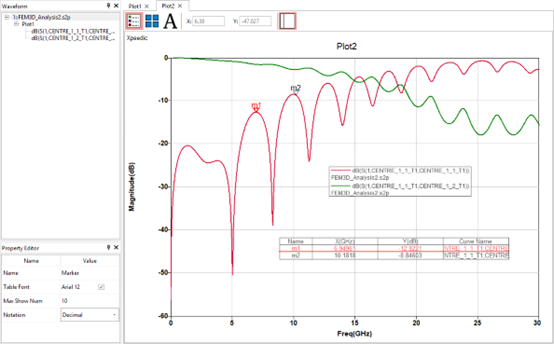
圖9
仿真結(jié)果
總結(jié)
本文介紹了采用芯和半導(dǎo)體Hermes軟件中的3D流程實(shí)現(xiàn)PCB板與SMA連接器的模型創(chuàng)建和組裝。Hermes內(nèi)置多種常規(guī)圖形創(chuàng)建模塊,設(shè)計(jì)者通過(guò)移動(dòng),鏡像,旋轉(zhuǎn)等功能快速完成模型的創(chuàng)建和組合,滿足用戶對(duì)PCB與連接器聯(lián)合仿真的需求。
審核編輯:劉清
-
連接器
+關(guān)注
關(guān)注
99文章
15341瀏覽量
140095 -
SMA
+關(guān)注
關(guān)注
4文章
260瀏覽量
25952 -
Fem
+關(guān)注
關(guān)注
4文章
47瀏覽量
20214 -
電磁場(chǎng)
+關(guān)注
關(guān)注
0文章
799瀏覽量
48057 -
PCB封裝
+關(guān)注
關(guān)注
21文章
78瀏覽量
30786
原文標(biāo)題:【應(yīng)用案例】如何在Hermes平臺(tái)進(jìn)行PCB+SMA聯(lián)合仿真
文章出處:【微信號(hào):Xpeedic,微信公眾號(hào):Xpeedic】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
Veloce平臺(tái)在大規(guī)模SOC仿真驗(yàn)證中的應(yīng)用
尋找ansoft與matlab的聯(lián)合仿真
怎樣使用labview2012和multisim進(jìn)行電路實(shí)驗(yàn)聯(lián)合仿真!
Labview做電池測(cè)試仿真平臺(tái) 能與哪個(gè)電動(dòng)車仿真軟件做實(shí)時(shí)聯(lián)合仿真?ADVISOR? CRUISE?...
quartus + modelsim 聯(lián)合仿真問(wèn)題
【MiniStar FPGA開發(fā)板】配套視頻教程——Gowin與Modelsim聯(lián)合仿真
simulink和pspice聯(lián)合仿真問(wèn)題
PCB layout如何進(jìn)行仿真?

芯和半導(dǎo)體設(shè)計(jì)小訣竅 如何使用Hermes3D仿真ODB++格式文件
在PSIM中進(jìn)行VHDL的聯(lián)合仿真

如何使用Hermes平臺(tái)的X3D實(shí)現(xiàn)對(duì)封裝走線的RLGC提取呢?






 如何在Hermes平臺(tái)進(jìn)行PCB+SMA聯(lián)合仿真?
如何在Hermes平臺(tái)進(jìn)行PCB+SMA聯(lián)合仿真?











評(píng)論