常見晶振封裝工藝及其特點(diǎn) 金屬殼封裝 金屬殼封裝堪稱晶振封裝界的“堅(jiān)固衛(wèi)士”。它采用具有良好導(dǎo)電性和導(dǎo)熱性的金屬材料,如不銹鋼、銅合金等,將晶振芯片嚴(yán)嚴(yán)實(shí)實(shí)地包裹起來。這種封裝
![的頭像]() 發(fā)表于
發(fā)表于 06-13 14:59
?165次閱讀

隨著半導(dǎo)體工藝復(fù)雜度提升,可靠性要求與測試成本及時間之間的矛盾日益凸顯。晶圓級可靠性(Wafer Level Reliability, WLR)技術(shù)通過直接在未封裝晶圓上施加加速應(yīng)力,實(shí)現(xiàn)快速
發(fā)表于 05-07 20:34
晶圓制備是材料科學(xué)、熱力學(xué)與精密控制的綜合體現(xiàn),每一環(huán)節(jié)均凝聚著工程技術(shù)的極致追求。而晶圓清洗本質(zhì)是半導(dǎo)體工業(yè)與污染物持續(xù)博弈的縮影,每一次工藝革新都在突破物理極限。
![的頭像]() 發(fā)表于
發(fā)表于 05-07 15:12
?1137次閱讀

晶圓高溫清洗蝕刻工藝是半導(dǎo)體制造過程中的關(guān)鍵環(huán)節(jié),對于確保芯片的性能和質(zhì)量至關(guān)重要。為此,在目前市場需求的增長情況下,我們來給大家介紹一下詳情。 一、工藝原理 清洗原理 高溫清洗利用物理和化學(xué)的作用
![的頭像]() 發(fā)表于
發(fā)表于 04-15 10:01
?345次閱讀
晶圓濕法清洗工作臺是一個復(fù)雜的工藝,那我們下面就來看看具體的工藝流程。不得不說的是,既然是復(fù)雜的工藝每個流程都很重要,為此我們需要仔細(xì)謹(jǐn)慎,這樣才能獲得最高品質(zhì)的產(chǎn)品或者達(dá)到最佳效果。
![的頭像]() 發(fā)表于
發(fā)表于 04-01 11:16
?391次閱讀
隨著半導(dǎo)體技術(shù)的飛速發(fā)展,晶圓級封裝(WLP)作為先進(jìn)封裝技術(shù)的重要組成部分,正逐漸成為集成電路封裝的主流趨勢。在晶圓級封裝過程中,Bump工藝扮演著至關(guān)重要的角色。Bump,即凸塊,是晶
![的頭像]() 發(fā)表于
發(fā)表于 03-04 10:52
?1943次閱讀

既然說到了半導(dǎo)體晶圓電鍍工藝,那么大家就知道這又是一個復(fù)雜的過程。那么涉及了什么工藝,都有哪些內(nèi)容呢?下面就來給大家接下一下! 半導(dǎo)體晶圓電鍍工藝
![的頭像]() 發(fā)表于
發(fā)表于 03-03 14:46
?779次閱讀
在半導(dǎo)體制造的復(fù)雜流程中,晶圓歷經(jīng)前道工序完成芯片制備后,劃片工藝成為將芯片從晶圓上分離的關(guān)鍵環(huán)節(jié),為后續(xù)封裝奠定基礎(chǔ)。由于不同厚度的晶圓具有各異的物理特性,因此需匹配不同的切割
![的頭像]() 發(fā)表于
發(fā)表于 02-07 09:41
?1485次閱讀

8寸晶圓的清洗工藝是半導(dǎo)體制造過程中至關(guān)重要的環(huán)節(jié),它直接關(guān)系到芯片的良率和性能。那么直接揭曉關(guān)于8寸晶圓的清洗工藝介紹吧! 顆粒去除清洗 目的與方法:此步驟旨在去除
![的頭像]() 發(fā)表于
發(fā)表于 01-07 16:12
?400次閱讀
半導(dǎo)體晶圓制造是現(xiàn)代電子產(chǎn)業(yè)中不可或缺的一環(huán),它是整個電子行業(yè)的基礎(chǔ)。這項(xiàng)工藝的流程非常復(fù)雜,包含了很多步驟和技術(shù),下面將詳細(xì)介紹其主要的制造工藝流程。第一步:晶圓生長
![的頭像]() 發(fā)表于
發(fā)表于 12-24 14:30
?3173次閱讀

一、概述
晶圓背面涂敷工藝是在晶圓背面涂覆一層特定的材料,以滿足封裝過程中的各種需求。這種工藝不僅可以提高芯片的機(jī)械強(qiáng)度,還可以優(yōu)化散熱性能,確保芯片的穩(wěn)定性和可靠性。
二、材料選擇
![的頭像]() 發(fā)表于
發(fā)表于 12-19 09:54
?620次閱讀

在半導(dǎo)體制造領(lǐng)域,晶圓級凸點(diǎn)制作是一項(xiàng)關(guān)鍵技術(shù),對于提高集成電路的集成度和性能具有重要意義。其中,甲酸回流工藝作為一種重要的凸點(diǎn)制作方法,因其具有工藝簡單、成本低廉、易于控制等優(yōu)點(diǎn)而被廣泛應(yīng)用。本文
![的頭像]() 發(fā)表于
發(fā)表于 11-07 10:41
?1663次閱讀

GaAs晶圓作為常用的一類晶圓,在半導(dǎo)體功率芯片和光電子芯片都有廣泛應(yīng)用。而如何處理好該類晶圓的清洗和進(jìn)一步的鈍化工作是生產(chǎn)工藝過程中需要關(guān)注的點(diǎn)。
![的頭像]() 發(fā)表于
發(fā)表于 10-30 10:46
?1220次閱讀

在本系列第七篇文章中,介紹了晶圓級封裝的基本流程。本篇文章將側(cè)重介紹不同晶圓級封裝方法所涉及的各項(xiàng)工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝
![的頭像]() 發(fā)表于
發(fā)表于 08-21 15:10
?2902次閱讀

同個型號生產(chǎn)工藝上晶圓差異較大的原因是?
發(fā)表于 08-07 07:02

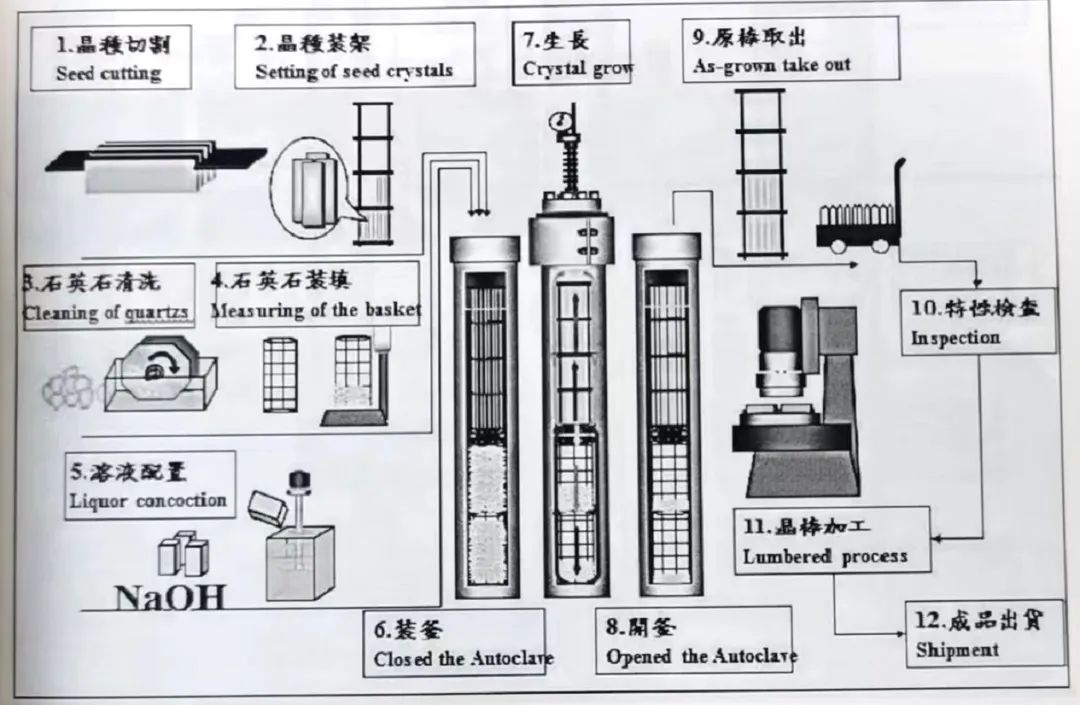


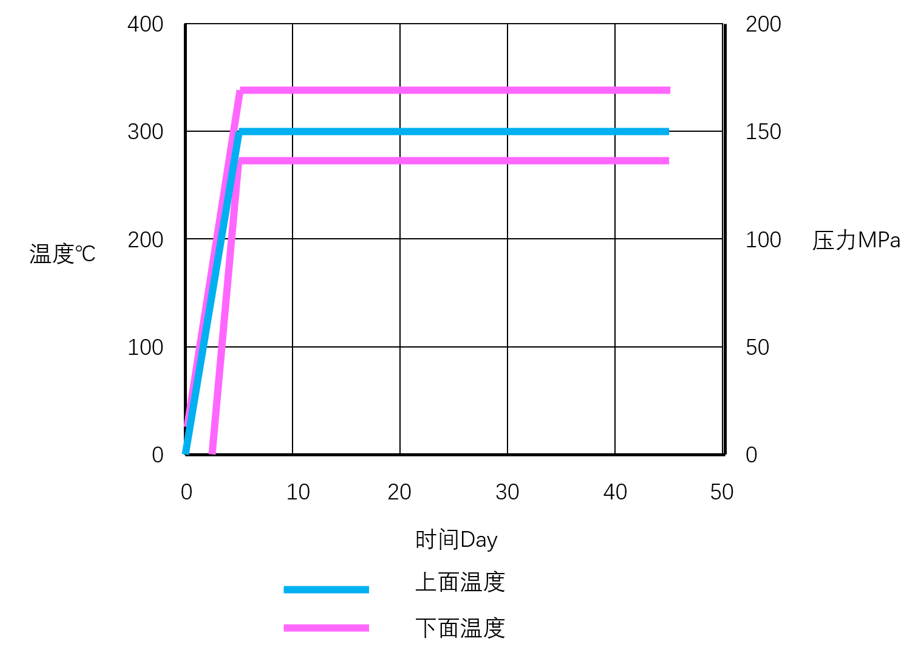














 人工長晶工藝
人工長晶工藝












評論