海外銷售終端(POS機)抗跌落bga芯片補強加固底部填充膠應用方案由漢思新材料提供
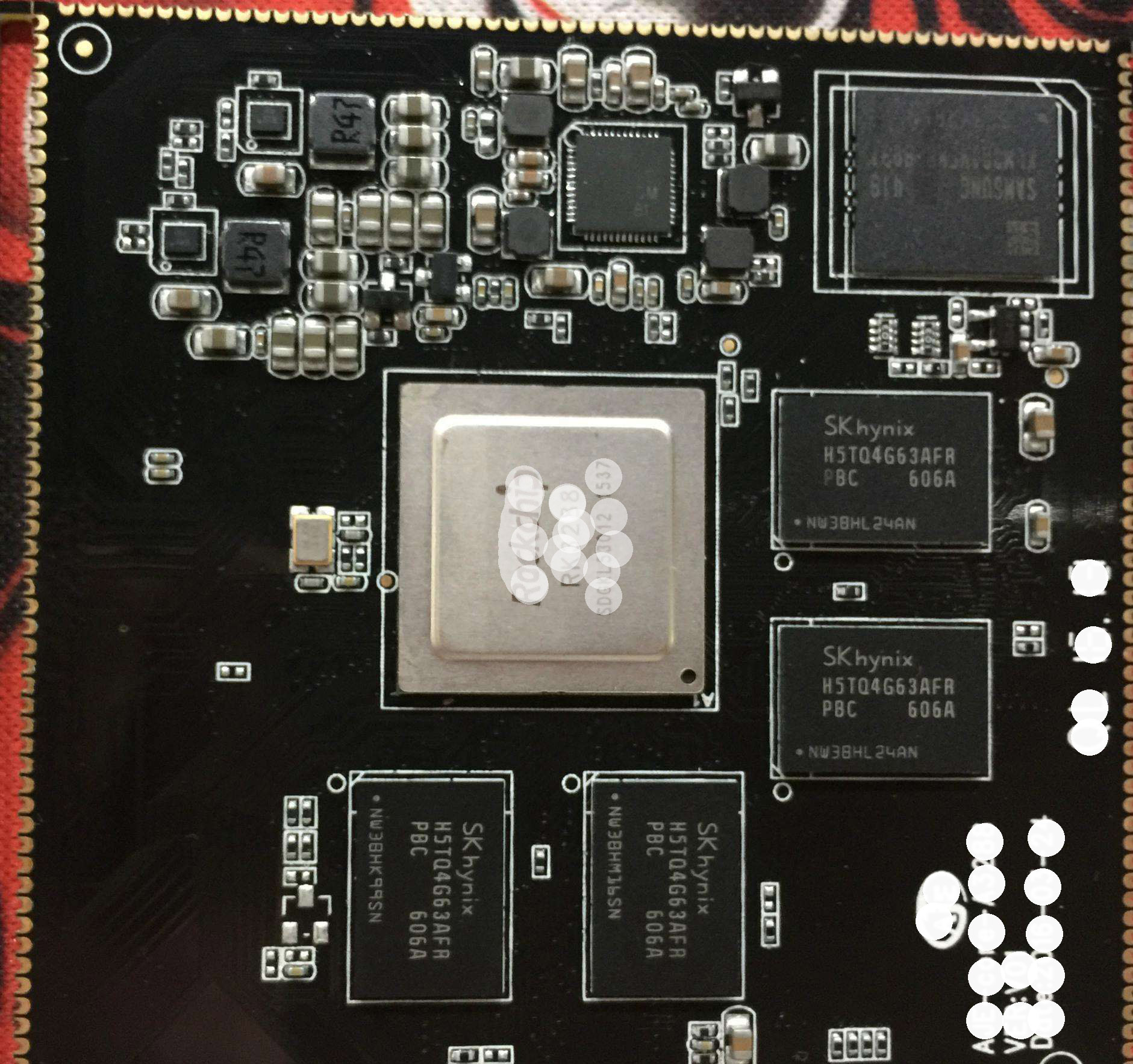
1.客戶產品類型 : 海外銷售終端(POS機);
2.用膠部位及要求 : 用于主芯片底部填充,以提高產品抗跌落特性
3.產品正常使用的溫度及環境 :產品正常使用維度為-40~85℃,濕度:95%無冷凝
4.用膠芯片的大小尺寸,錫球的大小 錫球的間距,數量。芯片有兩類,IC1: 11*11,0.65pitch,0.3Pad;IC2: 14*14,0.65pitch,0.3Pad;
5.后期的測試要求和重點測試事項 :裝置應能承受4英尺的跌落到6個表面和4個角落(6個循環)的混凝土上,且無損壞,并保持功能
6.有關膠水的固化溫度可以滿足130--150℃ 10分鐘左右烤箱加熱固化 : 外部代工,可以達到要求
7.有相關的點膠設備和固化設備 : 外部代工,可以達到要求.
漢思新材料 工程技術人員經過研究探討,最終推薦HS700系列底部填充膠給客戶測試.
-
芯片
+關注
關注
459文章
52352瀏覽量
438510 -
BGA
+關注
關注
5文章
570瀏覽量
48324
發布評論請先 登錄
BGA底部填充膠固化異常延遲或不固化原因分析及解決方案

漢思新材料:車規級芯片底部填充膠守護你的智能汽車

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程






 海外銷售終端(POS機)抗跌落bga芯片補強加固底部填充膠方案
海外銷售終端(POS機)抗跌落bga芯片補強加固底部填充膠方案





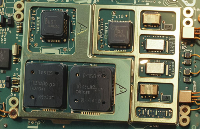
















評論