最近有許多正在全球范圍內研究和開發的技術,例如晶體管GAA(Gate All around)、背面供電以及3D IC。
“VLSI研討會2023”(VLSI2023)于2023年6月11日至16日在京都麗嘉皇家酒店舉行。今年VLSI2023提交的論文數量為273篇,比去年夏威夷舉辦的232篇多了41篇。這273篇論文是近10年來提交論文數量最多的。錄用論文數量達到89篇,創歷史新高。然而,錄用率只有33%。 在最近的半導體趨勢中,有許多正在全球范圍內研究和開發的技術,例如晶體管GAA(Gate All around)、背面供電以及3D IC。
那么,在論文數量和參會人數都非常多的VLSI2023上,進行了哪些演講呢?概要如下: 1)背面供電網絡(BSPDN)將在先進邏輯半導體領域取得突破,其中GAA結構引起了人們的關注。 2)在DRAM方面,從14nm節點左右開始使用EUV,但“3D DRAM”有可能在2020年代后半段出現。 3)在層數不斷增加的3D NAND中,隨著新的干法刻蝕技術的出現,層數將不斷增加。
三星電子采用GAA結構的3nm晶體管
三星電子以“世界首個采用新型多橋通道 FET (MBCFETTM) 工藝的 GAA 3nm 代工平臺技術 (SF3)”為題應用了 GAA 晶體管結構,宣布推出新的3nm代工平臺(SF3)。

三星稱之為“Multi-Bridge-Channel-FET (MBCFET)”的 GAA 結構晶體管,與 4nm FinFET 相比,速度提高了 22%,功耗降低了 34%,面積減少了 21%。 2022年6月30日,三星宣布已開始應用GAA的3納米邏輯半導體的初步生產。相比之下,臺積電于2022年12月29日宣布開始量產3nm,其晶體管正在延長FinFET。 僅看這個情況,由于三星在公告標題中加上了“全球首款GAA 3nm”,可以說,無論是開始量產3nm的時間,還是GAA量產的應用,三星都領先于臺積電。 然而,2023年上半年,仍有報道稱三星3納米良率低迷。因此,即使采用GAA的3nm量產比臺積電更早,也不能說對代工業務有利。 有專家表示,“臺積電從2nm開始采用GAA,三星不是要從2022年開始進行一場盛大的實驗,以在2nm競爭中取得優勢嗎?” 這樣,GAA結構的晶體管在先進邏輯半導體領域引起了人們的關注。
多層布線的困境
先進邏輯半導體具有15至16層或更多的多層布線。細信號線和粗電源線混合在多層布線中。這就出現了一個兩難的境地。
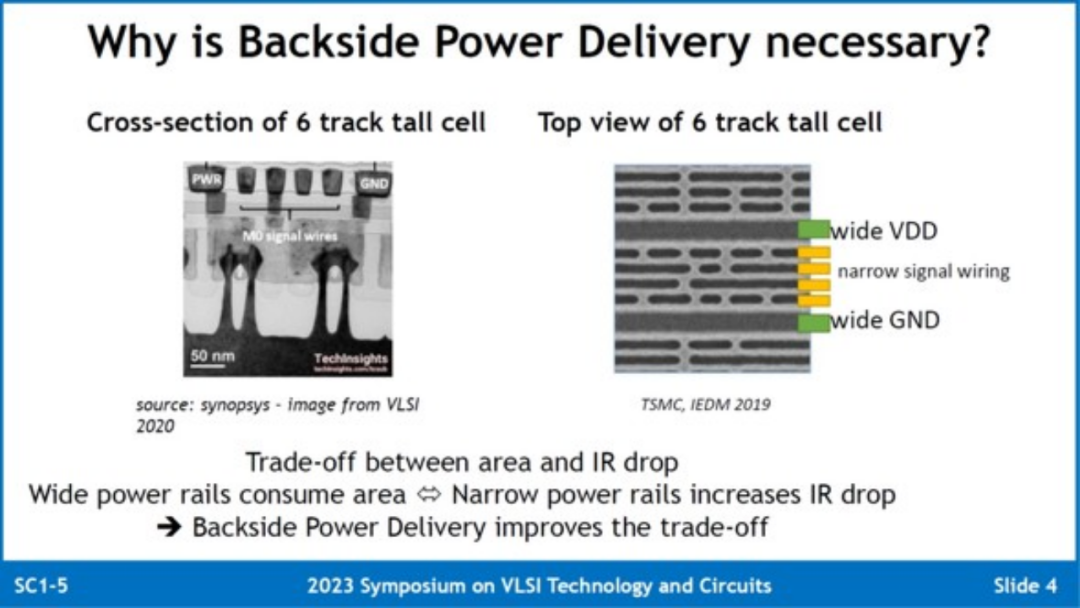
為了有效地利用芯片面積,電源線應該很細。然而,當電源線變細時,電源線的電阻會增加,因此由 I(電流)x R(電阻)計算出的 V(電壓)會下降(稱為 IR drop)。然后,晶體管的操作受到不利影響。 另一方面,如果電源線形成得足夠厚以防止IR降,則電源線占據的面積變大,并且信號線必須做得更小或封裝緊密。 換句話說,可以說IR drop和電源線的厚度是一種權衡關系。然而,邏輯半導體需要更加小型化。因此,解決這種權衡并使其更容易進行小型化的一個想法是埋地電源軌(BPR),它在晶體管下方形成電源線,或從背面供電( BSPDN)。
筆者想知道這些BPR和BSPDN是否會在GAA之后或與GAA同時應用于先進邏輯半導體,但看起來它們很可能在GAA之前使用。 原因之一是GAA的開發和量產非常困難,但根據制造方法的不同,BPR和BSPDN可能不會那么困難。另外,如果不采用BPR或BSPDN,還存在未來小型化困難的問題。 然而,由于 BPR 和 BSPDN 有多種可能的制造方法,領先的邏輯半導體制造商目前正在尋找最合適的一種。其中Intel公布了一個名為“PowerVia”的BSPDN,所以下面我來解釋一下。
英特爾的“PowerVia”
Intel發布了一個技術節點“Intel 4”,標題為“Intel PowerVia技術:用于高密度和高性能計算的后端供電”。
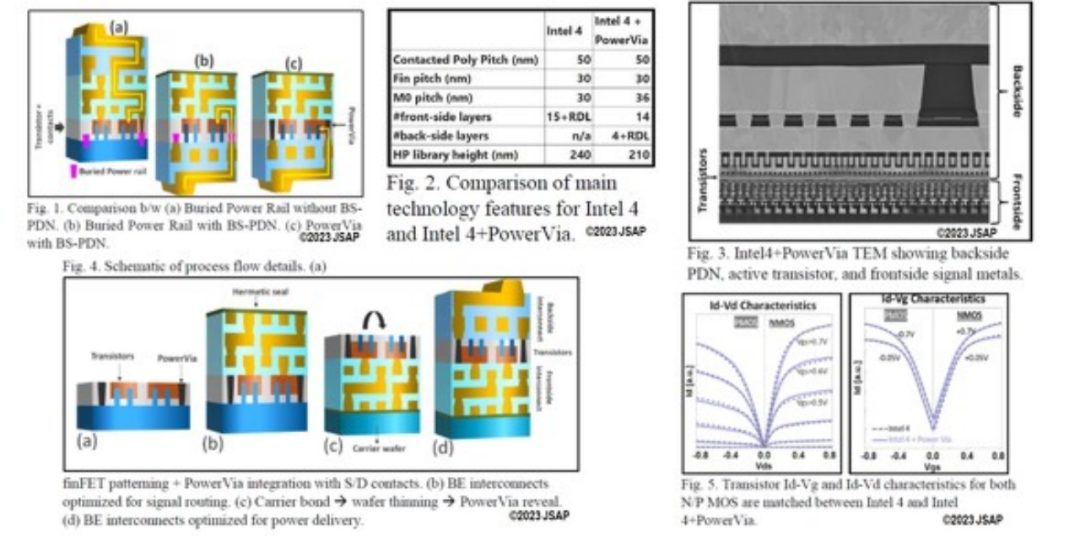
首先,圖1示出了三種供電方式。(a)是電源線嵌入晶體管下方的BPR,(b)是形成BPR后連接BPR和BSPDN的方法,(c)是直接從BSPDN供電的PowerVia。 PowerVia + BSPDN 方法的流程如圖所示。(a)首先,形成FinFET和PowerVia。(b)在FinFET和PowerVia上形成僅信號線的多層布線。(c)將該芯片翻轉并接合至載體芯片以形成FinFET和PowerVia。(d)通過從背面刮擦晶圓形成電源線以連接到 PowerVia 上圖是采用這種工藝制造的“Intel4+PowerVia”邏輯半導體的TEM圖像。底部有一個由晶體管和信號線組成的正面,以及上面有粗電源線的背面。
Power Via 的優點
圖2比較了“Intel 4”和“Intel4 + PowerVia”。兩個接觸多晶硅間距均為 50 納米,兩個鰭片間距均為 30 納米。然而,在M0 Pitch中,“Intel 4”是30nm,而“Intel4 + PowerVia”是36nm。換句話說,企業能夠在 PowerVia 的幫助下放松并形成 M0 Pitch。此外,“Intel 4”的HP庫高度為240 nm,而“Intel 4 + PowerVia”為210 nm,這意味著它可以縮小30 nm。 從圖5可以看出,“Intel 4”和“Intel4+PowerVia”在nMOS和pMOS的電氣特性上沒有區別。此外,論文指出,IR壓降改善了30%,晶體管的工作速度提高了6%。 這樣,Intel的PowerVia正如最初的預期,有利于小型化,減少IR壓降,并有助于提高晶體管性能。因此,Intel在VLSI2023上宣布將把PowerVia的應用從20A推進到Intel 4。 早期將BSPDN應用于量產的趨勢預計不僅會蔓延到Intel,還會蔓延到臺積電和三星。 那么接下來我們就來看看DRAM的變化。
三星14納米DRAM
最先進的EUV(極紫外)曝光設備(以下簡稱EUV)于2019年在“N7+”一代中由臺積電首次量產。從那時起,EUV 就理所當然地被用于先進邏輯半導體。 那么,EUV如何應用于DRAM呢?這個問題的答案是三星發布的“14nm DRAM開發和制造”。
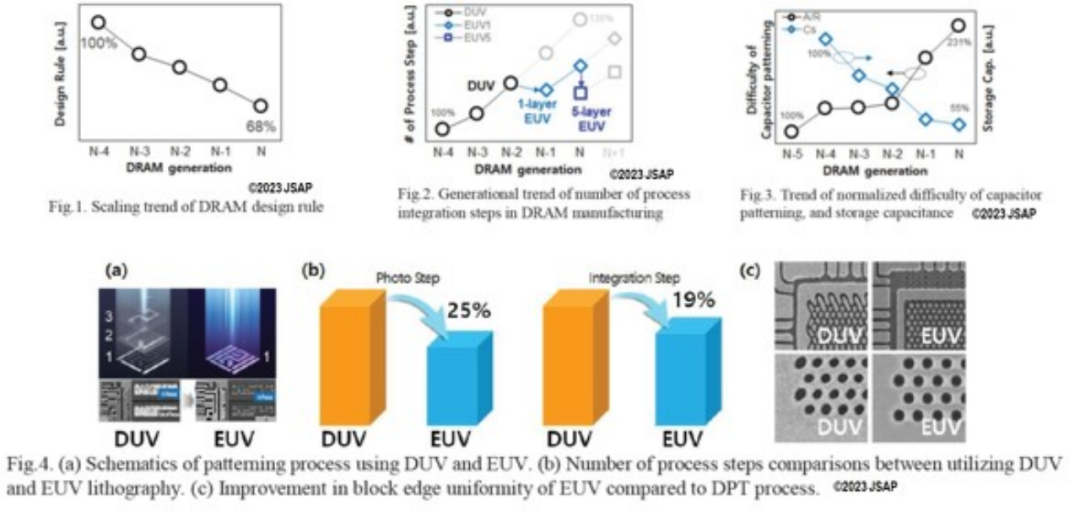
首先,三星如圖1所示,DRAM的設計規則從N-4代到N代縮小了68%。這里是N-4代20nm、N-3代19nm(1X)、N-2代18nm(1Y)、N-1代15.6nm(1Z)、N代13.8nm(1a)(縮寫為每一代都在括號中)。 接下來,三星在圖2中顯示,N-1(1Z)使用一層EUV,N代(1a)使用五層EUV。圖 4 總結了使用 EUV 的效果。(a) 首先,EUV 消除了復雜的 DUV + 多重圖案化 (MP) 的需要。(b) 其次,通過使用 EUV,光刻工藝可以減少 25%。(c)此外,整個工藝流程的步驟數可以減少19%。(d) 最重要的是,EUV 可以比 DUV+MP 更清晰地解析線、柱和孔。
這樣一來,在先進DRAM的制造中使用EUV的好處是很大的,所以如果成本問題能夠得到解決,EUV的量產應用將擴展到DRAM以及先進邏輯。 然而,DRAM的小型化有一個大問題。如圖3所示,用于DRAM存儲操作的電容器的容量減少了55%,而電容器的長寬比(長寬比)則增加了130%。我們可以繼續形成如此高深寬比的電容器嗎?
三星的3D DRAM
NAND達到了2D小型化的極限,因此被做成了3D。DRAM也可能像NAND一樣變成3D。 三星在“Ongoing Evolution of DRAM Scaling via Third Dimension- Vertically Stacked DRAM -”中提出了3D DRAM的可能性。三星將3D DRAM稱為“垂直堆疊DRAM”,但在本文中將其稱為3D DRAM。
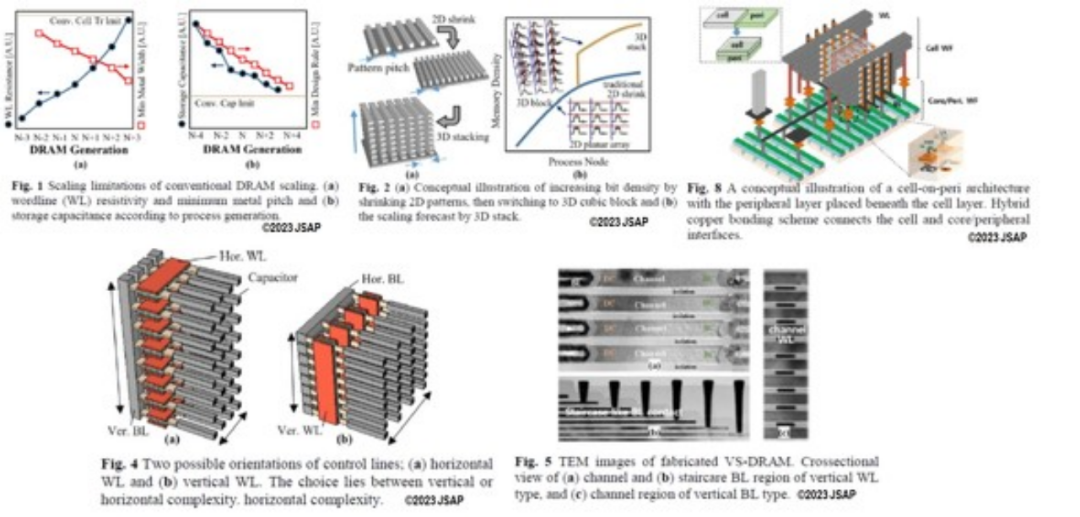
如果傳統的二維小型化在N+4代達到極限,為了增加存儲密度,如圖2所示,DRAM應該像“立方塊”一樣垂直排列,堆疊的想法如圖所示。 圖4解釋了3D DRAM有如下兩種類型。(a) 一個具有垂直位線 (BL),(b) 另一個具有垂直字線 (WL)。在這兩種情況下,電容器均水平形成為條狀。 圖5示出了實際形成3D DRAM時的截面TEM圖像。(a)示出了溝道附近的結構,(b)示出了垂直WL型中的階梯狀水平BL,(c)示出了垂直BL型溝道和WL的堆疊結構。 三星表示,立式BL型和立式WL型各有優缺點,目前似乎還不知道哪一種更好。
然而,無論選擇哪種方法,如果能夠實現“Cell on Peri(CoP)”結構,其中三維存儲單元和外圍電路分別形成并通過混合Cu結連接,單元面積可以最大化。 DRAM大約兩年換代,領先優勢更新。因此,根據簡單計算,N+4代二維小型化達到極限的時間是八年后。這意味著2030年左右,3D DRAM可能會出現在世界上。 另一方面,NAND出現了新的工藝技術,比DRAM更早實現3D化。它是什么樣的?
三星236層3D NAND
三星以“第 8 代 1Tb 3D-NAND 閃存的高度均勻和可靠單元特性的新穎策略”為題發布了 236 層 3D NAND。
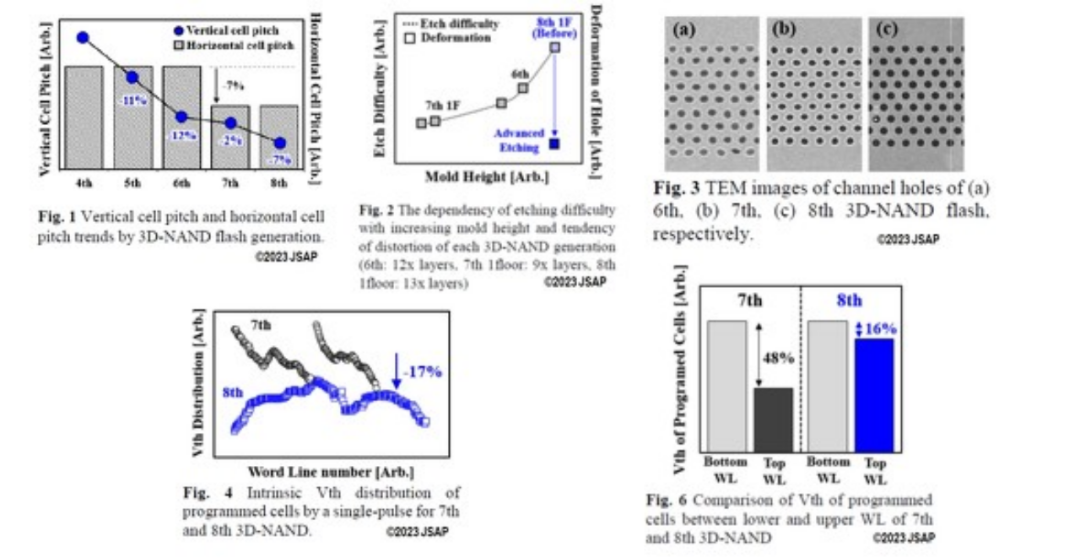
三星將3D NAND的層數增加至第4代(64層)、第5代(92層)、第6代(128層)、第7代(176層)、第8代(236層)。此時,如圖1所示,每一代的垂直單元間距都在減小。此外,從第6代過渡到第7代時,水平單元間距減小了7%。 圖2顯示,微單元深存儲孔的高深寬比(HAR)蝕刻難度隨著深寬比的增加呈指數增加。然而有了“高級蝕刻”,可以看出難度一下子就降低了。那么這個“高級蝕刻”到底是什么? 三星在公告中沒有透露任何內容,但其方式似乎是一種將晶圓冷卻至低溫(cryo)的蝕刻。我猜溫度是-40攝氏度(也許是-60到80攝氏度)。
換句話說,三星被認為通過使用低溫蝕刻技術實現了高速、高精度的HAR蝕刻。 這種低溫蝕刻技術明顯改善了存儲孔 HAR 蝕刻后的孔輪廓(圖 3)。結果,與第七代相比,第八代的字線閾值電壓(Vth)變化改善了17%(圖4)。此外,在第7代中,諸如編程速度等信息的WL單元特性劣化為48%,但在第8代中,其劣化改善為16%(圖6)。 簡而言之,三星通過將低溫蝕刻技術應用于存儲單元的HAR蝕刻,開發出了236層第8代,其單元特性比176層第7代更好。 內存孔的 HAR 蝕刻可能會進一步發展。
東京電子(TEL)發現新的絕緣膜蝕刻
通常,在VLSI研討會上,會接受設計新器件、制作原型并闡明器件特性的論文。然而,TEL 的演示文稿“Beyond 10 μm Depth Ultra-High Speed Etch Process with 84% Lower Carbon Footprint for Memory Channel Hole of 3D NAND Flash over 400 Layers”指出,“對于 3D NAND 存儲器孔論文被接受,內容僅為“進行了 HAR 蝕刻”。這是非常不尋常的。 然而,在筆者看來,HAR刻蝕是一項偉大的成就,將載入干法刻蝕的歷史。那么,TEL的HAR刻蝕有何卓越之處呢? 40多年來,CF基氣體一直用于絕緣膜蝕刻。在這種情況下,TEL發現了一種新的氣體系統,稱為HF+ PF3。通過將該氣體系統與極低溫度(公告中為-60°C)相結合,實現了3D NAND內存孔的高速蝕刻。
HF/PF3 + 冷凍蝕刻能力
圖3顯示了使用傳統CF基等離子體和這次使用HF/PF3 + Cryo的TEL蝕刻模型(圖13)。在CF基等離子體中,CF基聚合物厚厚地沉積在孔的側壁上。雖然這種聚合物可以防止橫向蝕刻(稱為彎曲),但孔越深,到達孔底部的CF自由基就越少,孔的蝕刻速率就會急劇降低。
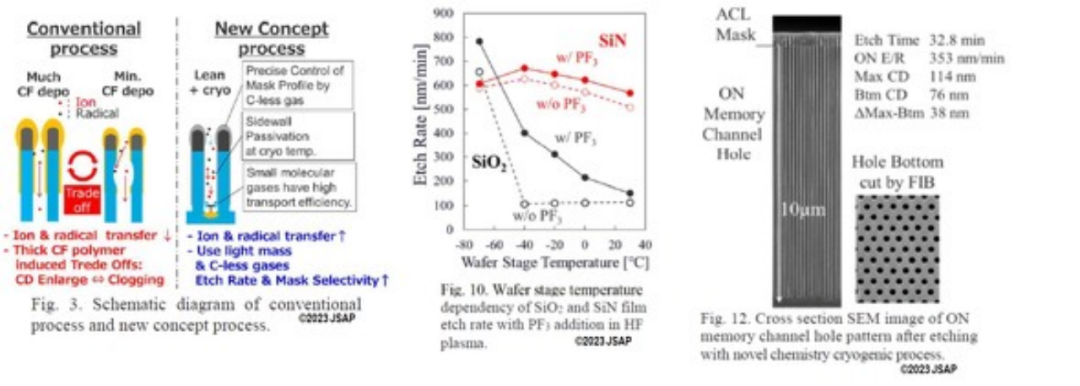
作為針對這些問題的對策,提高芯片溫度等使CF基聚合物難以沉積在孔的側壁上的條件將導致孔的橫向蝕刻,從而導致彎曲。簡而言之,CF自由基向孔底的運輸和防止彎曲之間存在權衡,這使得優化變得困難。 然而,在HF/PF3 +Cryo的情況下,孔的側壁上幾乎沒有沉積。也就是說,反應物質HF被供應到孔的底部而不被側壁“吃掉”。即使孔側壁上的沉積物很小,也可以防止彎曲。因此,可以實現高速 HAR 蝕刻而無需彎曲。 從圖10可以看出,SiN的蝕刻速率隨溫度變化不大,并且無論添加或不添加PF3 ,其蝕刻速率都沒有太大變化。另一方面,對于SiO2,溫度越低,蝕刻速率越高。此外,添加 PF3可以加快蝕刻速度。在本次演示中,實驗是在-60攝氏度下進行的,但如果溫度能夠進一步降低到-80到100攝氏度,或許可以蝕刻得更快。
最終結果如圖12所示。在HF/PF3+Cryo(-60℃)條件下,在32.8分鐘內蝕刻10μm厚的SiO2和SiN層。蝕刻速率為353nm/min,孔的最大CD為114nm,最小CD為76nm。 TEL此次宣布的成果是,通過結合新型氣體系統(HF/PF3)和低溫(-60℃),實現了可用于3D NAND存儲孔的HAR蝕刻。到目前為止,HAR刻蝕領域一直被美國Lam Research壟斷,但TEL未來可能會大幅增長。
審核編輯:劉清
-
DRAM
+關注
關注
40文章
2343瀏覽量
185382 -
晶體管
+關注
關注
77文章
10005瀏覽量
141203 -
NAND閃存
+關注
關注
2文章
227瀏覽量
23313 -
NAND芯片
+關注
關注
0文章
24瀏覽量
10238 -
GAA
+關注
關注
2文章
38瀏覽量
7715
原文標題:背面供電與DRAM、3D NAND三大技術的未來預測
文章出處:【微信號:ICViews,微信公眾號:半導體產業縱橫】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
光學系統的3D可視化
3D打印技術,推動手板打樣從概念到成品的高效轉化
3D掃描技術醫療領域創新實踐,積木易搭3D掃描儀Mole助力定制個性化手臂康復輔具

3D DRAM內嵌AI芯片,AI計算性能暴增
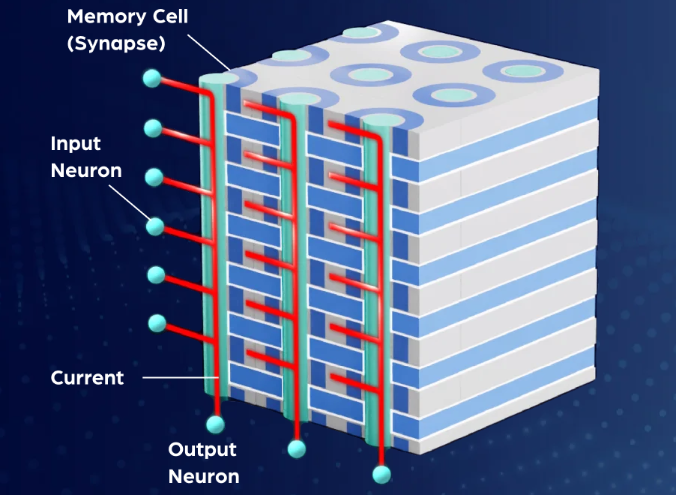





 背面供電與DRAM、3D NAND三大技術介紹
背面供電與DRAM、3D NAND三大技術介紹




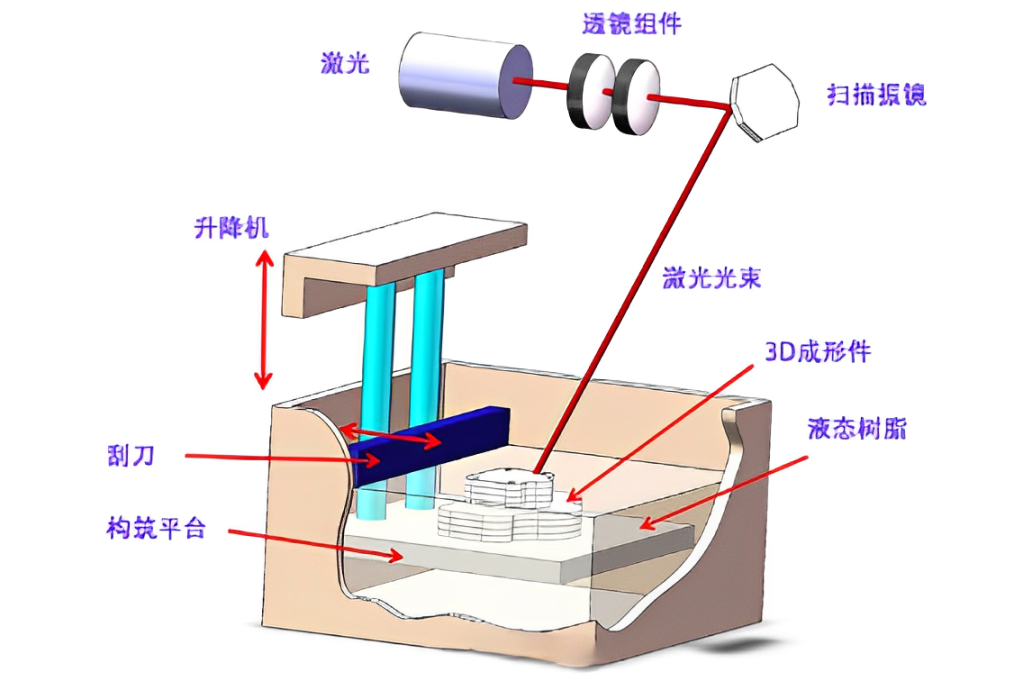












評論