經(jīng)過(guò)半導(dǎo)體制造(FAB)工序制備的電路圖形化晶圓容易受溫度變化、電擊、化學(xué)和物理性外部損傷等各種因素的影響。
為了彌補(bǔ)這些弱點(diǎn),將芯片與晶圓分離后再進(jìn)行包裝,這種方法被稱(chēng)為“半導(dǎo)體封裝(Packaging)”。與半導(dǎo)體芯片一樣,封裝也朝著“輕、薄、短、小”的方向發(fā)展。但是,當(dāng)將信號(hào)從芯片內(nèi)部連接到封裝外部時(shí),封裝不應(yīng)起到阻礙作用。
封裝技術(shù)包括“內(nèi)部結(jié)構(gòu)(Internal Structure)技術(shù)”、“外部結(jié)構(gòu)(External Structure)技術(shù)”和“表面安裝技術(shù)(Surface Mounting Technology,簡(jiǎn)稱(chēng) SMT)”。
1. 封裝發(fā)展趨勢(shì)
<圖1>焊接在主板上的半導(dǎo)體封裝引腳(或錫球)數(shù)量的變化
開(kāi)發(fā)新的半導(dǎo)體封裝,首先必須改變封裝在主板上的安裝方式和外部形式。其次,還要改變封裝的內(nèi)部結(jié)構(gòu)和材料。當(dāng)封裝結(jié)構(gòu)越復(fù)雜時(shí),焊接在主板上的引腳(Pin)或錫球(Ball)數(shù)量就越多,引腳間距就越小。目前,封裝與主板之間的接點(diǎn)數(shù)量已迅速接近其極限與飽和點(diǎn)。
2. 封裝結(jié)構(gòu)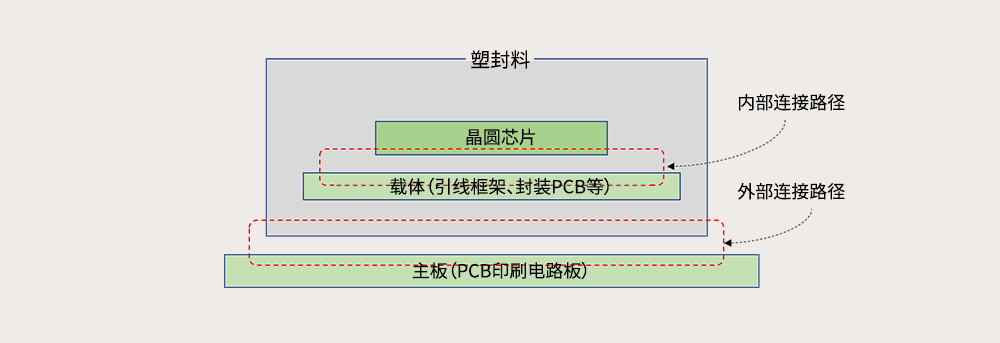
<圖2>半導(dǎo)體封裝的內(nèi)部和外部結(jié)構(gòu)
半導(dǎo)體封裝包括半導(dǎo)體芯片、裝載芯片的載體(封裝PCB、引線框架等)和封裝這些器件的塑封料。
此外,內(nèi)部和外部連接路徑用于將信號(hào)從內(nèi)部芯片連接到外部。無(wú)論是內(nèi)部還是外部連接,該連接過(guò)去都是使用線(導(dǎo)線或引線框架)進(jìn)行的,但近來(lái)普遍使用點(diǎn)(緩沖墊或錫球)。同時(shí),塑封料在排除內(nèi)部熱量和保護(hù)芯片免受外部損傷方面起著重要作用。
3. 決定封裝類(lèi)型的三要素:內(nèi)部結(jié)構(gòu)、外部結(jié)構(gòu)和貼裝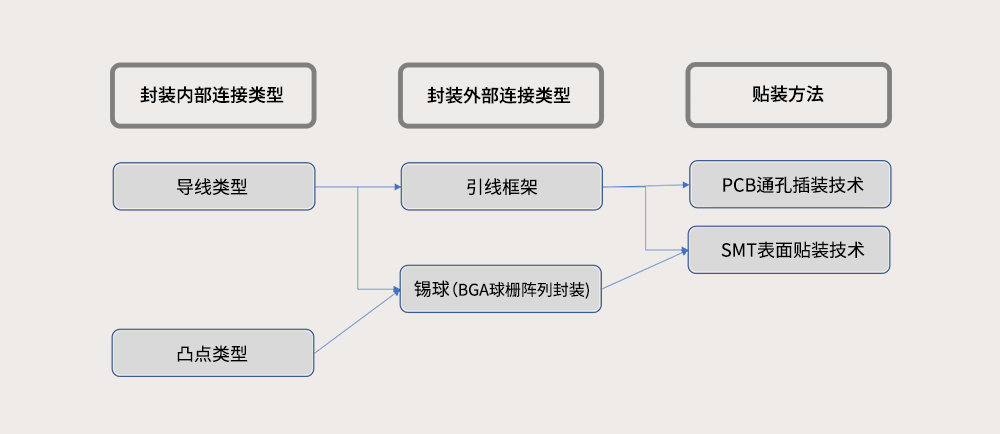
<圖3>封裝內(nèi)部連接類(lèi)型、外部連接類(lèi)型和貼裝方法的示意圖
直到上世紀(jì)80年代末,普遍采用的封裝內(nèi)部連接方式是引線鍵合(Wire Bonding),即用金線將芯片焊盤(pán)連接到載體焊盤(pán)。然而,隨著封裝尺寸減小,封裝內(nèi)金屬線所占體積也就隨之增大。為了解決這個(gè)問(wèn)題,沒(méi)有拆除金屬線,而是用凸點(diǎn)(Bump)代替金屬線進(jìn)行內(nèi)部連接。當(dāng)然,這并不意味著引線鍵合方法完全不可用。
當(dāng)使用凸點(diǎn)連接時(shí),需要采用凸點(diǎn)連接(Bump Attaching)工藝和環(huán)氧樹(shù)脂填充(Under-Fill)方法代替裝片(Die-Attaching)和引線鍵合工藝。 外部連接方式也已從引線框架改為錫球。這是因?yàn)橐€框架和導(dǎo)線有同樣的缺點(diǎn)。過(guò)去采用的是“導(dǎo)線-引線框架-PCB通孔插裝”,而現(xiàn)在最常用的是“凸點(diǎn)-球柵陣列(Ball Grid Array, 簡(jiǎn)稱(chēng) BGA)-表面貼裝技術(shù)”
4. 內(nèi)部封裝類(lèi)型
4.1 無(wú)引腳半導(dǎo)體(Wireless Semiconductor):倒裝芯片(Flip chip)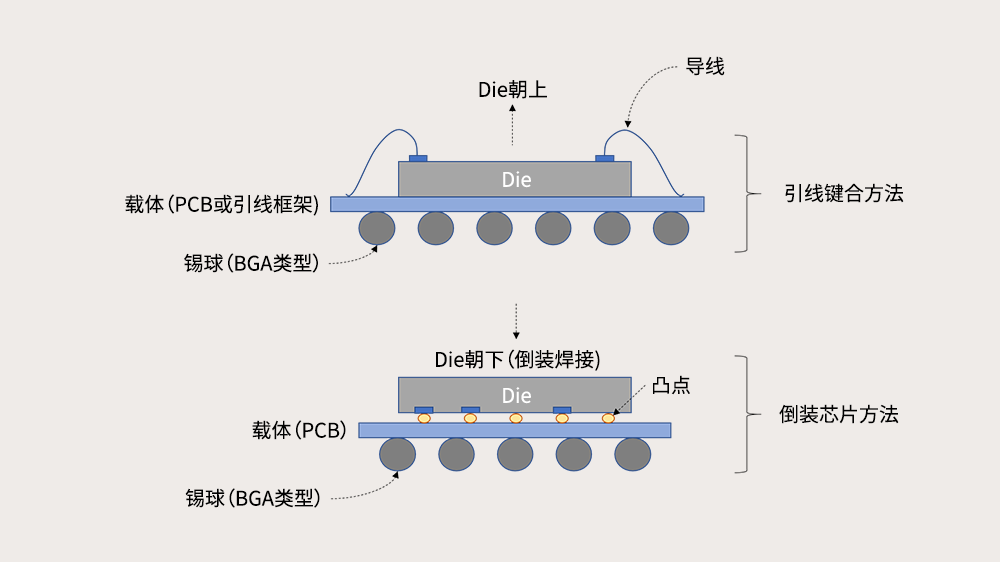
<圖4>引線鍵合類(lèi)型和倒裝芯片類(lèi)型之比較
半導(dǎo)體封裝還可以根據(jù)內(nèi)部結(jié)構(gòu)分成引線類(lèi)型(Wiring Type)與倒裝芯片類(lèi)型(Flip Chip Type)。引線方法將芯片朝上,通過(guò)引線鍵合與載體連接起來(lái)。而倒裝芯片方法是將芯片朝下,并把直徑極小的錫球(被稱(chēng)為凸點(diǎn)Bump的導(dǎo)電金屬)連接到焊盤(pán)上。
因此,倒裝芯片方法不需要用長(zhǎng)的導(dǎo)線,即可使半導(dǎo)體芯片連接于基板上,具有信號(hào)傳輸距離短、粘附力強(qiáng)的特性。這可以說(shuō)是一項(xiàng)改善引線鍵合缺陷的創(chuàng)新技術(shù)。 倒裝芯片最大的優(yōu)點(diǎn)是能減少封裝尺寸,改進(jìn)功耗和信號(hào)傳輸過(guò)程。由于其長(zhǎng)度較短,受到電阻和周邊噪音的影響較小,所以速度更快。
因此,凸點(diǎn)材料使用哪種金屬也很重要。目前最常見(jiàn)的是焊料或黃金。倒裝芯片的另外一個(gè)關(guān)鍵點(diǎn)在于用哪種環(huán)氧樹(shù)脂來(lái)填充凸點(diǎn)和載體之間的空隙。此外,倒裝芯片不使用占用大面積的導(dǎo)線,可以減小成形后的芯片尺寸,因此它被廣泛應(yīng)用于手機(jī)等小型電子設(shè)備。
也就是說(shuō),隨著封裝在主板上的焊墊(Footprint)面積的減小,它更多地被應(yīng)用于高密度基板技術(shù)上。智能手機(jī)等小型電子設(shè)備的出現(xiàn),給封裝技術(shù)帶來(lái)了重大轉(zhuǎn)變。
4.2 在芯片之間制作垂直導(dǎo)通孔的三維封裝技術(shù):硅通孔(Through Silicon Via,簡(jiǎn)稱(chēng) TSV)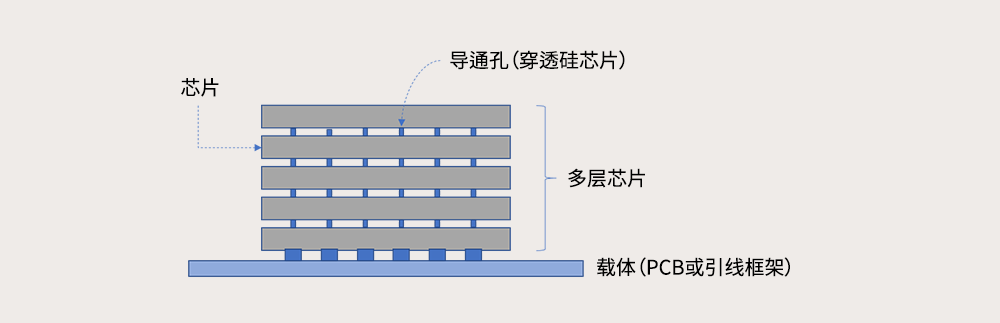
<圖5>采用穿透硅芯片的導(dǎo)通孔的三維封裝技術(shù)
為提高芯片封裝的密度,我們采用堆疊多個(gè)半導(dǎo)體芯片的多層封裝。晶圓級(jí)的多芯片封裝方式有引線鍵合(Wire Bonding)和硅通孔(TSV)兩種方式。硅通孔是堆疊芯片之后,在芯片鉆出垂直通孔并通過(guò)硅貫通電極連接信號(hào)線。其優(yōu)勢(shì)在于信號(hào)傳輸速度快,封裝密度高。
與處理單個(gè)芯片的二維封裝技術(shù)相比,硅通孔(TSV)可以被視為三維封裝技術(shù)。如果用導(dǎo)線連接多層芯片,則形成階梯堆疊結(jié)構(gòu),面積會(huì)增加約兩倍。但硅通孔(TSV)可以像公寓樓一樣形成垂直堆疊結(jié)構(gòu),只需要大約1.2倍的芯片面積。由于硅通孔(TSV)技術(shù)具有更高的空間使用效率,應(yīng)用范圍正逐漸擴(kuò)大。
5. 外部封裝類(lèi)型和貼裝方法 – 基于封裝與外部連接的方式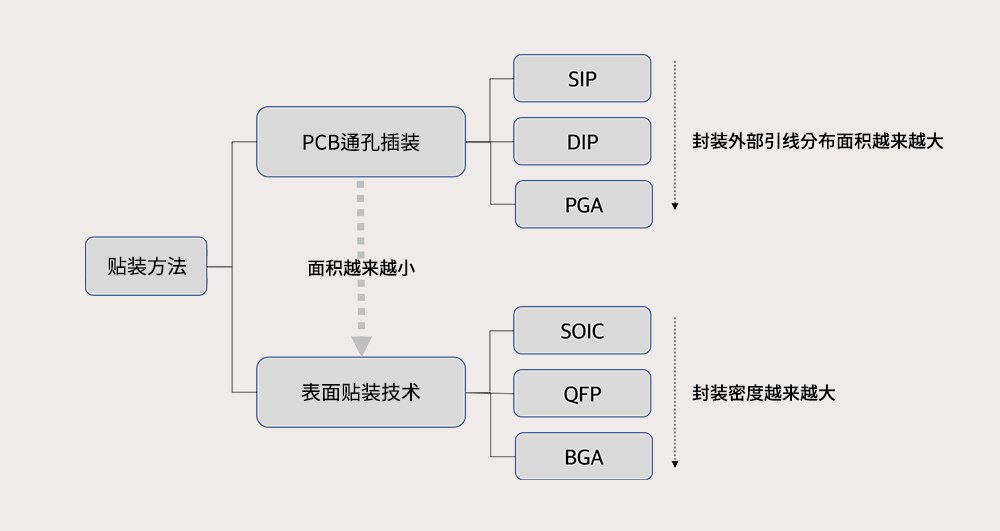
<圖6>外部封裝類(lèi)型和貼裝方法
5.1 外部封裝類(lèi)型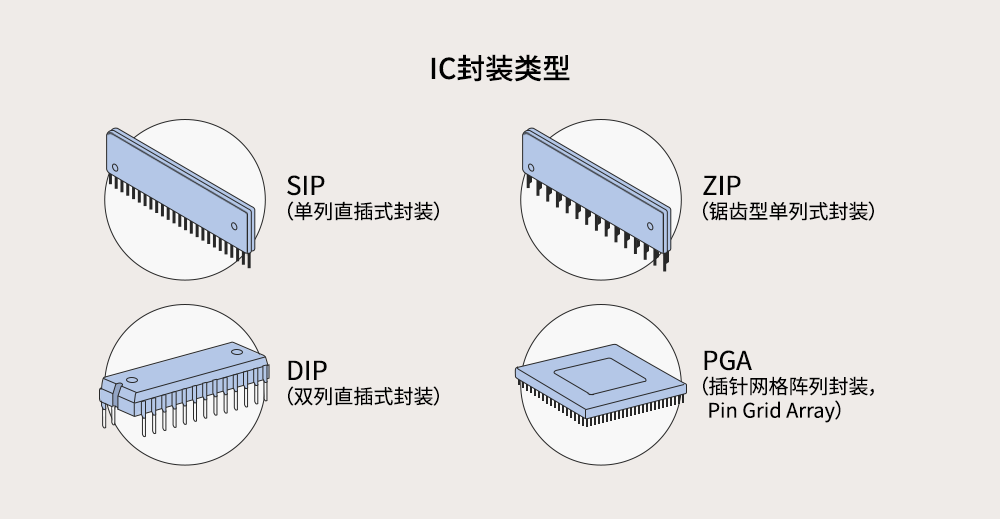
<圖7>IC封裝類(lèi)型
封裝芯片種類(lèi)多樣。以引線框架類(lèi)型為例,有適用于PCB通孔插裝的浸漬式(Dipping),其開(kāi)發(fā)順序?yàn)镾IP1、ZIP2、DIP3和PGA4。然而,由于其減少占用主板焊墊面積的能力極其有限,目前僅在某些情況下使用。 在引線框架類(lèi)型中還有一種小外形(Small Outline,簡(jiǎn)稱(chēng) SO)封裝技術(shù)它屬于表面貼裝技術(shù),通過(guò)彎曲引線來(lái)提高集成度。
目前已發(fā)展到SOIC和SOJ(J型引腳小外形封裝)并得到廣泛應(yīng)用。除此之外,方型扁平式封裝(Quad Flat Package,簡(jiǎn)稱(chēng) QFP)被用于CPU芯片上。隨后,封裝技術(shù)從引線框架類(lèi)型變?yōu)榍蛐危饾u派生出球形觸點(diǎn)陣列(BGA)。目前,球形已成主流。
5.2 貼裝方法
封裝組裝方法主要分為表面貼裝技術(shù)(SMT)和PCB通孔插裝技術(shù)。顧名思義,表面貼裝技術(shù)(SMT)就是通過(guò)焊接將芯片固定在主板表面上,而PCB通孔插裝技術(shù)是將芯片引腳插入主板相應(yīng)的安裝孔,然后與主板的焊盤(pán)焊接固定。 然而,由于主板上的安裝孔所占面積太大,為實(shí)現(xiàn)“輕薄短小”的封裝,貼裝方法已發(fā)展成為無(wú)孔表面貼裝技術(shù)。
在引線框架方法中,從一開(kāi)始就開(kāi)發(fā)了SO型(SOIC和SOJ)和TSOP用于表面安裝。BGA類(lèi)型的球本身就是用于安裝在主板上的,因此也適用表面貼裝方法。
審核編輯:劉清
-
連接器
+關(guān)注
關(guān)注
99文章
15341瀏覽量
140093 -
芯片設(shè)計(jì)
+關(guān)注
關(guān)注
15文章
1083瀏覽量
55591 -
smt
+關(guān)注
關(guān)注
43文章
3028瀏覽量
71831 -
半導(dǎo)體封裝
+關(guān)注
關(guān)注
4文章
292瀏覽量
14422 -
PCB走線
+關(guān)注
關(guān)注
3文章
135瀏覽量
14281
原文標(biāo)題:半導(dǎo)體封裝三要素:內(nèi)部結(jié)構(gòu)、外部結(jié)構(gòu)、SMT
文章出處:【微信號(hào):閃德半導(dǎo)體,微信公眾號(hào):閃德半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
EMC三要素中的耦合路徑
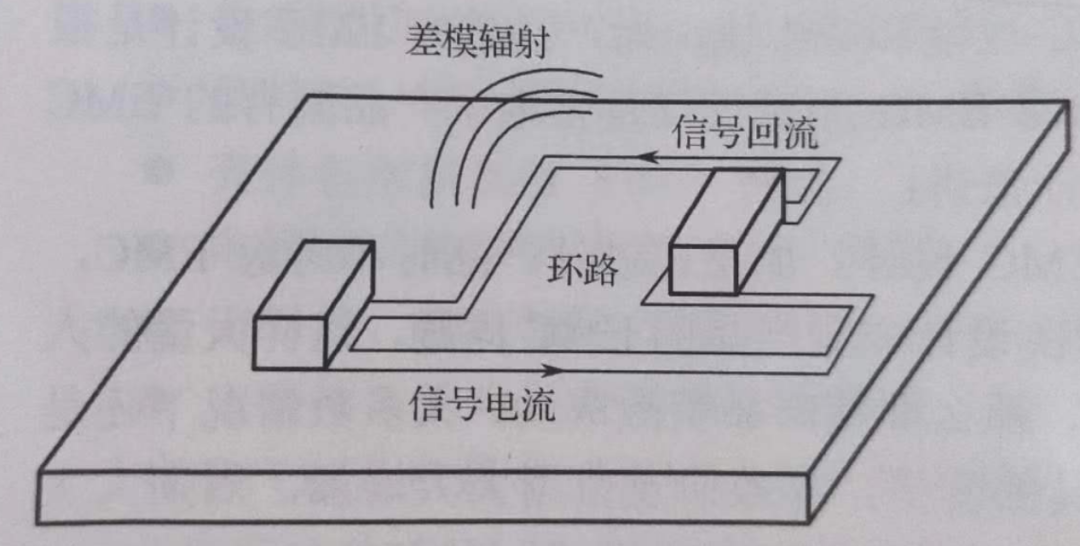
電磁兼容三要素和三規(guī)律

嵌入式系統(tǒng)的三要素
單片機(jī)工作的最小系統(tǒng)三要素
單片機(jī)工作基礎(chǔ)三要素
力的三要素是什么?什么是力?
半導(dǎo)體封裝類(lèi)型總匯(封裝圖示)
凹槽型光耦選型三要素
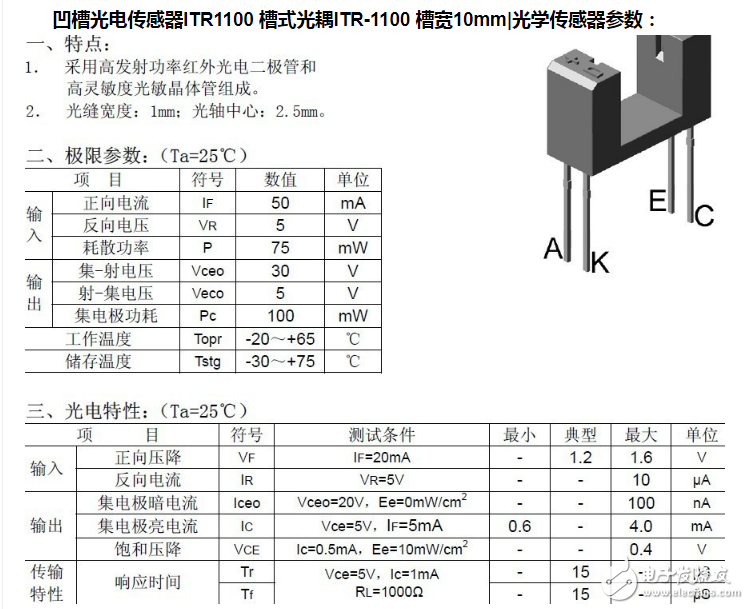





 決定半導(dǎo)體封裝類(lèi)型的三要素
決定半導(dǎo)體封裝類(lèi)型的三要素












評(píng)論