在郵寄易碎物品時,使用合適的包裝材料尤為重要,因?yàn)樗_保包裹能夠完好無損地到達(dá)目的地。泡沫塑料、氣泡膜和堅固的盒子都可以有效地保護(hù)包裹內(nèi)的物品。同樣地,封裝是半導(dǎo)體制造工藝的關(guān)鍵環(huán)節(jié),可以保護(hù)芯片免受物理性或化學(xué)性損壞。然而,半導(dǎo)體封裝的作用并不止于此。
本文是半導(dǎo)體后端(Back-End)工藝系列的第二篇文章,我們將詳述封裝技術(shù)的不同等級、作用和演變過程。
01半導(dǎo)體封裝工藝的四個等級
電子封裝技術(shù)與器件的硬件結(jié)構(gòu)有關(guān)。這些硬件結(jié)構(gòu)包括有源元件1(如半導(dǎo)體)和無源元件2(如電阻器和電容器3)。因此,電子封裝技術(shù)涵蓋的范圍較廣,可分為0級封裝到3級封裝等四個不同等級。圖1展示了半導(dǎo)體封裝工藝的整個流程。首先是0級封裝,負(fù)責(zé)將晶圓切割出來;其次是1級封裝,本質(zhì)上是芯片級封裝;接著是2級封裝,負(fù)責(zé)將芯片安裝到模塊或電路卡上;最后是3級封裝,將附帶芯片和模塊的電路卡安裝到系統(tǒng)板上。從廣義上講,整個工藝通常被稱為“封裝”或“裝配”。然而,在半導(dǎo)體行業(yè),半導(dǎo)體封裝一般僅涉及晶圓切割和芯片級封裝工藝。
1有源元件:一種需要外部電源才能實(shí)現(xiàn)其特定功能的器件,就像半導(dǎo)體存儲器或邏輯半導(dǎo)體。
2無源元件:一種不具備放大或轉(zhuǎn)換電能等主動功能的器件。
3電容器(Capacitor):一種儲存電荷并提供電容量的元件。
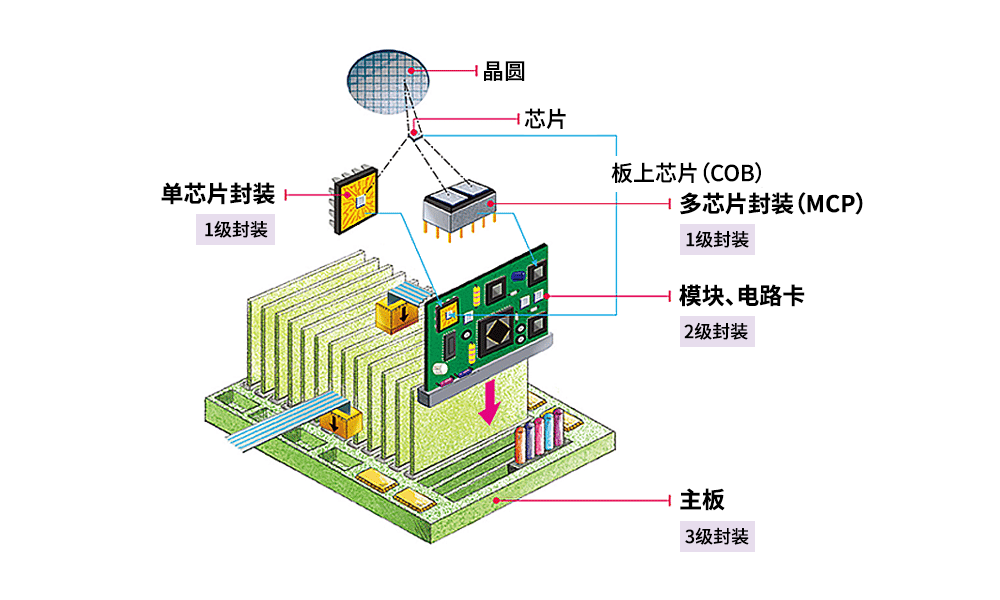
▲圖1:半導(dǎo)體的封裝等級(信息來源:“電子封裝原理 (Principle of Electronic Packaging)”,第5頁)
封裝通常采用細(xì)間距球柵陣列(FBGA)或薄型小尺寸封裝(TSOP)的形式,如圖2所示。FBGA封裝中的錫4球和TSOP封裝中的引線5分別充當(dāng)引腳,使封裝的芯片能夠與外部組件之間實(shí)現(xiàn)電氣和機(jī)械連接。
4錫(Solder):一種低熔點(diǎn)金屬,支持電氣和機(jī)械鍵合。
5引線(Lead):從電路或元件終端向外引出的導(dǎo)線,用于連接至電路板。
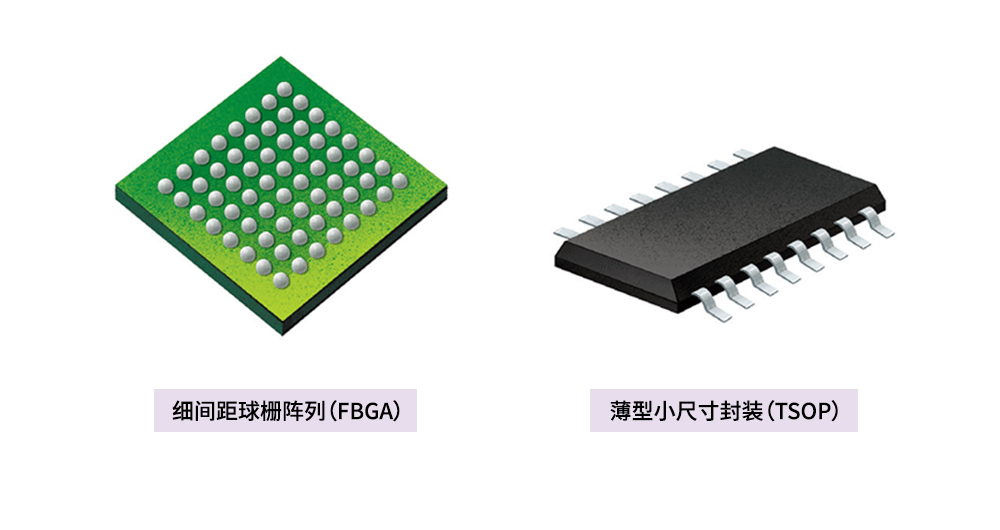
▲圖2:半導(dǎo)體封裝示例(來源:? HANOL出版社)
02半導(dǎo)體封裝的作用
圖3展示了半導(dǎo)體封裝的四個主要作用,包括機(jī)械保護(hù)、電氣連接、機(jī)械連接和散熱。其中,半導(dǎo)體封裝的主要作用是通過將芯片和器件密封在環(huán)氧樹脂模塑料(EMC)等封裝材料中,保護(hù)它們免受物理性和化學(xué)性損壞。盡管半導(dǎo)體芯片由數(shù)百個晶圓工藝制成,用于實(shí)現(xiàn)各種功能,但主要材質(zhì)是硅。硅像玻璃一樣,非常易碎。而通過眾多晶圓工藝形成的結(jié)構(gòu)同樣容易受到物理性和化學(xué)性損壞。因此,封裝材料對于保護(hù)芯片至關(guān)重要。
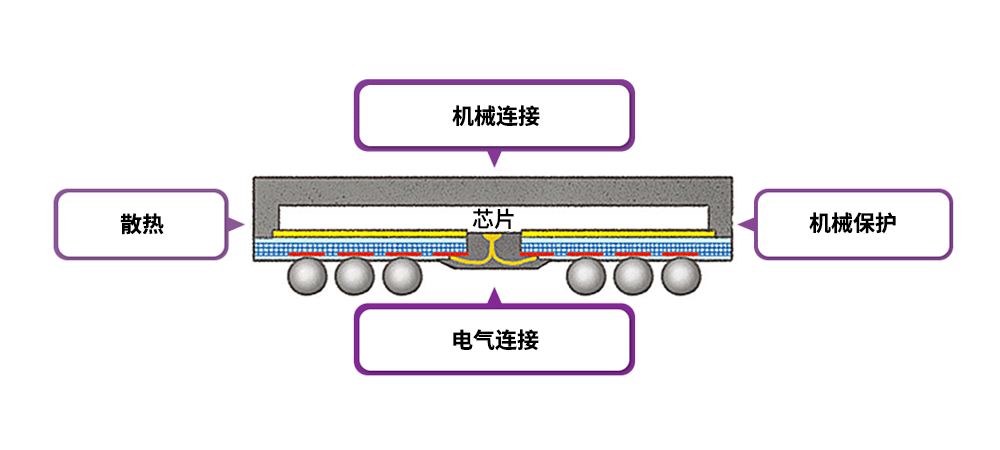
▲圖3:半導(dǎo)體封裝的作用(來源:? HANOL出版社)
此外,半導(dǎo)體封裝可以實(shí)現(xiàn)從芯片到系統(tǒng)之間的電氣和機(jī)械連接。封裝通過芯片和系統(tǒng)之間的電氣連接來為芯片供電,同時為芯片提供信號的輸入和輸出通路。在機(jī)械連接方面,需將芯片可靠地連接至系統(tǒng),以確保使用時芯片和系統(tǒng)之間連接良好。
同時,封裝需將半導(dǎo)體芯片和器件產(chǎn)生的熱量迅速散發(fā)出去。在半導(dǎo)體產(chǎn)品工作過程中,電流通過電阻時會產(chǎn)生熱量。如圖3所示,半導(dǎo)體封裝將芯片完全地包裹了起來。如果半導(dǎo)體封裝無法有效散熱,則芯片可能會過熱,導(dǎo)致內(nèi)部晶體管升溫過快而無法工作。因此,對于半導(dǎo)體封裝技術(shù)而言,有效散熱至關(guān)重要。隨著半導(dǎo)體產(chǎn)品的速度日益加快,功能日益增多,封裝的冷卻功能也變得越來越重要。
03半導(dǎo)體封裝的發(fā)展趨勢
圖4概述了近年來半導(dǎo)體封裝技術(shù)的六大發(fā)展趨勢。分析這些趨勢有助于我們了解封裝技術(shù)如何不斷演變并發(fā)揮作用。
首先,由于散熱已經(jīng)成為封裝工藝的一個重要因素,因此人們開發(fā)出了熱傳導(dǎo)6性能較好的材料和可有效散熱的封裝結(jié)構(gòu)。
6熱傳導(dǎo):指在不涉及物質(zhì)轉(zhuǎn)移的情況下,熱量從溫度較高的部位傳遞到相鄰溫度較低部位的過程。
可支持高速電信號傳輸?shù)姆庋b技術(shù)也成為了一種重要發(fā)展趨勢,因?yàn)榉庋b會限制半導(dǎo)體產(chǎn)品的速度。例如,將一個速度達(dá)每秒20千兆 (Gbps) 的半導(dǎo)體芯片或器件連接至僅支持每秒2千兆(Gbps) 的半導(dǎo)體封裝裝置時,系統(tǒng)感知到的半導(dǎo)體速度將為每秒2千兆 (Gbps)。由于連接至系統(tǒng)的電氣通路是在封裝中創(chuàng)建,因此無論芯片的速度有多快,半導(dǎo)體產(chǎn)品的速度都會極大地受到封裝的影響。這意味著,在提高芯片速度的同時,還需要提升半導(dǎo)體封裝技術(shù),從而提高傳輸速度。這尤其適用于人工智能技術(shù)和5G無線通信技術(shù)。鑒于此,倒片封裝7和硅通孔(TSV)8等封裝技術(shù)應(yīng)運(yùn)而生,為高速電信號傳輸提供支持。
7倒片封裝(Flip Chip):一種通過將凸點(diǎn)朝下安裝于基板上,將芯片與基板連接的互連技術(shù)。
8硅通孔(TSV):一種可完全穿過硅裸片或晶圓實(shí)現(xiàn)硅片堆疊的垂直互連通道。

▲圖4:半導(dǎo)體封裝技術(shù)的發(fā)展趨勢(來源:? HANOL出版社)
另一個發(fā)展趨勢是三維半導(dǎo)體堆疊技術(shù),它促進(jìn)了半導(dǎo)體封裝領(lǐng)域的變革性發(fā)展。過去,一個封裝外殼內(nèi)僅包含一個芯片,而如今可采用多芯片封裝(MCP)和系統(tǒng)級封裝(SiP)9等技術(shù),在一個封裝外殼內(nèi)堆疊多個芯片。
9系統(tǒng)級封裝(SiP):一種將多個器件整合在單個封裝體內(nèi)構(gòu)成一個系統(tǒng)的封裝技術(shù)。
封裝技術(shù)還呈現(xiàn)半導(dǎo)體器件小型化的發(fā)展趨勢,即縮小產(chǎn)品尺寸。隨著半導(dǎo)體產(chǎn)品逐漸被用于移動甚至可穿戴產(chǎn)品,小型化成為客戶的一項(xiàng)重要需求。為了滿足這一需求,許多旨在減小封裝尺寸的技術(shù)隨之而誕生。
此外,半導(dǎo)體產(chǎn)品正越來越多地應(yīng)用于各種環(huán)境中。除了健身房、辦公室或住宅等日常環(huán)境,熱帶雨林、極地地區(qū)、深海甚至太空等環(huán)境中也能見到半導(dǎo)體的身影。由于封裝的基本作用是保護(hù)半導(dǎo)體芯片和器件,因此需要開發(fā)高度可靠的封裝技術(shù),確保半導(dǎo)體產(chǎn)品在此類極端環(huán)境下也能正常工作。
最后,由于半導(dǎo)體封裝是最終產(chǎn)品,封裝技術(shù)不僅要實(shí)現(xiàn)預(yù)期功能,還要具有較低的制造成本。
除了上述旨在推進(jìn)封裝技術(shù)特定作用的發(fā)展趨勢,促使封裝技術(shù)發(fā)生演變的另一個驅(qū)動力是整個半導(dǎo)體行業(yè)的發(fā)展。在圖5中,紅色線條表示自20世紀(jì)70年代以來裝配過程中安裝的印刷電路板(PCB)10的特征尺寸變化情況,綠色線條則表示晶圓上CMOS晶體管的特征尺寸變化情況。縮小特征尺寸有助在印刷電路板和晶圓上繪制更小的圖案。
10印刷電路板(PCB):由電路組成的半導(dǎo)體板,且元件焊接在電路板表面。這些電路板通常用于電子設(shè)備中。
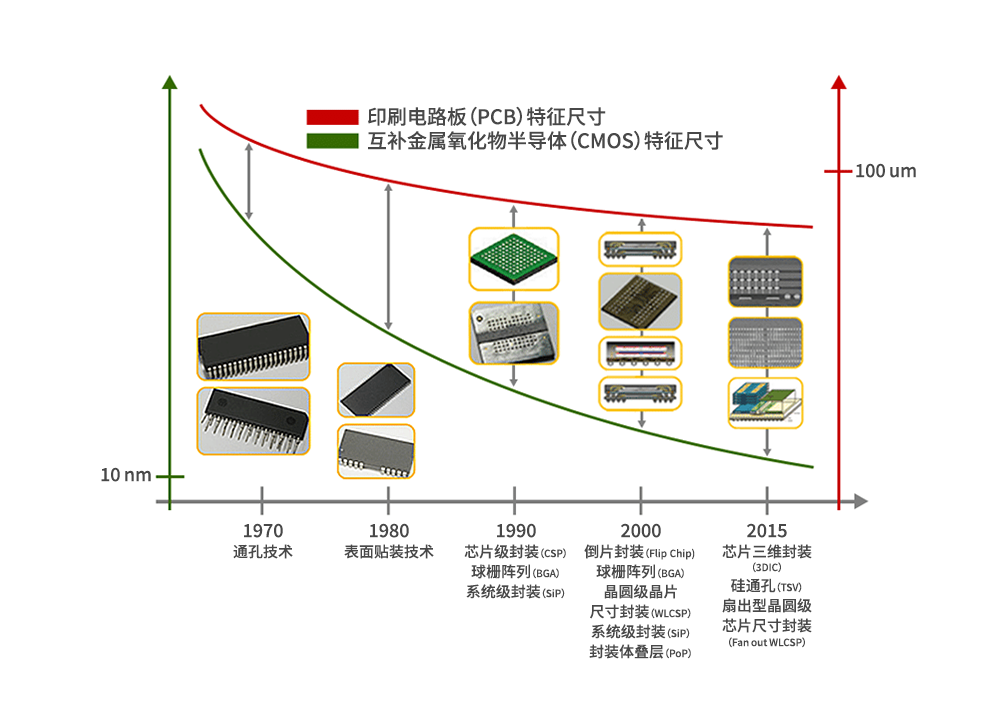
▲圖5:隨著時間的推移,晶圓和 印刷電路板特征尺寸的變化情況(來源:? HANOL出版社)
20世紀(jì)70年代,印刷電路板與晶圓的特征尺寸差異較小。如今,晶圓正在步入量產(chǎn)階段,同時特征尺寸小于10納米(nm)的CMOS晶體管也在開發(fā)中,而印刷電路板的特征尺寸依然在100微米(um)的范圍。兩者特征尺寸的差距在過去幾十年里顯著擴(kuò)大。
由于主板以面板的形式制造,且受到成本節(jié)約策略等因素的影響,印刷電路板的特征尺寸變化不大。然而,隨著光刻技術(shù)的進(jìn)步,CMOS晶體管的特征尺寸大幅縮小,這使得CMOS晶體管的尺寸與印刷電路板的尺寸差距逐漸拉大。但問題在于,半導(dǎo)體封裝技術(shù)需要對從晶圓上切割下來的芯片進(jìn)行個性化定制,并將其安裝到印刷電路板上,因此就需要彌補(bǔ)印刷電路板和晶圓之間的尺寸差距。過去,兩者在特征尺寸上的差異并不明顯,因而可以使用雙列直插式封裝(DIP)11或鋸齒型單列式封裝(ZIP)12等通孔技術(shù),將半導(dǎo)體封裝引線插入印刷電路板插座內(nèi)。然而,隨著兩者特征尺寸差異不斷擴(kuò)大,就需要使用薄型小尺寸封裝(TSOP)等表面貼裝技術(shù)(SMT)13將引線固定在主板表面。隨后,球柵陣列(BGA)、倒片封裝、扇出型晶圓級芯片尺寸封裝(WLCSP)14及硅通孔(TSV)等封裝技術(shù)相繼問世,以彌補(bǔ)晶圓和主板之間不斷擴(kuò)大的尺寸差異。
11雙列直插式封裝(DIP):一種電氣連接引腳排列成兩行的封裝技術(shù)。
12鋸齒型單列式封裝(ZIP):一種引腳排列成鋸齒型的封裝技術(shù),是雙列直插式封裝的替代技術(shù),可用于增加安裝密度。
13表面貼裝技術(shù)(SMT):一種通過焊接將芯片安裝到系統(tǒng)板表面的封裝方法。
14晶圓級晶片尺寸封裝(WLCSP):一種在晶圓級封裝集成電路的技術(shù),是倒片封裝技術(shù)的一個變體。扇出型晶圓級芯片尺寸封裝(WLCSP)的特點(diǎn)在于連接超出(“扇出”)芯片表面。
04通過測試確保半導(dǎo)體封裝的有效性
可以通過兩種方法來開發(fā)半導(dǎo)體封裝并確保其有效性。第一種方法是利用現(xiàn)有封裝技術(shù)來創(chuàng)建適用于新開發(fā)半導(dǎo)體芯片的封裝,然后對封裝進(jìn)行評估。第二種方法是開發(fā)一種新的半導(dǎo)體封裝技術(shù),將其應(yīng)用于現(xiàn)有芯片上,并評估新封裝技術(shù)的有效性。
一般來說,新芯片的開發(fā)和新封裝技術(shù)的應(yīng)用不會同時進(jìn)行。原因在于,如果芯片和封裝均未經(jīng)過測試,那么一旦在封裝完成后出現(xiàn)問題,就很難確定問題的原因。鑒于此,業(yè)界會使用已知缺陷較少的現(xiàn)有量產(chǎn)芯片來測試新的封裝技術(shù),以單獨(dú)驗(yàn)證封裝技術(shù)。在封裝技術(shù)得到驗(yàn)證后,才會將其應(yīng)用于新芯片的開發(fā),進(jìn)而再生產(chǎn)半導(dǎo)體產(chǎn)品。
圖6展示了針對新芯片的封裝技術(shù)開發(fā)流程。通常,在制造半導(dǎo)體產(chǎn)品時,芯片設(shè)計和封裝設(shè)計開發(fā)會同時進(jìn)行,以便對它們的特性進(jìn)行整體優(yōu)化。鑒于此,封裝部門會在芯片設(shè)計之前首先考慮芯片是否可封裝。在可行性研究期間,首先對封裝設(shè)計進(jìn)行粗略測試,以對電氣評估、熱評估和結(jié)構(gòu)評估進(jìn)行分析,從而避免在實(shí)際量產(chǎn)階段出現(xiàn)問題。在這種情況下,半導(dǎo)體封裝設(shè)計是指基板或引線框架的布線設(shè)計,因?yàn)檫@是將芯片安裝到主板的媒介。
封裝部門會根據(jù)封裝的臨時設(shè)計和分析結(jié)果,向芯片設(shè)計人員提供有關(guān)封裝可行性的反饋。只有完成了封裝可行性研究,芯片設(shè)計才算完成。接下來是晶圓制造。在晶圓制造過程中,封裝部門會同步設(shè)計封裝生產(chǎn)所需的基板或引線框架,并由后段制造公司繼續(xù)完成生產(chǎn)。與此同時,封裝工藝會提前準(zhǔn)備到位,在完成晶圓測試并將其交付到封裝部門時,立即開始封裝生產(chǎn)。

▲圖6:半導(dǎo)體封裝技術(shù)的開發(fā)流程(來源:? HANOL出版社)
半導(dǎo)體產(chǎn)品必須進(jìn)行封裝,以檢測和驗(yàn)證其物理特性。同時,可通過可靠性測試等評估方法對設(shè)計和流程進(jìn)行檢驗(yàn)。如果特性和可靠性不理想,則需要確定原因,并在解決問題之后,再次重復(fù)封裝流程。最終,直到達(dá)成預(yù)期特性和可靠性標(biāo)準(zhǔn)時,封裝開發(fā)工作才算完成。
05對半導(dǎo)體封裝作用的展望
在研究封裝技術(shù)在保護(hù)和連接半導(dǎo)體的各種元件方面發(fā)揮的作用時,了解封裝流程中所用的材料和方法同樣至關(guān)重要。下一篇文章將探討常規(guī)封裝與晶圓級封裝之間的差異,以及不同封裝方法如何影響封裝流程的質(zhì)量和效率。
審核編輯:湯梓紅
-
電容器
+關(guān)注
關(guān)注
64文章
6644瀏覽量
102547 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28828瀏覽量
236112 -
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
578瀏覽量
68545 -
半導(dǎo)體封裝
+關(guān)注
關(guān)注
4文章
292瀏覽量
14419
原文標(biāo)題:半導(dǎo)體后端工藝|第二篇:半導(dǎo)體封裝的作用、工藝和演變
文章出處:【微信號:SKhynixchina,微信公眾號:SK海力士】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
半導(dǎo)體工藝與制造裝備技術(shù)發(fā)展趨勢

先進(jìn)封裝技術(shù)的發(fā)展趨勢
半導(dǎo)體工藝技術(shù)的發(fā)展趨勢
新興的半導(dǎo)體技術(shù)發(fā)展趨勢
半導(dǎo)體工藝技術(shù)的發(fā)展趨勢是什么?
5G創(chuàng)新,半導(dǎo)體在未來的發(fā)展趨勢將會如何?
半導(dǎo)體芯片產(chǎn)業(yè)的發(fā)展趨勢
國外半導(dǎo)體設(shè)備現(xiàn)狀與發(fā)展趨勢
電力半導(dǎo)體模塊及其發(fā)展趨勢
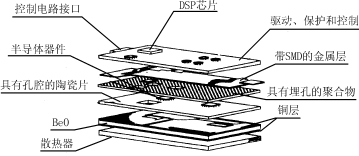
大功率半導(dǎo)體激光器封裝技術(shù)發(fā)展趨勢及面臨的挑戰(zhàn)
淺析半導(dǎo)體激光器的發(fā)展趨勢
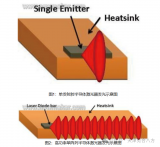





 半導(dǎo)體封裝技術(shù)的不同等級、作用和發(fā)展趨勢
半導(dǎo)體封裝技術(shù)的不同等級、作用和發(fā)展趨勢












評論