近年來,1200V和1700V的碳化硅(SiC)MOSFET已成為當(dāng)前使用IGBT的電力轉(zhuǎn)換器設(shè)計師的真正替代方案。到目前為止,大多數(shù)SiC MOSFET的設(shè)計成功主要發(fā)生在低功率到20kW范圍內(nèi)的電力轉(zhuǎn)換器中,這些通常是全新設(shè)計,這一趨勢主要是由于提高光伏逆變器和其他工業(yè)電源應(yīng)用的效率的需求。
 圖1
圖1設(shè)計師們現(xiàn)在正在使用市面上可用的高功率全SiC電力模塊和驅(qū)動器(見圖1),以升級現(xiàn)有的Si-IGBT系統(tǒng),以及新設(shè)計,特別針對這些新SiC產(chǎn)品進行優(yōu)化,以實現(xiàn)更小、散熱更好和總體性能更優(yōu)的電力轉(zhuǎn)換系統(tǒng)。
Si IGBT組件及其轉(zhuǎn)換為SiC
SiC在電力器件上的材料優(yōu)勢已得到充分證明,無需進一步討論。因此,我們的重點將放在全SiC模塊在大型電力轉(zhuǎn)換系統(tǒng)中的應(yīng)用上。我們選擇了一種基于62mm、400A、1.2kV模塊的商業(yè)現(xiàn)貨Si-IGBT組件,包括直流鏈接電容器、強制風(fēng)冷散熱器和風(fēng)扇,以及帶有保護邏輯和傳感器的門驅(qū)動器,進行了SiC轉(zhuǎn)換并測試以確定性能提升。
 圖2
圖2圖2描述了IGBT組件,我們將其稱為IGBT堆(轉(zhuǎn)換前)或SiC堆(轉(zhuǎn)換后),其關(guān)鍵性能規(guī)格如圖2所示,更多細(xì)節(jié)請參見制造商的數(shù)據(jù)表[3]。所選的200A IGBT堆在3kHz的開關(guān)頻率(Fsw)下額定輸出功率為140kW(200A rms),是該系列產(chǎn)品中最小的,能夠很好地代表我們在商業(yè)中央光伏逆變器或電機驅(qū)動中可能找到的通用商業(yè)模塊化電力子系統(tǒng)。
 圖3
圖3將IGBT堆轉(zhuǎn)換為使用SiC器件的過程非常簡單,因為現(xiàn)有的全SiC電力模塊具有相同的外形尺寸,并且兼容的門驅(qū)動器具備我們在典型IGBT模塊門驅(qū)動器中看到的所有功能。圖3總結(jié)了這些變化。額外添加的直流鏈接電容器僅用于在更高輸出電流下進行測試。三個1200V、400A的IGBT模塊分別被1200V、300A的全SiC模塊取代,并且6通道的門驅(qū)動器板被設(shè)計用于SiC模塊的三個2通道門驅(qū)動器板替代。對SiC堆的少數(shù)機械改動之一是將門驅(qū)動器的位置從距離功率模塊約8英寸的原始位置重新定位到直接安裝在SiC模塊上。這一修改是由SiC更高的開關(guān)速度驅(qū)動的,這要求我們盡可能減少由于布局引起的寄生電感和電容的影響。
1200V、300A的SiC MOSFET模塊內(nèi)置了用于自由輪回的SiC肖特基二極管,相比于被替代的400A IGBT模塊,有五個顯著的性能優(yōu)勢:
1、更低的開關(guān)損耗;
2、更低的導(dǎo)通損耗;
3、幾乎沒有二極管開關(guān)損耗;
4、更高的擊穿電壓裕度;
5、對宇宙輻射引起的故障或單事件燒毀(SEB)的免疫力。
大家普遍知道,SiC MOSFET的開關(guān)損耗較低,圖4a中比較了帶有快速恢復(fù)二極管(FRD)的Si-IGBT和帶有SiC肖特基二極管的同等額定SiC MOSFET在半橋電路的并聯(lián)位置的表現(xiàn)。
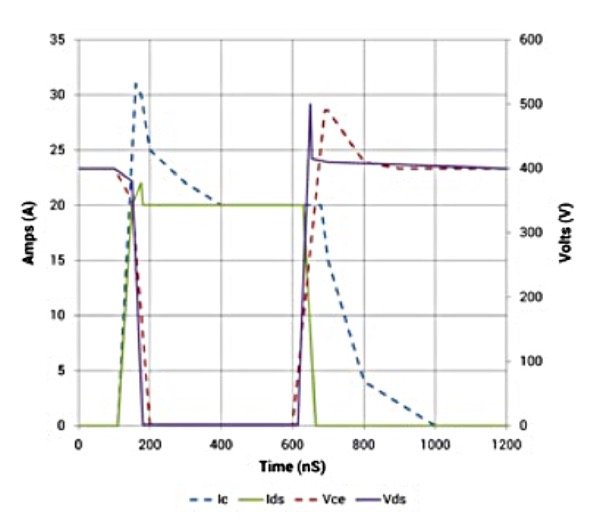 圖4a
圖4a注意,如圖4b所示,SiC肖特基二極管幾乎沒有反向恢復(fù)電荷,并在25°C到150°C的溫度范圍內(nèi)保持恒定,這有助于降低換流MOSFET的Eon和顯著降低二極管的開關(guān)損耗。然而,較少人知道的是,SiC MOSFET的總開關(guān)損耗(ET),即開通和關(guān)斷損耗之和,實際上在較高結(jié)溫下保持不變或減少(在某些情況下降低10%至25%),但Si-IGBT則相反。因此,在可用的工作溫度下,Si-IGBT的ET與SiC MOSFET的ET之間的差異比室溫下的值要大。
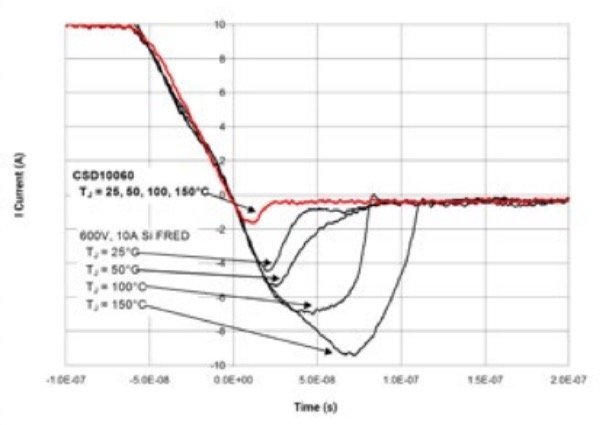 圖4b
圖4b為了更好地理解導(dǎo)通損耗,我們考慮一個額定為50A的IGBT與不同電流額定的SiC MOSFET的正向特性。如圖5所示,一個等效的50A SiC MOSFET的導(dǎo)通損耗約為一半。此外,不必用50A SiC器件替換50A IGBT以獲得相同性能。40A的SiC MOSFET與50A的Si-IGBT在IGBT的額定電流下具有相同的導(dǎo)通損耗。因此,可以假設(shè)這兩種器件的導(dǎo)通損耗相同。
然而,重要的是要注意,IGBT的額定電流是設(shè)備在給定外殼溫度下的直流電流額定值,并不包括設(shè)備的開關(guān)損耗。如果50A的IGBT正在開關(guān),則必須將其降額到較低的電流,以避免超過器件的最大功率損耗值(PDmax)。從圖5中線條的形狀可以看出,在50A以下的任何值,40A的SiC MOSFET在導(dǎo)通損耗方面具有優(yōu)勢,因為MOSFET的純歐姆損耗特性。鑒于兩個器件之間開關(guān)損耗的顯著差異,SiC器件在較高開關(guān)頻率下的降額電流將顯著低于Si-IGBT的等效值。
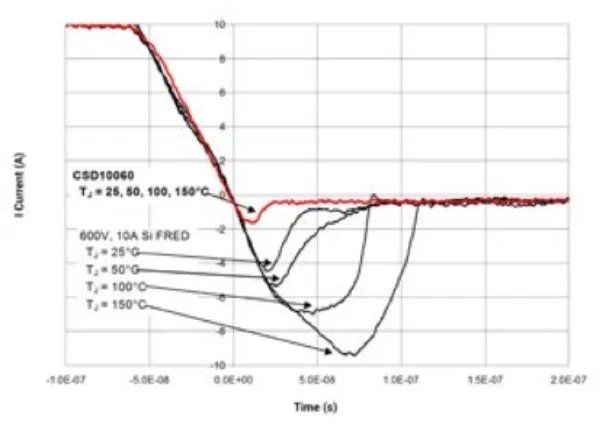 圖5
圖5在討論了SiC模塊的較低開關(guān)、導(dǎo)通和二極管開關(guān)損耗后,我們現(xiàn)在可以討論它們對高能粒子引起的故障或SEB的免疫性,因為SiC MOSFET預(yù)計對這種故障模式的敏感性顯著較低。有三個因素在這種故障模式中具有重要貢獻:器件材料類型、器件面積和電壓應(yīng)力[4]。
由于SiC的帶隙約為Si的3倍,且表面積僅為同樣額定Si器件的33%,并且擊穿電壓裕度是最大器件電壓額定值的1.33倍,因此很容易理解,與Si-IGBT相比,SiC MOSFET如何能夠最小化這三種主要因素對SEB的影響。
性能提升
在將IGBT堆轉(zhuǎn)換為SiC堆后,我們期望功率損耗顯著降低,這樣可以在更高的開關(guān)頻率下實現(xiàn)相同的輸出功率和效率。這可以減少整體系統(tǒng)的體積和重量,或者在相同的開關(guān)頻率下產(chǎn)生更多的功率,從而提高功率密度和每瓦特的成本(Watts/$),或者簡單地使系統(tǒng)在相同的工作條件下以更低的結(jié)溫和更高的效率運行,從而有效提高可靠性。圖6顯示了性能改進的模擬結(jié)果,后續(xù)通過測量數(shù)據(jù)進行了驗證,展示了IGBT堆的輸出電流與開關(guān)頻率之間的關(guān)系。
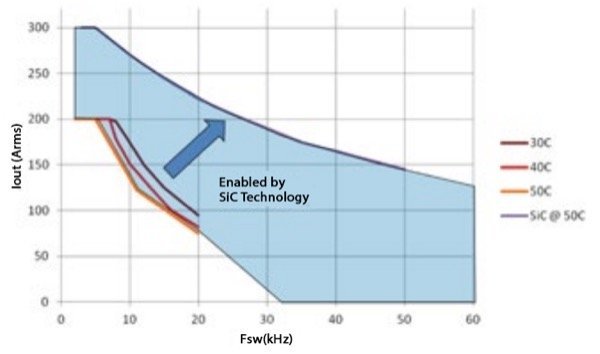 圖6
圖6為了確認(rèn)預(yù)期的性能提升,SiC堆作為三相逆變器進行了測試,測量結(jié)果與IGBT堆的發(fā)布數(shù)據(jù)表值進行了對比。測試是在700VDC電源上進行的,采用400m3/Hr風(fēng)扇強制冷卻,在環(huán)境溫度(TAMB)為25°C下進行。輸出電壓設(shè)定為480Vac rms(相對相)50Hz,并連接到一個可以從2.8kW調(diào)節(jié)到263kW的平衡三相電阻負(fù)載箱。初步測試在Fsw=10kHz下進行,然后在保持所有其他操作參數(shù)不變的情況下,在Fsw=50kHz下重復(fù)測試。結(jié)果總結(jié)在圖7中,展示了SiC堆所取得的明顯性能優(yōu)勢。


圖7
如果考慮整個IGBT堆系列,轉(zhuǎn)換后的SiC版本將在產(chǎn)品陣容中處于何種位置?答案取決于應(yīng)用的操作開關(guān)頻率。如圖8所示,我們展示了產(chǎn)品的額定輸出電流與Fsw的關(guān)系。正如預(yù)期,輸出電流與Fsw之間呈現(xiàn)反比關(guān)系。然而,由于IGBT堆的輸出電流降額較為顯著,我們可以看到在Fsw=10kHz時,750A額定的IGBT堆(其體積是SiC堆的三倍)具有相同的輸出電流能力。此外,圖8中以藍(lán)色突出顯示的區(qū)域展示了通過Si-IGBT無法以經(jīng)濟方式實現(xiàn)的新能力。
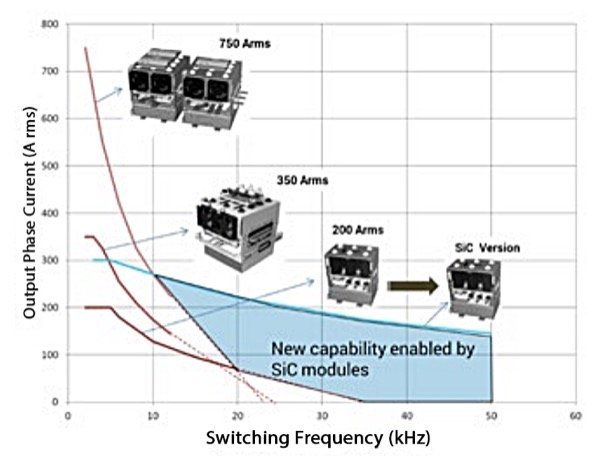 圖8
圖8總結(jié)
高功率轉(zhuǎn)換器設(shè)計師始終需要在性能、體積、成本和工作開關(guān)頻率(Fsw)之間找到平衡。更高的Fsw可以導(dǎo)致更小、更輕的轉(zhuǎn)換器,但會在效率上付出代價。通常,對于高功率系統(tǒng)(>500kW),這種平衡讓最佳Fsw約為3kHz。
全SiC電力模塊現(xiàn)在允許設(shè)計工程師在不顯著影響性能的情況下設(shè)計更高的Fsw,這使得高頻電力轉(zhuǎn)換系統(tǒng)的優(yōu)勢愈加明顯,從而可能實現(xiàn)更小的體積和重量,更快的響應(yīng)時間,以及簡化和更可靠的電力轉(zhuǎn)換系統(tǒng)。
-
IGBT
+關(guān)注
關(guān)注
1278文章
4066瀏覽量
254397 -
SiC
+關(guān)注
關(guān)注
31文章
3222瀏覽量
65077 -
IGBT模塊
+關(guān)注
關(guān)注
8文章
116瀏覽量
16809 -
電力轉(zhuǎn)換器
+關(guān)注
關(guān)注
0文章
26瀏覽量
6723
發(fā)布評論請先 登錄
全SiC功率模塊的開關(guān)損耗
傳統(tǒng)的硅組件、碳化硅(Sic)和氮化鎵(GaN)
什么是IGBT模塊(IPM Modules)

下一代主流SiC IGBT模塊封裝技術(shù)研發(fā)趨勢——環(huán)氧灌封技術(shù)

儲能變流器PCS中碳化硅功率模塊全面取代IGBT模塊
高頻感應(yīng)電源國產(chǎn)SiC碳化硅模塊替代英飛凌IGBT模塊損耗計算對比
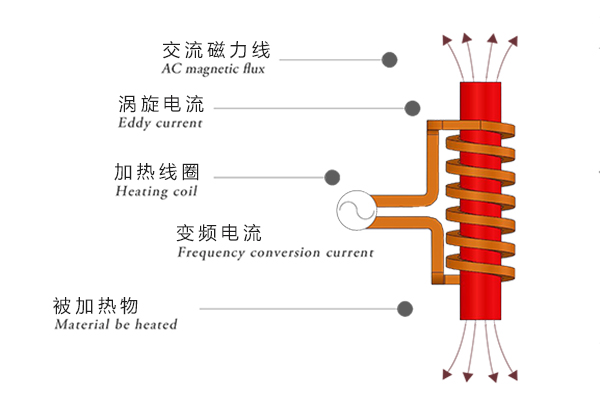
高頻電鍍電源國產(chǎn)SiC碳化硅模塊替代富士IGBT模塊損耗對比

BTP1521P解決IGBT模塊升級SiC模塊的正負(fù)驅(qū)動電壓
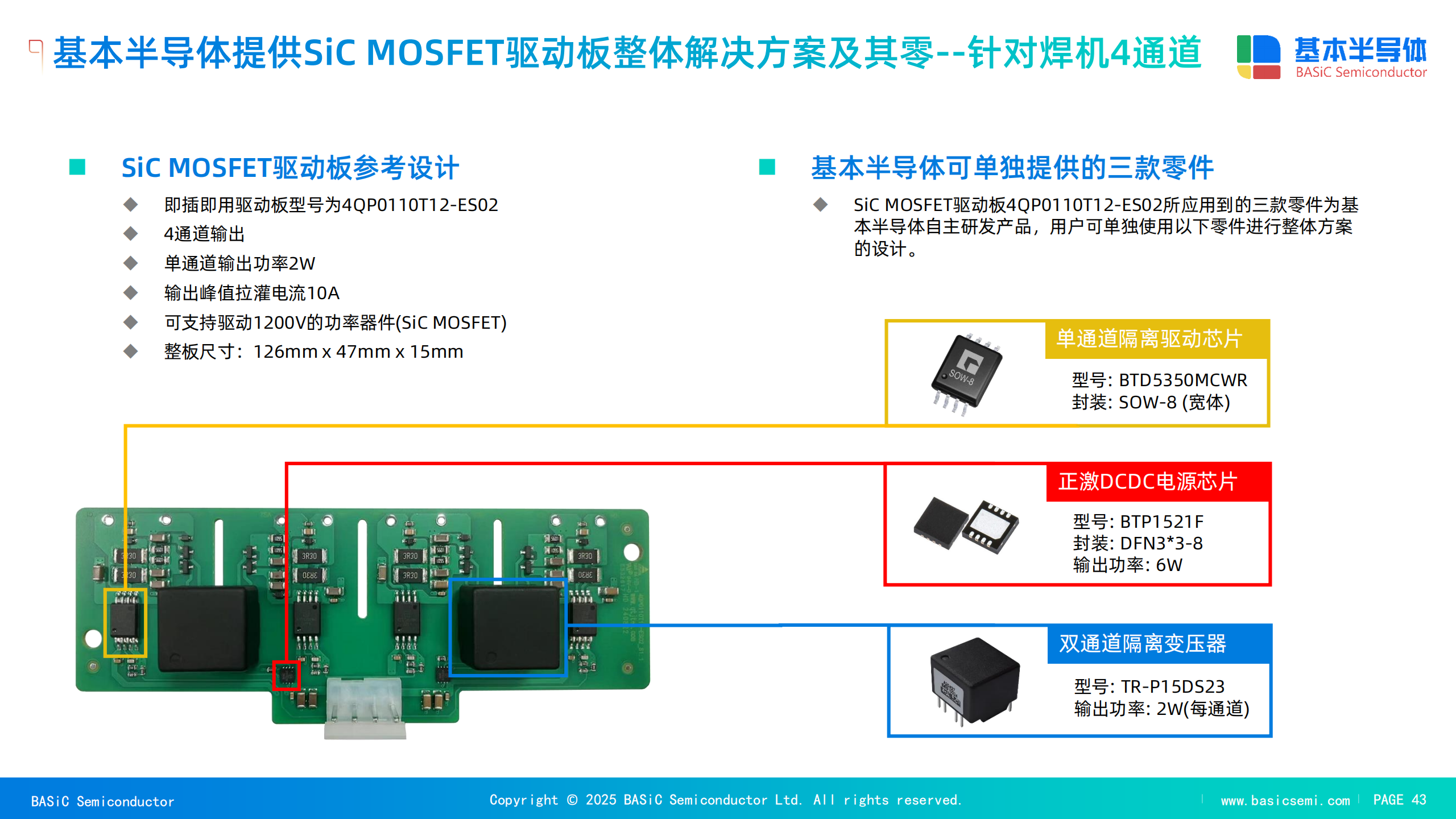
電力電子產(chǎn)業(yè)實現(xiàn)“換道超車”的戰(zhàn)略選擇:國產(chǎn)SiC模塊取代進口IGBT模塊
國產(chǎn)SiC模塊如何應(yīng)對25年英飛凌富士IGBT模塊瘋狂的價格絞殺戰(zhàn)
中國電力電子廠商創(chuàng)新之路:采用國產(chǎn)SiC模塊全面取代進口IGBT模塊
中國電力電子客戶不再迷信外資品牌的IGBT模塊和SiC模塊
SiC碳化硅MOSFET模塊革掉IGBT模塊來顛覆電鍍電源和高頻電源行業(yè)

國產(chǎn)SiC碳化硅功率模塊全面取代進口IGBT模塊的必然性
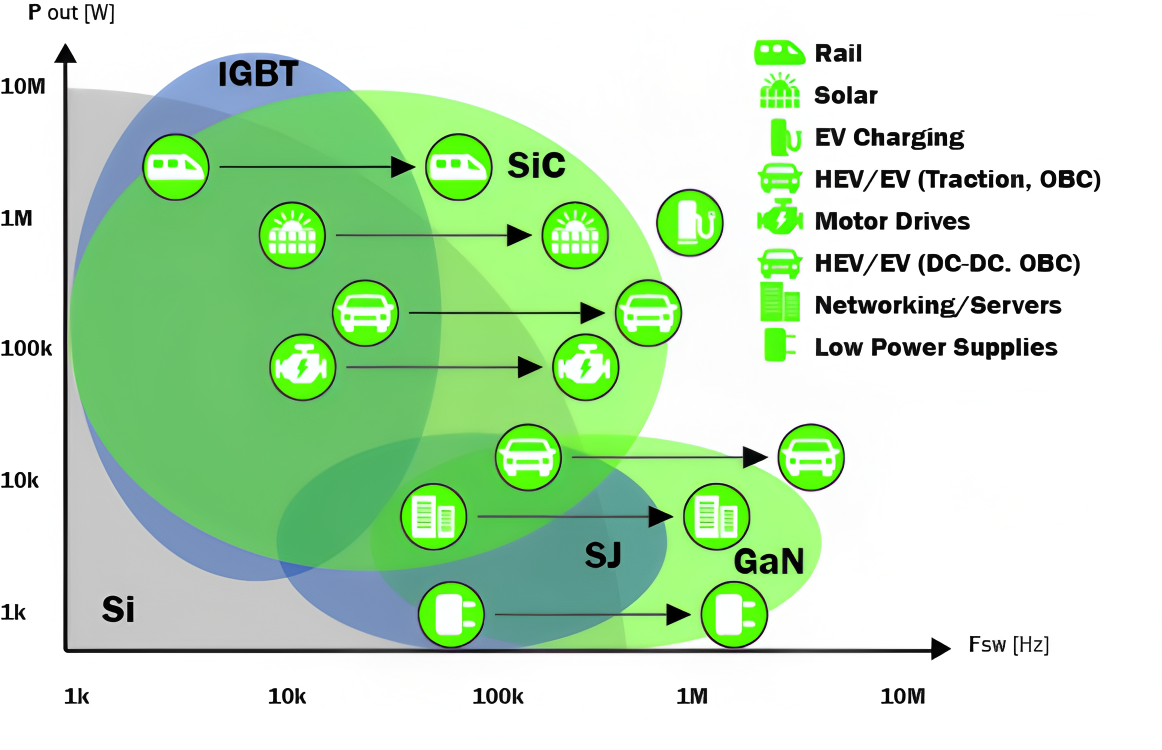





 提升傳統(tǒng)基于IGBT模塊的電力組件性能的SiC模塊
提升傳統(tǒng)基于IGBT模塊的電力組件性能的SiC模塊











評論