共讀好書
Die Bound芯片鍵合,是在封裝基板上安裝芯片的工藝方法。本文詳細介紹一下幾種主要的芯片鍵合的方法和工藝。
什么是芯片鍵合

芯片鍵合的流程

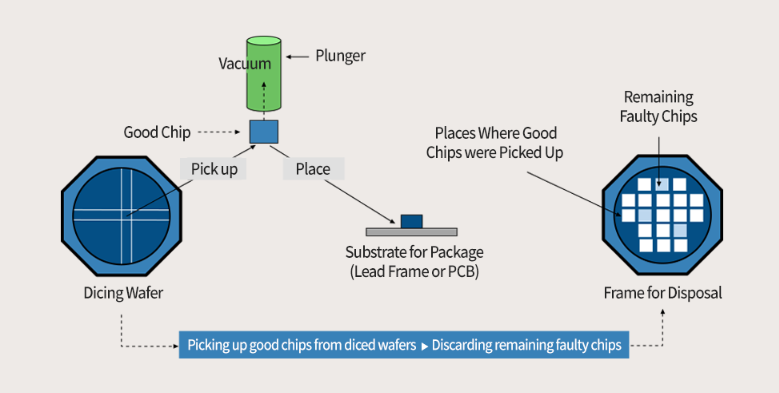
芯片彈壓

芯片粘合工藝
這就是為什么最近使用模貼膜(DAF)的更先進的粘合方法是首選的原因。雖然DAF有一些昂貴和難以處理的缺點,但它的厚度可以很好的控制,并且簡化了工藝過程,因此它的使用量逐漸增加。
模貼膜(DAF)粘接
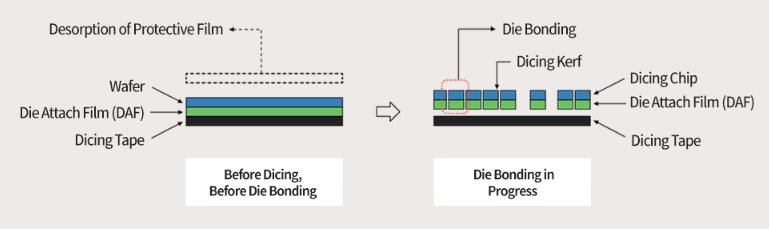
歡迎掃碼添加小編微信

掃碼加入知識星球,領取公眾號資料

原文標題:Die Bonding 芯片鍵合的主要方法和工藝
文章出處:【微信公眾號:半導體封裝工程師之家】歡迎添加關注!文章轉載請注明出處。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
封裝
+關注
關注
128文章
8630瀏覽量
145253
發布評論請先 登錄
相關推薦
熱點推薦
微流控芯片鍵合技術
和陽極鍵合技術實現密封。這些方法雖然有效,但可能需要較高的溫度和處理時間,可能增加能耗和生產成本。 聚合物材料(如PDMS和PMMA):這些材料因其便捷性和實用性,成為玻璃和聚合物芯片
Cu-Cu Hybrid Bonding技術在先進3D集成中的應用
引言 Cu-Cu混合鍵合(Cu-Cu Hybrid Bonding) 技術正在成為先進3D集成的重要技術,可實現細間距互連和高密度芯片堆疊。本文概述了Cu-Cu混合

微流控芯片的熱鍵合和表面改性鍵合的工藝區別
微流控芯片是一種在微尺度下進行流體操控的裝置,廣泛應用于生物、化學、醫學等領域。在微流控芯片的制造過程中,鍵合技術是至關重要的一步,它決定了芯片





 Die Bonding 芯片鍵合的主要方法和工藝
Die Bonding 芯片鍵合的主要方法和工藝























評論