?CoWoS(
Chip-on-Wafer-on-Substrate)邁向CoPoS (Chip-on-Panel-on-Substrate) 技術,生態系統加速構建。
?板級封裝中,RDL增層工藝結合有機材料與玻璃基板應用,盡顯產能優勢。
?Manz亞智科技板級RDL制程設備,實現高密度與窄線寬線距的芯片封裝。

【2024 年12月4日】 活躍于全球并具有廣泛技術組合的高科技設備制造商Manz 集團,領銜全球半導體先進封裝趨勢,憑借在RDL領域的優勢布局,針對RDL增層工藝搭配有機材料和玻璃基板的應用,成功向多家國際大廠交付了300mm、510mm、600mm及700mm等不同尺寸的板級封裝RDL量產線,涵蓋洗凈、顯影、蝕刻、剝膜、電鍍及自動化設備。同時,為跨領域客戶快速集成工藝技術和設備生產,積極助力板級封裝為基礎的未來玻璃基板應用于人工智能芯片,讓這一愿景變成現實。
半導體行業未來發展的驅動力是降低芯片生產成本,而板級封裝(FOPLP) 突破硅片面積的限制,在芯片尺寸變大的趨勢下,應用方型基板以增加產能,無疑是實現降本增效的關鍵解決方案之一。此外,隨著大算力需求的不斷增長,業界一致認為玻璃基板將幫助芯片行業達到新的高度!Manz亞智科技RDL生產設備解決方案,能夠在封裝中重新分配信號路徑,確保不同封裝層之間的精確互連,率先助力板級封裝量產落地及玻璃基板開發進程。
01大芯片和異構集成
市場調研顯示,先進封裝市場預計在2029年將達到695億美元,從2023年至2029年的CAGR為11%,從2023年到2029年,2.5D/3D(含CoWoS)的CAGR為15%。這些由AI、HPC、汽車和AI PCs所驅動。行業領導者正越來越多地采用大芯片和異構集成策略,使用先進封裝來補充前端擴展。它已成為制造廠、OSAT、IDMs和芯片設計關注的焦點。
02CoWoS產能吃緊,CoPoS力當先鋒
在短期內,AI芯片催生的強勁需求超出了目前市場供量,業界正在探索更先進的封裝形式與技術,從晶圓級封裝轉型板級封裝,以實現更好的面積利用率進而提升產能。Manz亞智科技作為板級RDL方案產業化的領導者之一認為,在當前CoWoS(
Chip-on-Wafer-on-Substrate)產能欠缺下,CoPoS(Chip-on-Panel-on-Substrate)技術概念是驅動先進封裝進階的趨勢。
CoPoS 是CoWoS的面板化解決方案,作為2.5D封裝的另外一種選擇,其硅中介層替換成有機材料中介層、BT基板替換成玻璃基板,在各種互連架構中實現的再分配層,包括RDL interposer (CoWoS-R/ CoWoS-L)和玻璃芯基板上的RDL(玻璃版的FC-BGA)——這也是當前業界形成的共識,以應對下一代更高密度的AI芯片。
扇出板級封裝(FOPLP),作為扇出晶圓級封裝的延伸,將多個芯片、無源組件和互連集成在一個封裝內,并以重新布線層(RDL)工藝,將芯片重新分布在具有面積利用率優勢的方形基板上進行互連,是具備產能優勢的先進封裝技術。FOPLP與傳統封裝方法相比,提供了更大的成本效益。
隨著中介層/有機基板將切換成玻璃, Manz亞智科技也將RDL工藝實現于510mm x 515mm的玻璃基板,實現高帶寬、高密度的D2D互連。這一特性在AI計算中尤為關鍵,能夠有效滿足數據傳輸與處理的迫切需求,CoPoS 概念正逐漸地實現中。
03Manz亞智科技的RDL制程生產設備支持玻璃基板生產
Manz亞智科技在RDL制程經驗的基礎上進行了前瞻性的技術研發,投入更多研發力量,轉向以玻璃基板為基礎的架構,聚焦于高密度玻璃基板與多樣化化學品等制程材料的合作開發與制程設備整合設計,強調針對不同類型、不同厚度的玻璃達成內接導線金屬化制程與TGV玻璃通孔制程技術;以不同溫度控制、流態行為控制及化學藥液,有效控制玻璃通孔內形狀配置及深寬比,滿足高縱深比的直通孔、高真圓度等制程工藝需求,以此使芯片具備更高頻寬、更大密度和更強散熱能力。
04Manz亞智科技支持本土定制化解決方案
近年來,中國先進封裝產業受到重點支持。《制造業可靠性提升實施意見》、《財政部海關總署稅務總局關于支持集成電路產業和軟件產業發展進口稅收政策的通知》、《中華人民共和國國民經濟和社會發展第十四個五年規劃和2035年遠景目標綱要》等產業政策為先進封裝行業的發展提供了明確、廣闊的市場前景。
同時,各地“十四五”規劃紛紛將其列為重點發展方向。例如,《江蘇省“十四五”制造業高質量發展規劃》中明確指出,要大力推進晶圓級封裝、系統級封裝、板級扇出封裝和異質集成封裝等關鍵技術的發展。此類政策導向為我國先進封裝領域提供了有力的支持與廣闊的發展前景。
隨著中國半導體的崛起,先進封裝成為本土最具國際競爭力和先導性的產業之一。板級封裝成本優勢明顯,與晶圓級封裝實現互補,板級封裝是先進封裝助力下一代AI芯片的前鋒。頭部先進封裝廠憑借先發優勢深度布局了2.5D、及FOPLP產線進入大規模建設和量產階段,頭部光電顯示面板廠正在轉型玻璃基板的研發試產。
Manz亞智科技憑借本土技術和經驗提供定制化解決方案,推動先進封裝制程的靈活性與創新性。Manz單板型PLP RDL技術已通過L/S 15μm/15μm 的驗證,并處于量產階段。輸送機類型(直列式)PLP RDL技術已通過L/S 5μm/5μm 的驗證,也適用于小批量生產。CoPoS技術中針對RDL增層工藝搭配有機材料和玻璃基板的應用生態系統正在建設中。

Manz亞智科技總經理林峻生先生指出:“為了提供客戶全方位及多元的RDL生產制程設備解決方案,迎接AI芯片面板級封裝的快速成長商機,我們積極整合供應鏈伙伴,在制程、設備、材料使用上積極布局,并在我們廠內建置試驗線,為客戶在量產前進行驗證。面板級封裝將是下一代封裝的新勢頭, Manz從 300mm 到 700mm的 RDL生產制造設備擁有豐富的經驗,從我們技術核心延伸實施到不同封裝和基板結構,確保了客戶在先進封裝制程上的靈活性。”

▲Manz RDL多項制程設備,應用于FOPLP以及TGV生產制程流程,助攻面板級封裝量產進程。
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。聯系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
封裝
+關注
關注
128文章
8630瀏覽量
145239 -
AI
+關注
關注
88文章
34917瀏覽量
277973
發布評論請先 登錄
NVIDIA 采用納微半導體開發新一代數據中心電源架構 800V HVDC 方案,賦能下一代AI兆瓦級算力需求
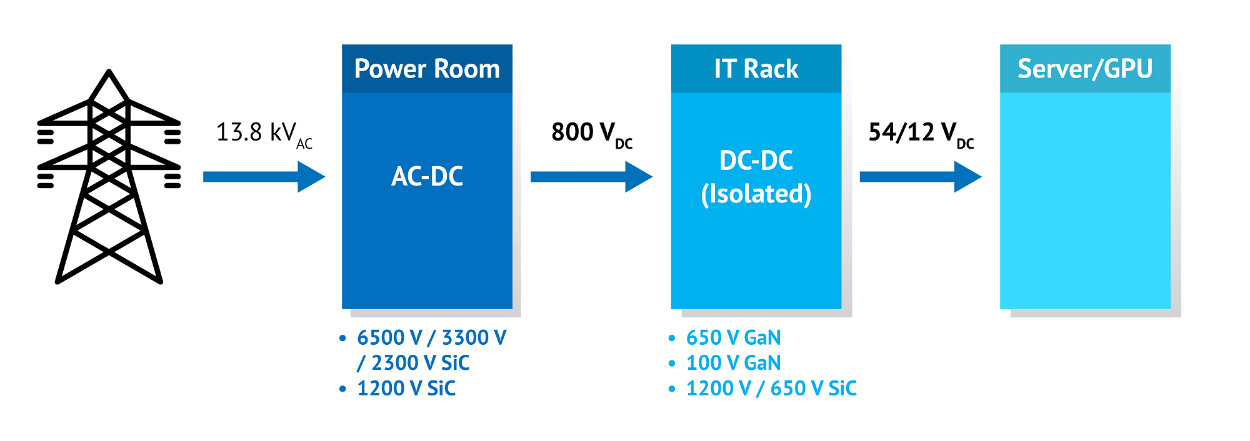
簽約頂級封裝廠,普萊信巨量轉移技術掀起晶圓級封裝和板級封裝的技術革命

玻璃通孔(TGV)技術深度解析
下一代FOPLP基板,三星續用塑料,臺積青睞玻璃
Manz集團成功交付多尺寸板級封裝RDL量產線
Manz亞智科技RDL制程打造CoPoS板級封裝路線, 滿足FOPLP/TGV應用于下一代AI需求

整合為王,先進封裝「面板化」!臺積電、日月光、群創搶攻FOPLP,如何重塑封裝新格局?

Manz亞智科技RDL設備切入五家大廠
下一代高功能新一代AI加速器(DRP-AI3):10x在高級AI系統高級AI中更快的嵌入處理






 Manz亞智科技RDL制程打造CoPoS板級封裝路線,滿足FOPLP/TGV應用于下一代AI需求
Manz亞智科技RDL制程打造CoPoS板級封裝路線,滿足FOPLP/TGV應用于下一代AI需求


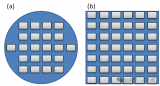










評論