在材料分析中的關(guān)鍵作用
在材料科學(xué)領(lǐng)域,聚焦離子束(FIB)技術(shù)已經(jīng)成為一種重要的工具,尤其在制備透射電子顯微鏡(TEM)樣品時(shí)顯示出其獨(dú)特的優(yōu)勢(shì)。金鑒實(shí)驗(yàn)室作為行業(yè)領(lǐng)先的檢測(cè)機(jī)構(gòu),能夠幫助研究人員準(zhǔn)確評(píng)估FIB加工對(duì)材料的影響,確保樣品的質(zhì)量和分析的可靠性。
本文將深入探討FIB技術(shù)在TEM樣品制備中的應(yīng)用,并分析由此產(chǎn)生的人工缺陷問(wèn)題。
FIB技術(shù)的卓越性能
FIB技術(shù)以其卓越的定位精度和高效的制備流程,大大縮短了樣品制備時(shí)間,并能夠生產(chǎn)出具有平整表面和平行邊緣的TEM樣品。
制備TEM樣品的FIB方法
FIB技術(shù)制備TEM樣品主要有兩種方法:一種是在預(yù)先減薄的樣品中制作“H型”截面;另一種是從塊狀樣品中直接制備電子透明的截面,并通過(guò)微操縱技術(shù)將其轉(zhuǎn)移到網(wǎng)格上進(jìn)行TEM分析。每種方法都有其特定的優(yōu)勢(shì),且可以根據(jù)具體的研磨順序和束流條件進(jìn)行優(yōu)化。
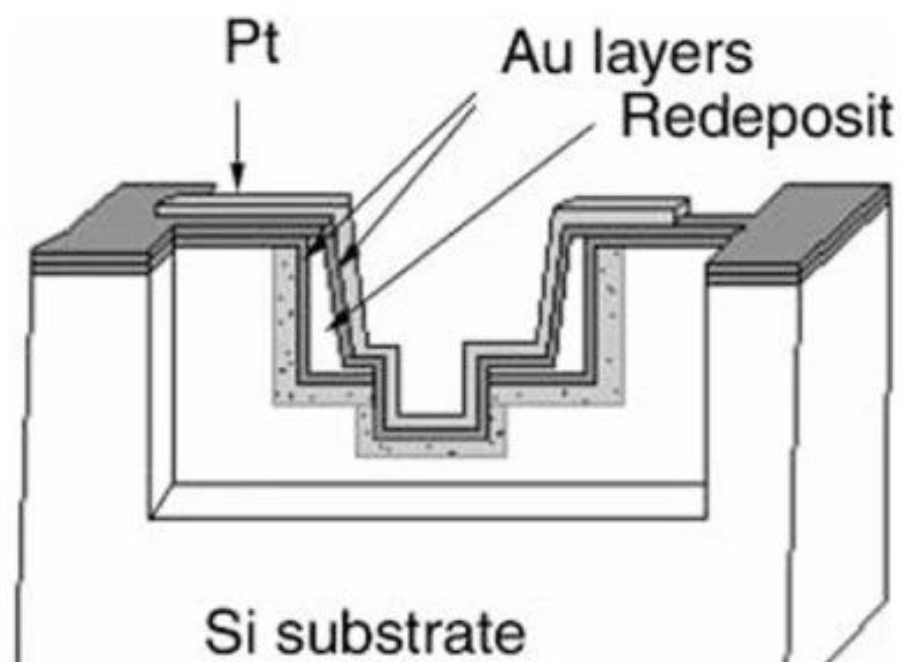
人工缺陷的多樣性與影響
FIB制備的TEM樣品中觀察到的人工缺陷包括“窗簾效應(yīng)”和非晶層的形成。這些缺陷不僅影響了樣品的局部厚度,而且在高分辨率TEM分析中對(duì)分析質(zhì)量有顯著影響。通過(guò)降低離子束能量,可以有效減少這些損傷層的厚度。
鎵離子殘留與再沉積的影響
在FIB加工過(guò)程中,鎵離子的殘留和再沉積現(xiàn)象對(duì)樣品的微區(qū)化學(xué)分析造成了影響。鎵離子與樣品相互作用產(chǎn)生的碰撞損傷可能導(dǎo)致空位和間隙原子的形成,進(jìn)而影響樣品位錯(cuò)結(jié)構(gòu)的分析。再沉積現(xiàn)象尤其在化學(xué)成分復(fù)雜的樣品中更為顯著。
實(shí)驗(yàn)方法與分析
本研究采用單晶Si(100)襯底,通過(guò)FIB刻蝕技術(shù)進(jìn)行離子束掃描。實(shí)驗(yàn)發(fā)現(xiàn),不同能量和束流條件下刻蝕出的溝槽顯示出不同的損傷層結(jié)構(gòu)和厚度。
研究的結(jié)果
FIB制備的TEM樣品中的損傷結(jié)構(gòu)和厚度與已有研究結(jié)果相吻合。30keV FIB加工后TEM樣品中側(cè)壁損傷的厚度與先前的數(shù)據(jù)一致。Zeigler的注入模型幫助我們理解了鎵離子在硅基底上的損傷剖面,蒙特卡羅模擬計(jì)算結(jié)果與實(shí)驗(yàn)觀察結(jié)果相符。盡管FIB技術(shù)在TEM樣品制備中存在引入人工缺陷的挑戰(zhàn),但其在提高樣品制備精度和效率方面的優(yōu)勢(shì)使其成為材料表征不可或缺的工具。
-
fib
+關(guān)注
關(guān)注
1文章
98瀏覽量
11382 -
硅材料
+關(guān)注
關(guān)注
0文章
47瀏覽量
8261 -
離子束
+關(guān)注
關(guān)注
0文章
90瀏覽量
7775
發(fā)布評(píng)論請(qǐng)先 登錄
FIB聚焦離子束電路修改服務(wù)
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束應(yīng)用介紹
聚焦離子束技術(shù)介紹
一文帶你了解聚焦離子束(FIB)
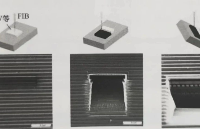
聚焦離子束顯微鏡(FIB):原理揭秘與應(yīng)用實(shí)例

聚焦離子束(FIB)技術(shù)原理和應(yīng)用

聚焦離子束技術(shù)在現(xiàn)代科技的應(yīng)用

聚焦離子束(FIB)技術(shù):微納加工的利器






 聚焦離子束(FIB)在加工硅材料的應(yīng)用
聚焦離子束(FIB)在加工硅材料的應(yīng)用
















評(píng)論