Dual Beam FIB-SEM技術
在現代材料科學的探索中,微觀世界的洞察力是推動技術進步的關鍵。隨著科技的不斷進步,分析儀器也在不斷升級,以滿足日益復雜的研究需求。其中,Dual Beam FIB-SEM(聚焦離子束-掃描電子顯微鏡雙束系統)以其獨特的多合一功能,成為材料科學領域不可或缺的利器。
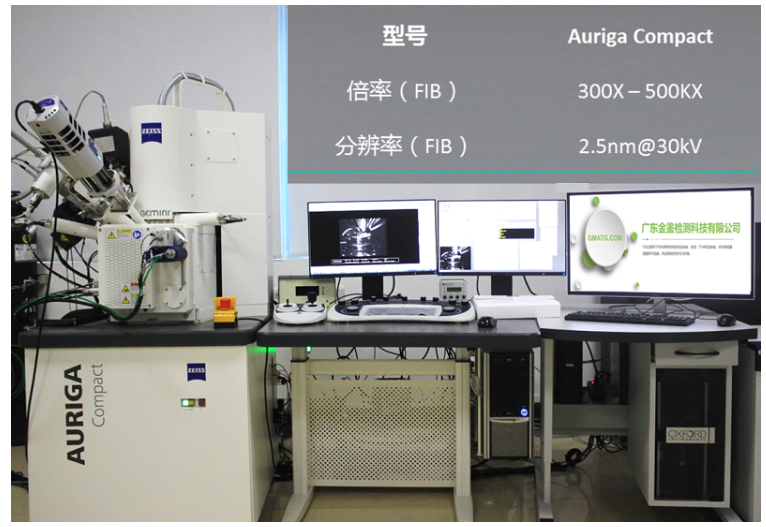
Dual Beam FIB-SEM系統的核心是將聚焦離子束(FIB)與掃描電子顯微鏡(SEM)完美耦合,并結合多種先進附件,形成一個多功能的分析平臺。
制樣技術與應用優勢
1.TEM樣品制備:高效與精準的結合
透射電鏡(TEM)樣品的制備一直是材料科學中的技術難點。傳統的電解雙噴和離子減薄方法雖然能夠制備出TEM樣品,但效率較低且難以實現定點加工。而FIB技術的引入,徹底改變了這一局面。通過Dual Beam FIB-SEM系統,研究人員可以在SEM的在線觀察下,快速、精準地制備高質量的TEM樣品。

FIB制樣過程分為三個階段:首先進行FIB粗加工,快速去除多余材料;然后利用納米操縱手將樣品轉移到合適位置;最后通過FIB精細加工完成最終制樣。整個過程不僅大大縮短了制樣時間,還提高了樣品的質量和重復性。這種高效的制樣方式,使得TEM分析能夠更快速地應用于材料微觀結構的研究。
2.材料微觀截面截取:揭示內部結構的奧秘
SEM雖然能夠提供材料表面的高分辨率圖像,但對于材料內部結構的觀察卻無能為力。而FIB的加入,使得研究人員能夠對材料進行縱向加工,從而觀察到材料內部的微觀形貌。通過對膜層內部厚度的監控以及對缺陷的失效分析,研究人員可以從根本上解決產品失效問題。
氣相沉積(GIS)
FIB GIS系統搭載的Pt氣體不僅能夠對樣品表面起到保護作用,還能根據其導電特性對樣品進行加工。在材料制備和分析過程中,GIS系統發揮著多種重要作用。

納米材料的電阻測量一直是一個技術難題。由于納米材料的尺寸極小,傳統的測量方法難以直接應用。而通過FIB GIS系統,研究人員可以在納米材料表面沉積Pt,將其連接到電極上,從而實現四探針法測量電阻。這種氣相沉積技術不僅解決了納米材料電阻測量的問題,還為其他類似材料的加工和測量提供了新的思路。
三維重構:微觀世界的立體呈現
FIB-SEM三維重構系統是該技術的又一亮點。通過FIB連續切出多個截面,再利用軟件將一系列二維圖像轉換為三維圖像,研究人員能夠以立體的方式觀察材料的微觀結構。
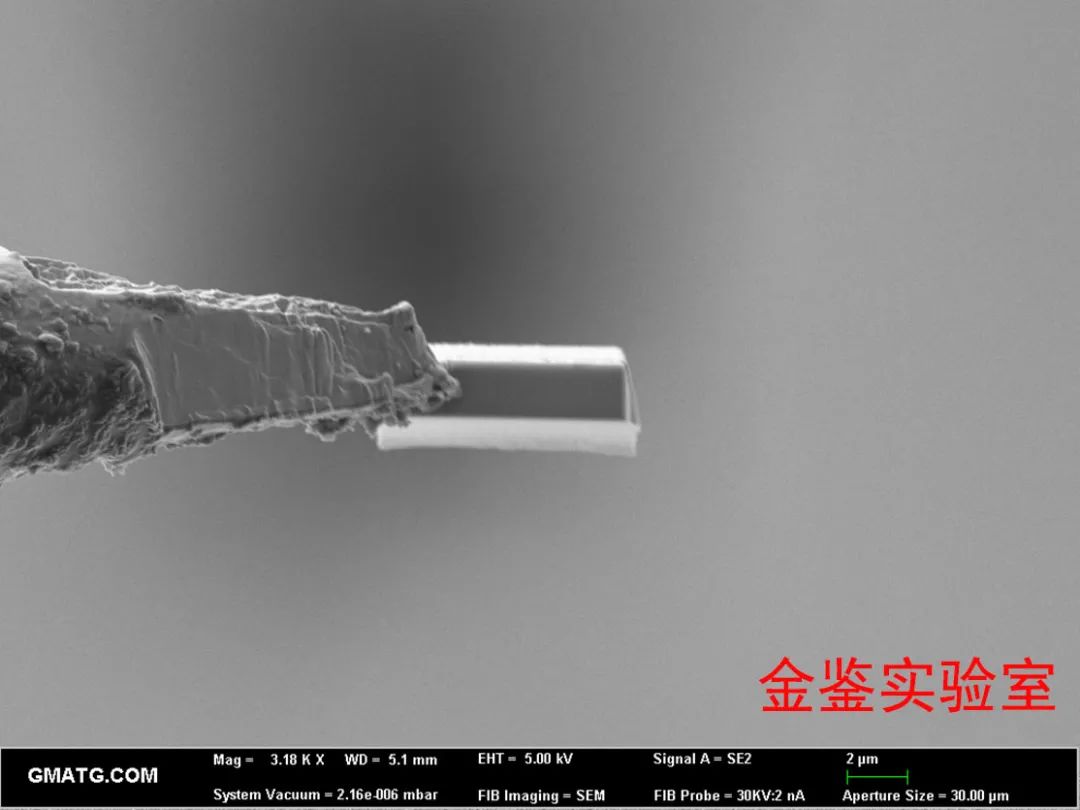
在材料科學的研究中,三維重構技術的應用范圍非常廣泛。例如,通過三維重構,研究人員可以觀察到材料內部的缺陷分布、晶粒形態以及相界面等微觀結構特征。這些信息對于材料的設計、優化和性能預測具有重要的指導意義。
跨領域應用的廣闊前景
Dual Beam FIB-SEM技術不僅在材料科學領域發揮著重要作用,其應用范圍還已經拓展至半導體行業、生命科學和地質學等多個領域。在半導體行業,FIB-SEM用于芯片制造過程中的缺陷檢測和修復;在生命科學領域,FIB-SEM能夠對生物組織進行高分辨率成像,為細胞結構和組織功能的研究提供有力支持;在地質學中,FIB-SEM可用于礦物成分分析和巖石微觀結構研究,幫助研究人員更好地理解地球的演化過程。隨著科技的不斷進步,Dual Beam FIB-SEM技術也在不斷發展和完善。未來,該技術有望在更多領域實現突破,為科學研究和工業應用提供更強大的支持。
總結
Dual Beam FIB-SEM技術以其集微區成像、加工、分析和操縱于一體的多功能性,成為材料科學領域的重要工具。通過高效的TEM樣品制備、微觀截面截取、氣相沉積以及三維重構等功能,該技術為材料的微觀結構研究提供了強大的支持。同時,其在多個領域的廣泛應用,也展示了其廣闊的發展前景。
-
SEM
+關注
關注
0文章
257瀏覽量
14849 -
fib
+關注
關注
1文章
97瀏覽量
11368 -
離子束
+關注
關注
0文章
89瀏覽量
7770
發布評論請先 登錄
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
當大范圍結構定點分析觀察 Dual-Beam FIB滿足不了時怎么辦?
聚焦離子束顯微鏡(FIB-SEM)
FIB-SEM雙束技術及應用介紹
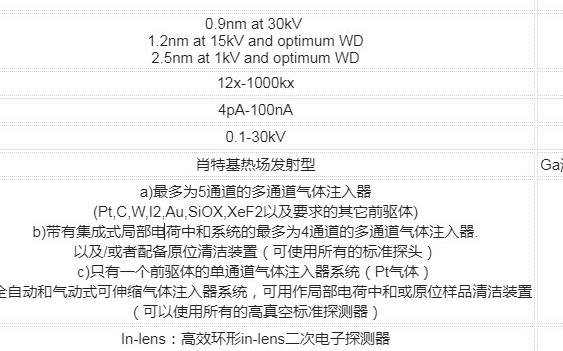
FIB-SEM雙束系統在材料科學領域的應用
聚焦離子束顯微鏡FIB-SEM的詳細介紹

FIB技術在印刷線路板PCB失效分析的應用
聚焦離子束掃描電鏡(FIB-SEM)技術原理、樣品制備要點及常見問題解答

雙束FIB-SEM系統在材料科學中的應用
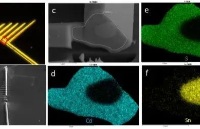
FIB-SEM技術全解析:原理與應用指南
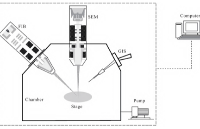
案例展示||FIB-SEM在材料科學領域的應用
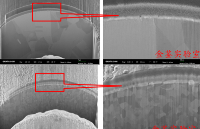
聚焦離子束顯微鏡(FIB-SEM)的應用領域
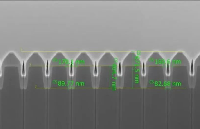





 Dual Beam FIB-SEM技術
Dual Beam FIB-SEM技術


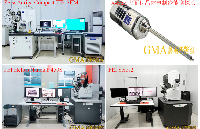











評論