為了補償光子不足,制造商可能會增加曝光劑量,這又會延長光刻過程中停留的時間。然而,這種做法直接影響了生產(chǎn)效率,使得整個過程變得更慢,經(jīng)濟性降低。此外,隨著幾何尺寸的縮小以適應更小的技術節(jié)點,對更高劑量的需求也加劇,從而造成了生產(chǎn)力的瓶頸。
DSA技術:一種革命性的方法
DSA技術通過利用嵌段共聚物的分子行為來解決EUV光刻面臨的挑戰(zhàn)。嵌段共聚物由兩個或多個化學性質(zhì)不同的聚合物鏈共價結(jié)合而成。當在特定條件下(如熱退火)處理時,這些聚合物會自發(fā)相分離成在基材上具有良好定義的納米結(jié)構(gòu),如線條或圓柱體。這種自組裝過程能夠創(chuàng)建具有最小線寬波動(LWR)和高度均勻特征尺寸的圖案,獨立于光刻工具分辨率的限制。
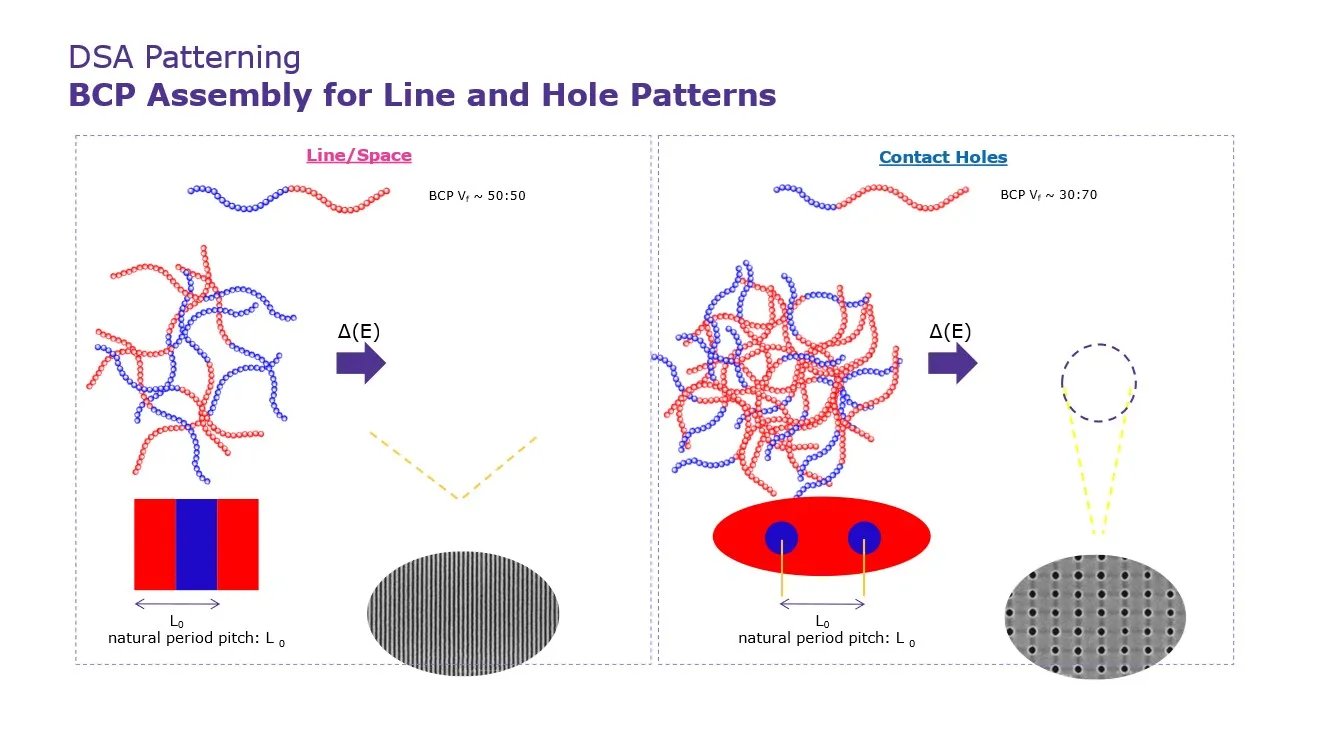
DSA技術的關鍵優(yōu)勢在于它能夠修正因EUV過程而產(chǎn)生的LWR和其他圖案缺陷。通過將DSA與EUV光刻相結(jié)合,制造商可以先使用傳統(tǒng)的EUV過程創(chuàng)建引導圖案,然后在圖案上涂覆嵌段共聚物。嵌段共聚物的自組裝能夠細化粗糙的圖案,生成高度均勻且變異性低的圖案,這些圖案可以轉(zhuǎn)移到硅片上。
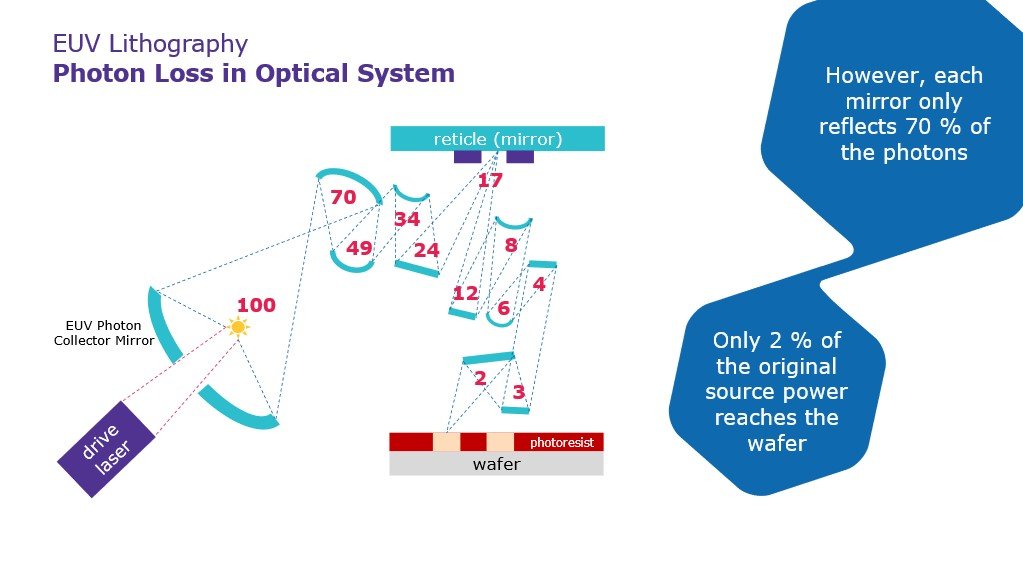
集成與工藝流程
將DSA集成到半導體制造過程中涉及幾個關鍵步驟:
硬掩模形成:該過程從沉積硬掩模層開始,通常采用氮化硅或氧化硅等材料制成。這個硬掩模為后續(xù)的圖案化步驟提供基礎。
使用EUV光刻進行引導圖案化:在硬掩模上使用EUV光刻創(chuàng)建引導圖案。盡管該圖案粗糙且存在LWR,但它作為DSA過程的模板。
嵌段共聚物涂覆和退火:然后,將嵌段共聚物涂覆到基材上。聚合物的選擇及其成分至關重要,因為它們決定了圖案的最終間距和特征尺寸。接著,基材經(jīng)過熱退火處理,促使嵌段共聚物自組裝成高度有序的結(jié)構(gòu)。
圖案修正:通過嵌段共聚物自組裝產(chǎn)生的圖案有效地“修正”了粗糙的EUV圖案,平滑LWR并產(chǎn)生最小缺陷的均勻圖案。
刻蝕和最終圖案轉(zhuǎn)移:經(jīng)過精細化的圖案通過一系列刻蝕步驟轉(zhuǎn)移到底下的硬掩模上,最終轉(zhuǎn)移到硅片中。硬掩模作為記憶層,允許在需要時進行進一步的圖案化步驟。
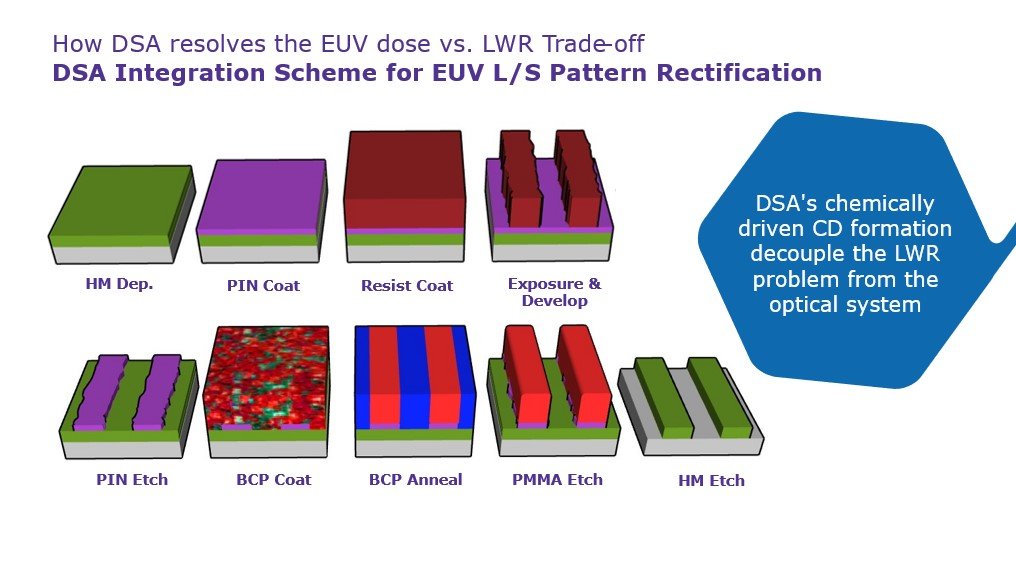
利益與前景
將DSA與EUV光刻結(jié)合應用帶來了幾個顯著的好處:
改善圖案質(zhì)量:DSA顯著減少了LWR,從而產(chǎn)生更高質(zhì)量的圖案,這對先進半導體器件的性能至關重要。
提高生產(chǎn)力:通過解決LWR和光子效率問題,而不需要增加曝光劑量,DSA提高了產(chǎn)出率,減少了生產(chǎn)時間,使得過程更具成本效益。
可擴展性:DSA無縫延續(xù)了摩爾定律,促進了更小特征尺寸的創(chuàng)建,而無需全新光刻工具。
互補技術:DSA并非旨在取代EUV光刻,而是作為補充,提供解決當前限制的方法,擴展其在未來技術節(jié)點的適用性。
DSA代表了克服EUV光刻所面臨障礙的關鍵進展。隨著半導體制造不斷推動微型化的邊界,將DSA與EUV光刻進行集成對于保持生產(chǎn)力、減少缺陷,以及推動下一代電子設備的發(fā)展至關重要。DSA技術的持續(xù)演進和完善有望進一步增強其能力,確保其作為先進半導體制造的基石的地位。
-
半導體
+關注
關注
335文章
28828瀏覽量
236191 -
DSA
+關注
關注
0文章
52瀏覽量
15534 -
EUV
+關注
關注
8文章
609瀏覽量
87139
發(fā)布評論請先 登錄





 DSA技術:突破EUV光刻瓶頸的革命性解決方案
DSA技術:突破EUV光刻瓶頸的革命性解決方案


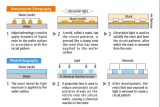










評論