文章來源:學習那些事
原文作者:小陳婆婆
本文介紹了什么是X射線光刻
隨著極紫外光刻(EUV)技術面臨光源功率和掩模缺陷挑戰(zhàn),X射線光刻技術憑借其固有優(yōu)勢,在特定領域正形成差異化競爭格局。
接近式X射線光刻
X射線光刻掩模版
投影式X射線光刻
接近式X射線光刻
X射線光刻作為下一代微納加工技術的關鍵方向,其核心優(yōu)勢在于利用波長僅1nm量級的X射線(能量范圍1~10 keV)實現(xiàn)超精細圖案化。
與傳統(tǒng)光學光刻不同,X射線的短波長特性使其衍射效應可忽略不計,理論上可突破光學衍射極限,為3nm及以下節(jié)點芯片制造提供解決方案。
一、X射線源技術體系
當前主流X射線源包含四大技術路線:
電子碰撞源(占比約70%應用)
原理:高能電子束轟擊鎢/鉬等難熔金屬靶材,通過內殼層電子躍遷產生特征X射線,同步伴隨韌致輻射形成連續(xù)譜
特點:設備成熟度高,但存在靶材熱負載問題(鎢熔點3422℃)
激光等離子體源
機制:高功率激光聚焦產生高溫等離子體(溫度達106 K),通過軔致輻射和線輻射復合產生X射線
優(yōu)勢:脈沖式輸出,峰值亮度可達1012W/cm2
放電等離子體源
結構:通過脈沖氣體放電形成Z箍縮等離子體,適用于大面積均勻輻射
應用場景:平板顯示器修復領域
同步加速器光源
特性:基于相對論電子在磁場中偏轉產生的同步輻射,具有高準直性和偏振特性
局限:設備體積龐大(北京同步輻射裝置周長240m),僅限實驗室使用
二、接近式X射線光刻系統(tǒng)架構
系統(tǒng)構成三要素:
輻射單元:電子碰撞源為核心組件,需配置鈹窗(厚度0.1-0.5mm)實現(xiàn)真空隔離
光路系統(tǒng):采用1:1成像架構,典型配置參數(shù)
工作距離D:1m(光闌至掩模間距)
間隙G:25μm(掩模與晶圓間距)
環(huán)境控制:充氦氣(壓力<100Pa)或真空腔體(<10-4Pa)
工件臺系統(tǒng)
步進式運動機構(精度±50nm)
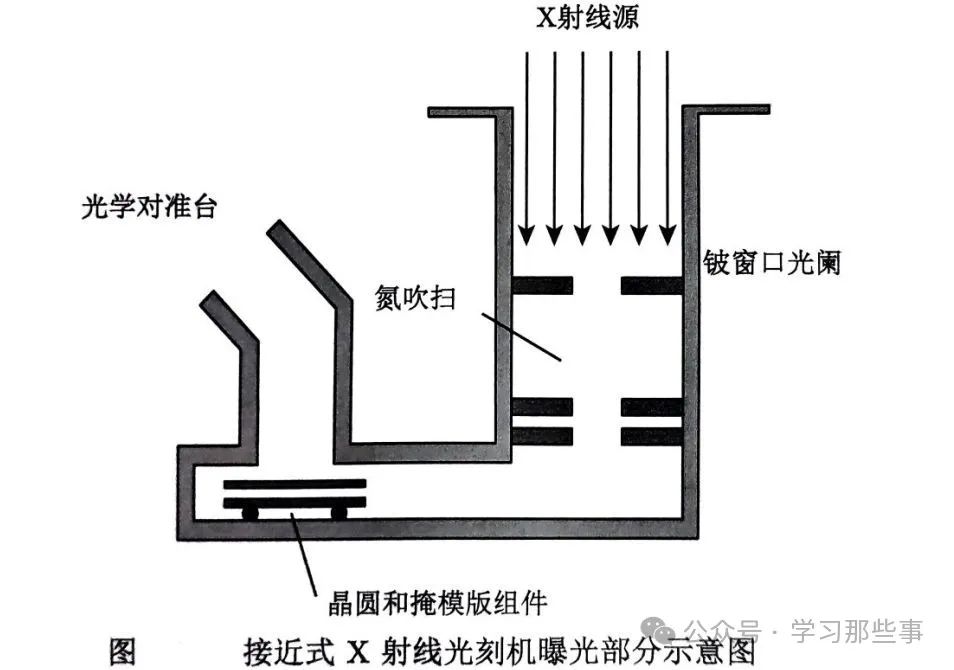
掩模-晶圓對準系統(tǒng)(采用莫爾條紋技術,對準精度<100nm)
三、接近式曝光工藝優(yōu)化
性能提升路徑
光源優(yōu)化:
采用多極磁聚焦電子槍,將電子束斑尺寸壓縮至50μm以下
實施脈沖式曝光(脈寬<1μs),降低熱負載效應
掩模技術突破
開發(fā)鉭基吸收體(Ta/TaN多層膜),實現(xiàn)20:1線寬比
應用應力補償層(SiNx/SiO2復合膜),控制膜層翹曲<5μm
環(huán)境控制創(chuàng)新
氦氣純度控制:H2O含量<1ppm,避免X射線吸收
振動隔離:采用主動阻尼平臺,振動幅值<0.1nm(1-100Hz)
四、行業(yè)應用展望
當前接近式X射線光刻系統(tǒng)已在以下領域實現(xiàn)產業(yè)化突破:
先進封裝:TSV轉接板加工(線寬/間距<1μm)
MEMS器件:加速度計彈簧結構制作(厚度變異<2%)
光子芯片:硅基波導刻蝕(側壁粗糙度<5nm)
X射線光刻掩模版
一、基底材料選擇:低Z元素薄膜的必然性
X射線光刻掩模版的基底材料選擇遵循獨特的光學定律:由于X射線穿透性與材料原子序數(shù)(Z值)呈負相關,低Z元素薄膜成為唯一可行方案。
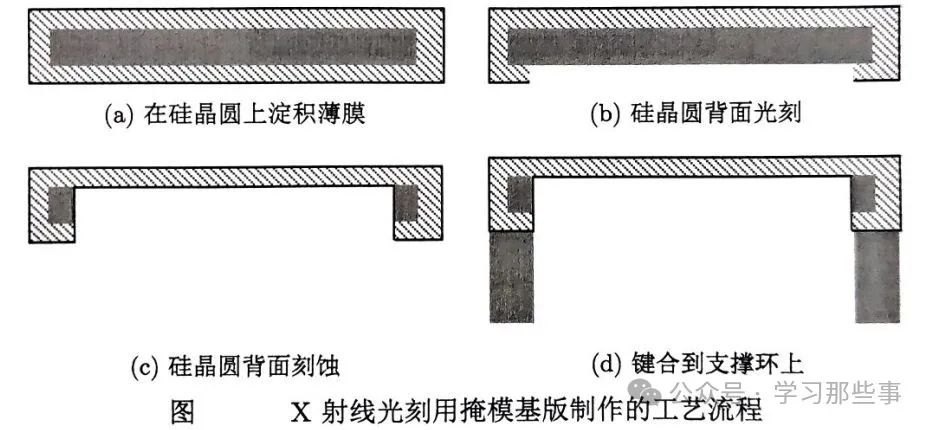
典型材料體系包含三大方向:
氮化硅(Si?N?)體系
優(yōu)勢:與硅基底工藝兼容性優(yōu)異,LPCVD制備溫度可控制在700-850℃
局限:硬度(HV≈15GPa)低于碳化硅,抗輻射劑量閾值約5×10? rad
碳化硅(SiC)體系
特性:硬度達HV≈28GPa,熱導率490 W/(m·K),在10 keV X射線處吸收系數(shù)僅0.03 cm?1
突破:采用化學氣相沉積(CVD)結合高溫石墨基座,實現(xiàn)單晶4H-SiC外延生長
金屬薄膜體系
鎢(W)方案:在5 keV處吸收系數(shù)0.35 cm?1,但熱膨脹系數(shù)(4.5×10??/K)與硅差異顯著
金(Au)方案:作為應急替代方案,需配合鈦(Ti)粘附層使用
二、吸收層薄膜制備工藝:應力控制的精密工程
吸收層薄膜制備的核心挑戰(zhàn)在于多層膜應力管理,典型工藝流程包含:
低壓化學氣相淀積(LPCVD)
參數(shù)優(yōu)化:在650℃下,通過調節(jié)SiH?/NH?比例(從1:3到1:10),實現(xiàn)薄膜壓應力從-200 MPa至+150 MPa的調控
創(chuàng)新技術:采用等離子體增強CVD(PECVD)在250℃低溫制備氮化硅,殘余應力控制在±50 MPa以內
摻雜選擇性刻蝕技術
實施步驟:在硅基底背面注入硼離子(能量150 keV,劑量5×101? cm?2),形成1μm厚的重摻雜層(電阻率<0.01 Ω·cm)
刻蝕優(yōu)勢:利用TMAH溶液(25wt%,80℃)實現(xiàn)硅與重摻雜層刻蝕速率比達400:1
三、掩模版制作工藝流程:雙工藝路徑解析
復雜工藝流程:

多層膜堆疊
基底:2μm LPCVD Si?N?/Si(100)
功能層:500nm Ta/Au(Ta 50nm粘附層,Au 450nm吸收層)
硬掩膜:200nm Cr
光刻膠:10μm AZP 1350(正膠)
圖形轉移關鍵步驟
反應離子刻蝕(RIE)參數(shù):CF?/O?=4:1,功率300W,壓強50mTorr,實現(xiàn)Cr:AZP選擇比>5:1
電鍍工藝:采用亞硫酸金鈉體系,電流密度0.5A/dm2,獲得純度99.99%的金圖形
簡化工藝流程
技術瓶頸:鎢刻蝕需解決CF?/SF?混合氣體對Si?N?基底的攻擊問題,當前最佳選擇比(W:Si?N?)僅15:1
突破方向:開發(fā)Cl?/BCl?基氣體組合,在100℃低溫下實現(xiàn)W:Si?N?選擇比提升至40:1
四、圖形畸變控制:多維誤差補償策略
四大畸變源及解決方案:
電子束直寫誤差
補償技術:采用鄰近效應校正(PEC)算法,結合蒙特卡洛模擬,將50kV電子束散射范圍控制在<30nm
壓緊不均勻性
機械優(yōu)化:采用氣浮式壓緊裝置,通過壓力反饋控制實現(xiàn)面內壓力波動<0.5%
薄膜應力失配
應力平衡設計:在吸收層下方引入50nm SiO?應力補償層,使總應力控制在±20 MPa以內
熱膨脹差異
材料配對:選擇熱膨脹系數(shù)匹配的Ta(6.3×10??/K)與Si(2.6×10??/K),通過金屬間化合物形成梯度過渡層
五、基底層減薄技術:透明度與機械強度的博弈
納米多孔硅技術
制備工藝:電化學陽極腐蝕形成孔隙率50%的多孔硅層,彈性模量從190GPa降至10GPa
強化措施:表面滲碳處理(1000℃,甲烷氣氛),形成3μm厚SiC保護層
復合支撐結構
結構設計:采用直徑200mm的石墨環(huán)支撐,配合鈦合金銷釘定位,實現(xiàn)基底有效厚度減至50μm
性能指標:在1g加速度下,面形精度(PV值)保持<50nm
六、行業(yè)應用與技術前沿
典型應用場景
先進封裝:2.5D轉接板TSV加工(孔徑<2μm,深寬比>10:1)
MEMS器件:諧振式壓力傳感器彈簧結構(線寬變異系數(shù)<1%)
光子集成電路:氮化硅波導刻蝕(側壁粗糙度Ra<2nm)
技術發(fā)展趨勢
極紫外兼容性:開發(fā)TaN/Ru多層膜,實現(xiàn)X射線/EUV雙模掩模版
智能掩模技術:集成壓電薄膜傳感器,實時監(jiān)測圖形變形量
自修復材料:探索形狀記憶合金基底,通過局部加熱實現(xiàn)亞微米級形變校正
X射線光刻掩模版技術正處于材料創(chuàng)新與工藝突破的交匯點,通過跨學科技術融合,正在開辟超越傳統(tǒng)光學光刻的新維度。隨著5nm以下節(jié)點技術的推進,掩模版技術將從單純圖形載體演變?yōu)橹悄芑墓饪滔到y(tǒng)核心組件。
投影式X射線光刻
一、系統(tǒng)架構與工作原理
投影式X射線光刻系統(tǒng)采用全反射式光學架構,其核心設計邏輯源于X射線與物質的相互作用特性。
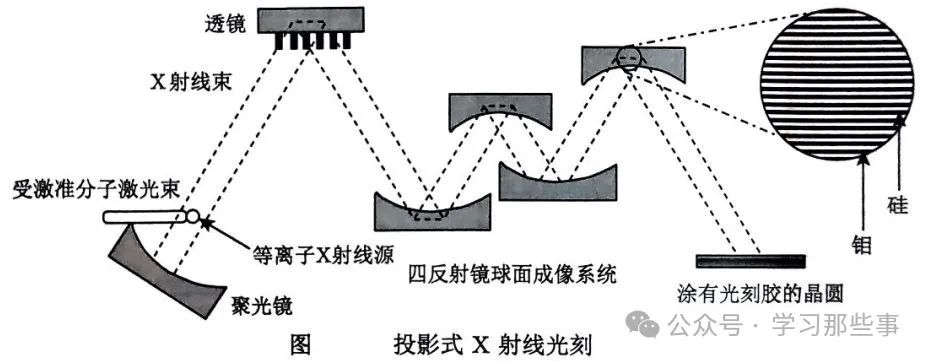
系統(tǒng)光路可分解為四大模塊:
等離子體X射線源
激發(fā)機制:采用受激準分子激光(如XeCl,308nm)轟擊液態(tài)錫靶,產生13.5nm波長的EUV輻射
脈沖特性:重復頻率50kHz,單脈沖能量達5mJ/cm2,實現(xiàn)125W平均功率輸出
聚光與照明系統(tǒng)
多層膜反射鏡:采用40對Mo/Si周期結構,每層厚度精確控制在6.9nm(Mo)和4.2nm(Si)
掠入射角設計:入射角控制在15°,實現(xiàn)X射線收集效率最大化
反射式掩模版
基底材料:采用熱導率優(yōu)異的超低膨脹玻璃(ULE,CTE<10??/K)
吸收層結構:60nm TaN薄膜(EUV波段吸收率>95%),表面粗糙度Ra<0.2nm
球面成像反射鏡組
四鏡系統(tǒng):采用Wolter型非球面設計,表面誤差PV值<0.5nm
數(shù)值孔徑:NA=0.3,實現(xiàn)0.1μm分辨率下的景深>1μm
二、反射鏡技術與材料科學突破
反射鏡性能是系統(tǒng)成像質量的關鍵制約因素,技術突破集中在:
多層膜沉積技術
磁控濺射工藝:在200mm直徑基底上實現(xiàn)Mo/Si周期厚度誤差<0.05nm
界面粗糙度控制:采用低溫沉積(<100℃),將層間擴散控制在<0.3nm
納米精度加工
應力補償技術:通過離子束拋光(IBF)實現(xiàn)面形精度PV<0.2nm
污染控制:在超潔凈室(ISO 1級)內組裝,碳氫化合物污染度<5000個/m3
熱管理方案
主動冷卻系統(tǒng):采用液氦循環(huán),將反射鏡溫度波動控制在±0.01℃
熱變形補償:通過有限元分析優(yōu)化支撐結構,實現(xiàn)熱膨脹抵消
三、光源技術與波長優(yōu)化
13.5nm波長的選擇基于三大物理優(yōu)勢:
反射率特性
Mo/Si多層膜在13.5nm處反射率達70%(單層界面),四鏡系統(tǒng)累積反射率>25%
相比5nm波長,反射率提升3倍,顯著降低光源功率需求
材料吸收特性
典型光刻膠(如PMMA)在13.5nm處吸收系數(shù)0.3μm?1,實現(xiàn)50:1的線寬比控制
掩模版吸收層厚度優(yōu)化至60nm,在保證吸收率的同時降低熱負載
等離子體產生效率
錫靶激光等離子體源在13.5nm波長處的轉換效率達2%
相比Xe氣體源,碎片產生率降低80%,延長反射鏡維護周期
四、掃描曝光與動態(tài)成像技術
系統(tǒng)采用雙掃描曝光模式實現(xiàn)大面積曝光:
同步掃描機制
掩模版與晶圓以1:1速度比反向掃描,速度精度控制在±0.1%
采用激光干涉儀(分辨率0.1nm)實現(xiàn)位置閉環(huán)控制
拼接精度控制
視場尺寸26mm×33mm,通過六自由度微動臺實現(xiàn)視場間重疊誤差<50nm
采用莫爾條紋技術,實現(xiàn)跨視場套刻精度<3nm
劑量控制算法
脈沖能量監(jiān)測:實時校正脈沖能量波動(目標值±0.5%)
灰度曝光技術:通過脈沖數(shù)量調制實現(xiàn)邊緣粗糙度(LER)<2nm
五、關鍵技術挑戰(zhàn)與突破方向
當前技術瓶頸及解決方案包括:
反射鏡壽命問題
錫污染控制:采用磁場約束等離子體,將錫沉積速率控制在<0.1nm/h
離子清洗技術:開發(fā)氬氣簇離子束(GCIB)清洗工藝,實現(xiàn)反射率恢復>95%
光源穩(wěn)定性
預脈沖技術:采用雙激光脈沖(預脈沖+主脈沖),將等離子體穩(wěn)定性提升至σ<1%
碎片過濾:設計三級碎片過濾系統(tǒng),關鍵光學元件污染周期延長至>10?脈沖
系統(tǒng)集成度
真空集成:采用差分真空系統(tǒng),實現(xiàn)光源區(qū)(10??Pa)與曝光區(qū)(10?3Pa)壓力隔離
熱隔離設計:通過熱屏蔽結構將光源熱負載對成像系統(tǒng)的影響控制在<0.1℃
六、行業(yè)應用與技術前瞻
投影式X射線光刻技術正在開辟三大應用前沿:
邏輯器件制造
3nm節(jié)點以下FinFET加工,實現(xiàn)接觸孔直徑<12nm
采用雙重曝光技術,突破單次曝光分辨率極限
存儲器技術
3D NAND垂直溝道刻蝕,層數(shù)突破500層
采用自對準多重成像(SAMP)技術,實現(xiàn)層間對準精度<5nm
異構集成
2.5D轉接板微凸點加工,間距<4μm
結合自組裝單分子層技術,實現(xiàn)銅互連電阻降低30%
未來技術發(fā)展將聚焦三大方向:
高NA系統(tǒng):開發(fā)NA=0.55系統(tǒng),實現(xiàn)8nm分辨率
光源創(chuàng)新:探索自由電子激光(FEL)光源,實現(xiàn)10kHz重復頻率
智能光刻:集成機器學習算法,實現(xiàn)實時像差校正與劑量優(yōu)化
-
工藝
+關注
關注
4文章
679瀏覽量
29374 -
X射線
+關注
關注
4文章
213瀏覽量
51859 -
光刻技術
+關注
關注
1文章
151瀏覽量
16166
原文標題:詳談X射線光刻
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
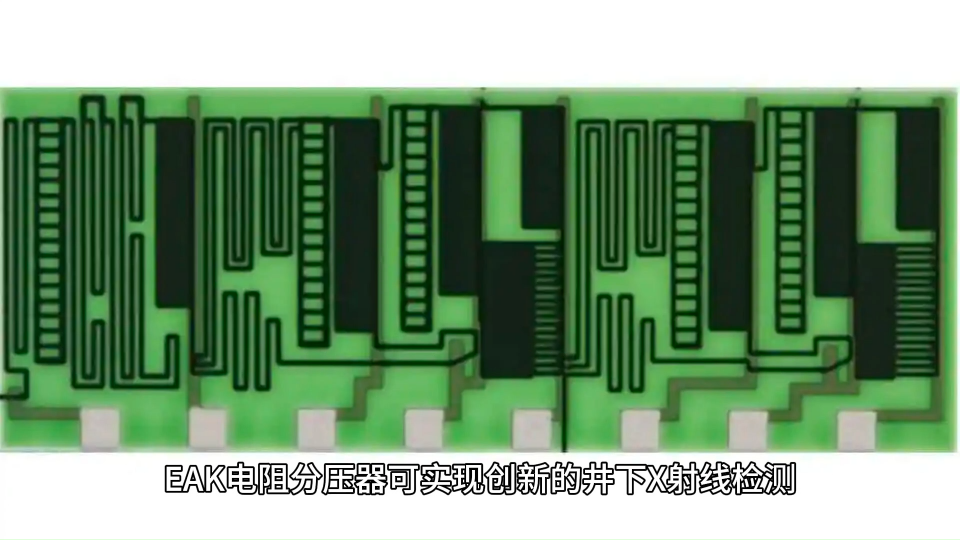
光刻技術原理及應用
數(shù)字X射線的發(fā)展歷史
俄羅斯簽署合同欲研發(fā)頂尖X射線光刻機
X射線光刻(X-ray lithography)技術是什么意思
通過X射線光刻在指尖大小的芯片中產生高精度微光學元件的晶圓級制造






 詳談X射線光刻技術
詳談X射線光刻技術



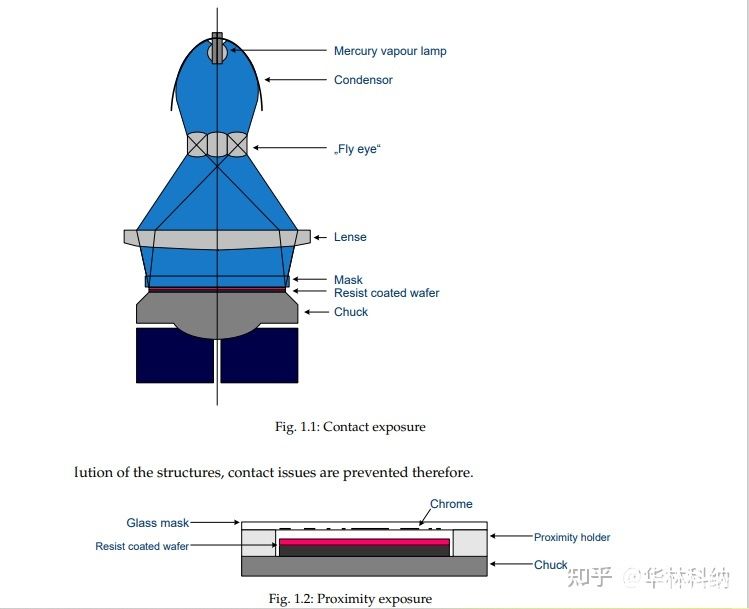










評論