MESFET 熱穩(wěn)定性較差、漏電流較大、邏輯擺幅較小、抗噪聲能力較弱。隨著頻率、功率容限以及低噪聲容限需求的增加,砷化鎵 MESFET已經(jīng)達(dá)到了其設(shè)計(jì)上的極限,因?yàn)闈M足這些需求需要更大的飽和電流和更大跨導(dǎo)的短溝道場(chǎng)效應(yīng)器件。一般可以通過(guò)增加溝道摻雜濃度來(lái)實(shí)現(xiàn)。由于溝道區(qū)是對(duì)體半導(dǎo)體材料的摻雜而形成的,多數(shù)載流子與電離的雜質(zhì)共同存在。多數(shù)載流子受電離雜質(zhì)散射,從而使載流子遷移率減小,器件性能降低。
早在1960年,IBM公司的 Anderson 就預(yù)言在異質(zhì)結(jié)界面將存在電子的累積。1969年,Easki 和Tsu提出在禁帶寬度不同的異質(zhì)結(jié)結(jié)構(gòu)中,離化的施主和自由電子是分離的。即,電子離開施主母體,由寬帶隙材料一側(cè)進(jìn)入窄帶隙材料一側(cè)。這種分離減少了母體對(duì)電子的庫(kù)侖作用,提高了電子遷移率。1978年,美國(guó)貝爾實(shí)驗(yàn)室的 Dingle 等人在調(diào)制摻雜的異質(zhì)材料中首次觀察到了載流子遷移率增高的現(xiàn)象。1980年,富士通公司的Hiyamize 等人率先采用這種結(jié)構(gòu),在調(diào)制摻雜 n-AIGaAs/GaAs 單異質(zhì)結(jié)結(jié)構(gòu)的實(shí)驗(yàn)中,證明了異質(zhì)界面二維電子氣(2DEG)的存在,而且具有很高的遷移率,成功研制出世界上第一只超高速邏輯器件—高電子遷移率晶體管(High Electron Mobility Transistor,HEMT)。
高電子遷移率晶體管(HEMT)這一術(shù)語(yǔ)也由富士通(Fujitsu)公司提出,它是一種異質(zhì)結(jié)場(chǎng)效應(yīng)晶體管(HFET),又稱為調(diào)制摻雜場(chǎng)效應(yīng)晶體管(MODFET)、二維電子氣場(chǎng)效應(yīng)晶體管(2-DEGFET)、選擇摻雜異質(zhì)結(jié)晶體管(SDHT)等。HEMT 器件利用半導(dǎo)體異質(zhì)結(jié)構(gòu)中電離雜質(zhì)與電子在空間能被分隔的優(yōu)點(diǎn),并由此產(chǎn)生具有很高遷移率的所謂二維電子氣來(lái)工作,能夠工作于超高頻(毫米波)、超高速領(lǐng)域。圖1.13 給出一 HEMT場(chǎng)效應(yīng)晶體管結(jié)構(gòu)示意圖以及器件能帶結(jié)構(gòu)圖 。
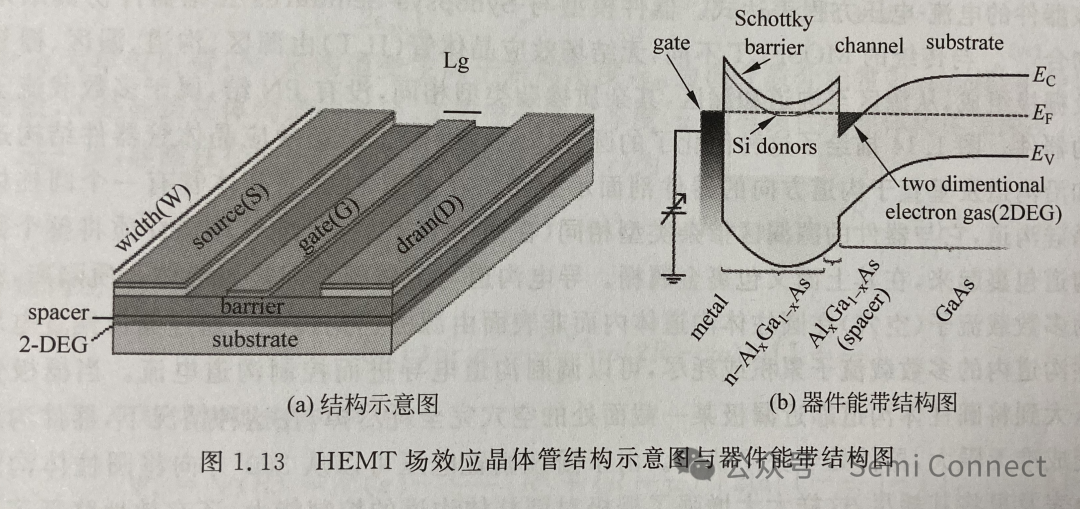
-
晶體管
+關(guān)注
關(guān)注
77文章
10004瀏覽量
141169
原文標(biāo)題:高電子遷移率晶體管
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
CGHV96050F1衛(wèi)星通信氮化鎵高電子遷移率晶體管CREE
CGHV40030氮化鎵(GaN)高電子遷移率晶體管
CGHV40030氮化鎵高電子遷移率晶體管
CMPA801B025F氮化鎵(GaN)高電子遷移率 基于晶體管
CGHV96100F2氮化鎵(GaN)高電子遷移率晶體管
CGH40010F氮化鎵(GaN)高 電子遷移率晶體管
FHX35X高電子遷移率晶體管銷售
FHX35X高電子遷移率晶體管(HEMT)
CGHV60040D-GP4高電子遷移率晶體管
CGHV1J025D-GP4高電子遷移率晶體管
CGH09120F GaN高電子遷移率晶體管的詳細(xì)數(shù)據(jù)手冊(cè)免費(fèi)下載

應(yīng)用于工程系統(tǒng)控制的GaN磁性高電子遷移率晶體管
一文詳細(xì)了解高電子遷移率晶體管
MXene范德華接觸在氮化鎵高電子遷移率晶體管中的應(yīng)用
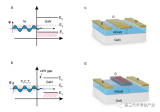





 高電子遷移率晶體管介紹
高電子遷移率晶體管介紹











評(píng)論