引言
在半導體制造與微納加工領域,光刻圖形線寬變化直接影響器件性能與集成度。精確控制光刻圖形線寬是保障工藝精度的關鍵。本文將介紹改善光刻圖形線寬變化的方法,并探討白光干涉儀在光刻圖形測量中的應用。
改善光刻圖形線寬變化的方法
優化曝光工藝參數
曝光是決定光刻圖形線寬的關鍵步驟。精確控制曝光劑量,可避免因曝光過度導致光刻膠過度反應,使線寬變寬;或曝光不足造成線寬變窄。采用先進的曝光設備,如極紫外(EUV)光刻機,利用其更短的波長減少光的衍射效應,提高曝光分辨率,從而降低線寬變化。同時,通過優化光源的均勻性,確保晶圓表面各處光刻膠接受的曝光劑量一致,減少線寬的不均勻性。
改進顯影工藝
顯影工藝對光刻圖形線寬有重要影響。選擇合適的顯影液濃度和顯影時間,可防止顯影不足或過度。顯影液濃度過高、時間過長,會導致光刻膠過度溶解,線寬變窄;反之,則會使線寬變寬。采用動態顯影技術,如噴霧顯影,可使顯影液更均勻地作用于光刻膠表面,提高顯影的一致性,有效改善線寬變化。此外,對顯影液的溫度進行精確控制,維持顯影過程的穩定性 。
控制工藝環境
工藝環境因素如溫度、濕度和潔凈度會影響光刻圖形線寬。保持恒定的溫度和濕度,避免光刻膠因環境變化發生膨脹或收縮,從而引起線寬波動。嚴格控制車間內的潔凈度,防止灰塵等顆粒污染物落在光刻膠表面,影響曝光和顯影效果,導致線寬異常。建立嚴格的環境監控系統,實時監測并調整環境參數 。
白光干涉儀在光刻圖形測量中的應用
測量原理
白光干涉儀基于白光干涉原理,通過對比參考光束與光刻圖形表面反射光束的光程差,將光強分布轉化為表面高度信息。由于白光包含多種波長,僅在光程差為零的位置形成清晰干涉條紋,利用這一特性,可實現納米級精度的光刻圖形形貌測量,精準獲取光刻圖形的線寬等關鍵尺寸信息 。
測量過程
將完成光刻工藝的樣品放置于白光干涉儀載物臺上,利用顯微鏡初步定位待測光刻圖形區域。精確調節干涉儀的光路參數,獲取清晰干涉條紋圖像。通過專業軟件對干涉圖像進行相位解包裹等處理,計算出光刻圖形的線寬、深度、側壁角度等關鍵參數,為評估光刻圖形質量提供數據支持 。
優勢
白光干涉儀采用非接觸式測量,避免對光刻圖形造成物理損傷,適用于脆弱的微小光刻結構檢測;具備快速測量能力,可實現對大量光刻圖形的批量檢測,滿足生產線高效檢測需求;其三維表面形貌可視化功能,便于工程師直觀觀察光刻圖形的質量狀況,快速定位線寬變化問題,及時調整光刻工藝參數 。
TopMap Micro View白光干涉3D輪廓儀
一款可以“實時”動態/靜態 微納級3D輪廓測量的白光干涉儀
1)一改傳統白光干涉操作復雜的問題,實現一鍵智能聚焦掃描,亞納米精度下實現卓越的重復性表現。
2)系統集成CST連續掃描技術,Z向測量范圍高達100mm,不受物鏡放大倍率的影響的高精度垂直分辨率,為復雜形貌測量提供全面解決方案。
3)可搭載多普勒激光測振系統,實現實現“動態”3D輪廓測量。

實際案例

1,優于1nm分辨率,輕松測量硅片表面粗糙度測量,Ra=0.7nm

2,毫米級視野,實現5nm-有機油膜厚度掃描
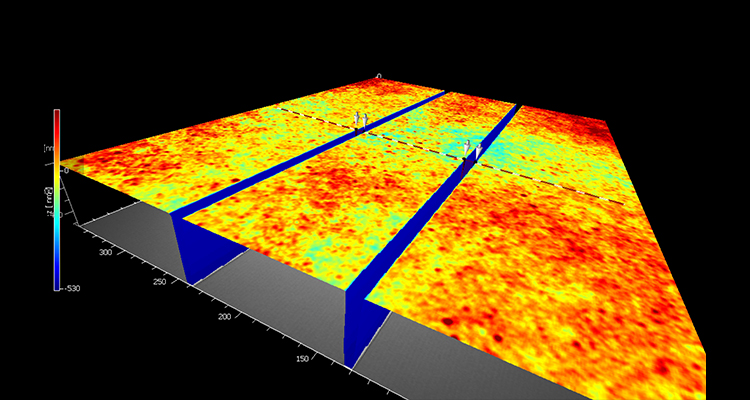
3,卓越的“高深寬比”測量能力,實現光刻圖形凹槽深度和開口寬度測量。
審核編輯 黃宇
-
光刻
+關注
關注
8文章
345瀏覽量
30645 -
干涉儀
+關注
關注
0文章
102瀏覽量
10369
發布評論請先 登錄
Micro OLED 陽極像素定義層制備方法及白光干涉儀在光刻圖形的測量






 改善光刻圖形線寬變化的方法及白光干涉儀在光刻圖形的測量
改善光刻圖形線寬變化的方法及白光干涉儀在光刻圖形的測量



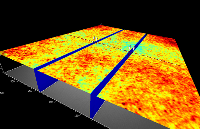











評論