聚焦離子束技術概述
聚焦離子束(Focused Ion Beam,FIB)技術是微納米尺度制造與分析領域的一項關鍵核心技術。其原理是利用靜電透鏡將離子源匯聚成極為精細的束斑,束斑直徑可精細至約5納米。
當這束高能離子束轟擊材料表面時,能夠在納米尺度上對材料實施剝離、沉積、注入、切割和改性等一系列操作。
FIB/SEM雙束系統加工過程
FIB/SEM雙束系統是聚焦離子束技術發展的一個重要里程碑。該系統將掃描電子顯微鏡(Scanning Electron Microscopy,SEM)與FIB系統耦合在一起,實現了離子束加工與電子束成像的同步進行。在工作過程中,樣品被放置在FIB和SEM的共軸高度處,這樣就能夠同時利用電子束進行高分辨率成像和離子束進行加工。通過樣品臺的靈活傾轉,還可以使樣品表面與電子束或離子束保持垂直,從而確保加工和成像的精確性。
當FIB離子束轟擊材料表面時,入射離子會在材料內部引發一系列復雜的散射過程。在這個過程中,離子不斷失去能量,最終停留在材料內部。離子損失的能量主要有兩個去向:一方面,通過與材料中的原子核發生碰撞,將部分能量傳遞給原子,使原子發生移位或者脫離材料表面,從而實現材料的刻蝕加工;
另一方面,將能量傳遞給原子核周圍的電子,激發這些電子產生二次電子,或者剝離原子核周圍的部分電子,使原子電離成離子,進而產生二次離子發射。這一過程不僅實現了材料的加工,還為后續的分析提供了重要的信號基礎。
FIB/SEM雙束系統應用領域
FIB/SEM雙束系統的應用領域極為廣泛,幾乎涵蓋了所有材料科學和微電子技術相關的領域。
在半導體材料領域,它可以用于芯片內部結構的定點觀測、故障分析以及集成電路的修改等關鍵環節。對于鋰電材料,能夠進行微觀結構的剖析和性能優化研究。金屬材料、陶瓷材料、光電材料以及高分子材料等眾多材料體系,都可以借助FIB/SEM雙束系統進行微觀結構的加工和性能分析。
此外,在離子注入、切割等微納加工工藝中,FIB/SEM雙束系統也發揮著不可或缺的作用,其高精度的加工能力為這些工藝的實現提供了有力支持。
FIB/SEM雙束系統分析案例
1.材料微觀截面截取與觀察
SEM僅能觀察材料表面信息,聚焦離子束的加入可以對材料縱向加工觀察材料內部形貌,通過對膜層內部厚度監控以及對缺陷失效分析改善產品工藝,從根部解決產品失效問題。
(1)FIB切割鍵合線
利用FIB對鍵合線進行截面制樣,不僅可以觀察到截面晶格形貌,還可掌控鍍層結構與厚度。
(2)FIB切割芯片金道
FIB-SEM產品工藝異常或調整后通過FIB獲取膜層剖面對各膜層檢查以及厚度的測量檢測工藝穩定性。
(3)FIB切割支架鍍層
利用FIB切割支架鍍層,避免了傳統切片模式導致的金屬延展、碎屑填充、厚度偏差大的弊端,高分辨率的電鏡下,鍍層晶格形貌、內部缺陷一覽無遺。FIB-SEM掃描電鏡下觀察支架鍍層截面形貌,鍍層界限明顯、結構及晶格形貌清晰,尺寸測量準確。此款支架在常規鍍鎳層上方鍍銅,普通制樣方法極其容易忽略此層結構,輕則造成判斷失誤,重則造成責任糾紛,經濟損失!
FIB-SEM掃描電鏡下觀察支架鍍層截面形貌。此款支架在鍍銅層下方鍍有約30納米的鎳層,在FIB-SEM下依然清晰可測!內部結構、基材或鍍層的晶格、鍍層缺陷清晰明了,給客戶和供應商解決爭論焦點,減少復測次數與支出。金鑒實驗室在進行試驗時,嚴格遵循相關標準操作,確保每一個測試環節都精準無誤地符合標準要求。
(4)FIB其他領域定點、圖形化切割
2.誘導沉積材料
利用電子束或離子束將金屬有機氣體化合物分解,從而可在樣品的特定區域進行材料沉積。本系統沉積的材料為Pt,沉積的圖形有點陣,直線等,利用系統沉積金屬材料的功能,可對器件電路進行相應的修改,更改電路功能。
聚焦離子束技術及其衍生的FIB/SEM雙束系統,以其獨特的加工和分析能力,在微納米尺度的科學研究和工業應用中發揮著越來越重要的作用。隨著技術的不斷進步和創新,其應用范圍還將進一步拓展,為人類探索微觀世界和推動科技發展提供更強大的工具支持。
-
聚焦
+關注
關注
0文章
14瀏覽量
8793 -
fib
+關注
關注
1文章
99瀏覽量
11405 -
離子束
+關注
關注
0文章
92瀏覽量
7788
發布評論請先 登錄





 聚焦離子束技術:微納米制造與分析的利器
聚焦離子束技術:微納米制造與分析的利器

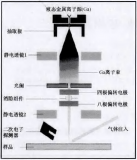
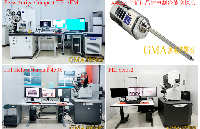
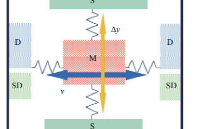




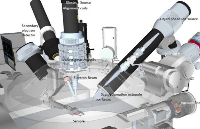



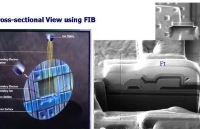










評論