一、BGA 的概述:
90 年代隨著集成技術(shù)的進(jìn)步、設(shè)備的改進(jìn)和深亞微米技術(shù)的使用,LSI、VLSI、ULSI相繼出現(xiàn),硅單芯片集成度不斷提高,對(duì)集成電路封裝要求更加嚴(yán)格,I/O 引腳數(shù)急劇增加,功耗也隨之增大。為滿足發(fā)展的需要,在原有封裝品種基礎(chǔ)上,又增添了新的品種——球柵陣列封裝,簡(jiǎn)稱 BGA(Ball Grid Array Package)。 設(shè)計(jì)工程師在設(shè)計(jì) BGA器件時(shí)將會(huì)面臨很多問(wèn)題,布局和布線設(shè)計(jì)的瓶頸、設(shè)計(jì)的工藝是否能與加工企業(yè)相互匹配、設(shè)計(jì) BGA 焊盤是否容易導(dǎo)致虛焊或容易短接、設(shè)計(jì)的規(guī)劃是否導(dǎo)致成本上漲等。
二、高密 BGA 器件的設(shè)計(jì)方法:
● BGA 封裝要求
● BGA 布局要求
● BGA 布線要求
● 0.5MM BGA 設(shè)計(jì)案例
三、BGA 焊盤大小設(shè)置:
焊盤直徑 = 焊點(diǎn)中心間距/2
例:BGA1.0mm PAD=0.5mm

四、BGA 焊盤阻焊設(shè)置:
BGA 焊盤阻焊直徑 = BGA 焊盤直徑+4mil
例如:焊盤=20mil 焊盤阻焊=24mil

五、BGA 過(guò)孔定義:
★通孔(through via):穿過(guò)整個(gè)線路板,可用于實(shí)現(xiàn)內(nèi)部互連或作為元件的安裝定位
孔。
★盲孔(blind via): 位于印刷線路板的頂層和底層表面,具有一定深度,用于表層線
路和下面的內(nèi)層線路的連接,孔的深度通常不超過(guò)一定的比率(孔徑)。
★埋孔(buried via): 位于印刷線路板內(nèi)層的連接孔,它不會(huì)延伸到線路板的表面。


六、孔銅厚度:國(guó)標(biāo)和 IPC 二級(jí) 孔銅厚在常規(guī) 20um 。
IPC 三級(jí)和軍品 孔銅 25um
使用時(shí)一般電流額降 30%-70%去評(píng)估,即 1.84A 保守按一個(gè)孔過(guò) 0.6A,評(píng)估不超過(guò) 1.3A。
關(guān)于過(guò)孔寄生電容這參數(shù),我個(gè)人認(rèn)為是過(guò)孔越小寄生電容越小,越適合用于高速信號(hào)。
七、BGA 過(guò)孔大小設(shè)置:
BGA 過(guò)孔焊盤直徑 = BGA 焊盤中心間距/2 BGA 過(guò)孔孔徑 = 過(guò)孔焊盤直徑/2
例:BGA1.27mm Via Pad = 24mil Via hole = 12mil
BGA1.0mm Via Pad = 20mil Via hole = 10mil
BGA0.8mm Via Pad = 16mil Via hole = 8mil
≤BGA0.5mm 需采用埋盲孔.
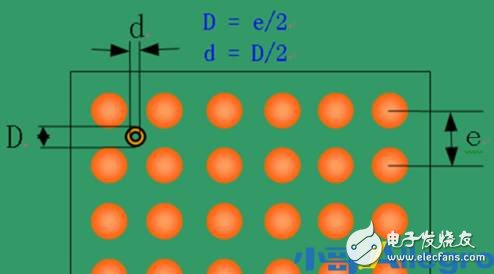
八、注意點(diǎn):
1, 過(guò)孔的高度(板厚)與孔徑比≤12:1
2, BGA 內(nèi)部過(guò)孔需要覆蓋綠油,切勿阻焊開(kāi)窗!


九、BGA 布局方面要求:
★為了使 BGA 更好的返修,BGA 四周 3MM 內(nèi)建議不要擺放元器件。
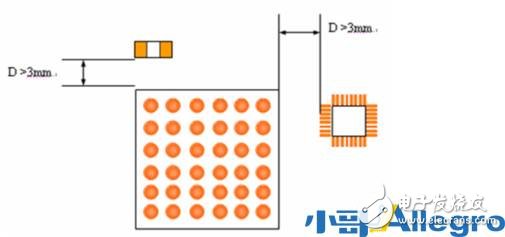
十、★一般情況下面 BGA 器件不建議放置背面;當(dāng)背面有 BGA 或面陣列器件時(shí),不能在
正面面陣列器件 3mm 禁布區(qū)的投影范圍內(nèi)。
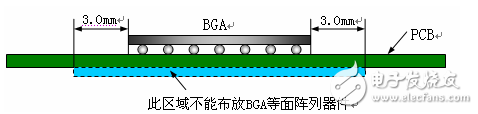
十一、 BGA 布局要求:
★ 為了使 BGA 電源濾波和儲(chǔ)能效果最佳,建議 BGA 四周各擺放 22uf 以上坦電容。


BGA 布線方面要求:
優(yōu)秀的 Fanout 特色:
? 能夠?yàn)椴季€提供更好的通道。
? 能夠防止割斷地/電源平面、保證通流能力。
? 能夠抑制 PI、EMC 等問(wèn)題的發(fā)生。
? 能夠更容易添加 ICT 測(cè)試點(diǎn),進(jìn)一步提高測(cè)試點(diǎn)的覆蓋率。
十二、BGA 布線基本要求:
? 將 BGA 由中心以十字劃分,VIA 分別朝左上、左下、右上、右下方向打。
? 線要保證在兩焊盤正中間引出,不要偏移某焊盤。
? 差分信號(hào)兩端需完全并行走線引入 BGA 管腳內(nèi)。
? BGA 內(nèi)過(guò)孔的反盤不易過(guò)大,否則影響電源銅箔通道面積。
? 以輻射型態(tài)向外拉出,避免在內(nèi)部回轉(zhuǎn)。
BGA Fanout 基本要求:?將 BGA 由中心以十字劃分,VIA 分別朝左上、左下、右上、
右下方向打.

?線要保證在兩焊盤正中間引出,不要偏移某焊盤。

?差分信號(hào)兩端完全并行走線引入 BGA 管腳內(nèi),盡量避免一對(duì)差分走各自通道進(jìn)入 BGA管腳內(nèi)。
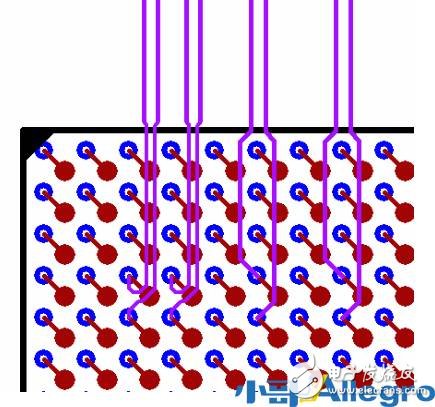

? BGA 內(nèi)過(guò)孔的反盤不易過(guò)大,否則影響電源銅箔通道面積。

?BGA 內(nèi)以輻射型態(tài)向外拉出,避免在內(nèi)部回轉(zhuǎn)。

?BGA Fanout 原則減少 BGA 內(nèi)過(guò)孔的個(gè)數(shù),盡可能將 BGA 四周向外的管腳通過(guò)表層走線進(jìn)行引出,越遠(yuǎn)越好。層面少的時(shí)候,最外圈盡量不要打過(guò)孔,向外引出!
-
芯片
+關(guān)注
關(guān)注
459文章
52331瀏覽量
438303 -
BGA
+關(guān)注
關(guān)注
5文章
570瀏覽量
48293 -
焊盤
+關(guān)注
關(guān)注
6文章
589瀏覽量
38763
原文標(biāo)題:iPhone 全球聯(lián)保?你需要知道這些真相
文章出處:【微信號(hào):ifanr,微信公眾號(hào):愛(ài)范兒】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
器件高密度BGA封裝設(shè)計(jì)
Altera器件高密度BGA封裝設(shè)計(jì)
高密度(HD)電路的設(shè)計(jì) (主指BGA封裝的布線設(shè)計(jì))
BGA器件如何走線、布線?

BGA焊盤脫落的補(bǔ)救方法
BGA封裝的缺陷問(wèn)題及其避免方法
通常的BGA器件如何走線?
BGA元器件移位頻發(fā)?這篇文章告訴你原因和處理方法!






 高密BGA器件的設(shè)計(jì)方法
高密BGA器件的設(shè)計(jì)方法












評(píng)論