隨著市場對芯片集成度要求的提高,I/O引腳數(shù)急劇增加,功耗也隨之增大,對集成電路封裝更加嚴格。為了滿足發(fā)展的需要,BGA封裝開始被應(yīng)用于生產(chǎn)。BGA也叫球狀引腳柵格陣列封裝技術(shù),它是一種高密度表面裝配封裝技術(shù)。在封裝底部,引腳都成球狀并排列成一個類似于格子的圖案,由此命名為BGA。
目前主板控制芯片組多采用此類封裝技術(shù),材料多為陶瓷。采用BGA技術(shù)封裝的內(nèi)存,可以使內(nèi)存在體積不變的情況下,內(nèi)存容量提高兩到三倍,BGA與TSOP相比,具有更小體積,更好的散熱性能和電性能。
兩種BGA封裝技術(shù)的特點
BGA封裝內(nèi)存:BGA封裝的I/O端子以圓形或柱狀焊點按陣列形式分布在封裝下面,BGA技術(shù)的優(yōu)點是I/O引腳數(shù)雖然增加了,但引腳間距并沒有減小反而增加了,從而提高了組裝成品率;雖然它的功耗增加,但BGA能用可控塌陷芯片法焊接,從而可以改善它的電熱性能;厚度和重量都較以前的封裝技術(shù)有所減少;寄生參數(shù)減小,信號傳輸延遲小,使用頻率大大提高;組裝可用共面焊接,可靠性高。
TinyBGA封裝內(nèi)存:采用TinyBGA封裝技術(shù)的內(nèi)存產(chǎn)品在相同容量情況下體積只有TSOP封裝的1/3。TSOP封裝內(nèi)存的引腳是由芯片四周引出的,而TinyBGA則是由芯片中心方向引出。這種方式有效地縮短了信號的傳導(dǎo)距離,信號傳輸線的長度僅是傳統(tǒng)的TSOP技術(shù)的1/4,因此信號的衰減也隨之減少。這樣不僅大幅提升了芯片的抗干擾、抗噪性能,而且提高了電性能。
基板或中間層是BGA封裝中非常重要的部分,除了用于互連布線以外,還可用于阻抗控制及用于電感/電阻/電容的集成。因此要求基板材料具有高的玻璃轉(zhuǎn)化溫度rS(約為175~230℃)、高的尺寸穩(wěn)定性和低的吸潮性,具有較好的電氣性能和高可靠性。金屬薄膜、絕緣層和基板介質(zhì)間還要具有較高的粘附性能。
三大BGA封裝工藝及流程
一、引線鍵合PBGA的封裝工藝流程
1、PBGA基板的制備
在BT樹脂/玻璃芯板的兩面層壓極薄(12~18μm厚)的銅箔,然后進行鉆孔和通孔金屬化。用常規(guī)的PCB加3232藝在基板的兩面制作出圖形,如導(dǎo)帶、電極、及安裝焊料球的焊區(qū)陣列。然后加上焊料掩膜并制作出圖形,露出電極和焊區(qū)。為提高生產(chǎn)效率,一條基片上通常含有多個PBG基板。
2、封裝工藝流程
圓片減薄→圓片切削→芯片粘結(jié)→等離子清洗→引線鍵合→等離子清洗→模塑封裝→裝配焊料球→回流焊→表面打標→分離→最終檢查→測試斗包裝。
二、FC-CBGA的封裝工藝流程
1、陶瓷基板
FC-CBGA的基板是多層陶瓷基板,它的制作是相當困難的。因為基板的布線密度高、間距窄、通孔也多,以及基板的共面性要求較高等。它的主要過程是:先將多層陶瓷片高溫共燒成多層陶瓷金屬化基片,再在基片上制作多層金屬布線,然后進行電鍍等。在CBGA的組裝中,基板與芯片、PCB板的CTE失配是造成CBGA產(chǎn)品失效的主要因素。要改善這一情況,除采用CCGA結(jié)構(gòu)外,還可使用另外一種陶瓷基板--HITCE陶瓷基板。
2、封裝工藝流程
圓片凸點的制備->圓片切割->芯片倒裝及回流焊->底部填充導(dǎo)熱脂、密封焊料的分配->封蓋->裝配焊料球->回流焊->打標->分離->最終檢查->測試->包裝。
三、引線鍵合TBGA的封裝工藝流程
1、TBGA載帶
TBGA的載帶通常是由聚酰亞胺材料制成的。在制作時,先在載帶的兩面進行覆銅,然后鍍鎳和鍍金,接著沖通孔和通孔金屬化及制作出圖形。因為在這種引線鍵合TBGA中,封裝熱沉又是封裝的加固體,也是管殼的芯腔基底,因此在封裝前先要使用壓敏粘結(jié)劑將載帶粘結(jié)在熱沉上。
2、封裝工藝流程
圓片減薄→圓片切割→芯片粘結(jié)→清洗→引線鍵合→等離子清洗→液態(tài)密封劑灌封→裝配焊料球→回流焊→表面打標→分離→最終檢查→測試→包裝。
BGA封裝流行的主要原因是由于它的優(yōu)勢明顯,封裝密度、電性能和成本上的獨特優(yōu)點讓其取代傳統(tǒng)封裝方式。隨著時間的推移,BGA封裝會有越來越多的改進,性價比將得到進一步的提高,BGA封裝有靈活性和優(yōu)異的性能,未來前景廣闊。
-
芯片
+關(guān)注
關(guān)注
459文章
52343瀏覽量
438438 -
IO
+關(guān)注
關(guān)注
0文章
490瀏覽量
40339 -
BGA
+關(guān)注
關(guān)注
5文章
570瀏覽量
48310
原文標題:一文讀懂BGA封裝技術(shù)的特點和工藝
文章出處:【微信號:bandaotiguancha,微信公眾號:半導(dǎo)體觀察IC】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
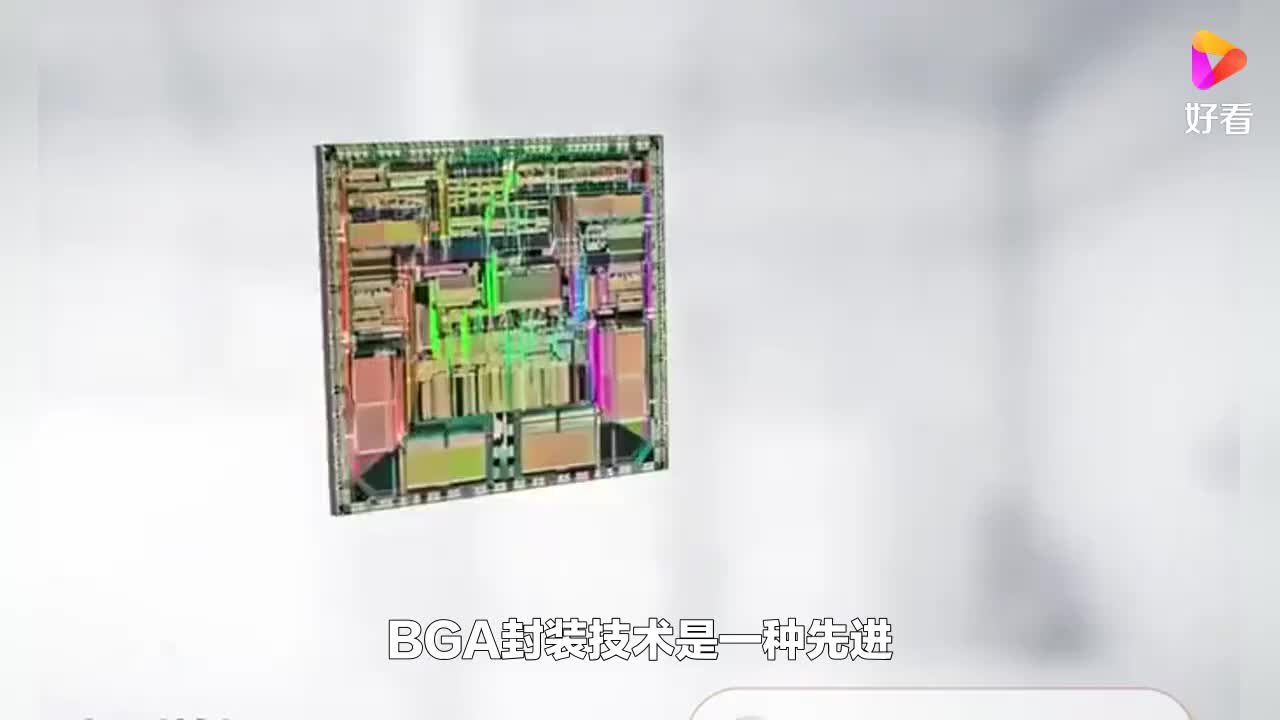
BGA——一種封裝技術(shù)
【轉(zhuǎn)帖】一文讀懂BGA封裝技術(shù)的特點和工藝
BGA封裝是什么?BGA封裝技術(shù)特點有哪些?
表面貼片BGA封裝,表面貼片BGA封裝是什么意思
BGA的封裝工藝流程基本知識簡介
BGA封裝技術(shù)及BGA元件焊點問題簡介
BGA組裝有哪些工藝特點,常見的不良現(xiàn)象有哪些
bga封裝是什么意思 BGA封裝形式解讀
什么是bga封裝 bga封裝工藝流程

常見的BGA混裝工藝誤區(qū)分享






 BGA是什么?BGA封裝技術(shù)有什么特點?三大BGA封裝工藝及流程介紹
BGA是什么?BGA封裝技術(shù)有什么特點?三大BGA封裝工藝及流程介紹












評論