底部填充膠簡單來說就是底部填充用的膠水,以主要成份為環氧樹脂的膠水對BGA 封裝模式的芯片進行底部填充,利用加熱的固化形式,將BGA芯片底部空隙大面積 (一般覆蓋80%以上)填滿,從而達到加固芯片的目的,進而增強芯片和PCBA 之間的抗跌落性能。
那么為什么使用底部填充膠呢?底部填充膠對SMT(電子電路表面組裝技術)元件(如:BGA、CSA芯片等)裝配的長期可靠性有了一定的保障性;還能很好的減少焊接點的應力,將應力均勻分散在芯片的界面上,在芯片錫球陣列中,底部填充膠能有效的減少焊錫點本身(即結構內的薄弱點)因為熱膨脹系數不同而發生的應力沖擊。此外,底部填充膠膠水還能防止潮濕和其它形式的污染。
AVENTK 1122系列底部填充膠
AVENTK 1122是一種單組份、改性環氧樹脂體系膠黏劑,主要設計用于BGA、CSP和Flip chip底部填充制程。這款膠水能形成一種無缺陷的底部填充層,能有效降低硅芯片與基板之間的總體溫度膨脹特性不匹配或外力造成的沖擊,緩震性能佳。這款膠水的主要有以下特點:
1.高可靠性,良好的耐熱性和抗機械沖擊性;
2.黏度低,流動快,PCB不需預熱;
3.固化前后顏色不一樣,方便檢驗;
4.固化時間短,可大批量生產;
5.翻修性好,減少不良率。
6.環保,符合無鉛要求。
AVENTK 1122 系列底部填充膠在滿足以上優勢的同時,滿足行業內客戶需求,能夠針對實際應用需求調整膠水配方,提供從粘接到固化的一站式解決方案。目前,AVENTK 1122系列底部填充膠已廣泛應用于CSP/BGA的底部填充以及MP3、USB、手機、籃牙等手提電子產品的線路板組裝等領域。
審核編輯 黃宇
-
芯片
+關注
關注
459文章
52355瀏覽量
438752 -
smt
+關注
關注
43文章
3026瀏覽量
71705
發布評論請先 登錄
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利

漢思新材料HS711板卡級芯片底部填充封裝膠

芯片底部填充膠填充不飽滿或滲透困難原因分析及解決方案

漢思新材料:車規級芯片底部填充膠守護你的智能汽車

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程

底部填充工藝在倒裝芯片上的應用

詳解點膠工藝用途和具體要求?
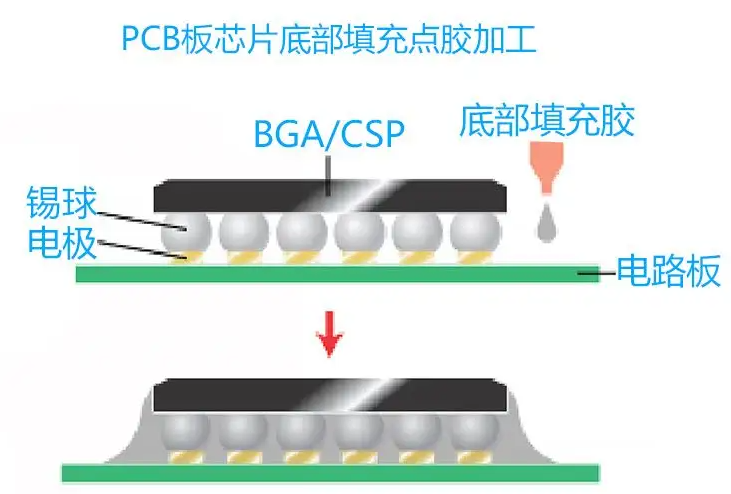





 AVENTK底部填充膠有什么優勢特點和應用?
AVENTK底部填充膠有什么優勢特點和應用?


















評論