最近,華為技術有限公司新增了多項專利信息。其中一項專利名稱為“芯片堆疊結構及其形成方法、芯片封裝結構、電子設備”,公開號碼為cn116504752a。
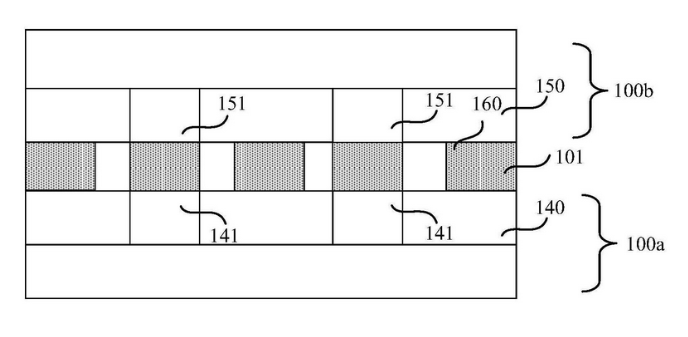
芯片技術領域的應用概要,用于簡化芯片堆疊結構及其形成方法、芯片封裝結構、電子設備、芯片堆棧結構的制造技術。該芯片的堆疊結構至少包括兩個堆疊的芯片,每一個芯片包括電線層,電線層設有電具組。其中至少有兩個芯片:堆疊的第一個芯片與第二個芯片,第一個芯片與第二個芯片之間通過耦合層電連接。結合層包括第1區,圍繞第1區的第2區,第1區和第2區以外的第3區。結合層的第一區域,第一芯片層的投影法和第一芯片層的前工具結構至少部分一致。金屬相層設置在第一,第三區域。
說明書中提到,它將用于簡化芯片堆疊結構及其形成方法、芯片封裝結構、電子設備技術和芯片堆棧結構的制造技術。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
封裝
+關注
關注
128文章
8636瀏覽量
145296 -
芯片技術
+關注
關注
1文章
163瀏覽量
18065 -
堆疊
+關注
關注
0文章
37瀏覽量
16853 -
芯片封裝
+關注
關注
11文章
576瀏覽量
31410
發布評論請先 登錄
相關推薦
熱點推薦
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利2025年4月30日消息,國家知識產權局信息顯示,深圳市漢思新材料科技有限公司取

TSV三維堆疊芯片的可靠性問題
TSV 三維封裝技術特點鮮明、性能好、前景廣闊, 是未來發展方向,但是 TSV 堆疊芯片這種結構和工 藝復雜性的提高,為三維封裝的可靠性控制
華進半導體榮獲中國專利優秀獎
近日,國家知識產權局正式發布第二十五屆中國專利獎評選通知,華進半導體一項名為“CN202010426007.5一種晶圓級芯片結構多芯片堆疊互
小鵬汽車公布人形機器人腿部結構創新專利
近日,廣州小鵬汽車科技有限公司在人工智能領域再次邁出重要一步,其申請的“腿部結構及人形機器人”專利正式公布。這一專利的公布,標志著小鵬汽車在
流場調控導熱微結構取向:三維堆疊芯片高效散熱新方案
熱源,如何實現熱源間的定點、定向導熱,一直是挑戰性難題。 02 成果掠影 近期,華中科技大學熱封裝實驗室團隊提出了一種通過三維流場對導熱微結構在復合材料中的空間排列與取向進行調控的方法,實現了三維導熱微



最新公布!華為新專利,腦機接口芯片曝光...大腦設備直接通信?? #芯片 #華為 #HGSEMI_華冠半導體
芯片半導體器件
HGSEMI_華冠半導體
發布于 :2024年10月19日 16:50:40

存儲器芯片的內部結構及其引腳類型
存儲器芯片是計算機和其他電子設備中用于存儲數據的關鍵組件。它們可以是易失性的,如動態隨機存取存儲器(DRAM)和靜態隨機存取存儲器(SRAM),也可以是非易失性的,如閃存(Flash)。存儲器芯片
LDO芯片的拓撲結構
LDO(Low Dropout Regulator)芯片,即低壓差線性穩壓器芯片,是一種用于電源穩壓的集成電路芯片。其拓撲結構是理解其工作原理和性能特點的基礎。

LED芯片的三種封裝結構
LED正裝芯片是最早出現的芯片結構,該結果中從上至下依次為:電極、P型半導體層、發光層、N型半導體層和襯底,該結構中PN結處產生的熱量需要經過藍寶石襯底才能傳導到熱沉,藍寶石襯底較差的
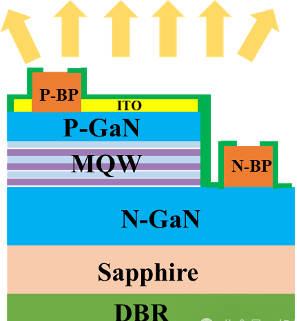





 華為公布“芯片堆疊結構及其形成方法、芯片封裝結構、電子設備”專利
華為公布“芯片堆疊結構及其形成方法、芯片封裝結構、電子設備”專利













評論