目前,陶瓷封裝雖然在整個封裝行業(yè)中所占比例較小,但卻是一種性能比較齊全的封裝方式。近年來,智能汽車、物聯(lián)網(wǎng)、無人機、數(shù)據(jù)中心等領域發(fā)展迅速。陶瓷封裝外殼廣泛應用于通訊、工業(yè)激光器、消費電子、汽車電子等領域。可以滿足智能汽車、物聯(lián)網(wǎng)、無人機市場、虛擬現(xiàn)實(VR)等新興領域的發(fā)展。他們要求嚴格且具有前瞻性。
陶瓷封裝外殼的主要結構包括多層陶瓷基體、金屬環(huán)框、封裝蓋板、引線框架、散熱底板等。多層陶瓷外殼制造技術包括原材料制備、流延、沖孔腔、金屬印刷、層壓、熱切、燒結、鍍鎳、釬焊、鍍金等技術;包裝過程包括外殼清洗、安裝、清洗、引線鍵合、蓋、外引線處理、標記、檢測等。所涉及的材料包括:氧化鋁、氮化鋁等陶瓷粉,以及匹配的金屬漿料(鎢漿、鉬錳漿)、可伐合金、焊料、熱沉等
陶瓷封裝管殼制造工藝復雜,技術門檻高,目前高端電子陶瓷外殼市場主要被日本等國外企業(yè)占有,我國高端電子陶瓷外殼多依賴進口。近年來國內(nèi)企業(yè)奮起直追,發(fā)展迅速,但是在生產(chǎn)規(guī)模、技術水平等方面仍然與國外大廠商差距明顯。
展至科技產(chǎn)品在配合高導熱的陶瓷基體,DPC顯著提高了散熱效率,在適合高功率、小尺寸LED發(fā)展需求的產(chǎn)品。而陶瓷散熱基板具有新的導熱材料和新的內(nèi)部結構,并且彌補了鋁金屬基板所具有的缺陷,從而改善基板的整體散熱效果。
合格的電子封裝材料需要擁有的性能要求有哪些?
(1)低的熱膨脹系數(shù)
(2)優(yōu)異的導熱性能
(3)良好的氣密性,可抵御高溫、高濕、腐蝕輻射等極端環(huán)境對電子器件的影響
(4)高強度和高剛度,可對內(nèi)里芯片起到支撐保護作用
(5)良好的加工成型和焊接性能,以便加工成復雜形狀
(6)在航空航天和其他便攜式電子器件的應用中,電子封裝材料應具有密度小的特性,以便減輕器件重量。
【文章來源】:展至科技
-
封裝
+關注
關注
128文章
8630瀏覽量
145246 -
電子封裝
+關注
關注
0文章
84瀏覽量
11104 -
散熱陶瓷
+關注
關注
0文章
4瀏覽量
7226 -
陶瓷基板
+關注
關注
5文章
241瀏覽量
11807
發(fā)布評論請先 登錄
PEEK注塑電子封裝基板的創(chuàng)新應用方案
電子封裝中的高導熱平面陶瓷基板及金屬化技術研究

紫宸激光焊錫機助力陶瓷基板焊接,推動電子行業(yè)發(fā)展
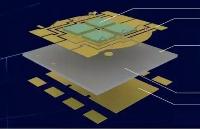
精密劃片機在切割陶瓷基板中有哪些應用場景
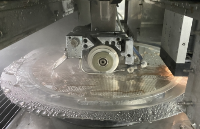
為什么選擇DPC覆銅陶瓷基板?
陶瓷基板五大工藝技術深度剖析:DPC、AMB、DBC、HTCC與LTCC的卓越表現(xiàn)

DPC、AMB、DBC覆銅陶瓷基板技術對比與應用選擇

封裝基板設計的詳細步驟
氮化鋁陶瓷基板:高性能電子封裝材料解析
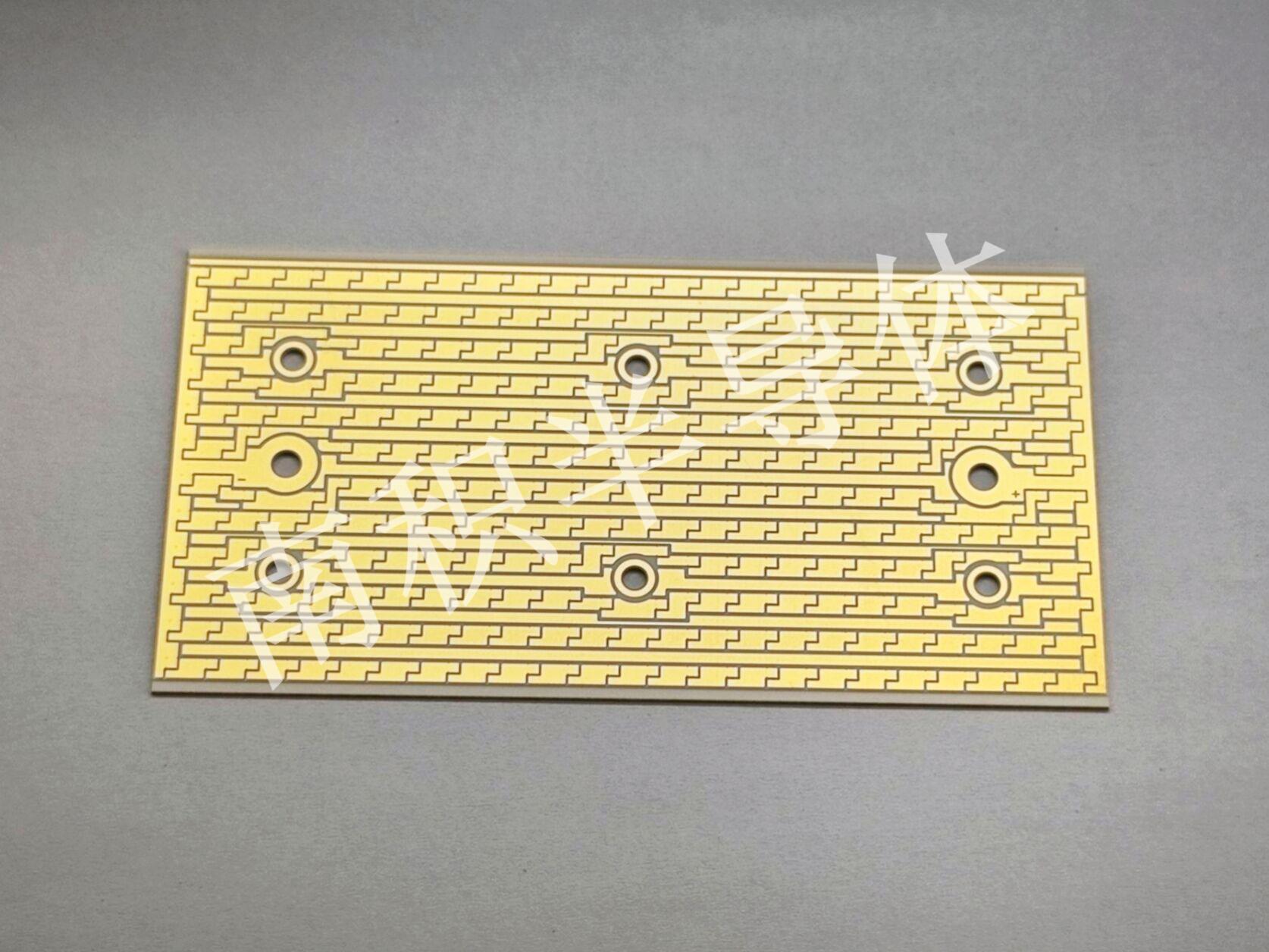
DOH技術工藝方案解決陶瓷基板DBC散熱挑戰(zhàn)問題






 合格的陶瓷基板在封裝行業(yè)要有什么性能
合格的陶瓷基板在封裝行業(yè)要有什么性能

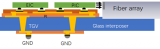












評論