近日,第九屆國際第三代半導體論壇(IFWS)&第二十屆中國國際半導體照明論壇(SSLCHINA)于廈門召開。期間,“氮化鎵功率電子器件技術(shù)分論壇”上,臺灣元智大學前副校長、臺灣成功大學特聘教授李清庭做了“GaN基單片電子器件的集成互補金屬氧化物半導體D模和E模高電子遷移率晶體管”的主題報告。
報告分享了光電化學蝕刻法和氧化物法,D模和E模GaN基MOSHEMT的制備工藝,采用LiNbO3鐵電柵極氧化物層的D模和E模MOSHEMT集成的單片反相器,采用LiNbO3/HfO2/Al2O3鐵電電荷陷阱柵堆疊結(jié)構(gòu)的D模和E模MOSHEMT集成的單片反相器等相關(guān)研究進展。
研究采用PEC氧化法在低界面態(tài)密度的AlGaN表面直接生長氧化膜,制備出高性能MOS器件。研究顯示,氧化的AlGaN膜與AlGaN接觸時具有低界面態(tài)密度。對于柵極凹陷的MOS HEMT,直流性能得到改善,關(guān)態(tài)擊穿電壓大于100V,Hooge’s系數(shù)約為10-4,PEC方法可以產(chǎn)生無損傷表面的澆口凹陷過程。

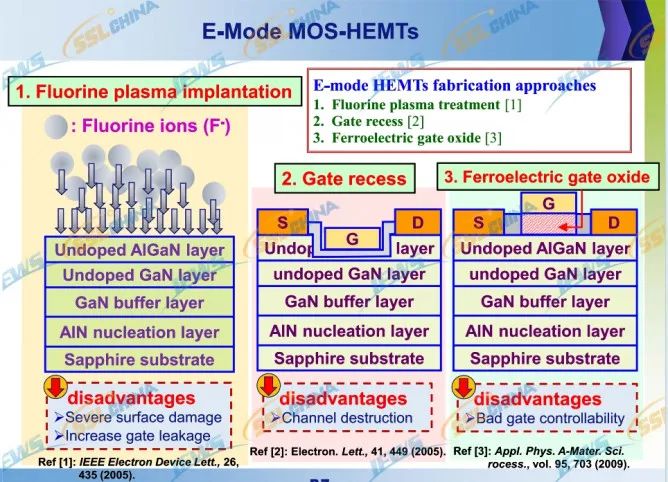
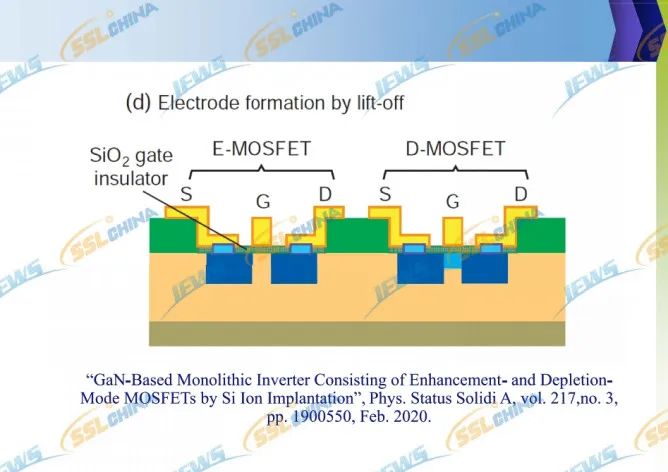
PEC刻蝕與PEC氧化的結(jié)合技術(shù)該方法是制備高性能GaN基MOS器件的一種很有前途的方法。表面處理的MOS HEMT的輸出性能優(yōu)于那些未經(jīng)處理的MOS HEMT。
通過使用氯表面處理,氯處理的MOS HEMT表現(xiàn)出更高的輸出性能。(NH4)2Sx處理的MOS HEMT的性能得到了改善歸因于表面態(tài)密度的降低,導致Al和Ga懸空鍵的減少與Al-S的鈍化和Ga-S鍵。
氯處理的MOS HEMT的性能得到了改善歸因于表面態(tài)密度的降低Al和Ga懸空鍵的減少以及GaOx和AlOx的N空位。ZnO柵極介電層與表面的結(jié)合技術(shù)處理是制備高性能MOS的一種很有前途的方法裝置。
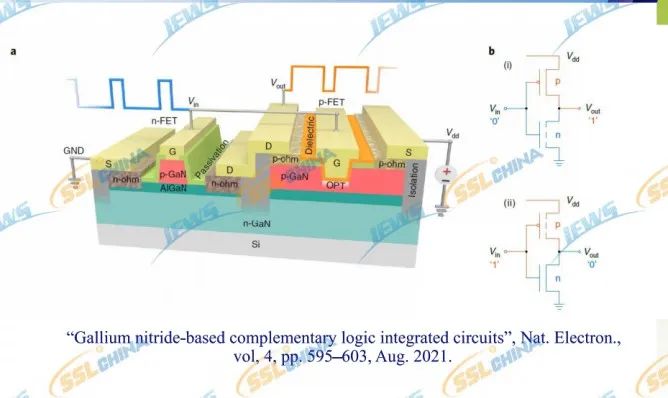
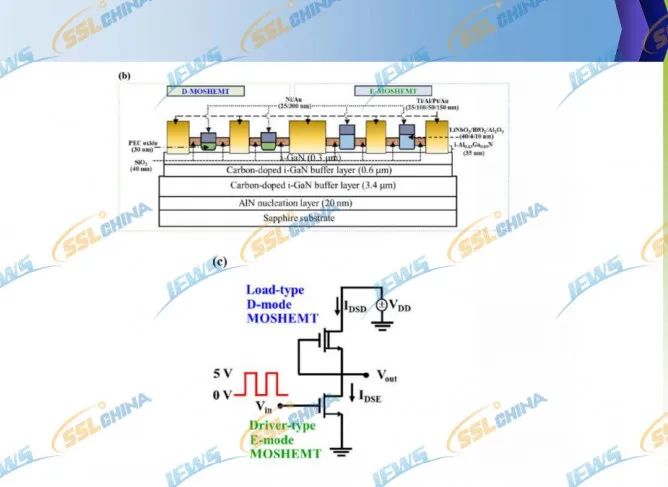
AlGaN上的LiNbO3薄膜具有c+極化特性后退火處理后的極化強度。鐵電體LNO薄膜的特性可以有效地補償壓電特性和AlGaN層與GaN層。采用組合柵技術(shù)成功地制備了E型MOS-HEMT凹陷結(jié)構(gòu)和150nm厚的LiNbO3柵極氧化物。閾值晶體管的電壓(Vth)和跨導(Gmmax)約為+0.4V和89.7mS/mm成功地制備了具有E/D型晶體管的CMOS HEMT帶電流比(β)共10個。當輸入信號為5Vp-p時,輸出擺幅為4.7Vp-p,并且噪聲裕度高和低分別為約1.8V和1.6V。
審核編輯:劉清
-
反相器
+關(guān)注
關(guān)注
6文章
316瀏覽量
44202 -
晶體管
+關(guān)注
關(guān)注
77文章
10009瀏覽量
141346 -
GaN
+關(guān)注
關(guān)注
19文章
2193瀏覽量
76596 -
PEC
+關(guān)注
關(guān)注
0文章
19瀏覽量
20887
原文標題:李清庭教授:GaN基單片電子器件的集成互補金屬氧化物半導體D模和E模高電子遷移率晶體管
文章出處:【微信號:第三代半導體產(chǎn)業(yè),微信公眾號:第三代半導體產(chǎn)業(yè)】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
東京大學開發(fā)氧化銦(InGaOx)新型晶體管,延續(xù)摩爾定律提供新思路

高電子遷移率晶體管介紹

有機半導體材料及電子器件電性能測試方案
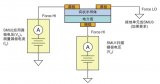
《電子技術(shù)基礎(chǔ)》(模電+數(shù)電)教材配套課件PPT
金屬氧化物和柔性石墨烯MOS的區(qū)別

如何通過霍爾效應(yīng)測量半導體中電子和空穴的遷移率?






 GaN基單片電子器件的集成互補金屬氧化物半導體D模和E模高電子遷移率晶體管
GaN基單片電子器件的集成互補金屬氧化物半導體D模和E模高電子遷移率晶體管












評論