在材料科學(xué)的研究領(lǐng)域,隨著對(duì)物質(zhì)微觀結(jié)構(gòu)探索的不斷深入,對(duì)于樣品制備技術(shù)的要求也在不斷提高。超高分辨率電鏡(HREM)技術(shù)的發(fā)展,已經(jīng)將分辨率推進(jìn)到了0.2納米以下,這使得科學(xué)家們能夠從原子級(jí)別上揭示物質(zhì)的內(nèi)在特性。然而,這種高分辨率的實(shí)現(xiàn)對(duì)樣品制備技術(shù)提出了更為嚴(yán)格的要求。傳統(tǒng)的制樣技術(shù),例如離子減薄和電解雙噴等方法,已經(jīng)無(wú)法滿足當(dāng)前科研的需求。在這種背景下,聚焦離子束(FIB)技術(shù)因其技術(shù)的成熟和成本的降低(從數(shù)萬(wàn)元降至幾千元),逐漸成為科研人員的新選擇。
FIB技術(shù)在透射樣品制備中的應(yīng)用
1. 精確定位:
首先在藍(lán)寶石襯底上的GaN/AlGaN材料中,通過(guò)電極線精確定位切割點(diǎn),并沉積Pt金屬以形成約2um*10um的矩形框架。
2. 制備凹槽:
在框架兩側(cè)制備凹槽,深度一般為3~5um,長(zhǎng)度需超過(guò)15um,這一步驟與樣品的具體結(jié)構(gòu)密切相關(guān)。
3. 切割樣品:
切斷樣品的一個(gè)側(cè)面和底面,以便后續(xù)將探針引入樣品上方。
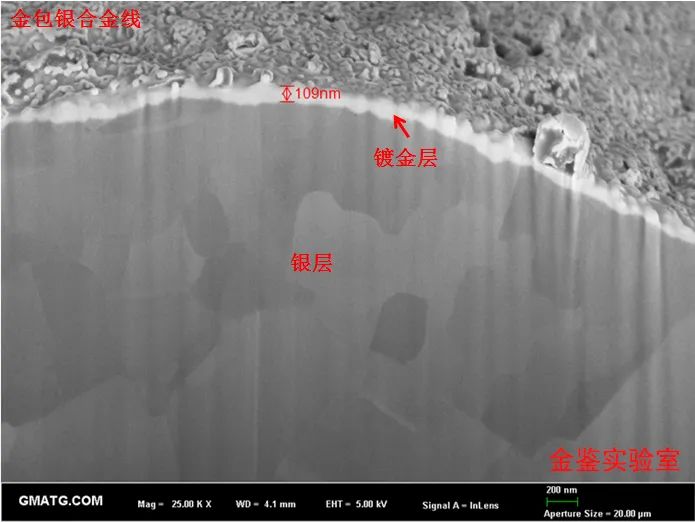
FIB切割金包銀合金線
4. 探針與樣品的連接:
通過(guò)控制程序切割探針針尖,形成平面與樣品片頂部進(jìn)行焊接,并取出樣品片。
5. 樣品焊接:
將樣品片焊接到樣品托的金手指尖端,為后續(xù)的減薄和拋光做準(zhǔn)備。
6. 樣品減薄和拋光:
通過(guò)調(diào)整束流和電壓,對(duì)樣品進(jìn)行反復(fù)的減薄和拋光,直至樣品厚度達(dá)到50~100nm。
7. 完成樣品制備:
經(jīng)過(guò)上述步驟,透射樣品的制備工作完成,隨后進(jìn)行觀察分析。
國(guó)內(nèi)FIB資源概況
國(guó)內(nèi)眾多科研機(jī)構(gòu)裝備了各種型號(hào)的FIB設(shè)備,為科研人員提供了便利的查詢和使用渠道。這些資源的集中分布,不僅促進(jìn)了材料科學(xué)研究的發(fā)展,也顯示了FIB技術(shù)在國(guó)內(nèi)的廣泛應(yīng)用和普及趨勢(shì)。

此外,F(xiàn)IB技術(shù)在半導(dǎo)體、生物醫(yī)學(xué)、地質(zhì)學(xué)等多個(gè)領(lǐng)域也有著廣泛的應(yīng)用前景。
-
材料
+關(guān)注
關(guān)注
3文章
1335瀏覽量
27818 -
fib
+關(guān)注
關(guān)注
1文章
97瀏覽量
11368
發(fā)布評(píng)論請(qǐng)先 登錄
聚焦離子束技術(shù)在透射電子顯微鏡樣品制備中的應(yīng)用

聚焦離子束(FIB)技術(shù)的應(yīng)用原理
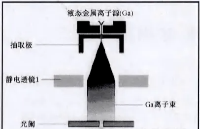
透射電鏡與 FIB 制樣技術(shù)解析

雙束聚焦離子束-掃描電鏡(FIB):TEM樣品制備

聚焦離子束FIB在失效分析技術(shù)中的應(yīng)用-剖面制樣
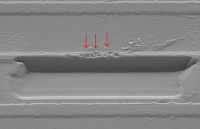
氬離子切拋技術(shù)在簡(jiǎn)化樣品制備流程中的應(yīng)用

聚焦離子束(FIB)在加工硅材料的應(yīng)用

TEM樣本制備:透射電子顯微鏡技術(shù)指南

詳細(xì)解讀——FIB-SEM技術(shù)(聚焦離子束)制備透射電鏡(TEM)樣品

氬離子拋光在電鏡樣品制備中的優(yōu)勢(shì):超越FIB的大面積處理能力

透射電鏡(TEM)樣品制備方法

制備透射電鏡及掃描透射電鏡樣品的詳細(xì)步驟
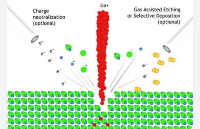
TEM樣品制備中載網(wǎng)的選擇技巧
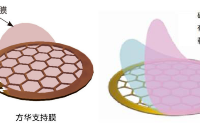
FIB在TEM樣品制備中的利與弊
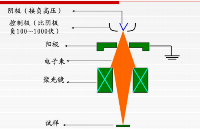





 FIB技術(shù)在透射樣品制備中的應(yīng)用
FIB技術(shù)在透射樣品制備中的應(yīng)用












評(píng)論