以下文章來源于SOC磁測試之家,作者SOC磁測試之家
引言:WAT為什么要測Vth?
在芯片制造的納米世界里,閾值電壓(Threshold Voltage, Vth)如同人體的“血壓值”——微小偏差即可導致系統性崩潰。作為晶圓接受測試(WAT)的核心指標之一,Vth直接決定晶體管的開關特性、功耗水平與信號完整性。本文將深入拆解Vth的測試原理、工藝關聯及行業應用,揭示這項參數如何牽動半導體制造的全局。
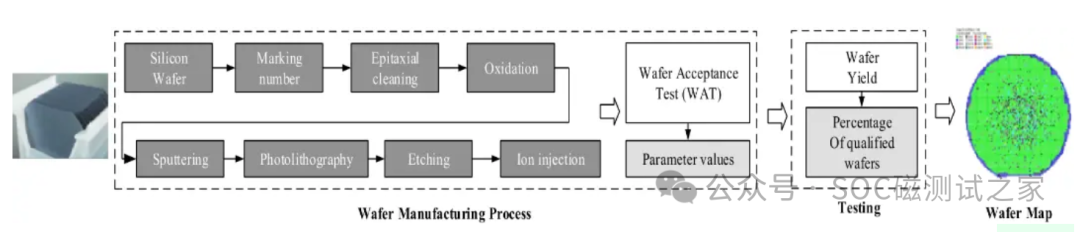
01Vth的本質:晶體管開關的“臨界點”
1. 物理定義
Vth指使MOSFET晶體管溝道形成導通所需的最低 柵極電壓 。當柵極電壓(Vg)達到Vth時,源漏極間開始形成導電通道(反型層),電流(Ids)顯著上升。
2. 工程意義
性能指標 :Vth越低,晶體管開啟速度越快,但漏電流(Ioff)增加;
功耗平衡 :Vth升高可降低靜態功耗,但會犧牲運算速度;
工藝標尺 :Vth波動反映柵氧化層厚度、摻雜濃度等核心工藝參數的穩定性。
行業標準 :在先進制程中,Vth的批次內波動需控制在±5%以內,否則將導致芯片性能離散甚至功能失效。
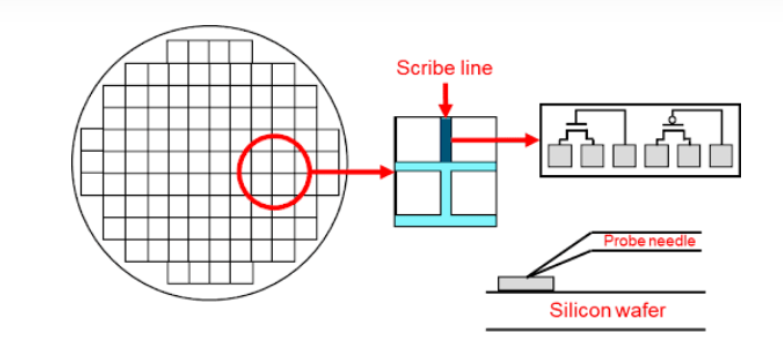
02WAT如何測試Vth?——從結構設計到數據采集
1. 專用測試結構設計
WAT通過以下特殊結構測量Vth:
Test Key的放置點布置:
在進行 WAT 測試之前,合理選擇和布置測試點是至關重要的一步。測試點的位置和數量直接關系到測試的準確性和工藝評估的全面性。
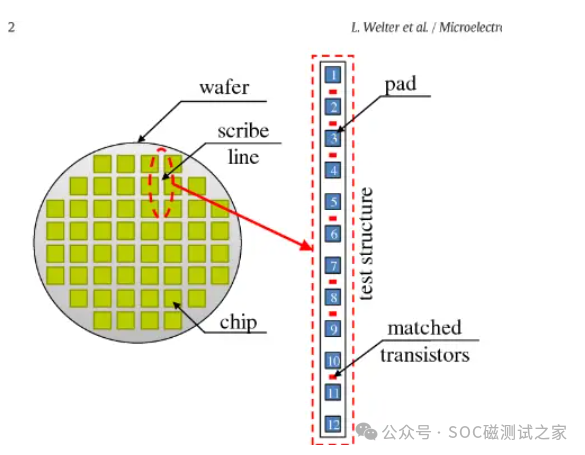
Van der Pauw結構 :用于提取載流子遷移率,輔助Vth計算
環形振蕩器(Ring Oscillator) :通過振蕩頻率反推Vth
單晶體管測試單元 :最直接的Vth測量結構
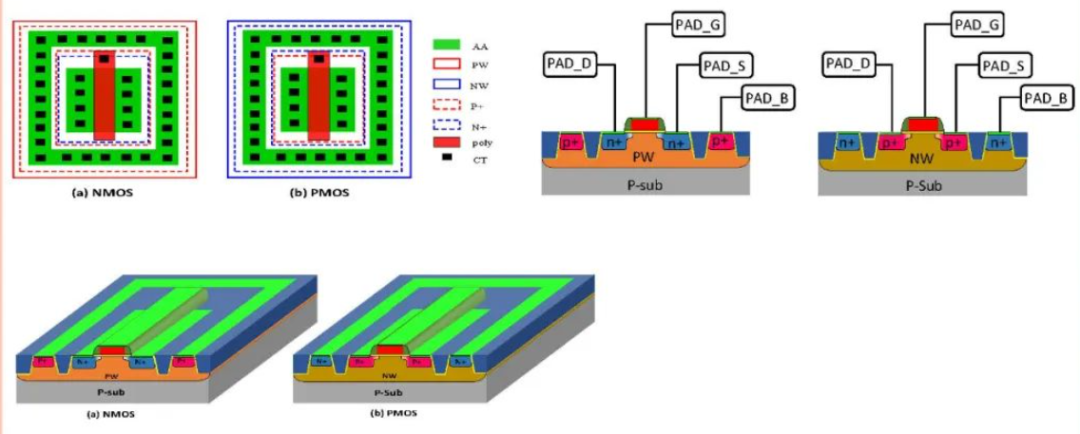
2. 測試設備與流程

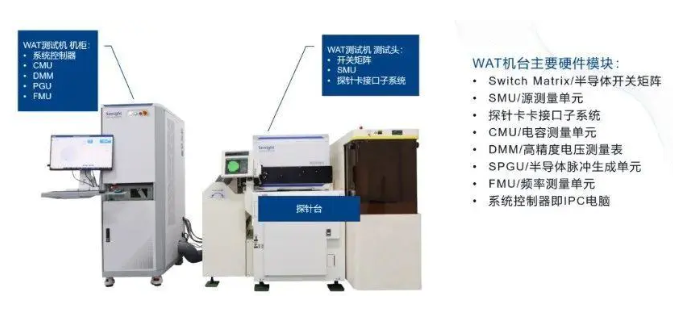
測試方法 :
線性區法 :固定Vd(漏極電壓)為0.1V,掃描Vg,取Ids=100nA·(W/L)對應電壓為Vth(適用于長溝道器件)
飽和區法 :固定Vd>Vg-Vth,通過外推Id-Vg曲線斜率確定Vth(短溝道器件主流方法)


03Vth異常背后的工藝“破案”邏輯
1. 關鍵工藝影響因素

2. 異常數據診斷流程
晶圓圖分析 :發現Vth呈現“同心圓”分布 → 指向爐管工藝溫度梯度問題
相關性檢驗 :Vth與柵極電容(Cox)強相關 → 鎖定氧化層厚度異常
根本原因追溯 :檢查CVD設備氣流分布 → 發現反應腔邊緣沉積速率偏低
經典案例 :
臺積電5nm危機 :某批次Vth偏移8%,經WAT數據分析發現EUV光刻膠殘留導致柵極形變,緊急升級顯影工藝后挽回數萬片晶圓損失。
中芯國際成熟制程優化 :通過WAT監控發現Vth隨晶圓位置規律性波動,最終定位至離子注入機掃描機構校準偏差,調整后良率提升12%。
04Vth測試的未來挑戰
1. 三維結構測試難題
FinFET/GAA晶體管 :三維溝道使傳統測試方法失效,需開發基于TCAD仿真的新型Vth提取算法
解決方案 :應用機器學習預測Vth與鰭片寬度的非線性關系(如ASML與IMEC合作項目)
2. 量子效應干擾
在3nm以下制程,量子隧穿效應導致Vth隨溫度劇烈波動
行業探索 :引入低溫WAT測試(-50℃),結合多物理場建模解析量子效應
3. 測試效率瓶頸
3D堆疊芯片需測試數千個TSV通孔對應的局部Vth,傳統探針臺速度無法滿足
突破方向 :應用超導探針技術(日本Advantest已實現100GHz高頻測試)
結語:Vth測試——半導體行業的“微觀戰場”
從一片晶圓的參數檢測到全球半導體產業鏈的博弈,Vth這個納米級的參數,實則是技術實力的微觀投射。當芯片制程逼近物理極限,Vth測試的精度將直接決定誰能掌控下一代技術的制高點。Vth不僅為晶圓的電氣性能提供了可靠的數據支持,也為制造工藝的穩定性和一致性提供了有效的監控手段。通過對電學參數的精確測量和深入分析,WAT測試能夠及時識別制造過程中的問題,進而指導工藝調整,從而提升晶圓的良率和整體產品質量。
-
半導體
+關注
關注
335文章
28801瀏覽量
235786 -
晶圓
+關注
關注
53文章
5138瀏覽量
129585 -
芯片制造
+關注
關注
10文章
682瀏覽量
29642
原文標題:晶圓接受測試(WAT):Vth測試解析
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
解答74HC14中正向閾值電壓和負向閾值電壓是什么/電壓為多少
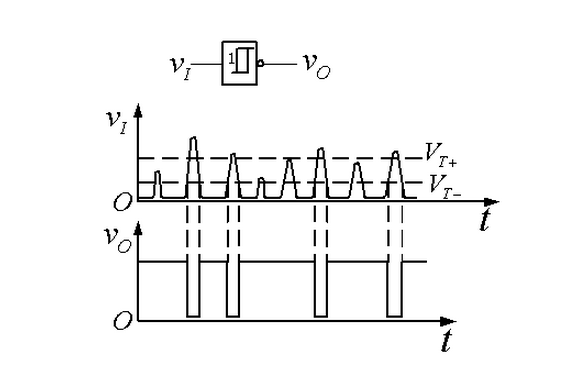
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
影響第三代半導體SiC MOS閾值電壓不穩定的因素有哪些?如何應對?
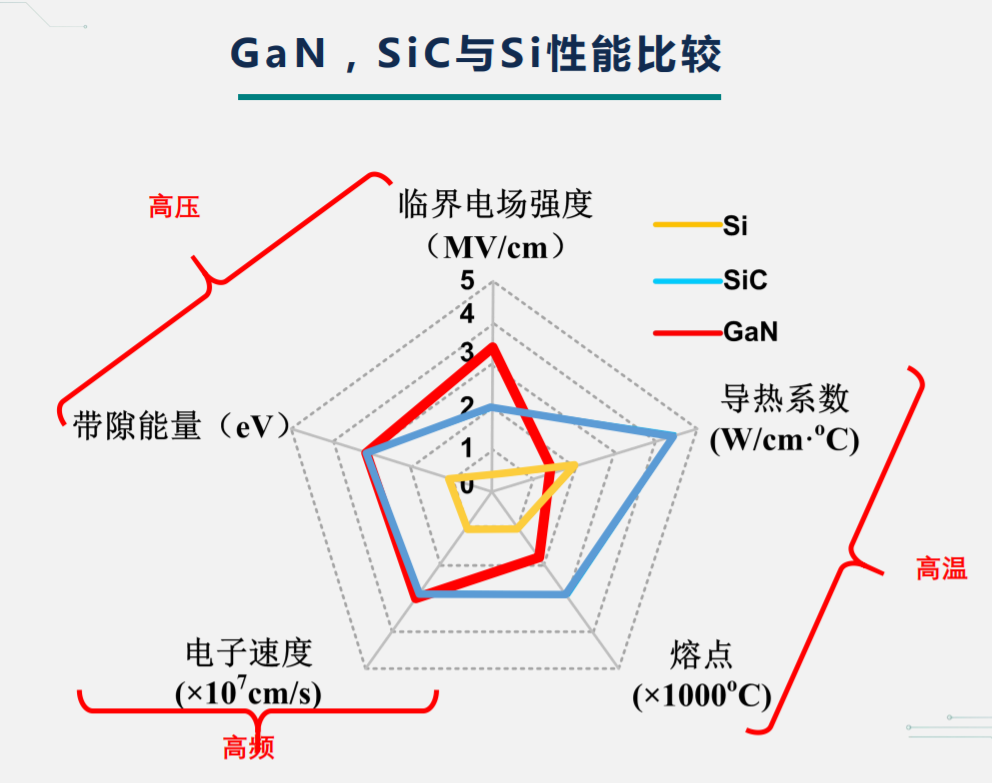
影響MOSFET閾值電壓的因素
什么是MOS管亞閾值電壓?MOSFET中的閾值電壓是如何產生的?
MOSFET閾值電壓是什么?影響MOSFET閾值電壓的因素有哪些?

MOS管的閾值電壓是什么
WAT晶圓接受測試簡介
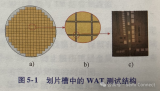





 晶圓接受測試中的閾值電壓測試原理
晶圓接受測試中的閾值電壓測試原理













評論