遠(yuǎn)程視頻會議系統(tǒng)硬件設(shè)備主控芯片填充膠加固補(bǔ)強(qiáng)點(diǎn)膠應(yīng)用由漢思新材料提供

客戶產(chǎn)品:遠(yuǎn)程視頻會議系統(tǒng)硬件設(shè)備
用膠部位:主控芯片:集成電路-
客戶問題點(diǎn):
終端客戶反饋產(chǎn)品異常,客戶分析是主控芯片在運(yùn)輸途中主控芯片受機(jī)械振動(dòng)應(yīng)力影響,連接受損。
漢思新材料推薦用膠:
基于以上信息我公司推薦樣膠漢思HS710底部填充膠供客戶測試。
-
芯片
+關(guān)注
關(guān)注
459文章
52383瀏覽量
439100 -
芯片封裝
+關(guān)注
關(guān)注
11文章
576瀏覽量
31371
發(fā)布評論請先 登錄
蘋果手機(jī)應(yīng)用到底部填充膠的關(guān)鍵部位有哪些?

漢思新材料HS711板卡級芯片底部填充封裝膠

芯片底部填充膠填充不飽滿或滲透困難原因分析及解決方案

漢思新材料:車規(guī)級芯片底部填充膠守護(hù)你的智能汽車

哪家底部填充膠廠家比較好?漢思底填膠優(yōu)勢有哪些?

先進(jìn)封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

塑封芯片多大才需要點(diǎn)膠加固保護(hù)?

電子產(chǎn)品主板點(diǎn)膠是怎么回事,為什么手機(jī)數(shù)碼產(chǎn)品芯片需要點(diǎn)膠?

芯片封裝膠underfill底部填充膠點(diǎn)膠工藝基本操作流程

詳解點(diǎn)膠工藝用途和具體要求?
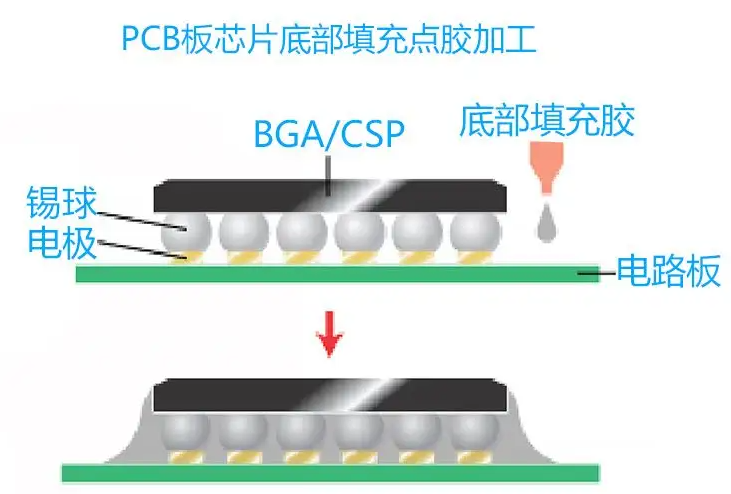





 遠(yuǎn)程視頻會議系統(tǒng)硬件設(shè)備主控芯片填充膠加固補(bǔ)強(qiáng)點(diǎn)膠應(yīng)用
遠(yuǎn)程視頻會議系統(tǒng)硬件設(shè)備主控芯片填充膠加固補(bǔ)強(qiáng)點(diǎn)膠應(yīng)用


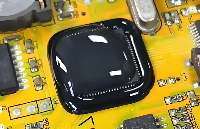













評論