即使采用所有最新技術(shù)并采用 3.5D 封裝,控制熱量仍然是一項挑戰(zhàn),但將熱效應(yīng)與其他組件隔離的能力是當(dāng)今可用的最佳選擇,并且可能在未來很長一段時間內(nèi)都是如此。不過,還有其他問題需要解決。即使是2.5D也不容易,而且很大一部分 2.5D 實現(xiàn)都是由財力雄厚的大型系統(tǒng)公司定制設(shè)計的。
剩下的一大挑戰(zhàn)是收斂時序,以便信號在幾分之一秒內(nèi)到達(dá)正確位置。隨著芯片中添加更多元素,這變得越來越困難,而在 3.5D 或 3D-IC 中,這可能非常復(fù)雜。
Synopsys研發(fā)總監(jiān) Sutirtha Kabir 表示:“時序最終是關(guān)鍵。我們無法保證無論在何種溫度下,您都可以使用相同的時序庫。因此,問題在于您需要進行多少熱感知和紅外感知時序?這些都是大型系統(tǒng)。您必須確保您的簽核是一致的。會出現(xiàn)兩件事。有很多多物理效應(yīng)都聚集在一起。是的,您可以按照傳統(tǒng)方式一次完成一個簽核,但效果不會很好。您需要弄清楚如何同時解決這些問題。最終,您是在進行一個設(shè)計。它不是一個用于熱、一個用于紅外、一個用于時序的設(shè)計。第二件事是數(shù)據(jù)正在激增。您如何高效地處理數(shù)據(jù),因為您不能等待數(shù)天的運行、模擬和分析?”
物理封裝這些設(shè)備也不容易。“這里的挑戰(zhàn)實際上是這些具有不同厚度和不同熱膨脹系數(shù)的各種芯片的熱、電和機械連接,”英特爾的 O‘Buckley 說。“因此,對于三個芯片,您擁有芯片和有源基座,并且它們被大大減薄以使其能夠組合在一起。然后 EMIB 位于基板中。總是需要進行大量的熱機械鑒定工作,不僅要管理封裝,還要確保在最終封裝中(當(dāng)它通過系統(tǒng)級卡連接時進行二級封裝時)這個東西保持在一起。”
根據(jù)對速度的要求,互連和互連材料可能會發(fā)生變化。Arm 的 DeLaCruz 表示:“到目前為止,混合鍵合為您提供了最佳的信號和功率密度。它還為您提供了最佳的熱導(dǎo)率,因為您不需要在芯片之間填充底部填充物,這是一個相當(dāng)大的障礙。這很可能是行業(yè)的發(fā)展方向。這只是一個擁有生產(chǎn)基地的問題。”
多年來,混合鍵合一直用于使用晶圓對晶圓連接的圖像傳感器。“棘手的部分是進入邏輯空間,在那里你要從晶圓對晶圓轉(zhuǎn)移到芯片對晶圓工藝,這更為復(fù)雜,”DeLaCruz 說。“雖然目前成本會更高,但這只是暫時的問題,因為沒有太多的安裝基礎(chǔ)來支持它并降低成本。實際上沒有昂貴的材料或設(shè)備成本。”
所有這些都朝著從菜單中選擇芯片并快速將它們連接到某種經(jīng)過驗證的架構(gòu)的目標(biāo)邁進。這可能需要數(shù)年時間才能實現(xiàn)。但商用芯片將在未來幾年出現(xiàn)在先進設(shè)計中,最有可能出現(xiàn)在帶有定制處理器堆棧的高帶寬內(nèi)存中,未來將有更多芯片走這條路。
這至少部分取決于設(shè)計、制造和測試流程的標(biāo)準(zhǔn)化程度。“我們看到很多 2.5D 客戶能夠保護硅中介層,”Amkor Technology 設(shè)計中心副總裁 Ruben Fuentes 表示。 “這些客戶希望將他們的芯片放在中介層上,然后將整個模塊放在倒裝芯片基板封裝上。我們也有客戶說他們不想使用硅中介層,或者無法保護它們。他們考慮/審查使用 S-SWIFT 或 S-Connect 的 RDL 互連,后者在非常密集的區(qū)域用作中介層。”
但是,這些領(lǐng)先設(shè)計中至少有三分之一僅供內(nèi)部使用,其余設(shè)計僅限于大型處理器供應(yīng)商,其余市場尚未趕上。一旦趕上,這將推動規(guī)模經(jīng)濟,并為更完整的封裝設(shè)計套件、商業(yè)芯片和更多定制選項打開大門。
“大家通常都朝著同一個方向發(fā)展,”Fuentes 說。“但并非所有東西都一樣高。HBM 是預(yù)封裝的,比 IC 更高。HBM 內(nèi)部可以堆疊 12 或 16 個 IC。從共面性和熱角度以及不同層上的金屬平衡來看,這會產(chǎn)生影響。因此,現(xiàn)在供應(yīng)商很難處理所有這些數(shù)據(jù),因為突然間你擁有了比標(biāo)準(zhǔn)封裝數(shù)據(jù)庫大得多的龐大數(shù)據(jù)庫。我們看到了橋梁、S-Connect、SWIFT,然后是 S-SWIFT。這是一個新領(lǐng)域,我們看到封裝工具的性能差距。這里需要做很多工作,但軟件供應(yīng)商一直非常積極地尋找解決方案。此外,這些封裝需要布線。自動布線有限,因此仍然需要大量交互式布線,因此需要大量時間。”
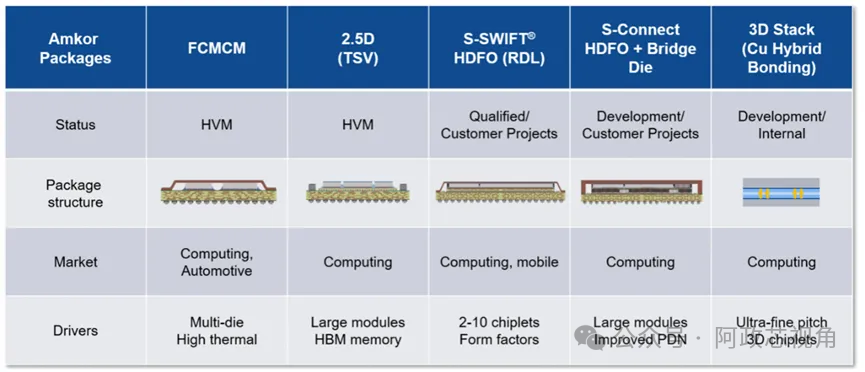
圖4:封裝路線圖分別顯示了模塊和芯片的橋接和混合鍵合連接。資料來源:Amkor Technology
3.5D 面臨的關(guān)鍵挑戰(zhàn)是經(jīng)過驗證的可靠性和可定制性 — 這些要求看似相互矛盾,而且超出了任何一家公司的控制范圍。實現(xiàn)所有這些目標(biāo)需要四個主要部分。
EDA 是這個難題的第一個重要部分,而挑戰(zhàn)不僅僅局限于單個芯片。“IC 設(shè)計師必須同時考慮很多事情,比如熱、信號完整性和電源完整性,”Synopsys 技術(shù)產(chǎn)品管理總監(jiān) Keith Lanier 表示。“但除此之外,在人們的工作方式方面還有一種新的模式。傳統(tǒng)封裝人員和 IC 設(shè)計師需要密切合作,才能使這些 3.5D 設(shè)計取得成功。”
這不僅僅是用相同或更少的人做更多的事情。它還涉及用不同的人做更多的事情。“這需要理解架構(gòu)定義、功能要求、約束,并對其進行明確定義,”Lanier 說。“但同時也需要可行性,包括分區(qū)和技術(shù)選擇,然后是原型設(shè)計和平面規(guī)劃。這需要生成大量數(shù)據(jù),并且需要分析驅(qū)動的探索、設(shè)計和實施。而人工智能將需要幫助設(shè)計師和系統(tǒng)設(shè)計團隊管理這些 3.5D 設(shè)計的復(fù)雜性。”
工藝/裝配設(shè)計套件是第二個關(guān)鍵部件,這很可能由代工廠和OSAT共同承擔(dān)。“如果客戶想要一個用于 2.5D 封裝的硅中介層,那么制造中介層的代工廠就應(yīng)該提供 PDK。我們將為我們所有的先進技術(shù)提供 PDK,例如 S-SWIFT 和 S-Connect 封裝,”Amkor 的 Fuentes 說道。
設(shè)定現(xiàn)實的參數(shù)是難題的第三部分。雖然處理元件的類型和一些模擬功能可能會發(fā)生變化——尤其是那些涉及電源和通信的功能——但大多數(shù)組件將保持不變。這決定了哪些可以預(yù)先構(gòu)建和預(yù)先測試,以及封裝的速度和難易程度。
“許多正在部署的標(biāo)準(zhǔn),如 UCIe 接口和 HBM 接口,正在朝著 20% 定制、80% 上架的方向發(fā)展,”英特爾的 O’Buckley 表示。“但我們今天還沒有達(dá)到這個水平。在我們的客戶部署這些產(chǎn)品的規(guī)模上,花費額外時間優(yōu)化實施的經(jīng)濟效益只是小數(shù)點后一位。它沒有利用 80/20 標(biāo)準(zhǔn)。我們會到達(dá)那里。但是由于這些設(shè)計所需的成本和規(guī)模,大多數(shù)設(shè)計都數(shù)不過來。在基于標(biāo)準(zhǔn)的芯片基礎(chǔ)設(shè)施成熟之前,那些想在沒有規(guī)模的情況下做到這一點的公司進入的門檻太高了。不過,這還是會發(fā)生的。”
確保流程一致是難題的第四部分。工具和單個流程無需改變。“客戶對于特定工具的結(jié)果有一個‘目標(biāo)’,這通常是計量工具測量的關(guān)鍵尺寸,”Tignis 營銷副總裁 David Park 說道。 “只要有某種‘測量’可以確定某種結(jié)果的好壞,這通常是工藝步驟的結(jié)果,我們就可以預(yù)測不良結(jié)果——工程師必須采取一些糾正或預(yù)防措施——或者我們可以實時優(yōu)化該工具的配方,以使結(jié)果保持在他們想要的范圍內(nèi)。”
帕克指出,有一種控制輸入的秘訣。“工具會做它應(yīng)該做的事,”他說。“然后你測量輸出,看看你偏離了可接受的輸出有多遠(yuǎn)。”
挑戰(zhàn)在于,在 3.5D 系統(tǒng)內(nèi)部,可接受的輸出仍在定義中。許多流程具有不同的容差。定義什么是足夠一致的需要廣泛了解所有部件在特定工作負(fù)載下如何協(xié)同工作,以及需要調(diào)整的潛在弱點在哪里。
“這里的問題之一是,隨著密度越來越高,銅柱越來越小,銅柱和基板之間所需的空間量必須得到嚴(yán)格控制,”Promex 總裁兼首席執(zhí)行官 Dick Otte 表示。“存在沖突——不是因為你制造芯片的方式,因為芯片上通常有銅柱——而是與基板有關(guān)。許多基板技術(shù)本身并不是平坦的。玻璃也存在同樣的問題。你有一塊非常漂亮的平坦玻璃。你要做的第一件事是鋪上一層金屬,然后對其進行圖案化。然后你鋪上一層電介質(zhì),突然你就得到了一個導(dǎo)體所在的腫塊。現(xiàn)在,你要把接觸點放在哪里?所以你總是有一個計劃,那就是所有銅柱都進入的接觸點。但如果我只需要一層,而不需要三層呢?”
在過去十年中,芯片行業(yè)一直在努力尋找一種平衡更快處理速度、特定領(lǐng)域設(shè)計、有限的光罩尺寸和 SoC 擴展的巨大成本的方法。在研究了幾乎所有可能的封裝方法、互連、電力輸送方法、基板和介電材料之后,3.5D 已成為領(lǐng)先者——至少目前如此。
這種方法為芯片行業(yè)提供了一條共同主線,可以在此基礎(chǔ)上開始開發(fā)封裝設(shè)計套件、商用芯片,并填補整個供應(yīng)鏈中缺失的工具和服務(wù)。這最終是否會成為全 3D-IC 的跳板,或成為更有效地使用 3D 堆疊的平臺,還有待觀察。但在可預(yù)見的未來,大型芯片制造商已經(jīng)匯聚在一起,走上了一條前進的道路,以提供數(shù)量級的性能改進和控制成本的方法。未來幾年,業(yè)內(nèi)其他公司將努力鋪平這條道路。
-
封裝
+關(guān)注
關(guān)注
128文章
8618瀏覽量
145139
原文標(biāo)題:3.5D封裝,來了!(下)
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
S32DS v3.5安裝S32k3開發(fā)包失敗的原因?
3D封裝與系統(tǒng)級封裝的背景體系解析介紹

3.5D Chiplet技術(shù)典型案例解讀
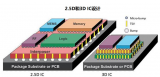
先進封裝技術(shù):3.5D封裝、AMD、AI訓(xùn)練降本

芯片3D堆疊封裝:開啟高性能封裝新時代!

TGV玻璃基板主流工藝詳解
3.5D封裝來了(上)

Cadence如何應(yīng)對AI芯片設(shè)計挑戰(zhàn)
博通股價躍升 或因蘋果與博通合作開發(fā)人工智能芯片的利好刺激
一顆芯片面積頂4顆H200,博通推出3.5D XDSiP封裝平臺
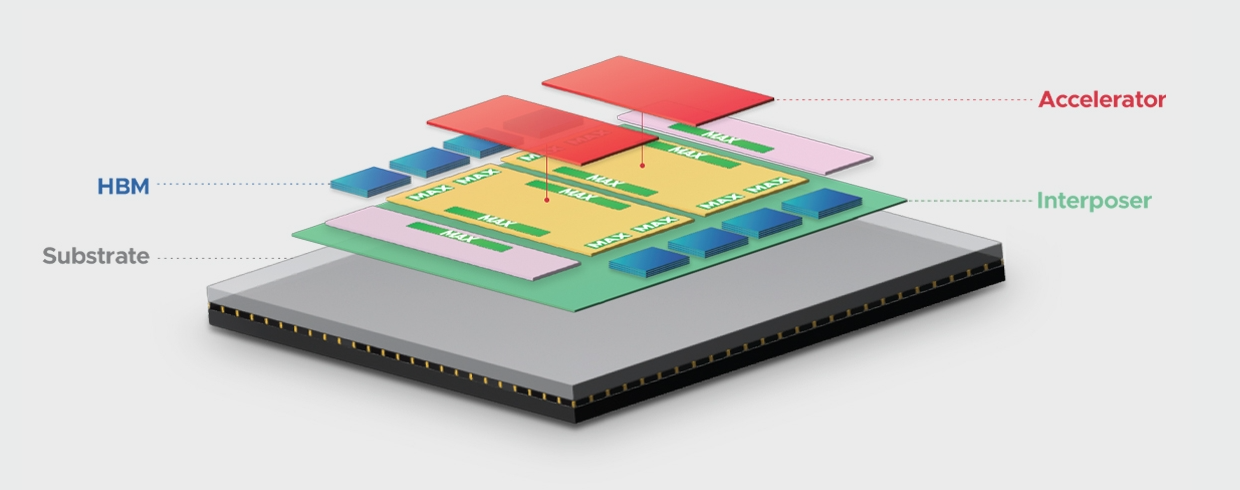
技術(shù)資訊 | 2.5D 與 3D 封裝

一文理解2.5D和3D封裝技術(shù)

什么是3.5D封裝?它有哪些優(yōu)勢?

3D封裝熱設(shè)計:挑戰(zhàn)與機遇并存






 3.5D封裝來了(下)
3.5D封裝來了(下)












評論